Oxford-100-Manual.pdf - 第250页
Plasma lab Ie P 180 Operating window Oxford Instruments Plasma Technology Equipment Manual The operating window of the ICP 180 source in nitrogen is shown in Fig 4. 2500 2000 :!: .. 1500 Gl ~ 0 Q. U. ~ 1000 ll. !d 500 Pr…

Equipment
Manual
Oxford
Instruments
Plasma
Technology
Plasma
lab
ICP
180
3.4 Graphs
of
typical
operating
characteristics
High
ion
flux
to
the
wafer
A
figure
of
merit
for
the
ICP
is
the
ion
current
density
at
the
wafer,
without
RF
applied
to
the
wafer.
This
was measured by using
the
wafer
table
as
an
ion
collection electrode, biased
to
-30 V dc. A
good
figure
to
achieve
is
1
mA
cm-2; much
less
than
this means
the
source
is
not
effective; much
higher
currents are
not
useful because
the
sample
is
heated
too
much.
The
graph
(see
Fig
3)
shows a nearly
linear
increase
of
ion
current
density
with
ICP
power. There
is
no
sign
of
saturation
behaviour
(unlike
ECR),
so
higher
powers could be used
to
get
higher
ion
fluxes
if
reqUired.
The
ICP
180 can
handle
up
to
3
kW
of
RF
power.
1.8
1.6
N
E 1.4
~
E
~ 1.2
'iii
r::
Gl
'C
1:
~
0.8
...
:::l
CJ
r::
0.6
..!2
0.4
0.2
1800160014001200
800 1000
ICPW
600400200
0l--~-4--------~---4----+----l..----------+------i
o
-+-
2 mtorr
_7
mtorr
-.-
60 mtorr I
Fig
3:
Jon current density at the wafer versus JCP power
Printed: 18-Jan-06. 8:44
ICP
180 Source
Page 9
of
26
Issue
3 : December 00
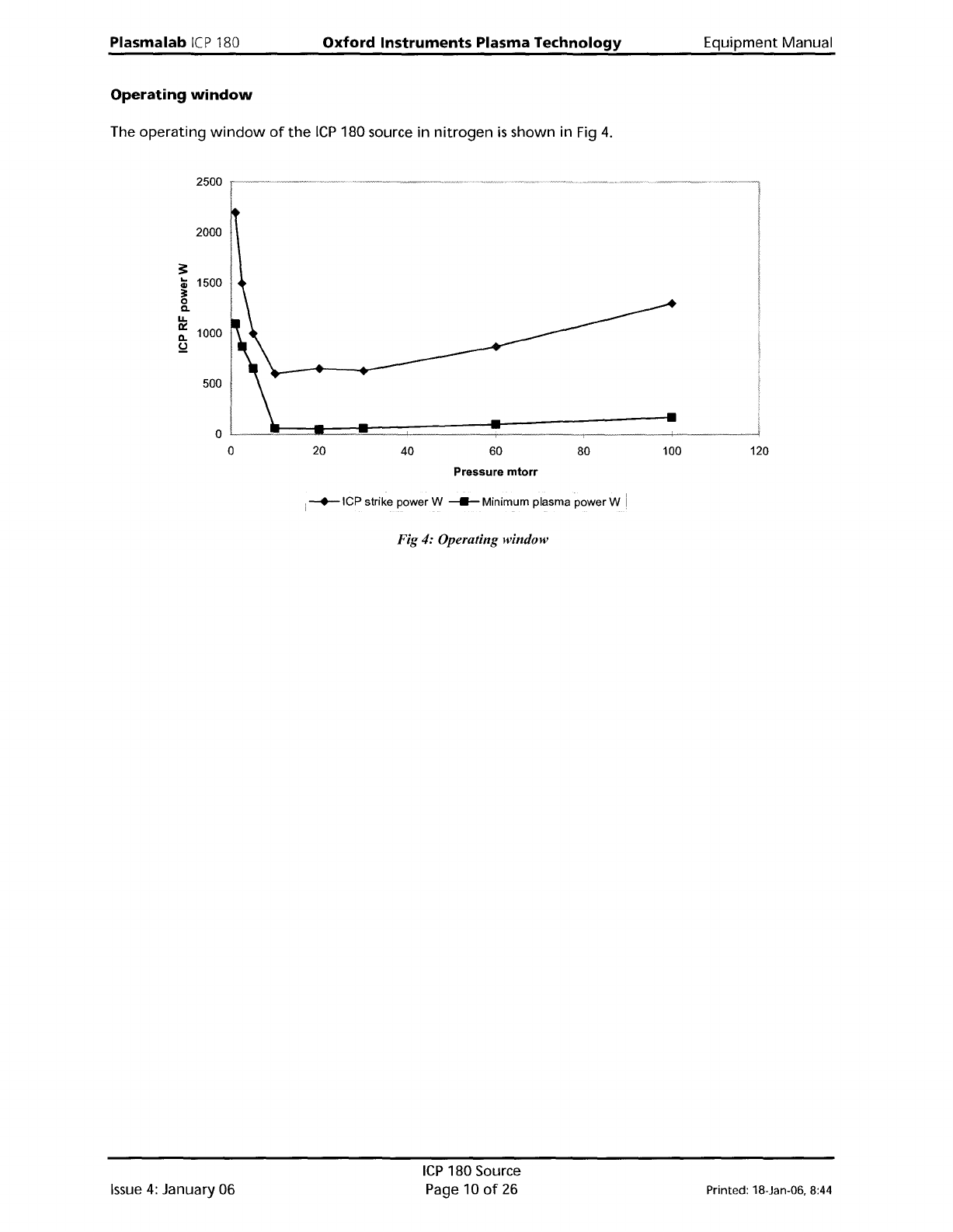
Plasma
lab
Ie
P180
Operating
window
Oxford
Instruments Plasma Technology Equipment Manual
The
operating
window
of
the
ICP
180 source in
nitrogen
is
shown in Fig
4.
2500
2000
:!:
..
1500
Gl
~
0
Q.
U.
~
1000
ll.
!d
500
Pressure
mtorr
i
-+-ICP
strike power W _ Minimum plasma power W
Fig 4: Operating window
Issue
4:
January 06
ICP
180 Source
Page 10
of
26
Printed: 18-Jan-06, 8:44

Equipment
Manual
4.
Installation
Oxford
Instruments
Plasma
Technology
Plasma
lab
rcp
180
&
WARNING
This section applies
if
the
Plasma
lab
IC
P180 source
is
supplied
as
an upgrade,
or
as
an exchangeable
plasma source.
The ICP180
is
installed
as
the
entire
top
lid
to
a
Plasma
lab
System 100,
with
a vacuum 0
ring
on
the
underside
of
the
ICP180 chamber lid. The chamber
lid
is
secured
by
hinges
which
enable
access
to
the
process chamber
interior
for
maintenance.
PINCH POINT -
WHEN
THE CHAMBER LID IS OPENED OR CLOSED, LIMBS,
FINGERS
ETC
CAN
BECOME TRAPPED BETWEEN THE LID
AND
THE PROCESS
CHAMBER BASE RESULTING
IN
SEVERE INJURY.
J----------j
Ensure
that
all
personnel
are
kept
clear
of
the
chamber
lid
when
it
is
opened
or
closed.
When
opening
or
closing
the
chamber
lid,
ensure
that
both
of
your
hands
are
kept
clear
of
the
pinch
point.
When
the
process
chamber
lid
is
to
be
kept
in
its
raised
position
for
prolonged
periods,
ensure
that
it
is
held
safely
in
its
open
position
without
relying
entirely
on
the
gas
support
struts.
After
mechanical
mounting,
connect
the
services
detailed
in
Section 2
of
this manual.
The
RF
generator
services should be connected according
to
the
manufacturer's
manual supplied
with
the
generator.
Printed: 18-Jan-06. 8:44
ICP
180 Source
Page
11
of
26
Issue
3 : December 00