MIL- STD-883F 2004 TEST METHOD STANDARD MICROCIRCUITS - 第221页
MIL-STD-883F METHOD 2010.11 18 June 2004 11 Condition A Conditi on B Class le vel S Class lev el B FIGURE 2010- 9. Terminat ion ends . e. Scratch in the meta llization , over th e e. Scratch in the meta llization , over …

MIL-STD-883F
METHOD 2010.11
18 June 2004
10
Condition A Condition B
Class level S Class level B
FIGURE 2010-8 Scratch criteria for class level B
.
NOTE: For condition B only. Criteria 3.1.1.1a, b, and c
can be excluded for peripheral power or ground
metallization where parallel paths exist such that an open
at the scratch would not cause an unintended isolation of
the metallization path.
d. Scratch in the metallization over a passivation step that leaves less than 75 percent of the original metal width at
the step undisturbed.
NOTE: For condition B only. Criteria 3.1.1.1a, b, c, and
d can be excluded for the last 25 percent of the linear
length of the contact cut and all metal beyond, on the
termination end(s) of the metallization runs. In these
cases there shall be at least 50 percent of the contact
opening area covered by metallization and at least a
continuous 40 percent of the contact opening perimeter
covered by undisturbed metallization (see figure 2010-9).
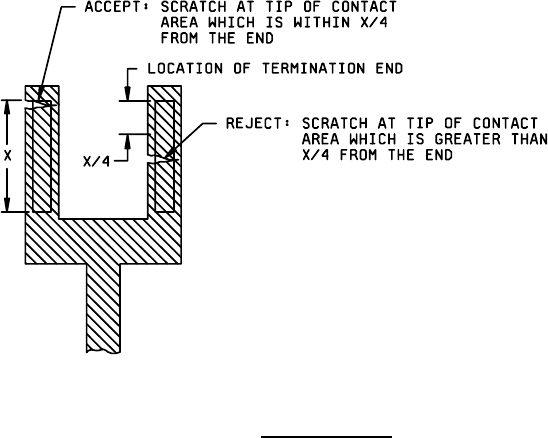
MIL-STD-883F
METHOD 2010.11
18 June 2004
11
Condition A Condition B
Class level S Class level B
FIGURE 2010-9. Termination ends
.
e. Scratch in the metallization, over the e. Scratch in the metallization, over the
gate oxide (applicable to MOS structures gate oxide, that exposes underlying
only) (see figure 2010-10). passivation and leaves less than 50 percent
of the length or width of the metallization
between source and drain diffusion undisturbed
(applicable to MOS structures only) (see figure
2010-11).
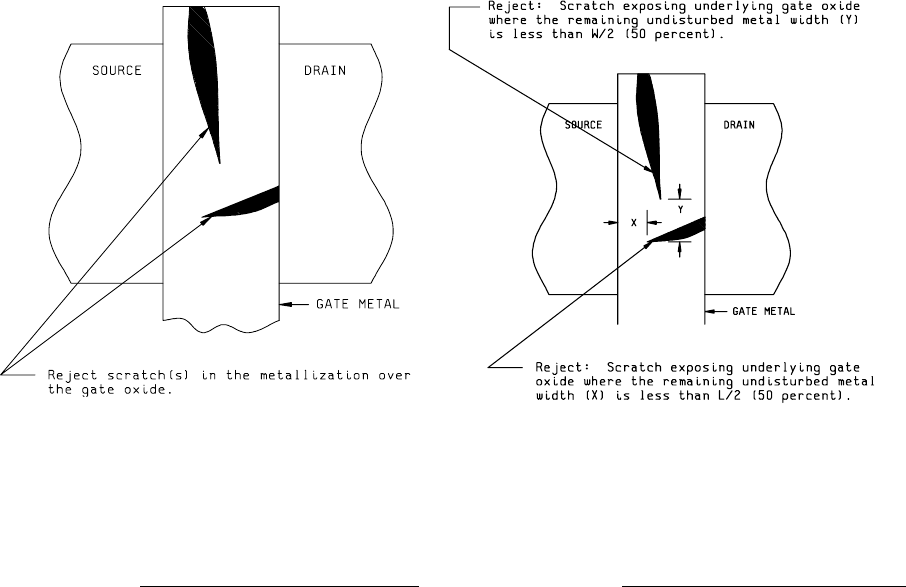
MIL-STD-883F
METHOD 2010.11
18 June 2004
12
Condition A Condition B
Class level S Class level B
FIGURE 2010-10. MOS scratch criteria for class level S
. FIGURE 2010-11. MOS scratch criteria for class level B.