MIL- STD-883F 2004 TEST METHOD STANDARD MICROCIRCUITS - 第245页
MIL-STD-883F METHOD 2010.11 18 June 2004 35 Condition A Conditi on B Class le vel S Class lev el B 3.2 Low power i nspect ion . Int ernal vis ual examinati on as requi red in 3. 2.1 thr ough 3.2.3 s hall be c onducted on…
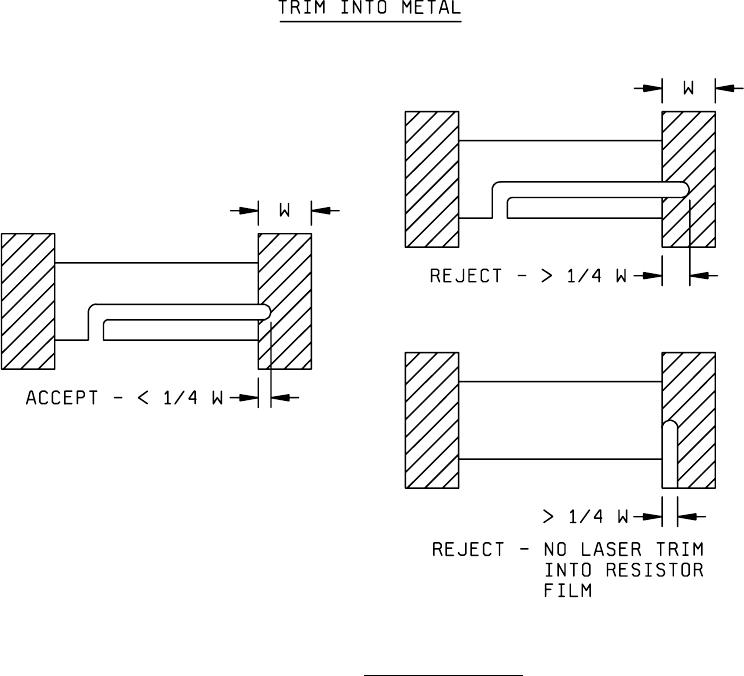
MIL-STD-883F
METHOD 2010.11
18 June 2004
34
Condition A Condition B
Class level S Class level B
e. Trim path into the metallization except block resistors.
NOTE: This criteria can be excluded for trim paths into terminator ends of metallization runs. Conductors or resistors
may be trimmed open for link trims or by design.
f. Trim for block resistors which extends into the metallization (excluding bonding pads) more than 25 percent of the
original metal width (see figure 2010-32).
FIGURE 2010-32. Block resistor criteria
.
g. Pits into the silicon dioxide in the kerf which do not exhibit a line of separation between the pit and the resistor
material.
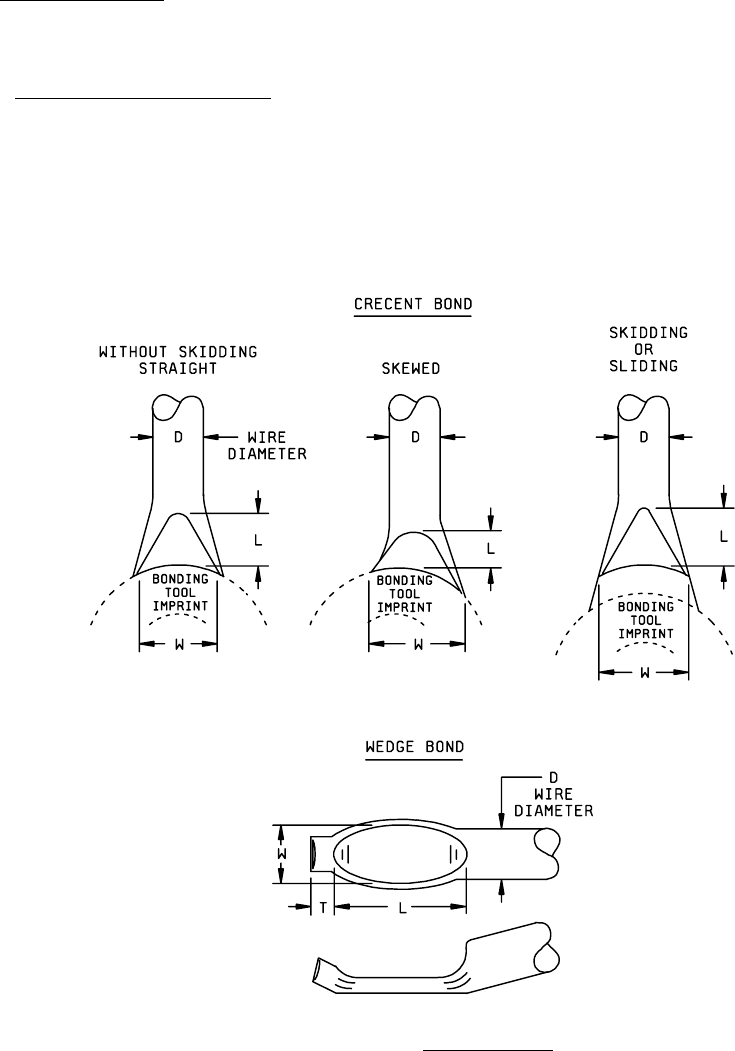
MIL-STD-883F
METHOD 2010.11
18 June 2004
35
Condition A Condition B
Class level S Class level B
3.2 Low power inspection
. Internal visual examination as required in 3.2.1 through 3.2.3 shall be conducted on each
microcircuit at low magnification range of 30X to 60X. In addition, the applicable criteria contained in 3.2.4 shall be
applicable where beam lead assembly technology is used and 3.2.5 shall be inspected at both high and low power as
indicated, high power magnification shall be same as 3.1, subject to conditions in 3b.
3.2.1 Lower power wire bond inspection
. This inspection and criteria shall be required inspection for the bond type (s)
and location(s) to which they are applicable when viewed from above (see figure 2010-33).
NOTE: The criteria applicable for bonds (called "wedgebonds" or "bonds") in this test method refers to the fully or partially
deformed area including the tool impression shown as "L and W" in figure. The criteria applicable for "bond tails" (or
"tails") in this test method refers to resulting length of bonding wire extending beyond the bond shown as "T" in
figure 2010-33. Tail is not part of bond.
FIGURE 2010-33. Bond dimensions
.

MIL-STD-883F
METHOD 2010.11
18 June 2004
36
Condition A Condition B
Class level S Class level B
3.2.1.1 Gold ball bonds
. No devices shall be acceptable that exhibits:
a. Gold ball bonds on the die or package post wherein the ball bond diameter is less than 2.0 times or greater than
5.0 times the wire diameter.
b. Gold ball bonds where the wire exit is not completely within the periphery of the ball.
c. Gold ball bonds where the wire center exit is not within the boundaries of the unglassivated bonding pad area.
3.2.1.2 Wedge bonds
. No device shall be acceptable that exhibits:
a. Ultrasonic wedge bonds on the die or package post that are less than 1.2 times or more than 3.0 times the wire
diameter in width, or less than 1.5 times or more than 6.0 times the wire diameter in length.
b. Thermosonic wedge bonds on the die or package post that are less than 1.5 times or more than 3.0 times the wire
diameter in width or are less than 1.5 times or more than 6.0 times the wire diameter in length.
c. Bond width less than 1.0 times the wire diameter for aluminum wires 2.0 mils or greater in diameter.
d. Wedge bonds where the tool impression does not cover the entire width of the wire.
3.2.1.3 Tailless bonds (crescent, terminating capillary bond)
. No device shall be acceptable that exhibits:
a. Tailless bonds on the die or package post that are less than 1.2 times or more than 5.0 times the wire diameter in
width, or are less than 0.5 times or more than 3.0 times the wire diameter in length.
b. Tailless bonds where tool impression does not cover the entire width of the wire.