MIL- STD-883F 2004 TEST METHOD STANDARD MICROCIRCUITS - 第405页
MIL-STD-883F METHOD 2031.1 27 July 1990 1 METHOD 2031.1 FLIP-CHIP PULL-OFF TEST 1. PURPOSE . The purpos e of thi s tes t is to measur e the st rength of internal bonds between a s emic onductor die and a subst rate t o w…
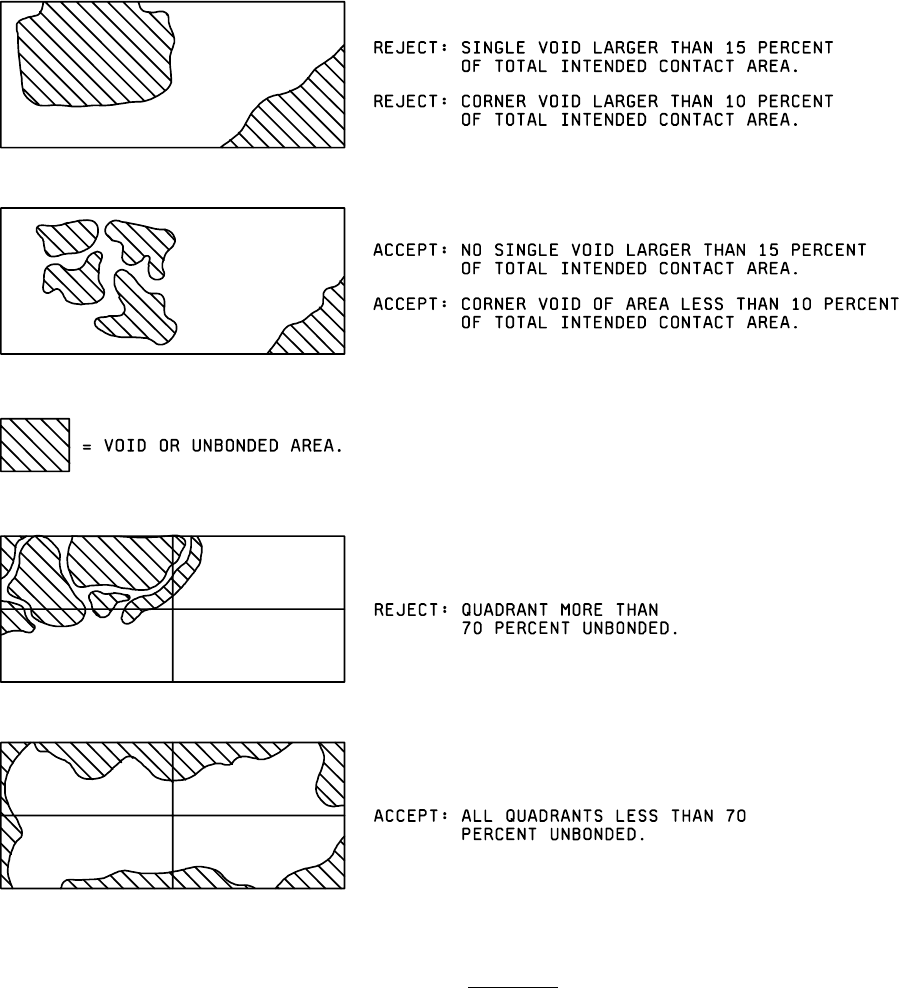
MIL-STD-883F
METHOD 2030
29 May 1987
4
FIGURE 2030-1. Void criteria
.

MIL-STD-883F
METHOD 2031.1
27 July 1990
1
METHOD 2031.1
FLIP-CHIP PULL-OFF TEST
1. PURPOSE
. The purpose of this test is to measure the strength of internal bonds between a semiconductor die and a
substrate to which it is attached in a face-bond configuration.
2. APPARATUS
. The apparatus for this test shall consist of suitable equipment for applying the specified stress to the
bonds. A calibrated measurement and indication of the applied stress in grams force (gf) shall be provided by equipment
capable of measuring stresses up to twice the specified minimum limit value, with an accuracy of ±5 percent or ±0.25 gf,
whichever is the greater tolerance.
3. PROCEDURE
. The test shall be conducted using the following procedure. All die pulls shall be counted and the
specified sampling, acceptance, and added sample provisions shall be observed, as applicable. The sample size number
and accept number specified shall determine the number of die to be tested (not bonds). For hybrid or multichip devices, a
minimum of 4 die or all die if four are not available on a minimum of 2 completed devices shall be used. All pull tests shall
be performed prior to the application of encapsulants, adhesive, or any material which may increase the apparent bond
strength.
When flip chips are bonded to substrates other than those in completed devices, the following conditions shall apply:
a. The sample of chips for this test shall be taken at random from the same chip population as that used in the
completed devices that they are intended to represent.
b. The chips for this test shall be bonded on the same bonding apparatus as the completed devices, during the time
period within which the completed devices are bonded.
c. The test chip substrates shall be processed, metallized, and handled identically with the completed device
substrates, during the same time period within which the completed device substrates are processed.
3.1 Testing
. The calibrated pull-off apparatus (see 2) shall include a pull-off rod (for instance, a current loop of nichrome
or Kovar wire) having a cross-sectional area of 75 percent, +3 percent, -5 percent of the chip surface area. The rod shall
make connection with a hard setting adhesive material (for instance, a cyanoacrylate or other adhesive possessing high
tensile strength) on the back of the flip chip. The substrate shall be rigidly installed in the pull-off fixture and the pull-off rod
shall make firm mechanical connection to the adhesive material. The die shall be pulled without shock, within 5° of the
normal at a rate of 500 grams ±100 grams per second, until the die separates from the substrate. When a failure occurs,
the force at the time of failure, the calculated force limit, and the failure category shall be recorded.
3.2 Failure criteria
. Any flip-chip pull which results in separation under an applied stress less than
500 kg/in
2
x average solder bump area (in
2
) x number of solder bumps shall constitute a failure.
3.2.1 Failure category
. Failure categories are as follows: When specified, the stress required to achieve separation and
the predominant category of separation or failure shall be recorded.
a. Silicon broken.
b. Lifted metallization from chip.
c. Separation at bond-chip interface.
d. Failure within bond.

MIL-STD-883F
METHOD 2031.1
27 July 1990
2
e. Separation at bond-substrate interface.
f. Lifted metallization from substrate.
g. Substrate broken.
4. SUMMARY
. The following details shall be specified in the applicable acquisition document.
a. Minimum bond strength if other than specified in 3.2 or details of required strength distributions if applicable.
b. Sample size number and accept number and selection and the number of die to be tested, if other than 4
c. Requirement for reporting of separation forces and failure categories, when applicable (see 3.2.1).