MIL- STD-883F 2004 TEST METHOD STANDARD MICROCIRCUITS - 第512页
MIL-STD-883F METHOD 3013.1 15 November 1974 8 This page i ntenti onally lef t blank
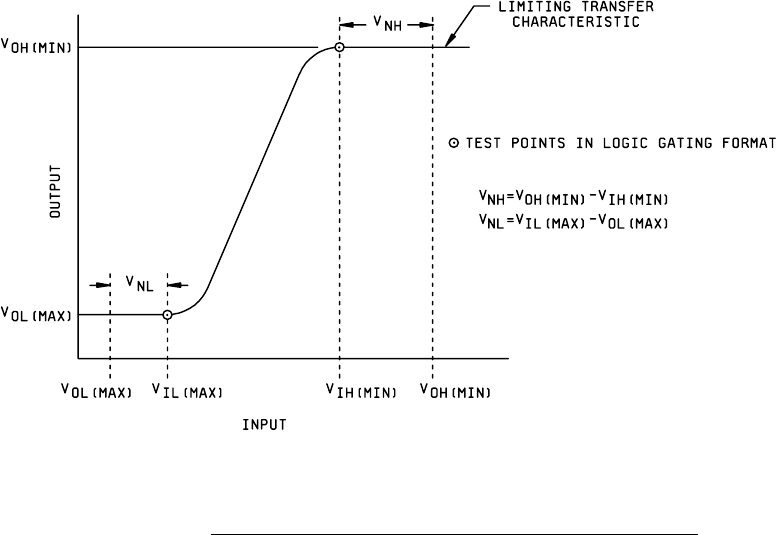
MIL-STD-883F
METHOD 3013.1
15 November 1974
7
FIGURE 3013-3. Noninverting logic gate transfer characteristic defining test points
.
MIL-STD-883F
METHOD 3013.1
15 November 1974
8
This page intentionally left blank

MIL-STD-883F
METHOD 3014
15 November 1974
1
METHOD 3014
FUNCTIONAL TESTING
1. PURPOSE
. This method establishes the means for assuring circuit performance in regard to the test requirements
necessary to verify the specified function and to assure that all logic element paths are not open, stuck-at-HIGH level or
stuck- at-LOW LEVEL. This method applies to digital microelectronic devices, such as TTL, DTL, RTL, ECL, and MOS.
2. APPARATUS
. An instrument shall be provided which has the capability of applying logic patterns (sequentially, if
specified) to the logic network input(s) in accordance with the applicable acquisition document. The test instrument shall
also be capable of applying nominal power supply voltages and monitoring the outputs for the specified logic levels. The
output monitoring circuit may be either a single or double comparator type. The threshold voltage (trip point) for a single
comparator or V
OL
(max) and V
OH
(min) for a double comparator shall be specified in the applicable acquisition document.
The test chamber shall be capable of maintaining the device under test at any specified test temperature.
3. PROCEDURE
. The device shall be stabilized at the specified test temperature. Nominal power supply voltages and
the specified input logic patterns shall be applied to the logic network under test and the output(s) monitored.
4. SUMMARY
. The following details shall be specified in the applicable acquisition document:
a. Test temperature.
b. Power supply voltage.
c. Input voltage levels.
d. Input and output logic patterns.
e. Output threshold voltage (see 2).
f. V
OH
(min) and V
OL
(max) (see 2).