17-2756-ASM Broschüre ASM AP EN_171020 - 第13页
Die Attach & SMT Encapsulation Singulation WLP Inspection, T ext & Packing 3 4 5 Molding with keep-out zone (KOZ) makes ORCAS the ideal solution for subsequent singulation using laser separation. Thanks to specia…

Die Attach & SMTDeposition
1
2
PrintingStencil technology
Whether fan-in, fan-out or embedded
chips – encapsulating and protecting elec-
tronic components in epoxy mold com-
pounds is an important step in WLP/PLP
and SiP processes.
Granulate or liquid epoxy resin, different
EMC patterns, wafers or panels as carri-
ers, the degree of automation – there are
many process details that determine the
requirements for your solution. ORCAS
(Over-molding of Resin Epoxy Compres-
sion Auto-Panel Encapsulation System) is
the most exible option on the market.
Coplanarity Control
Take closed-loop coplanarity control, for
example. Sensors detect thickness
variations in the substrate and adjust the
tooling accordingly. The SCARA wafer
handling robot can handle wafers that are
warped by up to 3 mm. Thanks to copla-
narity control, ORCAS recognizes and
compensates for even the nest variations
in substrate thickness.
ORCAS also features maximum auto-
mation exibility. With manual load, it is
the perfect solution for small-lot and proto-
type manufacturing, while fully automated
substrate handling and other functions
make it a highly ef cient solution for high-
volume production.
Molding
The efficient encapsulation solution for
advanced packaging: ORCAS
12
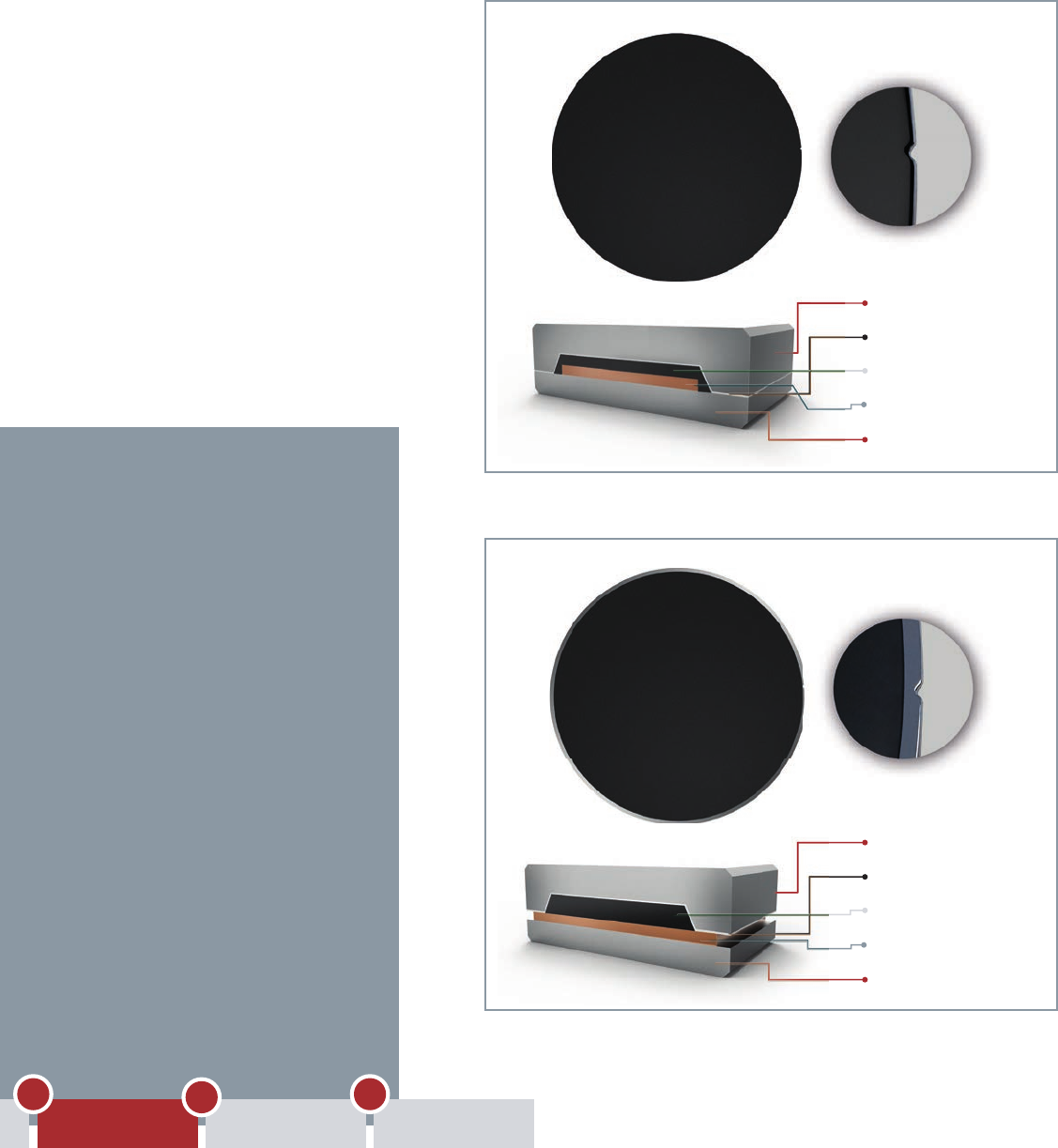
Die Attach & SMT
Encapsulation Singulation
WLP Inspection,
Text & Packing
3
4
5
Molding with keep-out zone (KOZ) makes
ORCAS the ideal solution for subsequent
singulation using laser separation. Thanks
to special tooling, the dicing patterns in the
keep-out zone at the edge of the carrier
remain visible after the molding process.
The laser-dicing process takes place with
exceptional precision and thus, without
any other preparatory steps – a prime
example of how ef ciently process chains
in advanced packaging can be integrated
and improved. The result: Improved yield
rates and the ability to make packaging
even more ef cient.
ORCAS
Quick and efficient molding
▪ Panel sizes up to 340 mm × 340 mm
and 12-inch wafers
▪ Closed-loop press system ensures
excellent coplanarity in large-area
molding applications (TTV: 20 µm)
▪ A highly flexible dispensing system
ensures best compound coverage
by processing liquid and granular
encapsulant
▪ Scalable from small-lot and prototype
manufacturing to high-volume
production
▪ One system for die-up and die-down
molding
▪ Two molding options: Molding,
configurable for with keep-out zone
(KOZ) or overmolding
In KOZ molding the edge of the wafer is not covered with EMC to make
the subsequent singulation process more efficient.
Simply clever:
Molding with keep-out zone
Top Mold Case
Film
Molding Compound
Substrate
Bottom Mold Case
Top Mold Case
Film
Molding Compound
Substrate
Bottom Mold Case
In overmolding the whole wafer is covered with molding
compound to also protect the edges.
13

Die Attach & SMTDeposition
1
2
PrintingStencil technology
Declining component sizes and wafer
thickness, and the desire for more efcien-
cy, i.e. more density on WLP/PLP carriers,
require increasingly accurate and gentle
component singulation capabilities.
Classic saws encounter limitations in
terms of cutting width and accuracy when
they cut into the carrier (for example, with
low-K materials and the resulting threat of
contamination) as well at the end of the
packaging process. In addition, the
packages are subject to mechanical
stresses during the sawing process.
ASM‘s LASER 1205 multi-beam laser
system is the answer to the rising require-
ments in singulation.
At substrate thicknesses of 100 µm, the
cutting width stays below 12-14 µm with a
positioning tolerance of less than < 1 µm.
The machine can cut a wide range of
materials like silicon wafer (Si, SiC etc.)
with thicknesses of up to 250 μm and
EMCs with thicknesses of up to 700 µm.
Thanks to multi-beam technology, signi-
cantly fewer cutting cycles are needed to
separate the wafers. As a result, the ASM
LASER 1205 achieves exceptionally short
cycle times and a correspondingly high
level of productivity.
Singulation
More precision and efficiency:
Singulation with the LASER 1205 multi-beam laser system
LASER 1205
Precise and efficient for silicon and EMC
▪ Enabling technology for fan-in applications
▪ Precise dicing of molding compound and silicon
▪ Higher yield due to minimized dicing street (12-14 µm)
▪ No wafer-chipping since the laser cut is aligned precisely
within the pre-cut position
▪ Seamless transition from fan-in to fan-out with the same basic
packaging platform intact
14