IPC-7095D-CHINESE NP 2019 - 第142页
IPC-7095D-W AM1 CN 2019 年 1 月 126 空洞呈现为焊料球中较亮的区域并通常会在整个封装中随机出现。一些 X 射线系统会扭曲空洞的尺寸。准确测 量空洞的真实体积是可行的, 但需要复杂的程序且需要一个已知的参考基准用于 X 射线胶片或探测器的辐射校准。 BGA 空洞的大小不一定是确定焊点疲劳寿命的最好标准。远离焊点到元器件 / 连接盘界面的大的工艺空洞可 能并不是个问题,然而位于界面的小空洞,一旦裂纹开始就会成为…

IPC-7095D-WAM1 CN2019 年 1 月
125
7.4 测试和产品验证
7.4.1 电气测试
电气测试常用来评估印制板组件的功能。两种常见的电气测试方法是探针测试(ICT 和飞针)
和 FT。
探针测试常用来探测由制造工艺导致的故障,也能隔离出大部分丧失功能的元器件。飞针测试采用机电控制的
探针来访问元器件,而 ICT 采用专用的针床工装夹具。飞针测试较慢,但不像 ICT 一样需要专用工装夹具。
探针测试发现的故障包括:
• 焊料桥连
• 焊点开路
• 元器件方向错误
• 错件
• 元器件失效
• 导体短路
探针测试可在组装结束后通过完整功能测试来补充。取决于产品类型和可接受性要求,产品功能测试简单的可
以如“通过 / 不通过”测试,或复杂的可像全电路功能检查那样。FT 常用来快速检测组件上的器件故障。
7.4.2 功能测试(FT)覆盖
考虑到当前电子组件的复杂度,测试的“覆盖”水平已成为业界的一大问题。
印制板或印制板组件越复杂,完整的测试越困难。在合理的时间(即成本效益)内,即使对组件的合理部分进
行测试可能也是困难的。
FT 是在生产线的最后阶段进行的。它模拟产品预期的运行环境。这样做是为了检查和纠正任何功能问题,它
通常只有在良率高时有效。
尽管将测试整合到硅器件中可能有助于印制板组件的测试,但这种策略却并不适用于印制板。测试的挑战在于
在合理的时间范围内提供一个高置信水平的测试覆盖。
7.4.3 老化测试
老化测试是完整印制板组件在应用上极限下的运行和环境测试。这种测试通常能发现比焊点
缺陷更多的与元器件相关的问题。老化测试仍用作对元器件评估。得益于某些形式的加速试验暴露可筛选出处
于失效边际的元器件,对电子组件的老化测试正在减少。
7.4.4 产品筛选测试
环境应力筛选(ESS)在持续生产筛选低劣产品质量以及潜在缺陷。ESS 将潜在缺陷加
速转化为实际失效,以消除这些潜在缺陷造成现场失效。ESS 程序必须十分小心,不能过于严酷而损害好的产
品并产生新的潜在缺陷。BGA 焊接疲劳寿命应该由这些 ESS 测试的热循环、其它测试以及运行寿命热环境来
评估。
7.5 空洞识别
了解 BGA 连接工艺所允许的空洞大小及空洞对可靠性的影响是很重要的。最终产品可接受的
详细要求
应当
符合 J-STD-001;工艺要求
应当
满足 IPC-A-610 的要求。本章节制定了有用的工艺开发和维持标
准以最小化空洞的发生。
业界数据表明焊点中的空洞不是个可靠性问题。组件再流后出现空洞标志着再流焊工艺已经发生且 BGA 焊球
特征已发生了改变。但是,工艺工程师的目标应该使空洞最小化,因为空洞出现频率过高可能意味着生产参数
需要调整。
已知的两个空洞原因是:
1)裹挟的助焊剂没有足够时间从焊膏中释放
2)印制板清洗不适当留有污染物

IPC-7095D-WAM1 CN 2019 年 1 月
126
空洞呈现为焊料球中较亮的区域并通常会在整个封装中随机出现。一些 X 射线系统会扭曲空洞的尺寸。准确测
量空洞的真实体积是可行的,但需要复杂的程序且需要一个已知的参考基准用于 X射线胶片或探测器的辐射校准。
BGA 空洞的大小不一定是确定焊点疲劳寿命的最好标准。远离焊点到元器件 / 连接盘界面的大的工艺空洞可
能并不是个问题,然而位于界面的小空洞,一旦裂纹开始就会成为断裂的条件。空洞在焊点中的位置与空洞的
大小和数量相比是个更关键的问题。在大多数情况下,通过执行本标准所建议的设计和再流曲线将精力放在识
别和消除空洞形成的原因上。
7.5.1 空洞的来源
空洞出现在 BGA 焊料球中、焊点 /BGA 界面中,及焊点 / 印制板界面中。这些空洞有各
种来源或原因。
焊点中的空洞可能来自于焊球中本身的空洞,这是焊球制造工艺的问题。再流焊后焊点中的空洞可由元器件焊
球本身的空洞诱发,或在焊球与元器件之间的再流焊接工艺时产生。空洞也可在 BGA 连接时,在印制板 / 焊
球的界面附近形成。这些空洞通常在再流焊工艺期间当熔融焊料凝固时,由裹挟的助焊剂挥发物造成的。助焊
剂挥发物可能来自于施加的助焊剂本身(通常返工时采用),或再流焊组装工艺所用焊膏中含有的成分之一。
空洞可能由以下因素导致:
• 元器件连接盘或印制板连接盘的表面污染物
• 焊球和连接盘之间形成的金属间化合物
• 组装过程中未排出的助焊剂残留
焊点空洞通常由凝固收缩、湿气和助焊剂挥发所致,
如下文所定义:
• 收缩-在凝固时金属收缩会导致一些空洞。焊点内
部是凝固连接的最后部分,因此可能会有空洞。
• 被截留的由湿气和污染物产生的气体
• 再流焊炉温度爬升阶段,焊膏中的助焊剂分解变为
气态。对 BGA 而言,气体被紧紧夹在两个表面之间,
通常产生的气泡会上升到焊点顶部。由于没有时间
让气体逸出焊点,温度爬升速率高会产生更多的空
洞。(温升速率示例:75°C/ 分钟 对比 60°C/ 分钟)
• 使用膏状助焊剂比使用焊膏产生的空洞要少。
• 返工过程中施加过多助焊剂会引起空洞
• 适当的炉温曲线和洁净的元件可以减少焊料空洞。
除了焊盘内导通孔结构(见 6.3.5)所形成的空洞,再流后焊点的中部至顶部(焊料球 /BGA 界面)会发现一些空洞。
这些是可预见的,因为截留的气泡和施加在印制板 BGA 连接盘上的助焊剂在再流焊期间会蒸发并上升。在再
流焊期间施加的焊膏和可塌陷共晶焊球会熔融在一起,此时锡铅焊料典型的峰值温度为 210℃至 220℃
、无铅
焊料的峰值温度为 235°C 至 245°C。来料元器件焊球的冶金成分和粗糙表面也会增加焊球空洞的形成。
如果再流曲线循环没有足够的时间让截留的空气或蒸发的助焊剂逸出,在再流焊曲线冷却区当熔融焊料凝固时
空洞会形成。作为形成空洞的贡献因子,再流温度曲线的开发是极其重要的。与焊膏供应商合作针对焊膏配方
建立再流焊曲线是重要的。
使用 X 射线设备可检测出有引线元器件下方焊点的空洞。但是,有引线元器件焊点以前只是目视检查(非 X
射线),因此隐藏的空洞从没被检测出。在进行 J-STD-002 表面贴装模拟测试(测试 S)前后,BGA 供应商应
该使用 X-ray 射线检查元器件,来显示可能导致可焊性问题的异常。
图 7-64 焊球至连接盘界面成群聚集的小空洞
A – 封装上的连接盘图形
B – 焊球至连接盘界面的小空洞
A
B
IPC-7095d-7-58-cn
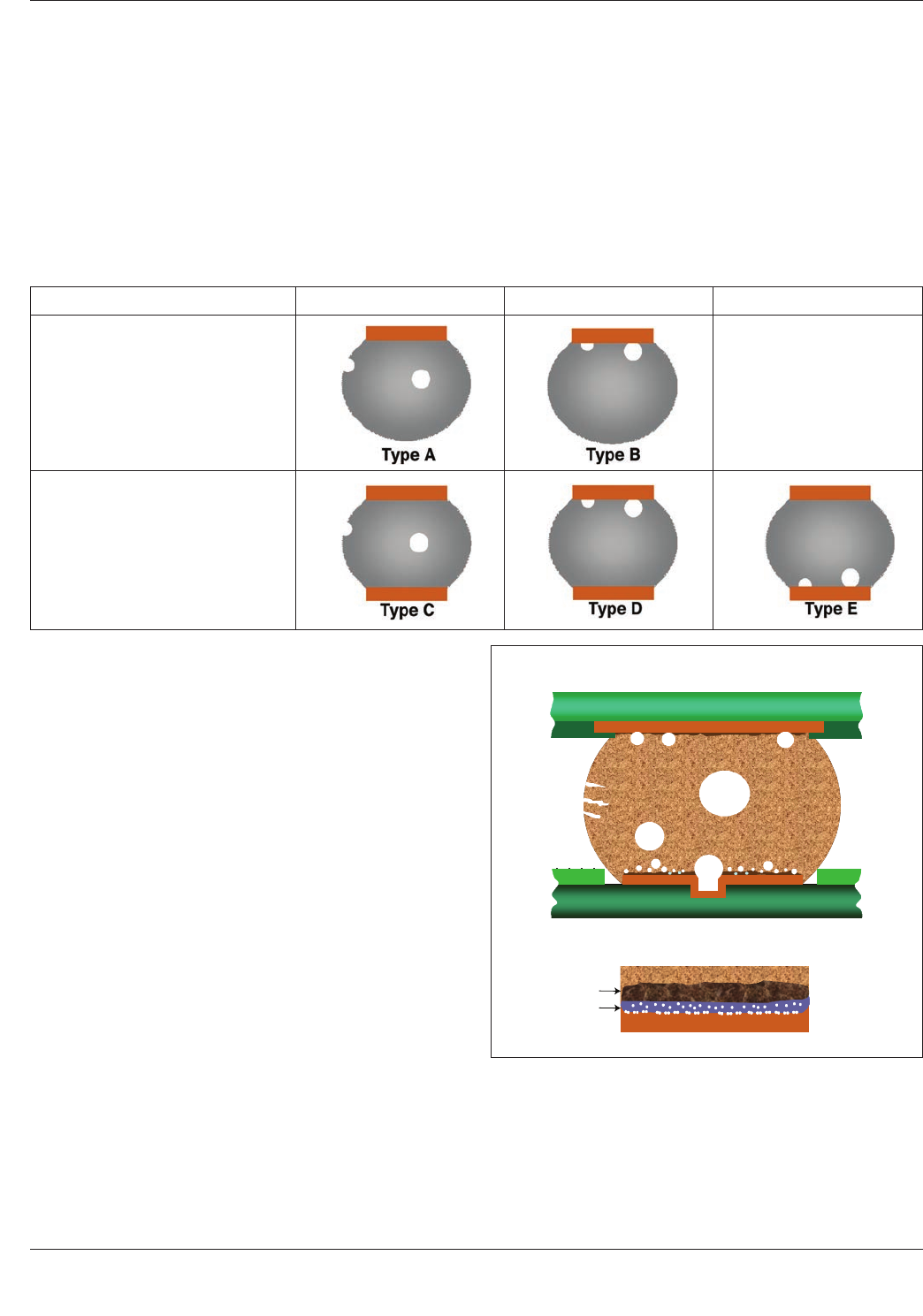
IPC-7095D-WAM1 CN2019 年 1 月
127
7.5.2 空洞的分类
为了评估不同情况,基于空洞的位置给予了特定的类别码,以建立空洞的识别方法和为工
艺改进采取纠正措施的可能性。表 7-10 给出了细节以及显示了 BGA 焊料球结构中的空洞位置分类标准。
以下说明如何识别五种不同类型的空洞:
类型 A:收料时焊球中的空洞(封装级)
类型 B:收料时焊球 / 封装基板界面的空洞
类型 C:在板级组装后焊球中的空洞
类型 D:在板级组装后,焊球 / 封装基板界面的空洞
类型 E:在板级组装后,焊球 / 产品基板界面的空洞
表 7-10 空洞分类
空洞分析 焊球内的空洞 封装界面的空洞 安装表面界面的空洞
连接到印制板前焊球内的空洞
类型 A 类型 B
N/A
连接到印制板后焊球内的空洞
类型 C 类型 D 类型 E
7.5.3 BGA 焊点中的空洞
焊点中有六种类型的空洞
得到识别和描述。图 7-65 显示了每种空洞特性,并说
明了这些空洞在 BGA 焊点中的典型尺寸和位置。不
管何时发现焊点中的空洞,首先识别空洞种类以确定
其对焊点可靠性的影响,并评估最小化或消除这种空
洞的纠正措施,参见 7.5.3.1 至 7.5.3.6。
7.5.3.1 大空洞
大空洞是焊点中最广泛出现的空
洞。它们由焊接工艺中产生的挥发性化合物所导致。
这些大空洞通常不会影响焊点可靠性,除非它们出现
在裂纹通常会扩张的焊点界面区域。
7.5.3.2 平面微空洞
平面微空洞是位于印制板连接
盘和焊料界面的、基本处于同一平面的一系列小空
洞。它们是由浸银(ImAg)涂覆连接盘下方的铜凹
坑引起的。它们并不会影响最初的产品质量,但是会
影响焊点长期的可靠性。它们可在表面处理电镀过程
中,通过对浸银电镀溶液、微蚀化合物以及其它关键
工艺参数的持续严格管控来消除。
7.5.3.3 收缩空洞
收缩空洞由凝固过程中的收缩导
致,常见于 SAC 和其它无铅焊料中。它们通常不会出
现在焊料到 PCB 连接盘界面的附近,并且不会影响焊
图 7-65 BGA 焊点内各种类型空洞的典型尺寸和位置
A– 再流焊后的 BGA 焊点
B– 高温老化后的铜金属间化
合物(IMC)焊料界面
C– Cu6Sn5
D– Cu3Sn
1– 大空洞
2– 平面微空洞
3– 收缩空洞
4– 微导通孔空洞
5–IMC 微空洞
6– 针孔空洞
1
1
1
1
1
2
2
2
4
6
6
1
1
1
1
1
2
2
2
3
5
4
6
6
A
B
C
D
IPC-7095d-7-65-cn