IPC-7095D-CHINESE NP 2019 - 第151页
IPC-7095D-W AM1 CN 2019 年 1 月 135 从研发到制造产品寿命的各个阶段,都有可能遇到空 洞的问题。维持最低的可接受空洞标准对于确保产品 满足客户期望、产品寿命和可靠性要求是必要的 。为 此目的可以采用现成的 SPC 和工艺改善工具。 空洞 发生频 率和大小的变化表明应该有工艺控制以 及工艺和材料改进的需要 。制造商可以采用空洞的 控制 基准 线确 定工 艺调整的需求以控制空洞发生频 率和大小。另外,需要建立空…
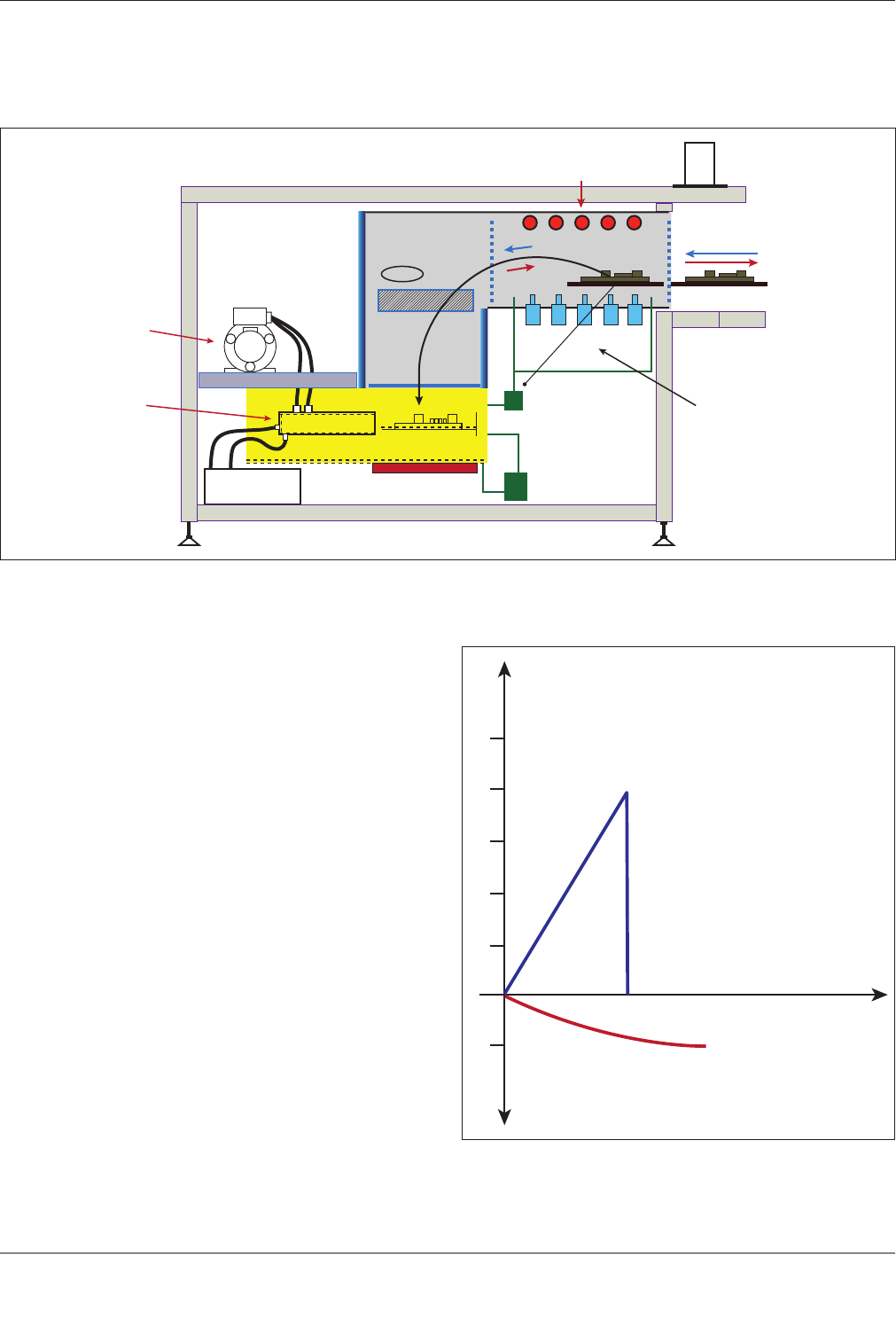
IPC-7095D-WAM1 CN 2019 年 1 月
134
真空辅助焊接在气相再流系统中也是可行的。最初将需要焊接的印制板传送至常规的气相区熔融焊料,接着移
入真空室 20 至 25 秒。随后将印制板移回正常的大气气相区,最后从炉子移出。
图 7-69 显示了在加热气相室下方有真空室、加热模块及冷却模块的真空辅助气相再流炉。
A
B
C
IPC-7095d-7-69-cn
图 7-69 真空辅助气相再流炉
A– 真空泵 B– 真空室 C– 内部流体回收单元
真空辅助焊接的另一种变化是高压焊接的使用。与最
初开始于大气环境压力然后通过施加真空降低环境
压力不同,这种高压焊接工艺在高环境压力下熔融
焊料,然后降至一个大气压的环境压力。这能产生
Laplace-Young 公式得到的相同效果,但没有应用高
真空。
图 7-70 通过时间与压力图显示了真空辅助和高压焊
接工艺的区别。与真空辅助系统相比,高压焊接系统
的主要优点是在整个再流过程中都保持对流加热机
制。炉子的制造就是基于这种高压焊接原理。
7.7.2 焊球中空洞的工艺控制标准
随着 BGA 连接
盘尺寸、焊球尺寸和连接盘节距持续减少,用于生产
的尺寸参数需要改变。为了满足质量和可靠性要求,
可能需采用新材料和新工艺。这导致制造商需要采纳
和使用工艺开发 / 控制和为控制空洞持续改善产品,
同时需适应技术的变化。
∆p = 1
∆p = 4
A
6
5
4
3
2
1
0
B
C
D
IPC-7095d-7-70-cn
图 7-70 时间与压力关系图显示了真空辅助和高压焊
接工艺的差别
A– 压力(帕) C– 高压焊接
B– 时间
D– 真空焊接

IPC-7095D-WAM1 CN2019 年 1 月
135
从研发到制造产品寿命的各个阶段,都有可能遇到空
洞的问题。维持最低的可接受空洞标准对于确保产品
满足客户期望、产品寿命和可靠性要求是必要的。为
此目的可以采用现成的 SPC 和工艺改善工具。
空洞发生频率和大小的变化表明应该有工艺控制以
及工艺和材料改进的需要。制造商可以采用空洞的
控制基准线确定工艺调整的需求以控制空洞发生频
率和大小。另外,需要建立空洞大小限值。确定空洞
大小关系到焊球。超过焊球横截面直径 25% 的空洞
大约为整个投影面积范围的 6%(见图 7-71)。任何
这样的工艺控制限值都应该在与客户协商的合同承诺
中规定。
当焊球中的空洞数不止一个时,应该将空洞的尺寸相
加以计算焊球中总空洞。
百分比计算公式如下,所有算式都与焊球直径或接触
表面有关。
空洞直径百分比
空洞直径
焊球直径
×100= 空洞百分比
空洞面积
触点或焊球面积
×100 = 空洞百分比
注:
焊球面积由直径和 Pi 计算得出(
π
r
2
)。
如已知空洞直径和焊球图像直径之间关系,空洞的实际数量和尺寸之间的关系就变得重要。直径 25% 的差异
对于较大的焊球尺寸来说并不重要,但是当连接盘直径缩减至适应一个较小的焊球或较小的 BGA 节距时,这
种差异会变得更重要。当空洞已确定后,这可通过确定连接到连接盘的面积来表明。
直径为 600
μ
m 的 BGA 焊球图像,带有一个 25% 的空洞,其空洞面积比 =
= 6.25%,也
就是 6.25% 面积被空洞占据。
比较焊球面积和空洞所占面积,焊点剩余面积 265073
μ
m
2
(
π
r
2
)。
直径为 300
μ
m 的 BGA 焊球图像,带有一个 25% 的空洞,其空洞面积比 =
= 6.25%,也
就是 6.25% 面积被空洞占据。
比较焊球图像面积和空洞图像面积,焊点剩余面积 66,268
μ
m
2
(
π
r
2
)。
关于来料时焊球中空洞(类型 A 和类型 B)的发生频次及连接工艺后发现的空洞(类型 C、类 型 D 和类型 E),
附录 A 提供了工艺改善建议。
纠正措施指标见附录 A 中表 A-1,表 A-2 和表 A-3。
7.7.3 工艺控制标准
本标准识别的过程纠正措施旨在基于空洞尺寸、空洞位置以及空洞出现频次的确定方法
来建立持续的工艺改善。J-STD-001 和 IPC-A-610 提供了用于合同协议的 BGA 组件的最终接受 / 拒收标准。
空洞分类也可按空洞发生在组装到安装结构前还是在组装之后来定义。基于最终使用环境,这项有用的信息与
可靠性条件相关联。采用空洞尺寸限值结构,可制定工艺来帮助满足客户定义的可接受性条件(见附录 A)。
图 7-71 连接盘和印制板界面空洞区域示例
A– 焊点外形
B– 空洞外形
A
B
d
0.25 d
IPC-7095d-7-71-cn

IPC-7095D-WAM1 CN 2019 年 1 月
136
7.8 焊接缺陷
7.8.1 焊料桥连
焊料桥连是不可接受的。有必要采用电气测试、光学检验(内窥镜)或者 X 射线检验对于
探测焊料桥连。
桥连的典型原因包括:
• 焊膏印刷不良
• 贴装偏位
• 贴片后,元件手动调整
• 再流焊过程中焊料飞溅
相对于两基板间的间隙,焊球太大也会造成桥连。
7.8.2 冷焊
再流焊曲线应该能达到足够高的温度以确保焊料完全融化和连接盘表面有良好润湿。冷焊会减弱
机械完整性导致电气失效或功能间歇性失效。切片后的光学检测是检验冷焊焊点的最好方法。
7.8.3 开路
焊点开路也是不可接受的。电气测试、光学检验(内窥镜)或 X 射线检验对于探测焊点开路是
必要的。
焊点开路与组装相关的原因包括:
• 焊膏印刷不良
• 贴装偏位
• 贴装后手动调整
共面性问题和基板可焊接性问题也会导致开路。过度
的机械应力也会导致焊点开裂,引发开路。
7.8.4 受热不充分 / 不均匀
一个常见的工艺问题是
BGA 受热不充分或不均匀,这个问题在返工过程中很
常见,但是在有许多接地层和电源层的多层印制板生
产中也能见到。当屏蔽元器件位于 BGA 位置附近的背
面时,此类问题也会出现在双面印制板中。在完全再
流发生之前,若有热导体将热量从 BGA 传导出,则会
发生此问题就。此问题的 X 射线图像的特征为:封装
下面不同位置的焊球大小有差异。
加热不充分在 X 射线图像通常表征为封装中央或一侧
的焊料球少部分再流。加热不充分也可表现为这些焊
料球外表粗糙,这说明焊料仅有部分发生再流,没有
足够的再流时间使连接盘完全润湿并使焊球塌陷形成
理想的圆球。相对于连接盘的焊球偏位也是加热不充
分的标志,焊球偏位的 X 射线图像表征为偏移方向不
一致的焊球拉长。
45°角 的 X 射线检测也是确定与加热不充分或不润湿相
关特征的一项有用技术。焊球应该与连接盘接触且完
全润湿以形成光滑的柱子。与不充分加热相关的特征包括连接盘不完全润湿,或焊料连接图像伸长,这表明焊
球和焊膏并没有熔合在一起形成单个焊点(见图 7-72 和 7-73)。
图 7-72 显示为不均匀受热的 X 射线图像
图 7-73 45°角的 X 射线图像,显示 BGA 的一个角
落受热不足