IPC-7095D-CHINESE NP 2019 - 第186页
IPC-7095D-W AM1 CN 2019 年 1 月 170 9.2.6 空洞和非均匀焊球 图 9-7 空洞和非均匀焊球 可能原因 焊球连接时有过多的空洞。 连接盘上导通孔设计。注:按照 IPC-A-610 ,焊盘上导通 孔相关的空洞不认为是缺陷。 温度曲线爬升过快。 有向前兼容的情形(用无铅焊膏焊接锡铅 BGA 焊球) 。 潜在解决方案 通过热应力或显微切片评估焊点的结构强度 使用保温时间长的再流曲线 避免上述潜在原因的情况。 …

IPC-7095D-WAM1 CN2019 年 1 月
169
9.2.2 有散热块的 BGA 焊球形状,375
μ
m 的间隙高度
图 9-5 有散热块的 BGA 焊球形状,375
μ
m 的间隙高度
可能原因
带有散热块的 BGA 重量引起焊球过度塌陷。
这种形变也许可接受(取决于元器件节距),因为焊球间
没有触碰。
潜在解决方案
强制要求封装包含有垫高以防止焊球塌陷
9.2.3 有散热块的 BGA 球形,300
μ
m 的间隙高度
图 9-6 有散热块的 BGA 焊球形状,300
μ
m 的间隙高度
可能原因
带有散热块的 BGA 重量引起焊球过度塌陷。
这是质量差的情况,应该予以纠正。
潜在解决方案
强制要求封装包含有垫高以防止焊球塌陷
9.2.4 关键的焊膏条件
沉积的焊膏量对塑封 BGA 连接是有帮助的,但对于形成良好焊点并不是非常关键,
因为焊球本身可以作为焊料的来源。但如果是 CBGA,沉积足够的焊膏量就非常重要。如果没有充足的焊膏沉
积(参见 9.3.1),焊点可靠性可能会有问题。必须给高温焊球或焊柱增添焊料是因为封装端子的焊料对焊点没
有贡献。
9.2.5 通过 X 射线和切片确定空洞
透射 X 射线可以探测空洞的存在(浅色区)及相关的空洞 X-Y 位置。这
项技术也可探测焊球不均匀或缺失(各种深色图像直径),这种状况的示例如 9.2.7 所示。其它方向的 X 射线
检查是需要的,以确定空洞在垂直方向上(Z 轴)的位置。
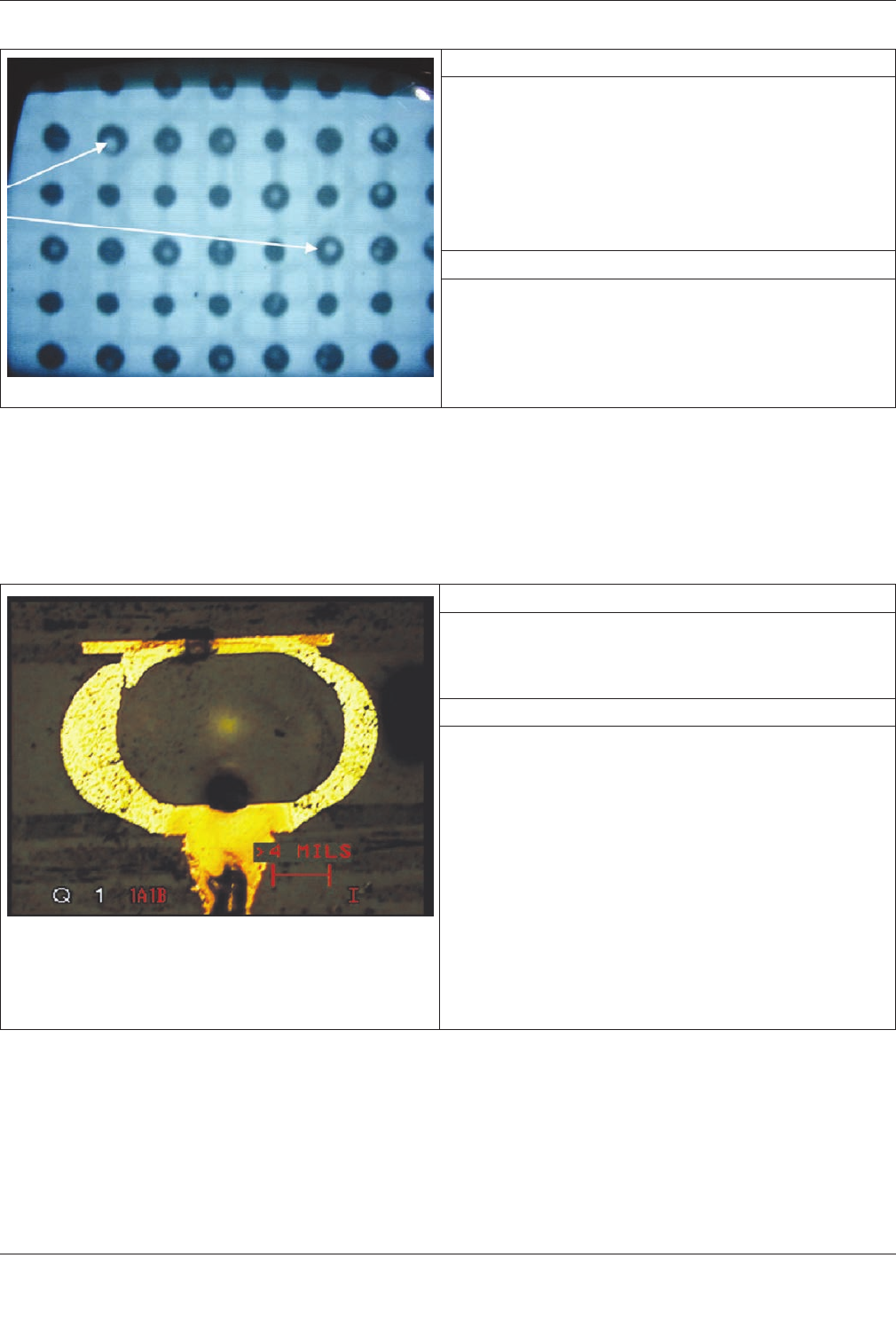
IPC-7095D-WAM1 CN 2019 年 1 月
170
9.2.6 空洞和非均匀焊球
图 9-7 空洞和非均匀焊球
可能原因
焊球连接时有过多的空洞。
连接盘上导通孔设计。注:按照 IPC-A-610
,焊盘上导通
孔相关的空洞不认为是缺陷。
温度曲线爬升过快。
有向前兼容的情形(用无铅焊膏焊接锡铅 BGA 焊球)。
潜在解决方案
通过热应力或显微切片评估焊点的结构强度
使用保温时间长的再流曲线
避免上述潜在原因的情况。
BGA 中空洞的形成有很多原因。然而空洞的存在并不会造成任何可靠性风险,除非空洞足够大而足以降低了
横截面和机械完整性。空洞(如 9.2.7 所示)可以承受 1,000 次热循环(无冲击,0°C
-100°C),尽管更常见的
空洞如图 9-7 所示。即使在某些测试中,空洞并未降低疲劳寿命,过多空洞存在于焊点中表示设计、工艺或材
料有问题。也应当验证产品可靠性。
9.2.7 蛋壳空洞
图 9-8 蛋壳空洞
图注:
1. 0.65mm 的微导通孔,
1,000 次循环
2. 图像显示焊点塌陷,导致间歇性接触失效
可能原因
再流时空气或其它气体被截留。
空气或其它气体可能来自于微导通孔的截留。
潜在解决方案
拆除元器件并用新的替换
9.3 BGA 翘曲
在正常再流焊组装过程中,PBGA 具有发生翘曲的倾向。翘曲会发生在 BGA 基板或产品印
制板上。这会导致遭受应力的焊点发生开路或短路。温度(再流曲线)、BGA 结构、焊膏量以及冷却条件都会
导致弓曲或扭曲。
角落焊球短路表示 BGA 有发生翘曲,此时 BGA 封装角落向内弯曲(哭脸 BGA)。同样的现象会造成焊球远离
角落而从安装基板抬离(笑脸 BGA), 如 9.3.1 和 9.3.2 所示。

IPC-7095D-WAM1 CN2019 年 1 月
171
9.3.1 BGA 翘曲
图 9-9 角落发生桥连的内凹(哭脸)BGA
可能原因
再流焊过程中热机械应力导致的 BGA 翘曲。
可能由 BGA 载板角落内凹(哭脸)引起。
潜在解决方案
增加角落焊球尺寸或使用点胶。
某些情况下,再流过程中增加胶带
在再流温度下,使用阴影叠纹法来检查共面性
检查其它角落类似的情况
角落焊球的开路表示有 BGA 翘曲(封装角落向上抬起)。这种开路,如 9.3.2 所示,可以通过增加额外的焊膏
量将其最小化,但施加过量的焊膏不是此问题的解决方法。
确定根本原因及处理异常原因对于建立稳健工艺更重要。仅当某工艺或元器件状况不可改变情况下(如,再流
焊工艺已得到优化,BGA 封装或 BGA 载板无法重新设计,或印制板无法重新设计),修改模板开口增加印制
板上焊膏沉积可作为解决角落开路的方案。另外在进行任何工艺变更前,异常必须是持续发生,并且应该考虑
到焊料和元器件库存。如果决定使用过量的焊膏来纠解决角落焊球开路问题,应密切监控此工艺以确保不会产
生额外的缺陷(如焊料桥连、锡珠等)。
9.3.2 由于载板翘曲导致的焊点开路
图 9-10 由于载板翘曲导致的焊点开路
可能原因
失效似乎是由于模板释放焊膏不充分或焊球大小不足够。
封装翘曲后,角落焊球抬离(微笑 BGA
)。
潜在解决方案
在组装前 / 来料时检查焊球。
在角落连接盘上施加额外的焊膏。
实施来料检查和 / 或货源审核