IPC-7095D-CHINESE NP 2019 - 第64页
IPC-7095D-W AM1 CN 2019 年 1 月 48 5.2 基材考量 用于生产 BGA 组件安装结构的基材应该满足 IPC-4101 的要求。该标准提供了订购基材所需 的具体细节和大量的技术规范表。 本章节重点介绍了 BGA 组件需要考虑的一些材料特性。与板子制造商讨论这些属性是重要的,以确保将最合 适和最具成本效益的材料用于基座安装结构。 5.2.1 树脂系统 层压树脂系统必须有与用于制造 BGA 部件的树脂系统相兼容的…
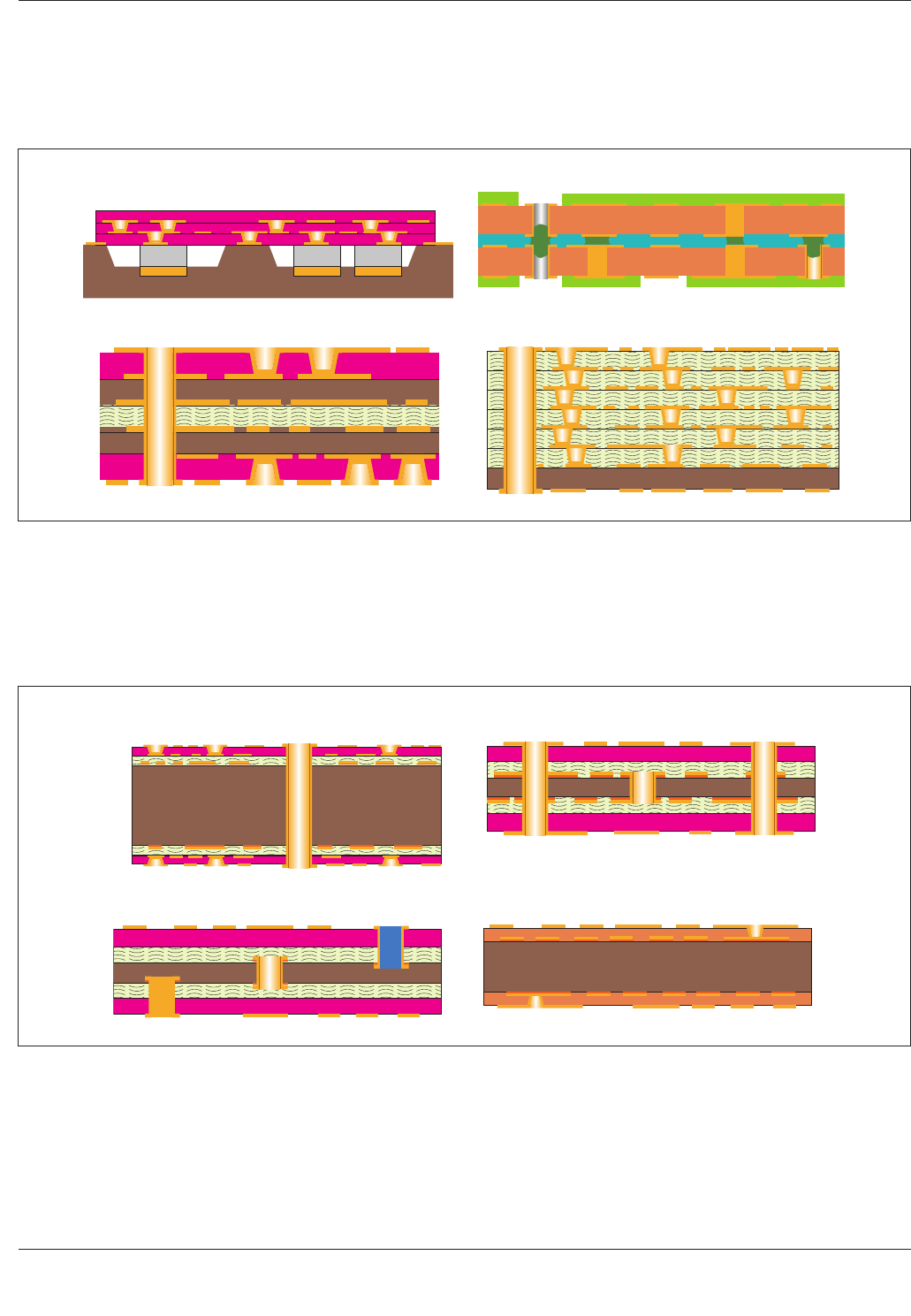
IPC-7095D-WAM1 CN2019 年 1 月
47
用于 HDI 叠构多层的微导通孔类型取决于制造商使用的设备。图 5-1 显示了可通过激光技术实现的典型叠构。
图 5-2 显示了可通过蚀刻和机械加工实现的叠构。
HDI 的设计要求与标准化设计参见 IPC-2226。
AB
CD
IPC-7095d-5-2-cn
AB
CD
IPC-7095d-5-1-cn
图 5-1 采用激光打孔生成的 HDI 可能叠构
A– 薄膜 HDI 陶瓷基板
B– 各向异性导电材料连接的挠性板
C– 激光盲孔
D– 顺序叠构
图 5-2 采用蚀刻和机械工艺生成的 HDI 可能叠构
A– 顺序压合的薄片(等离子蚀刻)
B– 顺序压合的薄片(微冲孔)
C– 层叠构(微钻孔)
D– 卷板叠构(化学蚀刻)

IPC-7095D-WAM1 CN 2019 年 1 月
48
5.2 基材考量
用于生产 BGA 组件安装结构的基材应该满足 IPC-4101 的要求。该标准提供了订购基材所需
的具体细节和大量的技术规范表。
本章节重点介绍了 BGA 组件需要考虑的一些材料特性。与板子制造商讨论这些属性是重要的,以确保将最合
适和最具成本效益的材料用于基座安装结构。
5.2.1 树脂系统
层压树脂系统必须有与用于制造 BGA 部件的树脂系统相兼容的共享性质(见第 4.6 节),并
且必须与这些部件所需的加工温度相匹配。例如,在树脂系统中,聚酰亚胺树脂系统提供最高的工作温度。由
于它们有高 Tg,聚酰亚胺树脂系统也提供了安全边际和降低了使用无铅 BGA 对印制板损伤的可能。
5.2.2 层压板材料性质
有几个材料特性对于用作 BGA 组装的印制层压板的选择是很重要的(见 5.2.2.1 至
5.2.2.5)。
5.2.2.1 热膨胀
热膨胀通常根据 X-Y 平面内的变化来表征,其主要受控于材料的增强程度。X-Y 平面内的膨
胀会对表面贴装元器件及其可靠性产生最大的影响。热膨胀也会发生在 Z 轴且膨胀率远高于 X-Y 平面,尤其
当温度高于 T
g
时。Z 轴的膨胀对镀覆孔和导通孔的可靠性有极大的影响。
不同层压材料的热膨胀条件参见 IPC-4101
5.2.2.2 玻璃化温度
T
g
是增强材料和树脂系统从线性 CTE 转变为高速率膨胀时的温度。T
g
是树脂的分子结
构由玻璃态转化为无定形态的温度范围;这些不同的分子结构可导致非常不同的物理性质,这种情况多发生在
树脂系统的温度超过其固化聚合态时。当规定温度以更快速率升高时,通常在 Z 轴方向上材料会膨胀,尽管
仍保持为线性关系(mm/mm 厚度)。图 5-3 以图示的方法解释了此概念并展示了两种树脂可能如何表现的。
不同树脂制成的层压板 T
g
不同,导致耐高温能力不同。例如,对于无铅应用的高温加工需要更高性能的层压板,
这些层压板成本通常更高。
T
g
可通过三种方法来测量:
1)动态力学分析(DMA)
2)差分扫描热量测定法(DSC)
3)热机分析(TMA)
B
A
C
E
D
F
IPC-7095d-5-3-cn
图 5-3 温度超过 T
g
的膨胀率
A– 膨胀
B– 温度
C– 树脂层压系统 -1
D– T
g
-1
E– 树脂层压系统 2
F– T
g
-2

IPC-7095D-WAM1 CN2019 年 1 月
49
这些方法中,TMA 与评估可靠性问题最相关。用此三种方法得到的结果,其关系可非常粗略地表示为:Tg
(TMA)≈T
g
(DSC)-10°C≈T
g
(DMA)-20°C。
不同的层压材料的 Tg 值参见 IPC-4101。
5.2.2.3 分层的时间(T260,T280 及 T300)
分层时间是指树脂和铜层或增强物分层所需的时间度量值。分层
时间用于评估焊接过程中的基材性能。
为了确定分层的时间,TMA 设备将一种材料样品暴露于规定温度,并维持规定的时间(如 10 分钟)或直至材
料失效(如分层)。选择可满足高温焊接(如无铅 BGA)和适合高温环境的一种材料是重要的。
各种温度下的测试(T260 = 260°C,T288 = 288°C,T300 = 300°C)给出了基材的热稳定性和焊接工艺兼
容性(例如锡铅对比无铅)的指标。各种层压材料的分层时间性质参见 IPC-4101。
5.2.2.4 吸湿性
大部分有机材料具有某种程度的吸湿性,并会以不同速率吸收水分,某些材料的吸水速率相
对较快。湿气的吸收改变了材料的电气性能(如损耗正切)和加工特性(如排气会引起气泡)。它也会影响物
理尺寸和层压板重量。
IPC-1601 定义了减少吸湿性的操作和储存指南,以及确定印制板中的湿气含量的测试流程。它还提供了印制
板在组装前去除水分的烘烤建议。
5.2.2.5 无铅焊接温度的可靠性问题
无铅焊接需要较高温度,带来了印制板树脂系统的存活性和印制板互连
结构(如镀覆通孔和导通孔)完整性方面的可靠性问题。
在此方面最重要的性质为 Td、Tg 和热膨胀。Td 是树脂开始进行不可逆分解并损失重量时的温度;通常为重量
损失 2% 或 5% 时测到的温度。温度范围为 50°C -260
°C 是高于/低于 Tg 温度热膨胀的复合,在此温度范围内
树脂改变了其分子结构,从玻璃态转化为无定形态。
这三种性质的影响可以整合为焊接温度影响指数(STII),定义式为:
STII = T
g
/2 + T
d
/2 - (TE%(50°C 至 260°C) × 10)
5.3 印制板表面处理
表面处理的主要目的是为了防止印制板裸露铜箔的氧化。这为了确保 BGA 贴装时表面
是可焊接的。表面处理也有其它用途,包括:
• 为测试探针提供可靠的接触面
• 触点或开关
• 金属线键合
• 为焊膏印刷提供平整的表面
尽管 BGA 是本标准的重点,在选择最适合的表面处理时,其它元器件和组装操作必须加以考虑。
没有一种理想的表面处理能适合所有应用的要求,表 5-1 给出了在选择合适的表面处理时必须考虑的一些应用
特点。
注:
操作印制板时必须很小心,因为人手上的盐份会对表面处理造成损伤(特别是 OSP)。对任何表面处理的
板子要达到最长的保存期限,就需要正确的包装和贮藏。
IPC-1401 对印制板的适当操作提供了指南和要求。