IPC-7095D-CHINESE NP 2019 - 第78页
IPC-7095D-W AM1 CN 2019 年 1 月 62 6.2.2.1 金属限定 ( MD )连接盘 金属限定连接盘所需 的铜连接盘直径较小,可供布线和导通孔的金属间间距较 大。铜材比阻焊膜更容易控制尺寸,可以产生更加均匀的 表面处理 ,尤其是 HASL 印制板 。由于连接盘周围没有 阻焊膜使得焊料可以包围住连接盘边缘,这可消除有应力 集中的任何区域。 金属限定连接盘能形成改善的焊点外形,但这也会使得间 隙高度变小(见图 6-…
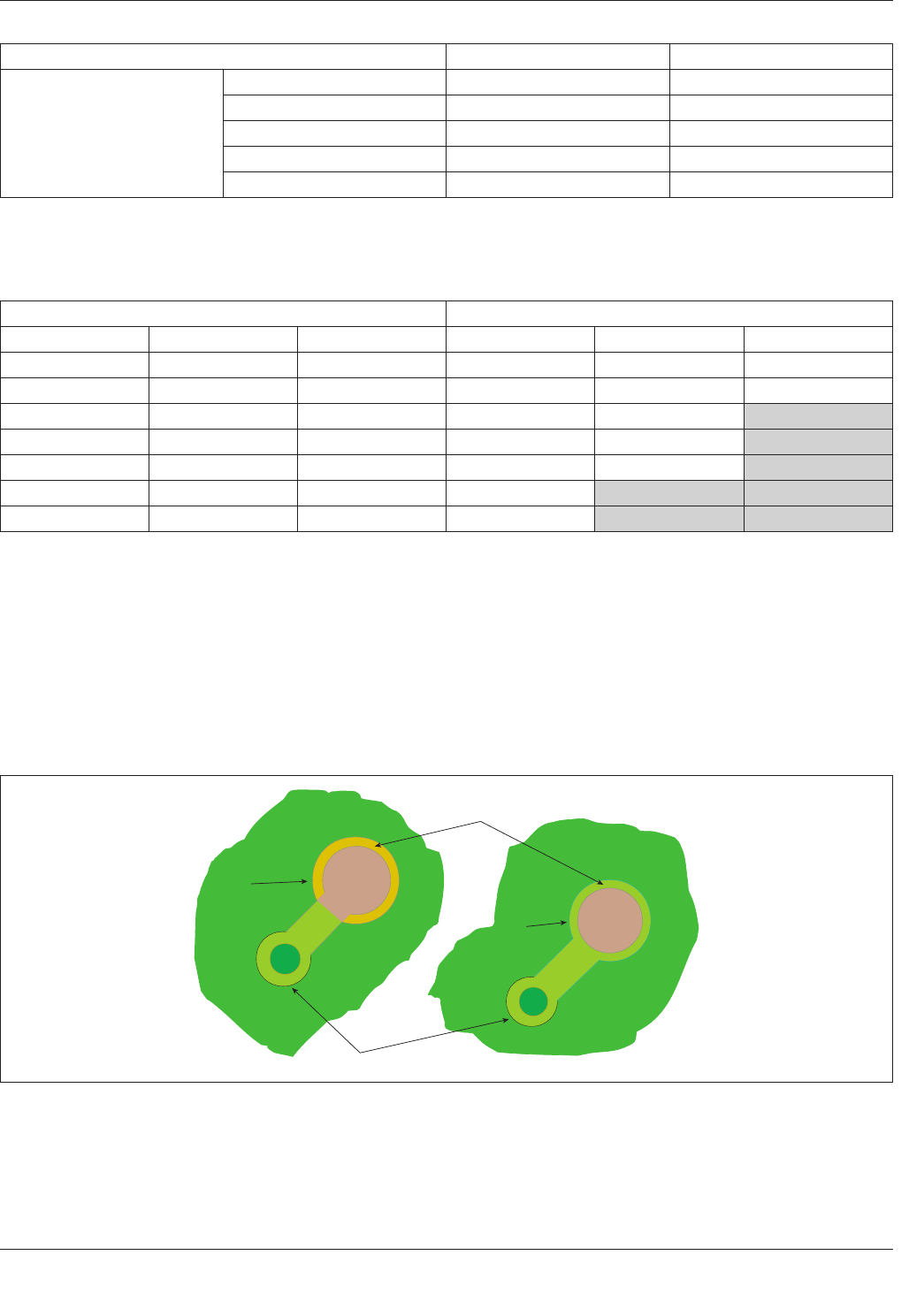
IPC-7095D-WAM1 CN2019 年 1 月
61
表 6-5 节距为 0.50mm 的 BGA(焊球直径 0.30mm)连接盘之间的导体数量
连接盘直径 (mm) 0.25 0.20
导体宽度 (mm)
0.20 0 1
0.15 1 1
0.125 1 1
0.10 1 1
0.075 1 2
表 6-6 展示了在导体数量给定的情况下可能的最大连接盘尺寸,而非对应不同连接盘尺寸的导体数。它还包括
了额外的节距,并提供了中间导通孔的信息。
表 6-6 最大连接盘与节距(mm)的关系
最大连接盘尺寸
BGA 节距 焊球尺寸 连接盘尺寸
2
导通孔直径 一条线路 两条线路
1.25 0.75 0.55 0.40 0.90 0.65
1.0 0.60 0.45 0.35 0.65 0.40
0.80 0.40 0.30 0.30 0.45
0.75 0.40 0.30 0.20 0.40
0.65 0.40 0.30 0.20 0.30
0.50 0.30 0.25 0.15
0.40 0.25 0.20 0.10
假定:125/125
μ
m 导体宽度和间距。
所有数值向下取整到 0.05mm。
CBGA 的连接盘尺寸应该使非塌陷焊球或焊柱在连接盘上有足够的可用平台以实现 CBGA 焊球或焊柱的焊接。建
立这个最低要求会使连接盘稍大,而焊点通常由熔化焊膏沉积形成,这要求对保证焊点可靠性来说是必要的。
6.2.2 阻焊膜限定(SMD)与金属限定连接盘设计
金属限定连接盘通过蚀刻限定而成,因此该连接盘周围
与阻焊膜有间隙,与绝大部分表面贴装连接盘类似。SMD 连接盘是由阻焊膜部分覆盖在铜连接盘上(见图 6-2)。
这两种连接盘类型各有优缺点,6.2.2.1 和 6.2.2.2 包含了这些内容。
图 6-2 BGA 器件的连接盘
A– 覆盖阻焊膜的互连导通孔
B– 远离焊盘的阻焊膜
C– 铜焊盘
D– 焊盘上的阻焊膜
A
C
B
D
IPC-7095d-6-2-cn
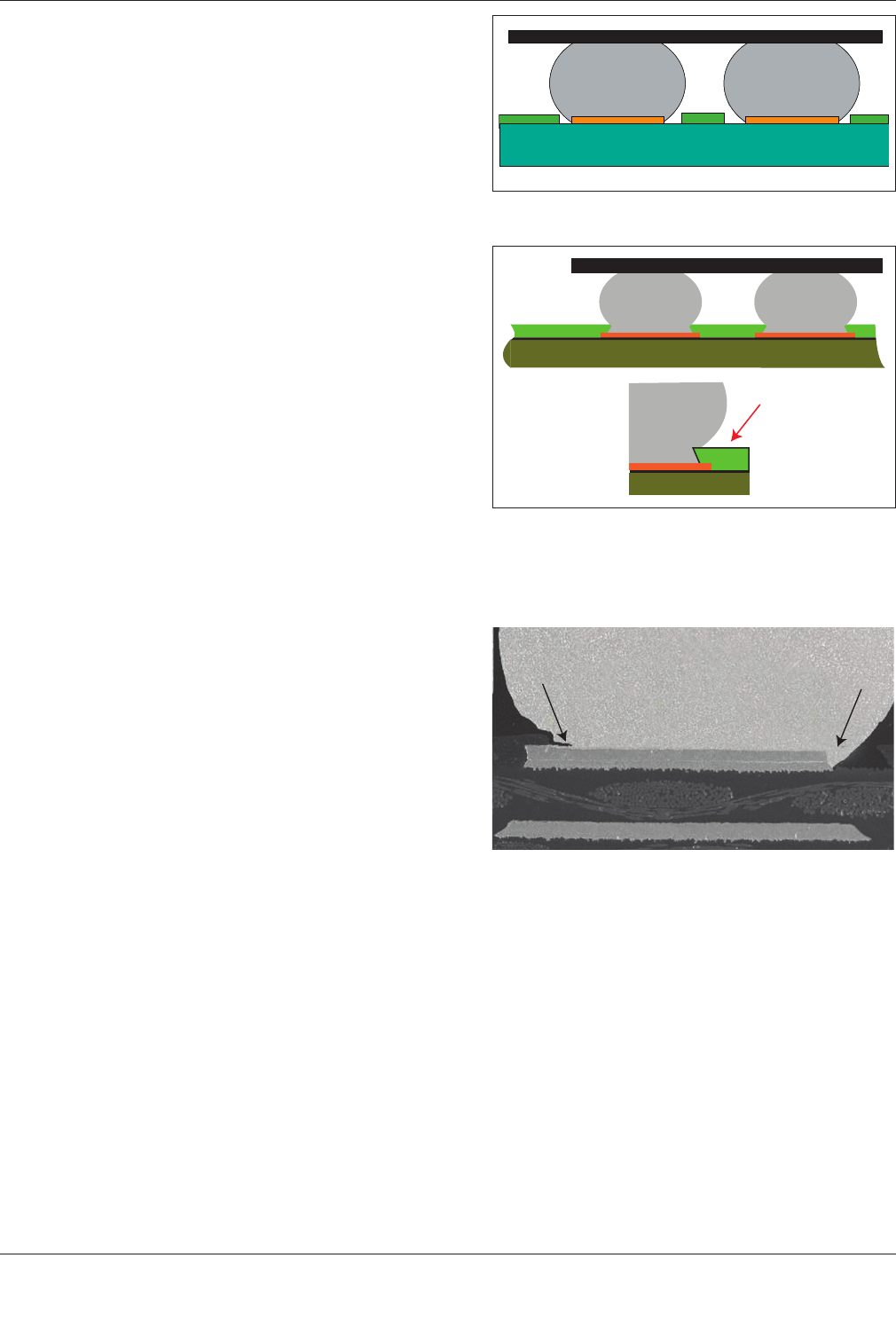
IPC-7095D-WAM1 CN 2019 年 1 月
62
6.2.2.1
金属限定(MD)连接盘
金属限定连接盘所需
的铜连接盘直径较小,可供布线和导通孔的金属间间距较
大。铜材比阻焊膜更容易控制尺寸,可以产生更加均匀的
表面处理,尤其是 HASL 印制板。由于连接盘周围没有
阻焊膜使得焊料可以包围住连接盘边缘,这可消除有应力
集中的任何区域。
金属限定连接盘能形成改善的焊点外形,但这也会使得间
隙高度变小(见图 6-3)。改善的焊点外形会潜在地增加焊
点的抗疲劳强度;但是,较小的间隙高度会部分抵消掉抗
疲劳强度的改善。
6.2.2.2 阻焊膜限定(SMD)连接盘
由于有阻焊膜的部
分重叠,SMD 连接盘需要较大直径的金属连接盘以达到
像金属限定连接盘相同的尺寸。阻焊膜限定的焊点会产生
应力集中(见图 6-4),但会有较大的间隙高度。相应的效
果如图 6-5 所示,图中展示了 SMD(左侧)和金属限定
连接盘(右侧)上的焊点形状差异。SMD 连接盘上的应
力集中可能会导致在贴装表面引发的裂纹。因为铜连接盘
和阻焊膜重叠有较大的表面区域,SMD 连接盘与印制板
附着性较好。
SMD 连接盘的主要缺点是焊点在阻焊膜和焊料交界处
的脆弱性。一些测试表明焊点疲劳寿命远小于金属限定
(MD)连接盘。采用 SMD 连接盘的主要优点是可预防连
接盘从印制板上剥离。连接盘剥离,也被称为焊盘坑裂,
通常发生于角落焊球。因为角落焊球有较大的应变率而更
容易失效,元器件制造商经常不会将这些焊球用作关键功
能(CTF)。在角落焊球为非关键功能 CTF 的情况下,这
些焊球的相应位置可设计为 SMD 连接盘。
6.2.3 导体宽度
导体宽度会影响 BGA 的布线。导体
越宽,连接盘间用于布线的空间越小。目前并没有针对
SMD 连接盘采用最大导体宽度建议;然而,连接 NSMD
连接盘的最大导体宽度为 0.2mm。导体宽度大于该值会对
该位置的连接盘转变为 SMD 连接盘有影响。为了消除尖角,在导体与连接盘连接处应该采用圆角填充处理。
6.2.4 导通孔尺寸和位置
导通孔可布在连接盘图形上的 BGA 连接盘之间。导通孔连接盘应该足够小以使
导通孔与其相邻连接盘间能产生间隙。可采用的导通孔最大尺寸取决于所采用连接盘尺寸和类型(SMD 或
MD)。对于对应的板厚,推荐使用最小标准尺寸的导通孔盘/钻头。连接盘尺寸为 0.6mm,导通孔钻孔尺寸
为 0.35mm,在节距为 1.5mm 和 1.27mm 的 BGA 中很常见;同时连接盘尺寸为 0.5mm,导通孔钻孔尺寸为
0.25mm,则常用于节距为 1.0mm 和 0.75mm 的封装。
为了使标准尺寸导通孔和连接盘之间发生焊料桥连的风险最小化,可掩蔽导通孔或让阻焊膜侵入(覆盖)导通
孔连接盘。
IPC-7095d-6-3-cn
图 6-3 金属限定连接盘连接外形
B
C
A
IPC-7095d-6-4-cn
图 6-4 阻焊膜应力集中
A– 焊球缩小后的横截面积
B– 阻焊膜应力集中
C– 阻焊膜在 Z 轴方向的热膨胀比焊球更大
A
B
图 6-5 焊点形状对比
A– 有应力集中的 SMD 形状
B– 没有应力集中的金属限定形状
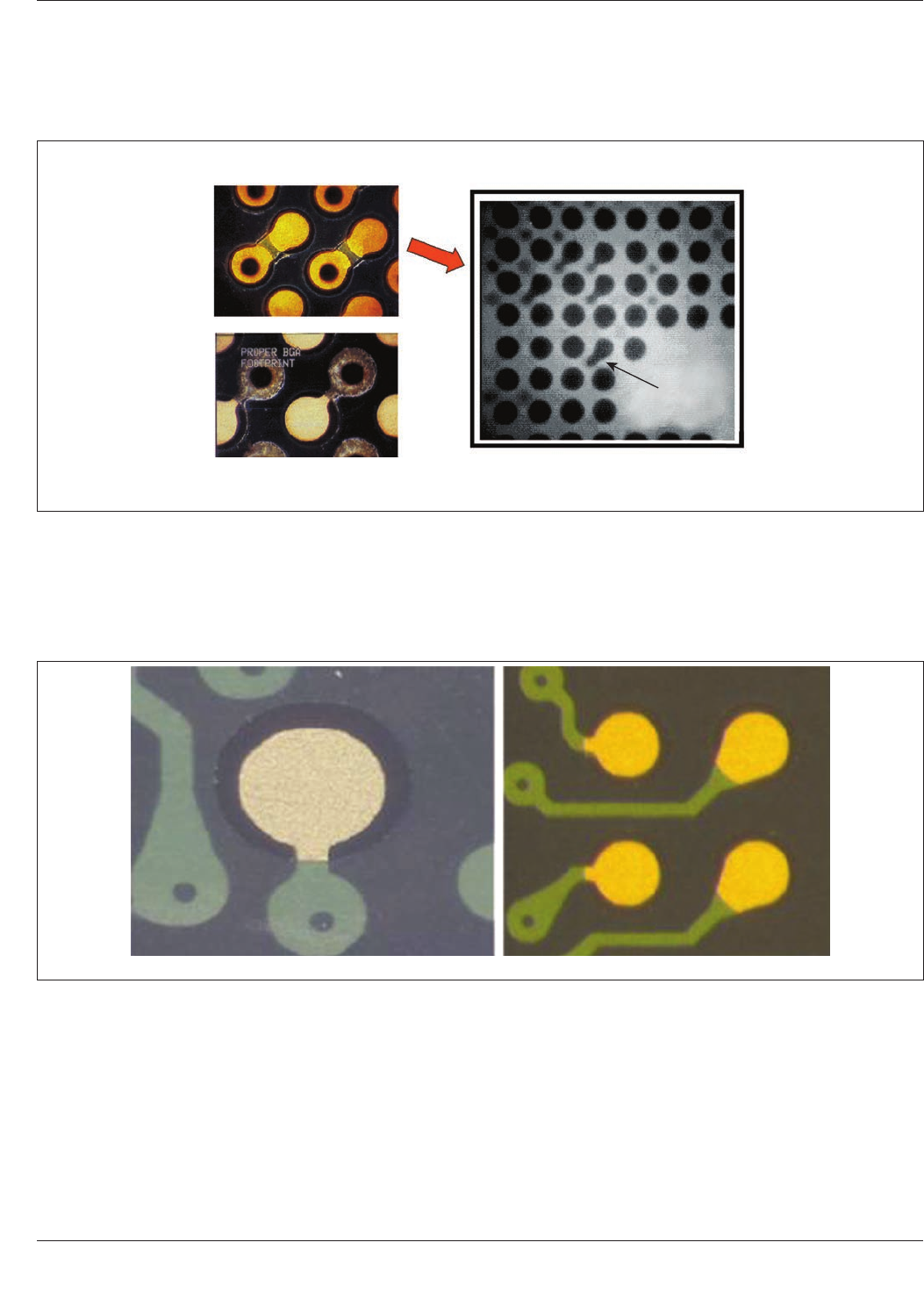
IPC-7095D-WAM1 CN2019 年 1 月
63
导通孔连接盘上覆盖阻焊膜也会降低 BGA 返工时狭窄阻焊膜坝脱落的风险。某些阻焊膜与表面处理组合的掩
蔽导通孔可能并不可靠。侵入孔上的阻焊膜开窗应该大到足以使助焊剂和其它污染物在焊接时排出。在准备用
掩蔽或侵入导通孔时,咨询印制板制造商确认其能力。图 6-6 为较好的和较差的阻焊膜设计示例,图 6-7 是金
属限定连接盘的示例。
A
B
C
IPC-7095d-6-6-cn
图 6-6 好 / 差的阻焊膜设计
A– BGA 走线和阻焊膜设计
B– 显示焊点影响
C– 由于不正确的走线和阻焊膜设计导致焊料被吸入导通孔
IPC-7095d-6-7-cn
图 6-7 金属限定连接盘示例
BGA 连接盘图形上导通孔的其它选择包括盲孔和微导通孔。盲孔可用钻孔、激光、烧蚀或者通过湿式或干式(等
离子)化学的感光限定法来实现。外层和内层依次制备,然后层压在一起。因为盲孔仅穿透外层,故采用尺寸
较小的钻头。但是通常这种方法成本较高。盲孔可以布置在连接盘之间,但是由于该盲孔盘尺寸较小,是否将
盲孔布置在两连接盘间的中心并没有那么重要。
微导通孔由二次加工实现,仅穿透印制板外层。标准微导通孔连接第 1 层与第 2 层和/或第 n-1 层与第 n 层。
典型的微导通孔连接盘大小为 0.3mm,钻孔尺寸为 0.1mm。由于尺寸较小,这种微导通孔被置于连接盘的中央,