IPC-7095D-CHINESE NP 2019 - 第89页
IPC-7095D-W AM1 CN 2019 年 1 月 73 连接 盘周 围蚀刻出月牙形浮雕图形(见图 6-31 ) ,以生 成一个金属限定连接盘 ,该连接盘可能会使用 2 个、 3 个或者 4 个轮辐( SMD 段) 。金属限定段的布置应该 使 SMD 段朝向 BGA 角落,以提供最大的抗疲劳强度。 6.4 波峰焊接对正面 BGA 的影响 6.4.1 正面再流焊 印制板混合技术常见的组装顺序 为首先再流焊接印制板正面的表面贴装封装…
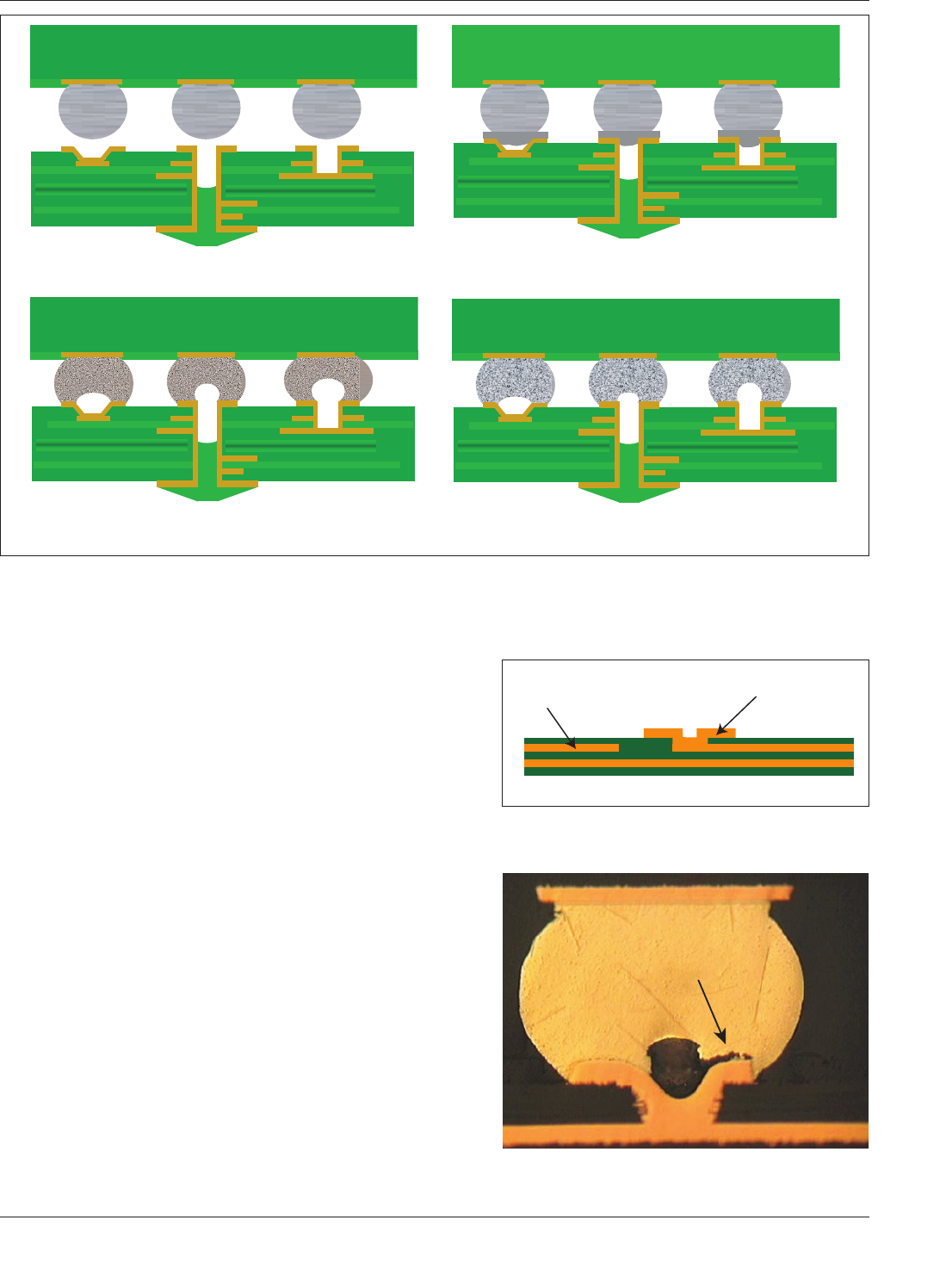
IPC-7095D-WAM1 CN 2019 年 1 月
72
图 6-28 焊盘内导通孔工艺描述(BGA 在顶部)
A– 来料状况 - 组装工艺开始前 C– 再流焊过程中
B– 焊膏印刷和 BGA 贴装后
D– 再流焊接之后
6.3.6 密节距 BGA(FBGA)连接盘内微导通孔策略
对于节距小于 0.8mm 的 BGA 全阵列元器件,就现有的机械钻
孔技术来说,连接盘上没有足够空间可进行布孔。对于节距
更密的 BGA,为了增大布线面积,可能需要在焊盘中使用微
导通孔。这些孔是连接印制板第一层或内部第二层的盲孔。
它们通常由激光钻孔形成,但在某些场合也会使用机械钻孔
工艺(见图 6-29)。
除非填塞或电镀封闭该微导通孔,否则空气可能会截留在焊
膏下并在再流焊过程中在焊球内形成空洞。对于带有微导通
孔的金属限定连接盘,裂纹会由与导通孔相关的空洞开始扩
张并朝向焊球外部。(见图 6-30)
与可比较的不带焊盘内导通孔的金属限定连接盘相比,这些
空洞已显示降低了焊点可承受应力的量级。由于这个原因,
不建议在高应力区域诸如角落焊球或者那些直接在芯片边缘
之下的的焊球处采用焊盘内导通孔。
6.3.7 电源和接地连接
当接地或电源层内需要连接盘时,
通常的做法是在阻焊膜覆盖的层留下开口以提供对连接盘的
访问入口。当这些位置需要增加疲劳寿命或热隔离时,可在
A
B
C
D
IPC-7095d-6-28-cn
图 6-29 微导通孔示例(剖面图)
A– 铜层 B– 印制板焊盘
A
B
IPC-7095d-6-29-cn
图 6-30 微导通孔内的空洞
A – 裂纹
A

IPC-7095D-WAM1 CN2019 年 1 月
73
连接盘周围蚀刻出月牙形浮雕图形(见图 6-31),以生
成一个金属限定连接盘,该连接盘可能会使用 2 个、3
个或者 4 个轮辐(SMD 段)。金属限定段的布置应该使
SMD 段朝向 BGA 角落,以提供最大的抗疲劳强度。
6.4 波峰焊接对正面 BGA 的影响
6.4.1 正面再流焊
印制板混合技术常见的组装顺序
为首先再流焊接印制板正面的表面贴装封装,然后再
波峰焊接通孔封装(由正面插入)。对于双面印制板,
反面表面贴装元器件通常在正面元器件之前贴装,并
通过再流焊接或点胶的方式将它们固定在所需位置。
反面元器件如果没有被点胶固定的话,应该通过波峰
焊载具与波峰隔开。
但是在波峰焊接过程中,印制板正面已再流焊接过的
表面贴装元器件也会受热。当温度升高到接近焊料合
金液相线点时,这种加热会导致这些元器件的焊点融
化。因此要注意防止这些元器件的焊点温度达到液相线温度。
6.4.2 正面再流焊的影响
需要注意 BGA 焊点,因为它们的焊点在波峰焊接中处于受应力状态。如果这些焊
点达到液相线温度(共晶锡铅焊料成分为 183°C;SAC 合金 217°C),那么由于升温过程中导致的热机应变,
此时焊点就存在退润湿或从印制板/封装基板脱离的潜在风险。因为受热后焊料极其柔软,即使是在接近液相
线温度,当温度没达到固相线时也会存在冷焊、退润湿或者焊球变形的风险。
图 6-32 描述了主板正面 BGA 器件发生焊球变形和退
润湿的情况。在波峰焊接时,BGA 焊点会达到 180°C
的峰值温度。BGA 焊点比有引线 SMT 器件焊点更易
出现这些缺陷,因为它们缺少应变消除。
为了避免印制板正面出现 BGA 焊点问题,在锡铅波峰
焊接过程中其温度不应该超过 150°C
,对于无铅合金波
峰焊接不应该超过 190°C
。这比密节距有引线元器件(如
塑封 QFP)所允许的最高温度要低。
图 6-33 是一例混合技术印制板上焊点在波峰焊接中可
接受的温度曲线。
要确定保持温度低于 150°C
(对于无铅为 190°C)的各
种方法,最好先确定波峰焊工艺中 BGA 焊点受热的多种方式。
图 6-34 展示了三种路径 :
路径 A- 穿过印制板的厚度,热量由反面传导至正面
路径 B- 经由导通孔壁传导,沿着连接导通孔的导体到 BGA 焊点连接盘
路径 C- 位于波峰焊接设备上方的预加热器产生的对流和辐射
A
E
D
C
B
IPC-7095d-6-31-cn
图 6-31 BGA 接地或电源连接
A– 金属限定段
B–SMD 段
C– 阻焊膜
D– 铜层
E– 蚀刻成月牙形开口的平面
图 6-32 正面再流焊点退润湿和焊球变形案例

IPC-7095D-WAM1 CN 2019 年 1 月
74
图 6-33 正面元器件混装板组件,波峰焊温度曲线
A– 温区 1
B– 温区 2
C– 温区 3
D– 紊波(译者注)
E– 平波
F– 密节距的最大峰值温度为 160 °C
G– BGA 的最大峰值温度为 150 °C
150 ° C
160 ° C
183 °C
80 ° C
B
100 ° C
A C D E
40 ° C
60 ° C
G
F
IPC-7095d-6-33-cn
图 6-34 波峰焊接时,到达 BGA 焊点的热通道
A– 路径 A
B– 路径 B
C– 路径 C
D– 热源
E– BGA
F– 印制板
G– 波峰
D
E
C
A
G
B
F
IPC-7095d-6-34-cn