IPC-CM-770D-1996 - 第59页
January 1996 IPC-CM-770 12.9 Cleaning General techniques for cleaning applying to all types of components are described in Section 28. Because of generally smaller spacing between leads, smaller clearances between substr…

IPC-CM-770
Januaty
1996
make adequate contact with substrate solder lands. Flatness
of the substrate is also of concern and needs to be con-
trolled.
12.3.2 Land Patterns
The land patterns used with chip
carriers fall into two main categories, high density and low
density,based on the local routing density associated with
the surface mounted device. The selection, design and posi-
tion of the land geometry in relation to the chip carrier
have a significant impact on the resultant solder joint con-
figuration. An example of a land pattern is presented in
Figure 12-6 for use with Type A leaded chip carriers (see
IPC-SM-782).
The attachment lands for surface mounting leadless chip
carriers should be the same width as the component termi-
nal maximum plus 1.3 mm whenever possible. The land
length should extend between 3.8 to
1.0
mm beyond the
maximum chip carrier outline on each of all four sides to
create a horizontal solder fillet length equal to the vertical
fillet rise.
IPC-I-
L
Figure 12-6 Land Pattern for Type A Leaded Chip Carrier
Mounting
12.3.3 LeadlLand Configuration After Assembly
Care
must be taken to assure the condition of the chip carrier
terminations is such that solderability is not adversely
impacted. Techniques in storage, handling and placement
must be adequate to preserve good metallurgical and
mechanical properties of the termination up to and through
placement of the device.
12.3.4 Mounted Component Configuration
Quality,
reliable, solder joints, device performance, and the ability
to withstand operating environments are in part dependent
on control of the configuration of the mounted component/
substrate interface.
Assembled chip carriers may be constrained mechanically
or with adhesive prior to soldering, or they may be allowed
to float.
If
adhesives are used, they should not absorb mois-
ture, create a conductive leak path or interfere with solder
joint formation. Standoffs may be used to control solder
joint configuration and/or provide required clearance for
cleaning after solder. It is generally recommended that a
clearance of 0.25 mm minimum be provided between the
chip carrier and the substrate to facilitate adequate
cleaning.
In some solder paste applications, the leadless components
may be allowed to “float”, because surface tension will
serve to pull the chip carrier into correct alignment with
respect to the land pattern. However, this is dependent
upon chip carrier size, positional tolerance, flatness of
leads, etc.
For leaded chip carriers having through-hole clip leads,
adequate tooling should be used to assure the leads mate
with holes in substrate. Preforms can be used on either
side, depending upon structures and orientation during
reflow.
12.4 Mixed Technology
General techniques for mixed
assemblies are discussed in Section 25.
The process sequence for mixed assembly using chip car-
riers will vary depending on what type of other compo-
nents are mounted on both sides of the substrate; and what
specific solder process (or processes) will be used.
Where through-hole mounted components and discrete
chips and chip carriers are all mounted on the same side of
the board the order of assembly must take into account the
solder process to be used. As for class C-1 assemblies, if
solder preforms are utilized with the through-hole mounted
components one of the solder passes can be eliminated (see
Section 22 for more details).
12.5 Manual Assembly
Manual mounting techniques for
surface mount devices can be found in Section 22.
12.6 Automated Assembly
Automated placement tech-
niques applied to high volume, high density mounting of
chip carriers provides benefits in quality and productivity.
Currently several manufacturers provide automatic place-
ment equipment and robotic devices to place chip carriers.
Robotics may offer more flexibility than other placement
equipment while packaging standards are developed; how-
ever, placement systems utilizing vacuum pickup and/or
self centering tweezer grips are in use today and provide
versatility for chip carrier placement.
12.7 Handling and Storage
The handling and storage of
chip carriers should be in accordance with the guidelines of
Section 26.
12.8 Soldering
General soldering characteristics apply-
ing to all types of components and assemblies are
described in Section 27.
3
-22
COPYRIGHT Association Connecting Electronics Industries
Licensed by Information Handling Services
COPYRIGHT Association Connecting Electronics Industries
Licensed by Information Handling Services

January
1996
IPC-CM-770
12.9 Cleaning
General techniques for cleaning applying
to all types of components are described in Section 28.
Because of generally smaller spacing between leads,
smaller clearances between substrate and the component
body, and large area beneath the devices, chip carriers
present a more difficult cleaning situation than through-
hole mounted devices. Clearance under the package should
be adequate to facilitate an effective cleaning operation.
Some surface mounting soldering processes result in
exposing the fluxes to high heat for longer and repeated
periods of time than experienced with through-hole compo-
nent soldering. This can lead to a more stable flux residue
making the cleaning more difficult. There is generally less
flux residue associated with chip carriers, but it is concen-
trated in smaller crevices under and between close spaced
devices.
Techniques using azeotropic solvents, aqueous cleaning
with detergents, as well as combinations of aqueous and
solvent cleaning process have been successfully applied.
12.10 Conformal Coating
General techniques for con-
formal coating for all types of assemblies are described in
Section 29.
13.0 AREA ARRAY COMPONENTS
The advent of very large scale integration (VLSI) and very
high speed integrated circuit (VHSIC) has brought a need
for very high pin count packages with lead symmetry and
methods to reliably assemble them onto circuit boards.
Grid arrays are pinned or leadless carriers with I/O contacts
that populate one surface of the package on a
0.100
inch
(eventually
0.050
inch) grid. The use of a solid grid neces-
sitates placing the die cavity on the side opposite the
Il0
contacts.
A
double or multiple concentric row grid permits
having die cavity and
Il0
contacts on the same side with
an optional heat sink on the opposite side.
13.1 Pin Grid Array Components
13.1.1 Port Types
The pin grid array package is the
package designed for high pin out ICs for through-hole
mounting because of its space efficiency and compatibility
with existing DIP facilities.
The main advantage of the pin-array is to avoid the
Il0
limitations of peripherally terminated packages such as
LCC at the same time providing terminal separations of
100-mil centerlines.
As
such it can be readily installed into
a conventional printed board and also wave soldered.
Offset disadvantages which have to be weighed:
Inspection of solder joints
Impedance limitations
Removal and replacement
A
typical pin grid array is a square, multilayer (usually
ceramic package having terminals on 2.54 x 2.54 mm cen-
ters. These packages are available in either cavity up or
cavity down versions.
A
cavity up configuration mounts the die opposite the pins,
thereby allowing a full grid of pins and the highest I/O
density.
A
cavity down configuration has the die on the same side
as the pins and is generally used with high power circuits
in air cooled applications to allow a heat sink opposite the
die. However, this version is not as space efficient.
Pin grid arrays have good electrical characteristics due to
the short signal paths from I/O pin to die. Pin grid arrays
overcome thermal expansion problems typically encoun-
tered at ceramic/printed board interfaces because the pins
are compliant. Conventional soldering techniques such as
wave soldering can attach these packages to printed boards.
The higher the I/O lead count becomes, the lower the per-
centage of the total package area any given-size die cavity
will occupy, e.g., the 96-lead, 40-mil center chip carrier is
over one-inch square.
For optimum packaging density, this percentage should be
as high as possible. Therefore, 0.635 and
0.5
mm chip car-
riers and grid arrays are used (Figure 13-1).
Figure 13-2 shows the
Il0
density achievable with the vari-
ous packages.
As
can be seen, for lead count require- ments
in excess of
100,
a 0.10-mil centerline solid grid provides
greater I/O density than either
50-
or 40- mil centerline
chip carriers.
IPC-I-
Figure 13-1 149 Pin Array Package
The 25-mil centerline chip carrier is clearly more I/O effi-
cient than is a 0.100-mil grid array. However, a double-
row 50-mil solid grid provides the greatest I/O density.
With pins brazed on 100-mil centers, pin grid arrays are a
logical carrier for high lead counts intended for through-
hole (not surface mount) board assembly compatible with
3-23
COPYRIGHT Association Connecting Electronics Industries
Licensed by Information Handling Services
COPYRIGHT Association Connecting Electronics Industries
Licensed by Information Handling Services
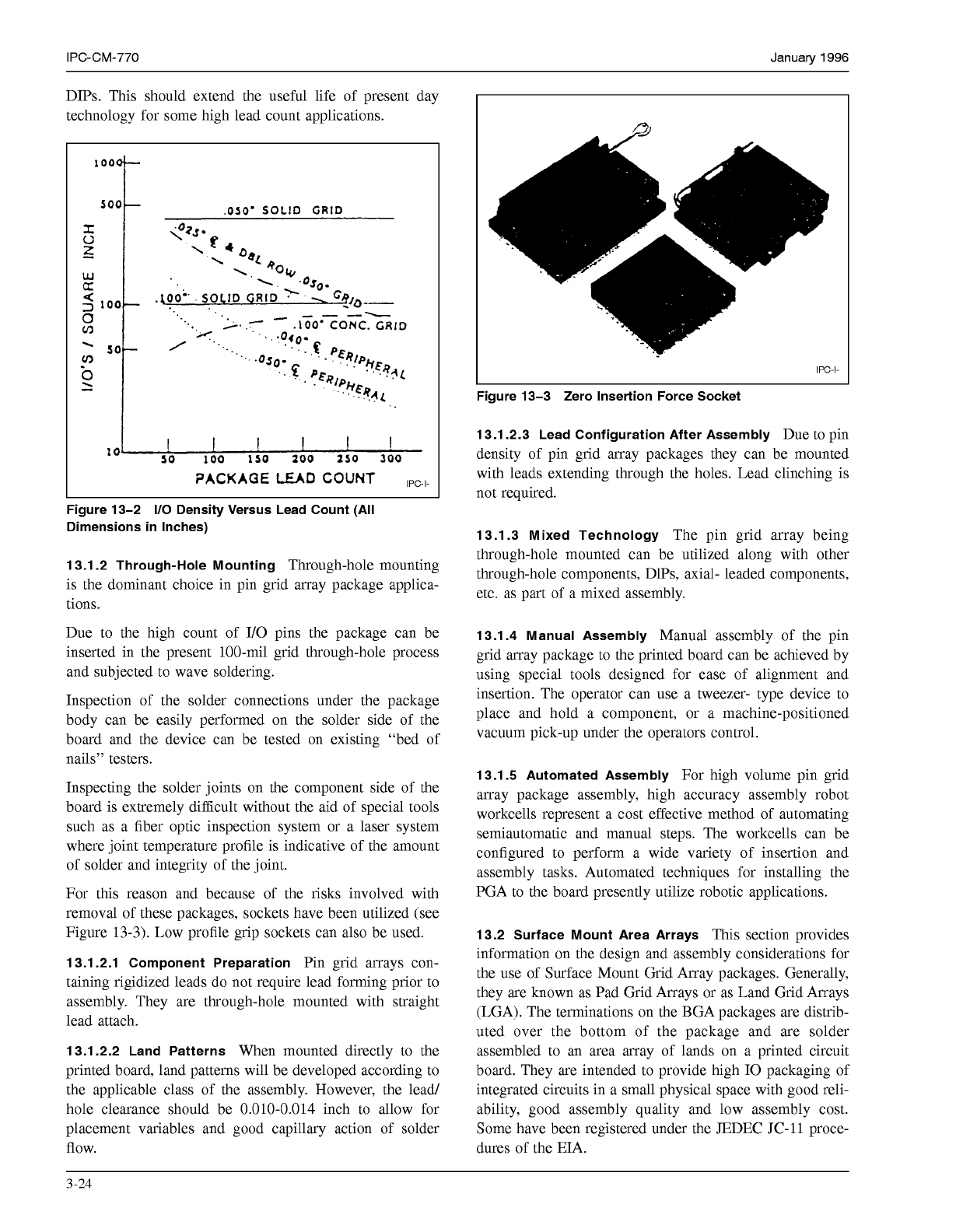
IPC-CM-770
Januaty
1996
DIPS. This should extend the useful life of present day
technology for some high lead count applications.
soot-
.OSO'
SOLID
CRlD
I
I
l
lo'
50
110
110
id0
II0
300
PACKAQE
LEAD
COUNT
Ipc.I.
L
Figure 13-2
110
Density Versus Lead Count (All
Dimensions in Inches)
13.1.2 Through-Hole Mounting
Through-hole mounting
is the dominant choice in pin grid array package applica-
tions.
Due to the high count of I/O pins the package can be
inserted in the present 100-mil grid through-hole process
and subjected to wave soldering.
Inspection of the solder connections under the package
body can be easily performed on the solder side of the
board and the device can be tested on existing "bed
of
nails" testers.
Inspecting the solder joints on the component side of the
board is extremely difficult without the aid of special tools
such as a fiber optic inspection system or a laser system
where joint temperature profile is indicative of the amount
of solder and integrity of the joint.
For this reason and because of the risks involved with
removal of these packages, sockets have been utilized (see
Figure
13-3).
Low profile grip sockets can also be used.
13.1.2.1 Component Preparation
Pin grid arrays con-
taining rigidized leads do not require lead forming prior to
assembly. They are through-hole mounted with straight
lead attach.
13.1.2.2 Land Patterns
When mounted directly to the
printed board, land patterns will be developed according to
the applicable class of the assembly. However, the lead
hole clearance should be
0.010-0.014
inch to allow for
placement variables and good capillary action of solder
flow.
Figure 13-3 Zero Insertion Force Socket
13.1.2.3 Lead Configuration After Assembly
Due to pin
density of pin grid array packages they can be mounted
with leads extending through the holes. Lead clinching is
not required.
13.1.3 Mixed Technology
The pin grid array being
through-hole mounted can be utilized along with other
through-hole components, DlPs, axial- leaded components,
etc. as part of a mixed assembly.
13.1.4 Manual Assembly
Manual assembly of the pin
grid array package to the printed board can be achieved by
using special tools designed for ease of alignment and
insertion. The operator can use a tweezer- type device to
place and hold a component, or a machine-positioned
vacuum pick-up under the operators control.
13.1.5 Automated Assembly
For high volume pin grid
array package assembly, high accuracy assembly robot
workcells represent a cost effective method of automating
semiautomatic and manual steps. The workcells can be
configured to perform a wide variety of insertion and
assembly tasks. Automated techniques for installing the
PGA to the board presently utilize robotic applications.
13.2 Surface Mount Area Arrays
This section provides
information on the design and assembly considerations for
the use of Surface Mount Grid Array packages. Generally,
they are known as Pad Grid Arrays or as Land Grid Arrays
(LGA). The terminations on the BGA packages are distrib-
uted over the bottom of the package and are solder
assembled to an area array of lands on a printed circuit
board. They are intended to provide high IO packaging of
integrated circuits in a small physical space with good reli-
ability, good assembly quality and low assembly cost.
Some have been registered under the JEDEC JC-11 proce-
dures of the EIA.
3
-24
COPYRIGHT Association Connecting Electronics Industries
Licensed by Information Handling Services
COPYRIGHT Association Connecting Electronics Industries
Licensed by Information Handling Services