m220_383_02_process_manual工艺手册 - 第28页
PROCESS SETUP AND ACCEPTANCE P ROCESS M ANU AL 3.4-3 - Thickness and refractive i ndex measurements shoul d be done with a Plas mos automated ellipsometer or comparable equipment. - Sheet resistivity should be measured w…
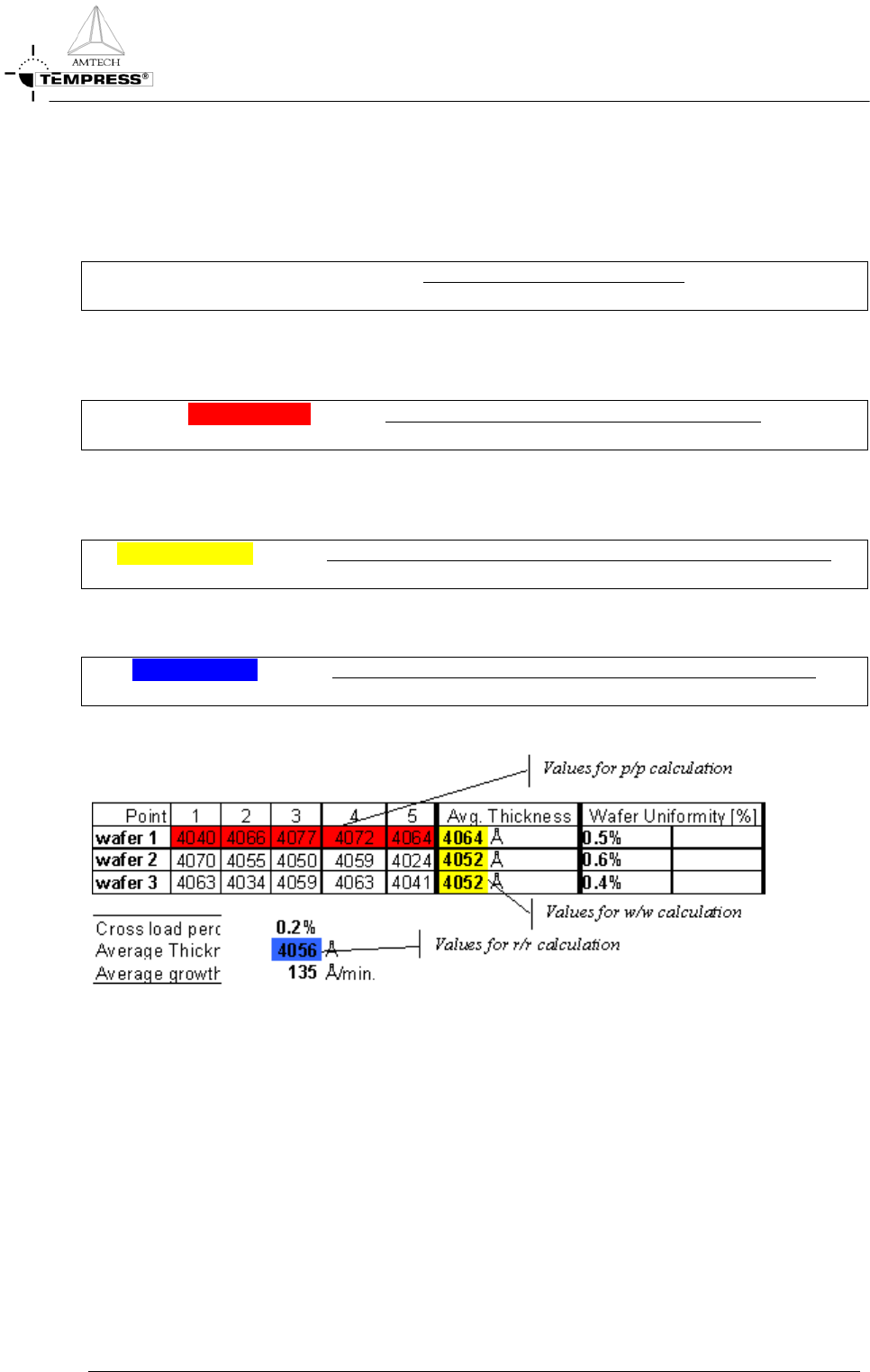
PROCESS SETUP AND ACCEPTANCE
P
ROCESS MANUAL
3.4.1.2 Formula’s
- The general formula that is used for the uniformity calculation:
Uniformity [+-%] =
maximum value – minimum value
2 * average value
- The point-to-point (cross wafer) uniformity is presented as an average wafer value +/- the
uniformity in %. It is based on 5 or 9 measurement points as indicated in section Error!
Reference source not found..
P/P Uniformity [+-%] = maximum (point) value – minimum (point) value
2 * average (5 or 9 point) value
- The wafer-to-wafer (cross load) uniformity is presented as an average load value +/- the
uniformity in %. It is based on the average wafer values as determined in the point-to-point
uniformity calculation.
W/W Uniformity [+-%] = maximum (wafer average) value – minimum (wafer average) value
2 * average (all wafer average) value
- The run-to-run uniformity is presented as an average run value +/- the uniformity in %. It is
based on the average load values as determined in the wafer-to-wafer calculation.
R/R Uniformity [+-%] = maximum (load average) value – minimum (load average) value
2 * average (run average) value
Example:
Figure 3-5 : Example of process result calculation
3.4.1.3 Equipment
- Standard Process recipes supplied by Amtech/Tempress Systems will be used for process
acceptance runs.
- All measurement equipment should be supplied by the customer and be available to the
Amtech/Tempress Systems Engineer.
3.4-2

PROCESS SETUP AND ACCEPTANCE
P
ROCESS MANUAL
3.4-3
- Thickness and refractive index measurements should be done with a Plasmos automated
ellipsometer or comparable equipment.
- Sheet resistivity should be measured with an automated 4-point probe or comparable machine.
- Dopant concentration measurement should be supplied by the customer. Dopant variation will
be characterised in absolute percentages and measured with SIMS or a comparable technique.
- Particle measurements should be done with a Tencor Surfscan 6420 or comparable equipment.

PROCESS SETUP AND ACCEPTANCE
P
ROCESS MANUAL
3.4-4
3.4.2 Default process test conditions
3.4.2.1 Test material requirements
Bare Si wafers are prime wafers, single or double side mirror polished and according to SEMI
standard M1-0298.
Standard film thickness, sheet resistivity and/or dopant concentration as indicated in this section
apply unless otherwise stated in the customer specific process specifications.
3.4.2.2 Tempress Systems, Inc. Atmospheric processes
Atm-01 Anneal
Test: temperature overshoot and stability
Atm-02 Metalalloy anneal
Test: temperature overshoot and stability
Atm-03 Dry oxidation
test thickness: 500Å
test temperature: 1000
o
C
time indication: 60 min
base: bare Si wafer
testmethod: ellipsometer
Atm-04 Dry oxidation + liquid cleaning
test thickness: 500Å
test temperature: 1000
o
C
time indication: 60 min
base: bare Si wafer
testmethod: ellipsometer
Atm-04s Thin gate oxidation +Atmoscan®
test thickness: 500Å
test temperature: 1000
o
C
time indication: 60 min
base: bare Si wafer
testmethod: ellipsometer
Atm-05 Pyrogenic oxidation
Equipment: Tempress Systems, Inc. external torch
test thickness: 2000Å
test temperature: 1000
o
C
time indication: 30 min