ASMPT_Brochure_SIPLACE_CA2_DE_250403 - 第2页
DIE HYBRIDE HIGHSPEED-PLATTFORM SIPLACE CA2 REVOLUTIONIERT DIE SiP-FERTIGUNG Smarte Devices, 5G-Kommunikationsstandard, autonomes Fahren: Erst konsequente Miniaturisierung und stetig wachsende Komplexität in der Elektron…

(
Highspeed Chip Assembly direkt vom Wafer
und SMT-Bestückung in einer Maschine
SIPLACE CA2
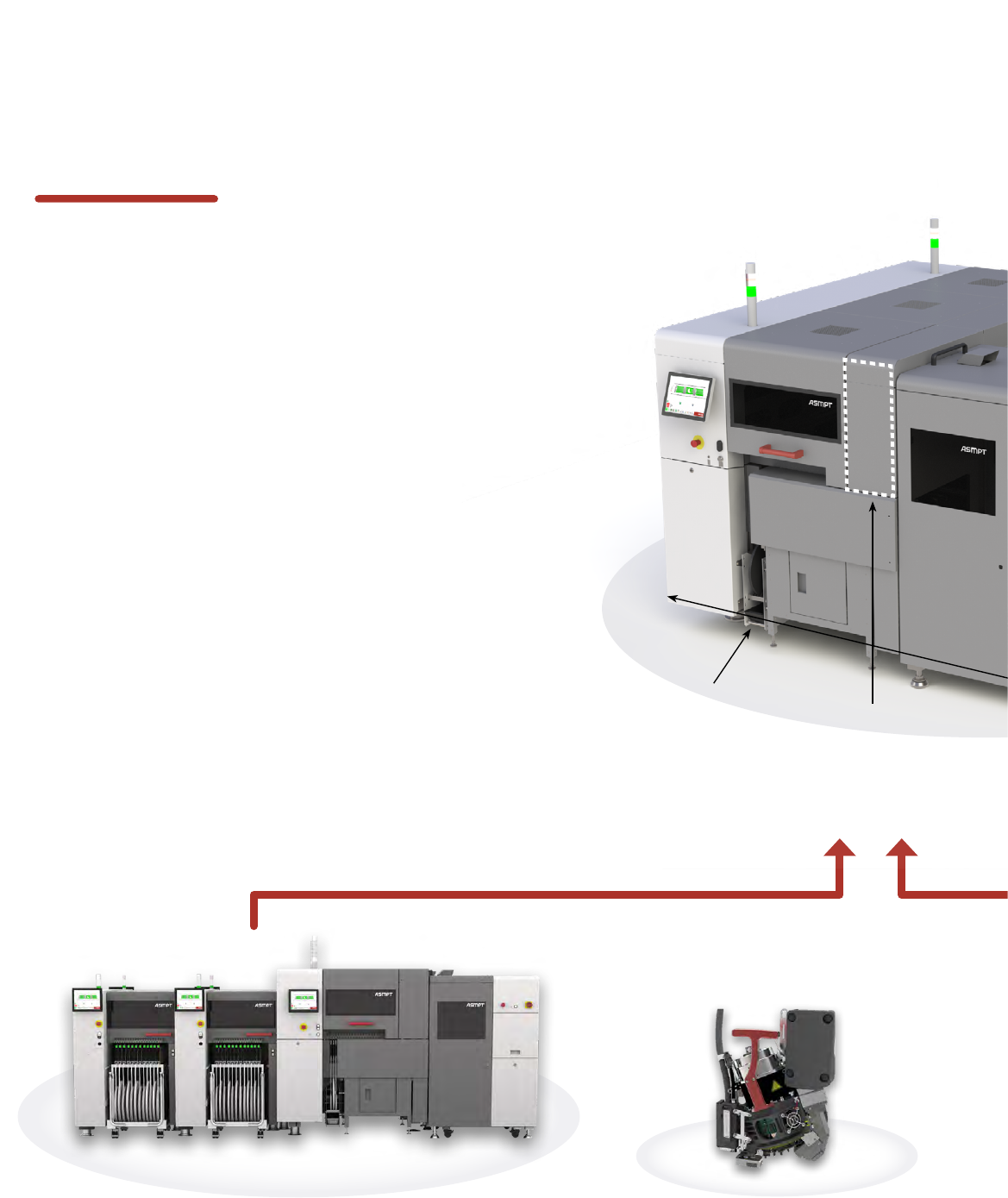
DIE HYBRIDE HIGHSPEED-PLATTFORM SIPLACE CA2
REVOLUTIONIERT DIE SiP-FERTIGUNG
Smarte Devices, 5G-Kommunikationsstandard, autonomes Fahren: Erst
konsequente Miniaturisierung und stetig wachsende Komplexität in der
Elektronik machen all dies möglich. System in Packages (SiP) ist hier die
Schlüsseltechnologie: ICs und SMT-Komponenten werden zu einem kom-
pakten, hochinnovativen System vereint.
Mit enormer Geschwindigkeit und höchster Genauigkeit kann die neue
SIPLACE CA2 als hybrides System aus SMT-Bestückmaschine und Die
Bonder sowohl über Wechseltische/Förderer zugeführte SMDs als auch
Dies direkt vom gesägten Wafer in einem Arbeitsgang verarbeiten. Durch
die Integration des aufwendigen Die-Bonding-Prozesses in die SMT-Linie
wird der Einsatz von dedizierten Spezialmaschinen in der Fertigung ein-
gespart. Reduzierter Personaleinsatz, hohe Konnektivität und integrative
Datennutzung machen die neue SIPLACE CA2 zum perfekten Match für
die Intelligent Factory.
Bestückung direkt vom Wafer: kostengünstiger und nachhaltiger
Durch die direkte Bestückung vom Wafer entfällt der komplette Die-
Taping-Prozess. Das Ergebnis: weniger Nachfüll- oder Spleißarbeiten,
weniger Aufwand bei der Materialversorgung der Linie. Der Wegfall der
Gurtzuführung bei den empndlichen Dies senkt zudem das Handha-
bungsrisiko und erhöht die Resilienz in der Fertigung. All diese Faktoren
führen zu einer signikanten Kostenreduktion. Gleichzeitig fällt kein
Gurtabfall mehr an, was die Fertigung insgesamt umweltfreundlicher
und nachhaltiger macht und zudem den ROI erhöht.
SMT UND DIE BONDING:
SIPLACE CA2
Bestückkopf CP20
▪ Bauteilspektrum: 0201metrisch
bis 8,2 mm × 8,2 mm × 4 mm
▪ Touchless Pick-up und Placement
▪ Bestückkraft 0,5 N - 4,5 N
▪ Extrem schnell: bis 38.000 BE/h
▪ Extrem genau: bis ±10 µm @ 3 σ
Flexible Kombination
SMT und Die Bonding in einer Linie
vereinfachen Ihren Prozessablauf
und verbessern die Materiallogistik.
Platz für JEDEC trays,
sollte das Multi-Wafer-
System nicht benutzt
werden
5 × 8-Millimeter-
Tape-and-Reel-
Förderer
Platz für das
Multi-Wafer-
System
2,56 m

Höchste Produktivität
Verarbeitung von SMT-Komponenten und Dies im
Die-Attach- und Flip-Chip-Verfahren direkt vom
Wafer im gleichen Arbeitsschritt.
Kostensparend
Die Kosten für das Taping, die Qualitätssicherung des
Die-Taping-Prozess und die Abfallentsorgung entfallen.
„Left in Left Out“-Funktion erfordert nur eine
Be- und Entladeeinheit.
Einzigartige Flexibilität
Wafersystem für bis zu 50 verschiedene Wafer mit einer
Wafer-Swap-Dauer von weniger als 10 Sekunden („Full multi-
die capability“). Ein Wafer Chuck, eine Flux (Linear) Dipping Unit
(LDU) und 10 × 8 mm Tape-and-Reel Feeder Tracks können
parallel zum Aufnehmen von Wafern verwendet werden.
Lückenlose Rückverfolgbarkeit
Tracedaten jedes einzelnen Dies: von ihrem Ursprung
auf dem Wafer bis zu ihrer Bestückposition auf der
Leiterplatte („Full single die level traceability“).
Konsequent nachhaltig
Die-Verarbeitung direkt vom gesägten Wafer
spart den gesamten Die-Taping-Prozess – und
damit jede Menge Gurtabfall.
Maximale Leistung
Dank Puerung und Prozess-Parallelisierung
erreicht die SIPLACE CA2 eine Bestückleistung für
Dies von bis zu 54.000 BE/h direkt vom Wafer
mit einer Genauigkeit von bis zu 10 μm @ 3 σ.
Umfassende Qualitätssicherung
Mehrere Highend-Visionsysteme für eine
umfassende Kontrolle aller Prozesse erkennen
selbst kleinste Bauteile und Elemente sicher.
MULTITALENT VEREINT
ZWEI WELTEN IN EINER MASCHINE
Wafer Exchange Unit
▪ Extrem exibel: Verarbeitung
von bis zu 50 verschiedenen Wafern
▪ Extrem schnell: Wafer Swap
in nur 13 Sekunden
Mehr zur
SIPLACE CA2
Zugang für
Hoist-System
Wafer Exchange Unit
mit Waferwechsel in
13 Sekunden
Schubfach für
das Wafer-
Magazin
2,5 m
2,56 m