Utah-94-721002-System-Manual.pdf - 第114页
mä~ëã~ä~Ä póëíÉãNMM lñÑçêÇ =fåëíêìã Éåíë= mä~ëã~ =qÉÅÜåçäçÖó == System Manual RKUKU= pÉêîáÅÉ=ãçÇÉ= The Service Mode page is displayed by selecting the System button, then the Service option. Fig 5.19: Servi ce mode page …

System Manual lñÑçêÇ=fåëíêìãÉåíë=mä~ëã~=qÉÅÜåçäçÖó== mä~ëã~ä~ÄpóëíÉãNMM
RKUKT= j~ëë=Ñäçï=Å~äáÄê~íáçå=é~ÖÉ=
Fig 5.18: Mass flow calibration page
CAUTION
Some gas mixtures may produce particles in the chamber or gas lines.
Check only ONE gas at a time.
Allow at least 15 minutes of pumping before and after any chamber fill using
Silane or SiCl4.
This is similar to the Leak Detection page (see sub-section 5.8.6, page 5-45.) with the addition
of setpoint boxes for the Mass Flow Controllers. Only the ‘Pump to Time’ feature should be
selected, because the selected gases will turn on during the initial pumpdown period. (If
‘Pump to pressure’ is selected with a gas flowing, it is unlikely to reach the target pressure).
When the initial pumping and MFC stabilisation period ends, the chamber seals and fills
slowly. The rate-of-pressure rise is calculated and displayed.
NOTE: Chamber pressure depends on quantity of gas added and on the chamber
temperature. If a high-power plasma has been run recently, the chamber
will be hotter and the rate-of-pressure rise will be greater for the same gas
flow.
Operating Instructions
Printed: 22-Mar-06, 10:42 Page 5-47 of 52 UC Davis 94-721001 Issue 1: March 06
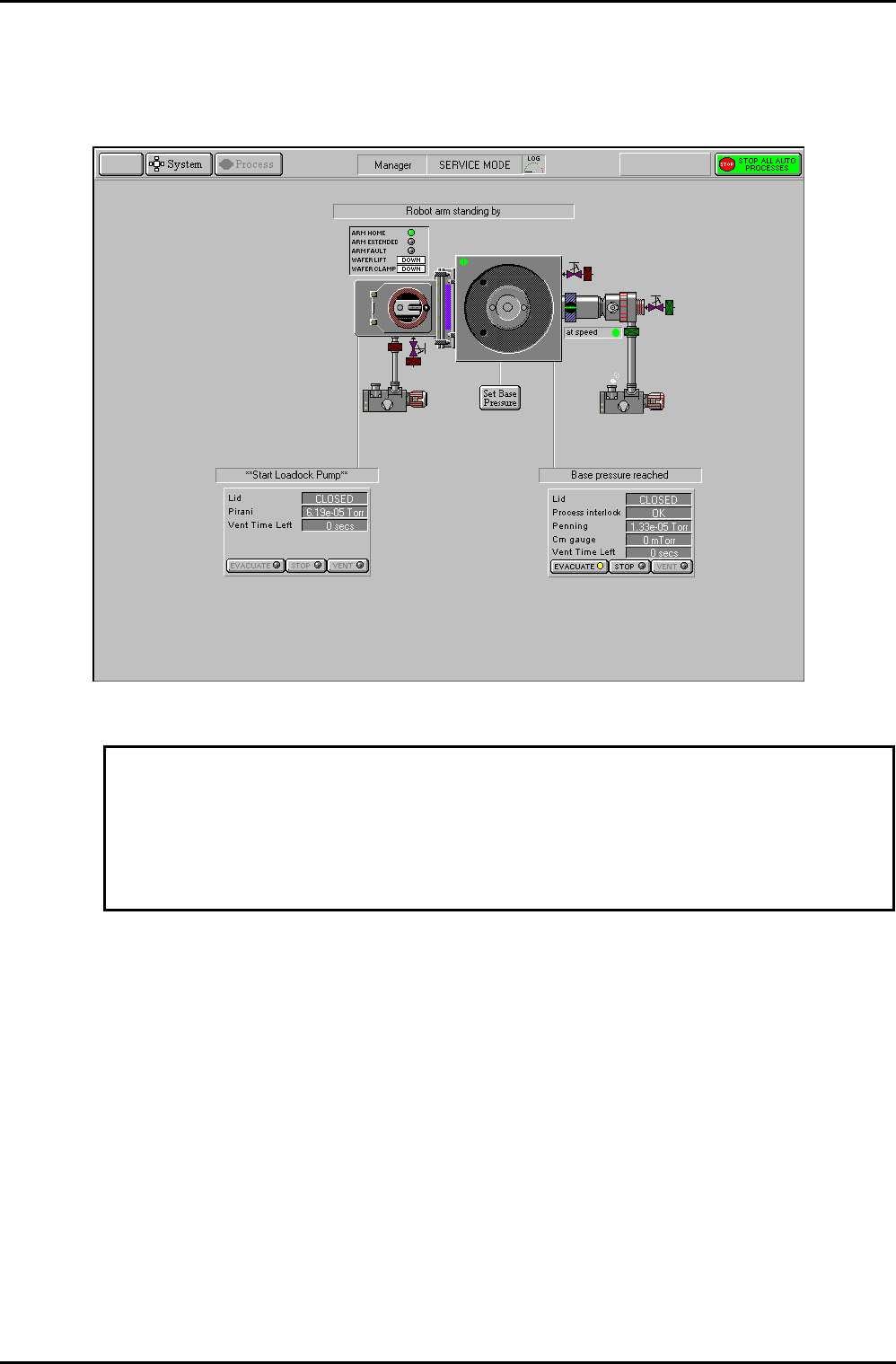
mä~ëã~ä~ÄpóëíÉãNMM lñÑçêÇ=fåëíêìãÉåíë=mä~ëã~=qÉÅÜåçäçÖó== System Manual
RKUKU= pÉêîáÅÉ=ãçÇÉ=
The Service Mode page is displayed by selecting the System button, then the Service option.
Fig 5.19: Service mode page
CAUTION
The software interlocks which prevent collisions between the wafer, robot arm,
slit valve and the wafer clamp are overridden in the Service Mode. Therefore,
before clicking on any button, consider very carefully the consequences of your
proposed actions.
This page is used during maintenance to manually control system components. The page can
also used to manually transfer wafers between the Automatic load lock and process chamber.
Manual control of the following features is available by clicking on them (confirmation is
requested before any action is carried out):
Note that moving the mouse pointer over a feature will cause a box to be displayed around
the feature indicating that it can be manually controlled.
a) Process chamber turbo pump.
b) Process chamber wafer lift and wafer clamp.
c) Process chamber vent valve.
d) Process chamber APC valve.
e) Process chamber turbo backing valve and purge valve.
Operating Instructions
UC Davis 94-721001 Issue 1: March 06 Page 5-48 of 52 Printed: 22-Mar-06, 10:42

System Manual lñÑçêÇ=fåëíêìãÉåíë=mä~ëã~=qÉÅÜåçäçÖó== mä~ëã~ä~ÄpóëíÉãNMM
f) Process chamber rotary vane/dry pump.
g) Automatic load lock transfer arm (click red dot to insert/withdraw arm).
h) Automatic load lock isolating valve.
i) Automatic load lock vent valve.
j) Automatic load lock dry/rotary vane pump.
k) Slit valve.
RKUKUKN= qê~åëÑÉêêáåÖ=ï~ÑÉêë=áå=ëÉêîáÅÉ=ãçÇÉ=
To transfer wafers between chambers in service mode, click on the wafer mimic (either in the
Automatic load lock or process chamber). The following screen is displayed:
Fig 5.20: Wafer transfer in service mode
Click on the wafer destination. The wafer will be transferred.
The ADD WAFER button is used to inform the system that a wafer is present. This facility
would be used if the machine were powered-up with a wafer in the Automatic load lock. The
legend on this button changes to KILL WAFER when a wafer is present, enabling the selected
wafer to be removed from system memory.
Operating Instructions
Printed: 22-Mar-06, 10:42 Page 5-49 of 52 UC Davis 94-721001 Issue 1: March 06