00197497-03_UM_SiplaceCA-Serie_DE - 第202页
4 SIPLACE Wafer-System (SWS) Betriebsanleitu ng SIPLACE CA-Serie 4.1 Funktionsbeschreibung Ab Softw areversion SR 708.0 Ausgabe 12/2014 202 4.1.3.1 Flip-Chip-Prozess Der Flip-Chip-Prozess ist das S tandardverfah re n des…
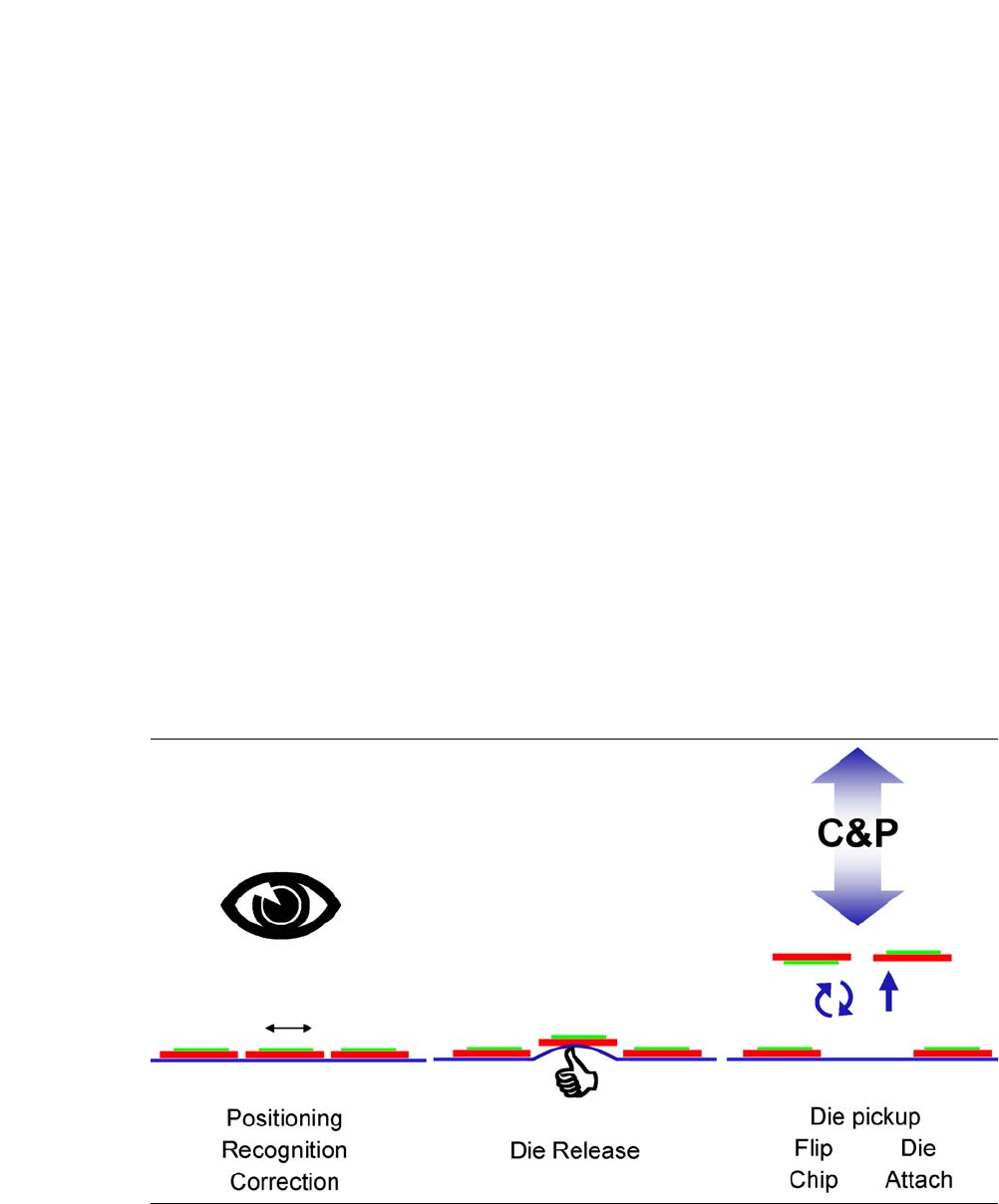
Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS)
Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung
201
Um das ganze Spektrum prozessorientierter Funktionen zu unterstützen sind folgende Optionen
verfügbar:
– Wafer-Map-System
– Linear-Dipping-Unit
– Die-Attach-Unit
– Small-Die-Kit (auf Anfrage)
– Barcodescanner
– Wafer-Expander
– Inspektionskamera
4.1.3 Basic-Die-Presentation-Prozess
Der von der SWS unterstützte Basic-Die-Presentation-Prozess kann in 3 Hauptabschnitte unter-
teilt werden:
– Die-Erkennung und Positionierung für den Ausstechvorgang (incl. Ink-Punkt-Erkennung oder
Wafer-Map)
– Ausstechvorgang
– Abholvorgang für Die-Attach- oder Flip-Chip-Verarbeitung.
Abb. 4.1 - 1 Basic-Die-Presentation-Prozess
Grundsätzlich gibt es zwei wesentliche Bestückvarianten, den Flip-Chip- und den Die-Attach-Pro-
zess.
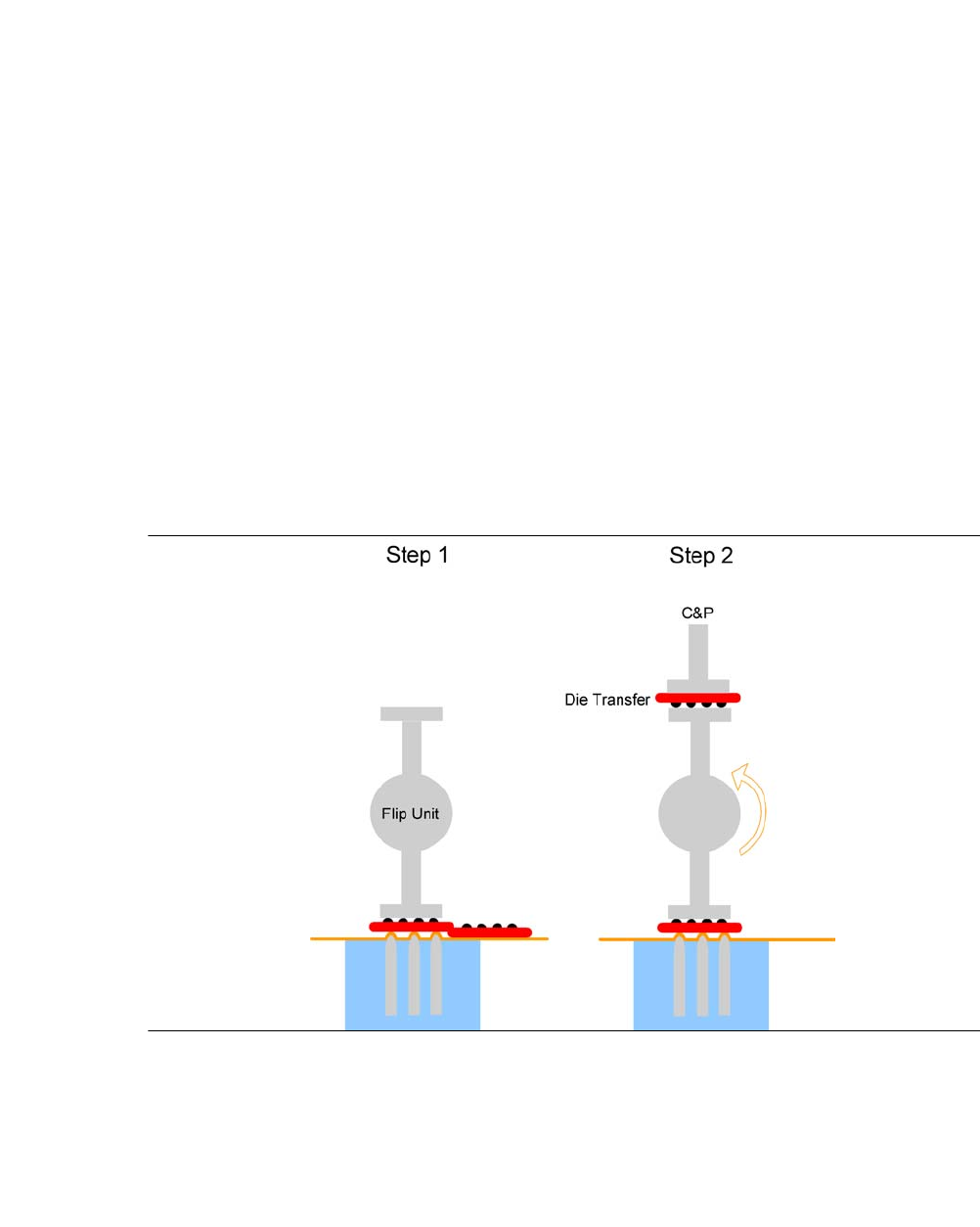
4 SIPLACE Wafer-System (SWS) Betriebsanleitung SIPLACE CA-Serie
4.1 Funktionsbeschreibung Ab Softwareversion SR 708.0 Ausgabe 12/2014
202
4.1.3.1 Flip-Chip-Prozess
Der Flip-Chip-Prozess ist das Standardverfahren des SWS. Dabei wird das Die vor der Bestü-
ckung auf der Platine um 180° gedreht (Face-Down-Bestückung).
Der Flip-Chip-Prozess ist eine stark wachsende Technologie. Dieser Prozess wird vor allem für
Baugruppen in der Consumer-Elektronik verwendet (z. B. Prozessoren, Grafik-Prozessoren,
Speicher).
Die Ein-/Ausgänge (E/A) des Dies sind direkt mit der Leiterplatte verbunden, was gegenüber dem
klassischen Die-Attach-Prozess einige Vorteile hat:
Geringerer Platzverbrauch
Schnellere Signalübertragung
Höhere E/A-Dichte pro Bauteil
Abb. 4.1 - 2 Flip-Chip-Prozess
Die Schritte des Flip-Chip-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um 180° gedreht und an den Bestückkopf übergeben. Parallel dazu wird
das nächste Die mit der zweiten Pipette der Flip-Unit aufgenommen.
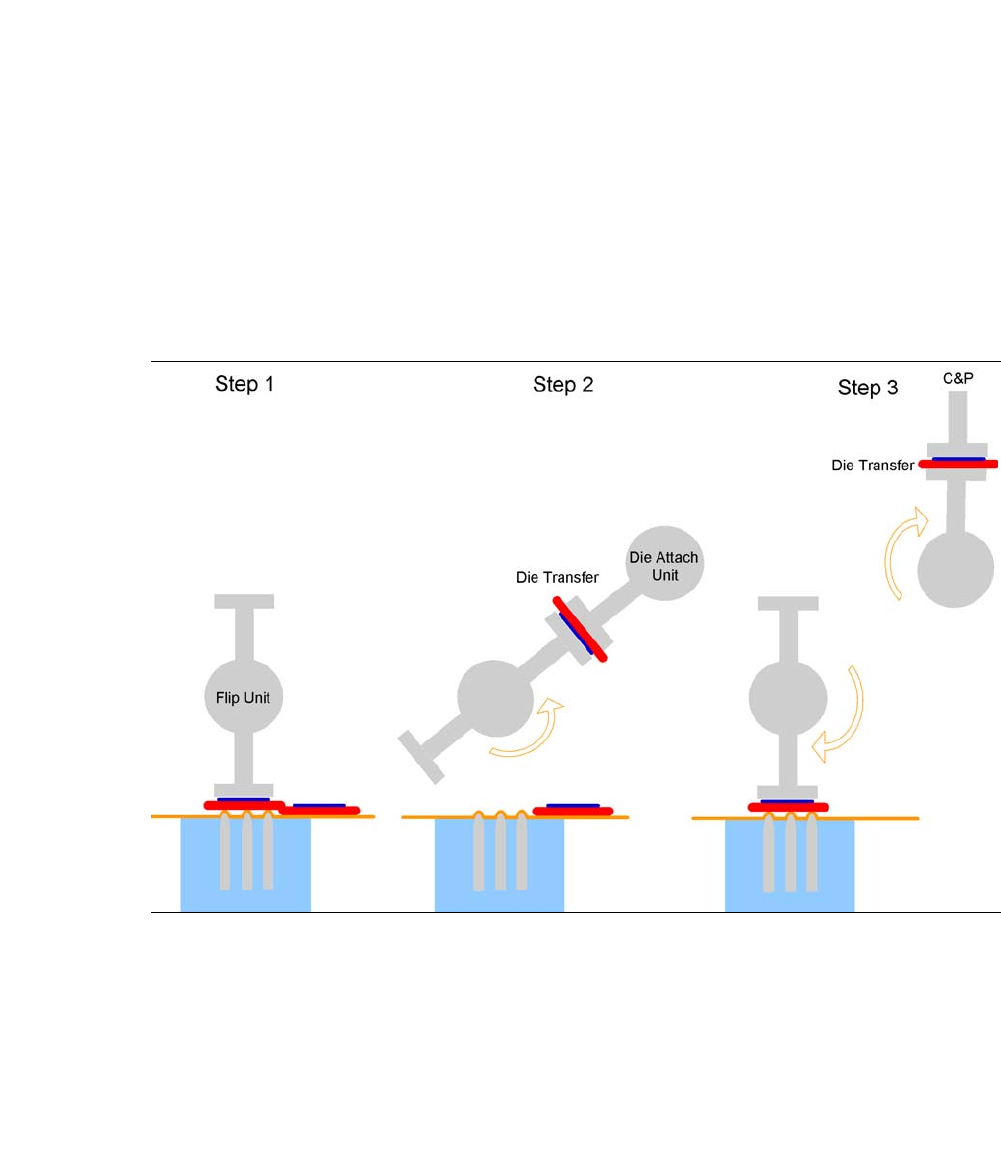
Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS)
Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung
203
4.1.3.2 Die-Attach-Prozess
Für den Die-Attach-Prozess wird die optionale Die-Attach-Unit benötigt.
In diesem Verfahren wird das Die in der selben Oben-Unten-Orientierung bestückt wie es auf der
Wafer-Folie vorliegt ("face-up"-Bestückung).
Die-Attach ist das klassische etablierte Die-Bestückungsverfahren. Die-Attach erfordert einen zu-
sätzlichen Schritt um die Verbindungen vom Die zur Leiterplatte herzustellen (Drahtanschlüsse).
Abb. 4.1 - 3 Schritte des Die-Attach-Prozesses
Die Schritte des Die-Attach-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um ca. 130° gedreht und an die Die-Attach-Unit übergeben.
– Step 3: Die Die-Attach-Unit dreht das Die zur Abholposition und übergibt es an den Bestück-
kopf. Parallel dazu wird von der Flip-Unit das nächste Die abgeholt.