00197497-03_UM_SiplaceCA-Serie_DE - 第203页
Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS) Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung 203 4.1.3.2 Die-Att ach-Prozess Für den Die-Attach -Prozess wird die optionale Die -At…
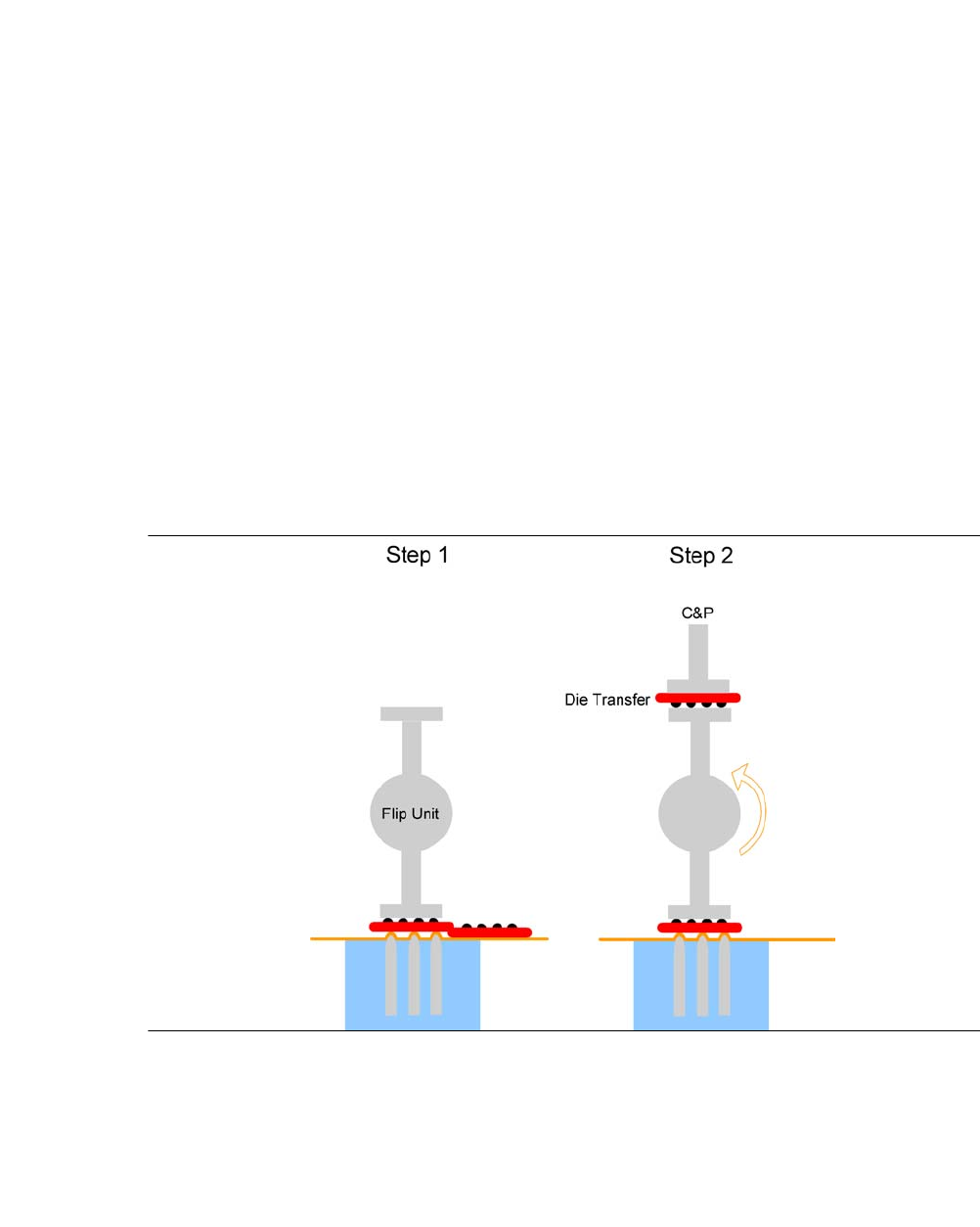
4 SIPLACE Wafer-System (SWS) Betriebsanleitung SIPLACE CA-Serie
4.1 Funktionsbeschreibung Ab Softwareversion SR 708.0 Ausgabe 12/2014
202
4.1.3.1 Flip-Chip-Prozess
Der Flip-Chip-Prozess ist das Standardverfahren des SWS. Dabei wird das Die vor der Bestü-
ckung auf der Platine um 180° gedreht (Face-Down-Bestückung).
Der Flip-Chip-Prozess ist eine stark wachsende Technologie. Dieser Prozess wird vor allem für
Baugruppen in der Consumer-Elektronik verwendet (z. B. Prozessoren, Grafik-Prozessoren,
Speicher).
Die Ein-/Ausgänge (E/A) des Dies sind direkt mit der Leiterplatte verbunden, was gegenüber dem
klassischen Die-Attach-Prozess einige Vorteile hat:
Geringerer Platzverbrauch
Schnellere Signalübertragung
Höhere E/A-Dichte pro Bauteil
Abb. 4.1 - 2 Flip-Chip-Prozess
Die Schritte des Flip-Chip-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um 180° gedreht und an den Bestückkopf übergeben. Parallel dazu wird
das nächste Die mit der zweiten Pipette der Flip-Unit aufgenommen.
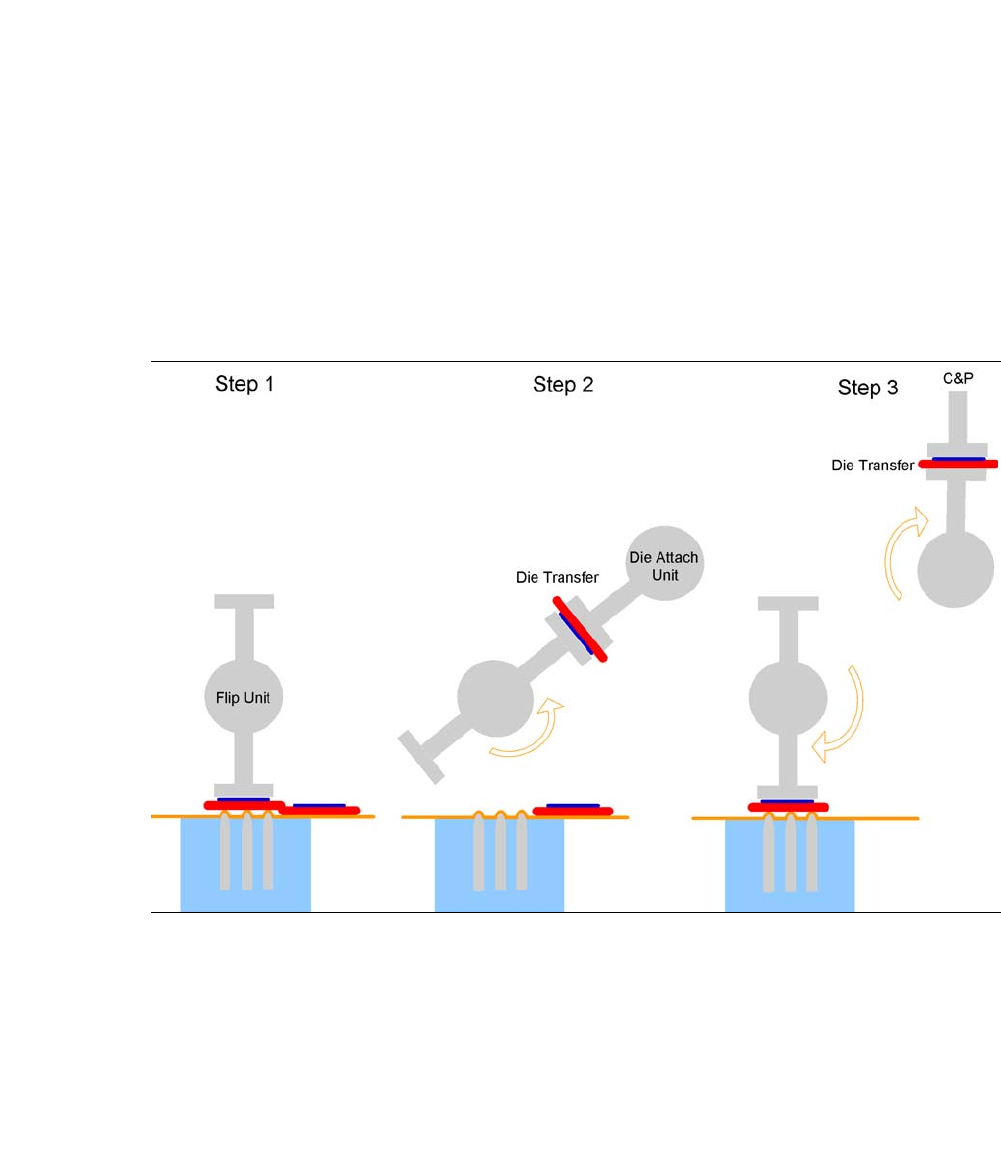
Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS)
Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung
203
4.1.3.2 Die-Attach-Prozess
Für den Die-Attach-Prozess wird die optionale Die-Attach-Unit benötigt.
In diesem Verfahren wird das Die in der selben Oben-Unten-Orientierung bestückt wie es auf der
Wafer-Folie vorliegt ("face-up"-Bestückung).
Die-Attach ist das klassische etablierte Die-Bestückungsverfahren. Die-Attach erfordert einen zu-
sätzlichen Schritt um die Verbindungen vom Die zur Leiterplatte herzustellen (Drahtanschlüsse).
Abb. 4.1 - 3 Schritte des Die-Attach-Prozesses
Die Schritte des Die-Attach-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um ca. 130° gedreht und an die Die-Attach-Unit übergeben.
– Step 3: Die Die-Attach-Unit dreht das Die zur Abholposition und übergibt es an den Bestück-
kopf. Parallel dazu wird von der Flip-Unit das nächste Die abgeholt.
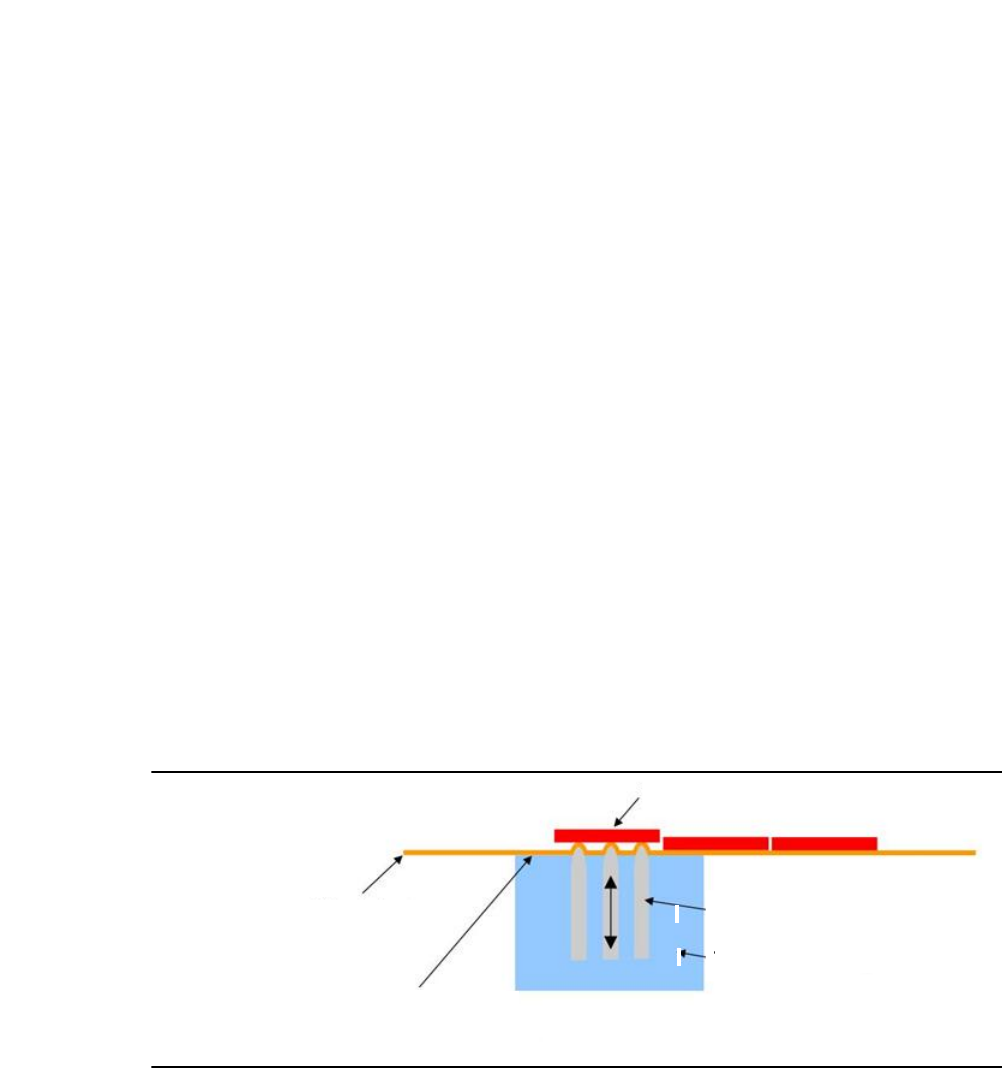
4 SIPLACE Wafer-System (SWS) Betriebsanleitung SIPLACE CA-Serie
4.1 Funktionsbeschreibung Ab Softwareversion SR 708.0 Ausgabe 12/2014
204
4.1.3.3 Die-Erkennung und -Positionierung
Die Wafer sind grundsätzlich, mit einer bestimmten Positions- und Winkeltoleranz, auf einer Wa-
fer-Folie befestigt.
Daher ist es nicht möglich das Die ohne Erkennung und Korrektur sicher in der Mitte der Ausste-
cheinheit zu platzieren. Dies ist besonders bei kleinen Dies notwendig um einen einwandfreien
Ausstechvorgang sicherzustellen.
Darüber hinaus kann es notwendig sein nur eine Auswahl an Dies zu verarbeiten. Eine solche
Auswahl kann über eine Ink-Punkt-Markierung auf "schlechten" Dies oder mit einer zum jeweili-
gen Wafer gehörigen Wafer-Map-Datei erfolgen.
Für diesen Verfahrensschritt ist die folgende technische Ausrüstung notwendig:
2-Achsen-Wafer-Tisch für die Positionierung
Wafer-Kamera-System für die Die- und die optionale Ink-Punkt-Erkennung
Optionales Wafer-Map-System
4.1.3.4 Ausstechvorgang
Ist das Die über dem Ausstechsystem zentriert, dann kann es mit Hilfe von Nadeln von der Wafer-
Folie abgelöst und an die Flip-Unit übergeben werden. Während die Nadeln das Die von der Folie
lösen, wird die Wafer-Folie in Richtung Ausstechsystem gesaugt.
Abb. 4.1 - 4 Die-Bereitstellungs-Prozess
Für dieses Verfahren ist die folgende technische Ausrüstung notwendig:
– Ausstechsystem mit austauschbarem Ausstech-Tool
Ausstechnadel
Vakuum-Kappe
Ausstechsystem
Aktives Bauteil - bereit zur Abholung
Wafer-Folie
Die Wafer-Folie wird mit Vakuum an
die Vakuum-Kappe angesaugt