00197497-03_UM_SiplaceCA-Serie_DE - 第206页
4 SIPLACE Wafer-System (SWS) Betriebsanleitu ng SIPLACE CA-Serie 4.1 Funktionsbeschreibung Ab Softw areversion SR 708.0 Ausgabe 12/2014 206 4 Abb. 4.1 - 5 Schritte des Embedded Wafer Level Ballgrid Array Prozesses (1) Da…

Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS)
Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung
205
4.1.3.5 Pickup-Prozess
Während des Pickup-Prozesses wird das Die an das Tool bzw. an die Pipette der Flip-Unit über-
geben. Die Flip-Unit übergibt das Die darauf entweder an den Bestückkopf (Flip-Chip-Prozess)
oder an die Die-Attach-Unit (Die-Attach-Prozess).
Die Die-Attach-Unit stellt das Die nach einem weiteren Drehvorgang für den Bestückkopf bereit.
Für diesen Verfahrensschritt ist folgende technische Ausrüstung notwendig:
Flip-Unit
Die-Attach-Unit (optional)
4.1.4 Embedded Wafer Level Ballgrid Array (eWLB/WLFO) Prozess
Embedded Wafer Level Ball Grid Array ist eine Verpackungs-Technologie die es erlaubt dünne
Bauteile mit hervorragender eklektischer Leistung mit einem Chip Fan Out herzustellen. D. h die
für die Anschlusspads verwendete Fläche ist größer als das eigentliche Silizium um SMD verträg-
liche Abstände der Kontatkierung zu ermöglichen.
Für diesen Prozess werden die Chip Bauelemente mit der aktiven Fläche nach unten (Face down)
auf einen Träger mit doppelt-klebender Folie bestückt. Nach der Bestückung wird diese Struktur
gemoldet. Nach dem Die-Bond Prozess des Trägers werden Wafer-Strukturierungs-Prozesse
verwendet, um die elektrische Kontaktierung herzustellen. Hierzu wird auch die Moldfläche um
das Silizium als Träger für „Leiterbahnen“ verwendet (Fan out). Anschließend werden die Bauteile
getestet, beschriftet und zum Beispiel in Gurte verpackt.
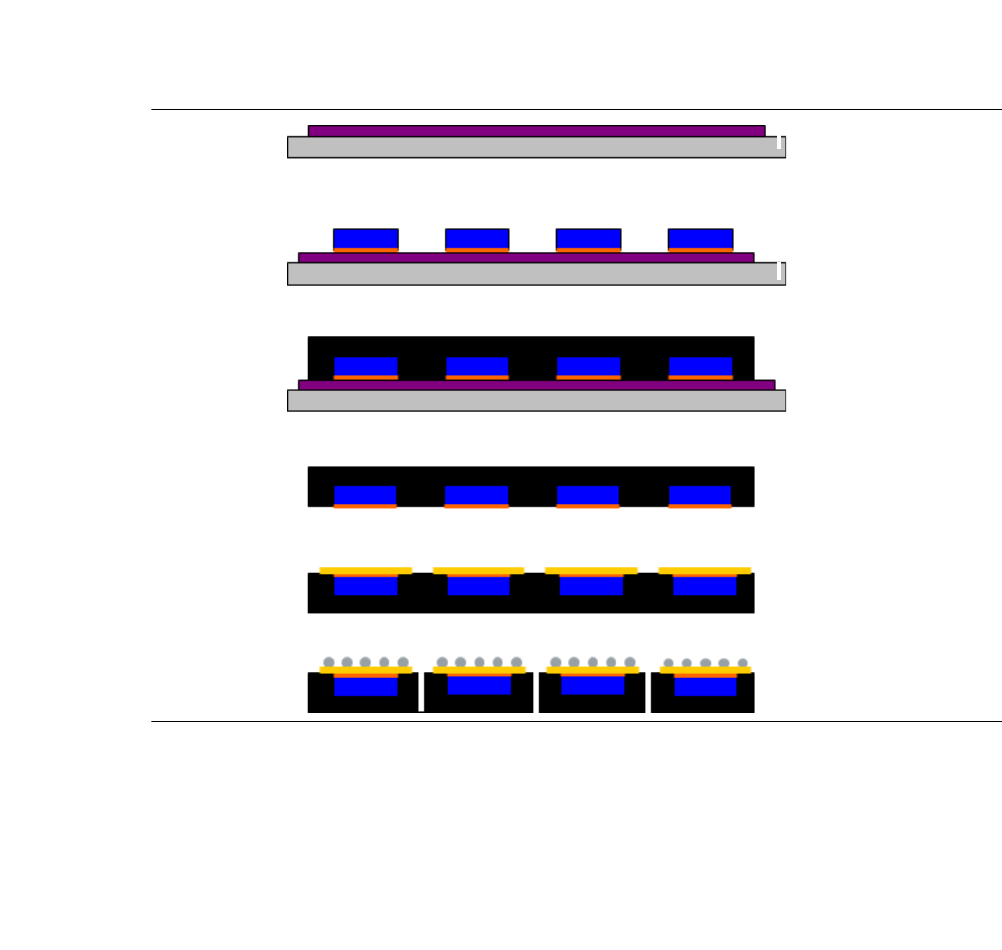
4 SIPLACE Wafer-System (SWS) Betriebsanleitung SIPLACE CA-Serie
4.1 Funktionsbeschreibung Ab Softwareversion SR 708.0 Ausgabe 12/2014
206
4
Abb. 4.1 - 5 Schritte des Embedded Wafer Level Ballgrid Array Prozesses
(1) Das Thermo-Release-Tape auf den Metall-Träger laminieren
(2) Die vom Wafer bestücken (Flip Chip) aktive Seite unten auf Thermo-Release-Tape
(3) Molding unter Druck; aushärten bei 150°C
(4) Release
(5) Re-Distribution Layer (RDL)
(6) Balling & Vereinzeln
(7) Testen, Markieren, Verpacken
1
2
3
4
5
6

Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS)
Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung
207
4.1.5 Pick & Transferprozess im Detail
4.1.5.1 Flip Chip Segment 1 (Pipette)
4
Abb. 4.1 - 6 Flip Chip Segment 1 (Pipette)
(1) Der Wafer X-Y fährt zum nächsten Chip
(2) Die Flip Chip Dreheinheit Segment 1 dreht zur Übergabeposition "Die Attach".
Während der Drehbewegung (ab der Kamera "free Position") wird die Bilderkennung des
nächsten Chips durchgeführt. 4
Wafer-
Kamera