IPC 7525B-2011 中文版 模板设计指导(钢网设计指南).pdf - 第15页
IPC-7525b-3-3-cn 图 3-3 6mil 厚度模板—锡铅和⽆铅 1. 电铸成型、激光切割、⾼精密蚀刻或者化学蚀刻范围(⾯积⽐> 0.9 ) 2. 电铸成型、激光切割、⾼精密蚀刻( 0.66 <⾯积⽐< 0.9 ) 3. 电铸成型范围( 0.5 <⾯积⽐< 0.66 ) 4. 推荐重新设计开孔或者减少模板厚度(⾯积⽐< 0.5 ) 80 70 60 50 40 30 20 10 0 123…
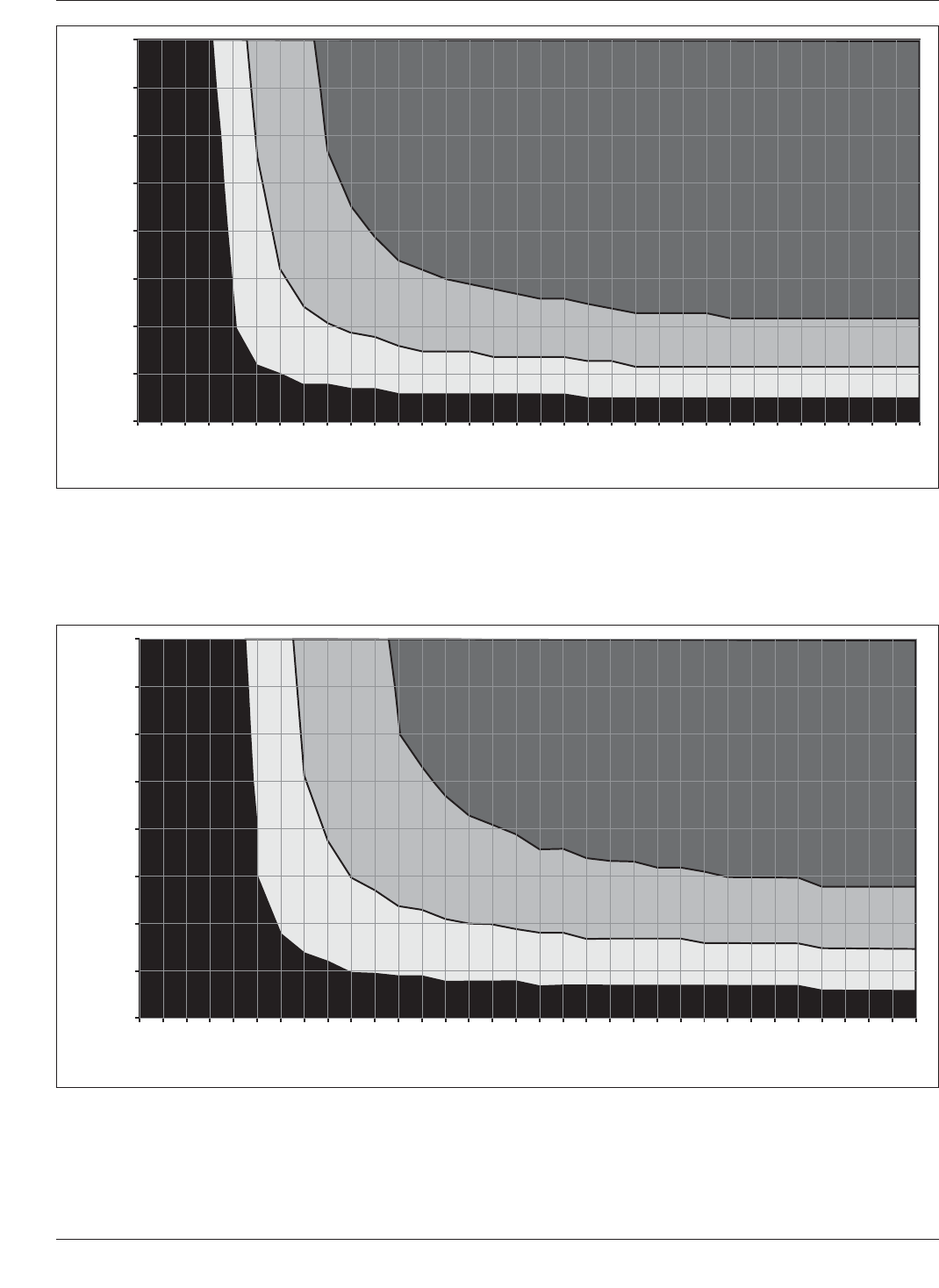
IPC-7525b-3-1-cn
图3-1 4mil厚度模板—锡铅和⽆铅
1. 电铸成型、激光切割、⾼精度蚀刻或者化学蚀刻范围(⾯积⽐>0.9)
2. 电铸成型、激光切割、⾼精度蚀刻(0.66<⾯积⽐<0.9)
3. 电铸成型范围(0.5<⾯积⽐<0.66)
4. 推荐重新设计开孔或者减少模板厚度(⾯积⽐<0.5)
80
70
60
50
40
30
20
10
0
123456789101112
ᔰਓᇭᓖPLOV
ᔰਓ䮯ᓖPLOV
13 14 15 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34
1
2
3
4
IPC-7525b-3-2-cn
图3-2 5mil厚度模板—锡铅和⽆铅
1. 电铸成型、激光切割、⾼精度蚀刻或者化学蚀刻范围(⾯积⽐>0.9)
2. 电铸成型、激光切割、⾼精度蚀刻(0.66<⾯积⽐<0.9)
3. 电铸成型范围(0.5<⾯积⽐<0.66)
4. 推荐重新设计开孔或者减少模板厚度(⾯积⽐<0.5)
80
70
60
50
40
30
20
10
0
1 2 3 4 5 6 7 8 9 10111213141516171819202122232425262728293031323334
ᔰਓᇭᓖPLOV
ᔰਓ䮯ᓖPLOV
1
2
3
4
IPC-7525B-C 2011年10月
6
Copyright Association Connecting Electronics Industries
Provided by IHS Markit under license with IPC
Licensee=Sanmina SCI Corp - Loc 8, 14, 15, 17, 18, 20, 23,/5964569001, User=Jin,
Not for Resale, 04/13/2018 21:19:06 MDT
No reproduction or networking permitted without license from IHS
--`,`,,,,`,,`,,,,,,``,,,,,,``,``-`-`,,`,,`,`,,`---
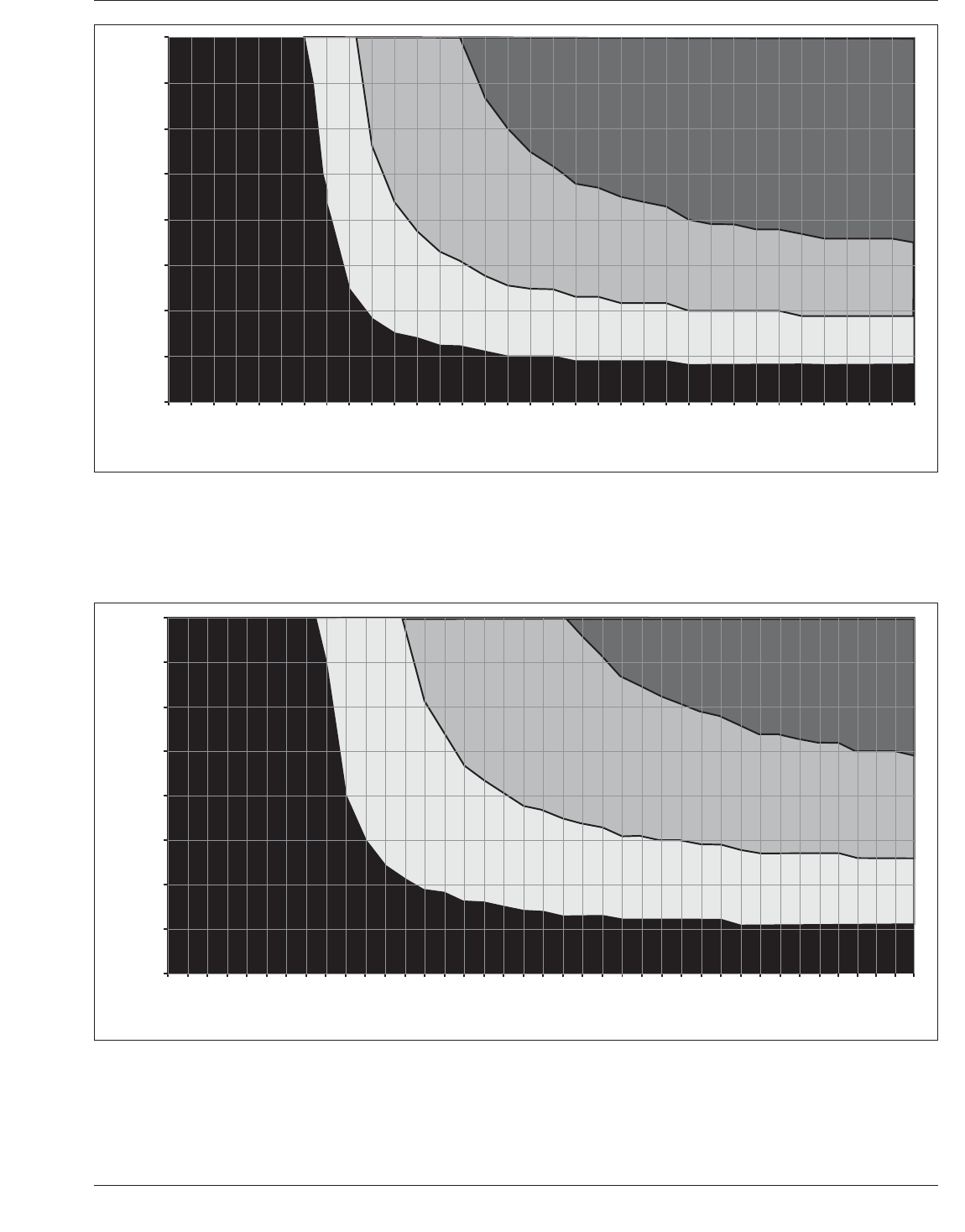
IPC-7525b-3-3-cn
图3-3 6mil厚度模板—锡铅和⽆铅
1. 电铸成型、激光切割、⾼精密蚀刻或者化学蚀刻范围(⾯积⽐>0.9)
2. 电铸成型、激光切割、⾼精密蚀刻(0.66<⾯积⽐<0.9)
3. 电铸成型范围(0.5<⾯积⽐<0.66)
4. 推荐重新设计开孔或者减少模板厚度(⾯积⽐<0.5)
80
70
60
50
40
30
20
10
0
12345678910111213141516171819202122232425262728293031323334
ᔰਓᇭᓖPLOV
ᔰਓ䮯ᓖPLOV
1
2
3
4
IPC-7525b-3-4-cn
图3-4 8mil厚度模板—锡铅和⽆铅
1. 电铸成型、激光切割、⾼精密蚀刻或者化学蚀刻范围(⾯积⽐>0.9)
2. 电铸成型、激光切割、⾼精密蚀刻(0.66<⾯积⽐<0.9)
3. 电铸成型范围(0.5<⾯积⽐<0.66)
4. 推荐重新设计开孔或者减少模板厚度(⾯积⽐<0.5)
80
70
60
50
40
30
20
10
0
123456789101112131415161718192021222324252627282930313233343536373839
ᔰਓᇭᓖPLOV
ᔰਓ䮯ᓖPLOV
1
2
3
4
2011年10月 IPC-7525B-C
7
Copyright Association Connecting Electronics Industries
Provided by IHS Markit under license with IPC
Licensee=Sanmina SCI Corp - Loc 8, 14, 15, 17, 18, 20, 23,/5964569001, User=Jin,
Not for Resale, 04/13/2018 21:19:06 MDT
No reproduction or networking permitted without license from IHS
--`,`,,,,`,,`,,,,,,``,,,,,,``,``-`-`,,`,,`,`,,`---

面积比和宽厚比在图3-5中,使用如下的公式:
宽厚比 =
开孔宽度
模板厚度
=
W
T
面积比 =
开孔面积
开孔孔壁面积
=
LxW
2x(L+W) xT
3.2.2 锡铅焊膏中开孔⼤⼩与PCB焊盘⼤⼩的对⽐ 作为通用设计准则,应该根据PCB焊盘大小减
小开孔大小。模板开孔大小通常对比PCB原始焊盘作修改。减小面积和修改开孔形状通常是为了改
善焊膏印刷、再流焊或者模板清洁工艺。例如,减小开孔尺寸将会降低模板开孔和PCB焊盘偏移的
机率,也就减小焊膏印刷偏离焊盘的机率,而印刷偏离焊盘易导致焊料球和焊料桥连。在所有开孔
上倒圆角能减少模板的清洁频次。然而存在需要增加锡量,而不能增加模板厚度的情况,此时可以
使用模板套印。当设计使用套印技术的模板时,确保开孔之间的间隙非常重要。通常在使用模板层
时,不能清晰地看到邻近板层的特征,如过孔、表层导线等。
3.2.2.1 带引脚的SMD元器件 针对带引脚SMD元器件(如间距为1.3-0.4mm[51.2-15.7mil]的J型引
脚或者翼型引脚元器件),通常开孔大小缩减量:宽为0.03-0.08mm[1.2-3.1mil],长为0.05-0.13mm
[2.0-5.1mil]。
3.2.2.2 塑封BGA器件 减少圆形开孔直径0.05mm[2.0mil]。然而,由于枕头缺陷问题,设计BGA
器件模板时,应该考虑器件的翘曲、器件的共面性、焊料高度和焊料量。
3.2.2.3 陶瓷栅格阵列 陶瓷栅格阵列封装需要特定的焊膏量以保证焊点的长期可靠性。陶瓷球栅阵
列比陶瓷柱状栅格阵列需要更多的焊膏量。这些封装所需要的焊膏量信息可参考IPC-7095。
3.2.2.4 细间距BGA和CSP器件 应该选择方形开孔,开孔宽度等于或者比PCB上圆形焊盘开孔直径
小0.025mm[0.98mil]。方型开孔应该开倒圆角。一个设计准则就是针对0.25mm[9.8mil]的方孔,倒圆
角0.06mm[2.4mil];针对0.35mm[14mil]的方孔,倒圆角0.09mm[3.5mil]。 考虑到枕头缺陷问题,当在
为BGA和底部端接元器件设计模板时,应该分析器件的翘曲、器件的共面性、焊料高度和焊料量。
对细间距BGA和CSP器件而言,确保面积比和宽厚比是非常重要的。
3.2.2.5 ⽚式元器件——电阻和电容 有几种开孔
形状有利于减少焊料球的产生。所有这些设计都
是为了减少过多焊膏留在元器件下。最流行的设
计如图3-6、3-7和3-8所示。这些设计通常适用于
免清洗工艺。
3.2.2.6 圆柱形、⼩型MELF和⽚式元器件 对这
些元器件,推荐使用“C”形状开孔(见图3-9),
但是要小心防止部件在再流焊接前由于极少的焊
膏接触及导轨的振动使他们从所在位置弹离。这
些开孔的尺寸设计应该与元器件端相匹配。
3.2.2.7
LCC/BTC器件 LCC器件端子焊盘的开孔
尺寸与推荐给QFP器件的开孔尺寸是一样的(见表
3-2)。如果在再流过程中观察到封装发生偏移,
IPC-7525b-3-5-cn
图3-5 模板开孔截⾯图
L
W
T
IPC-7525b-3-6-cn
图3-6 屋顶型开孔设计
1. 开孔
2. 焊盘
1
2
2/3 L
L
1/2 W
W
IPC-7525B-C 2011年10月
8
Copyright Association Connecting Electronics Industries
Provided by IHS Markit under license with IPC
Licensee=Sanmina SCI Corp - Loc 8, 14, 15, 17, 18, 20, 23,/5964569001, User=Jin,
Not for Resale, 04/13/2018 21:19:06 MDT
No reproduction or networking permitted without license from IHS
--`,`,,,,`,,`,,,,,,``,,,,,,``,``-`-`,,`,,`,`,,`---