Brochure-PacTech-Solder-Jetting-Laser-Bonding.pdf - 第5页
7 8 Applications SB 2 -WB The SB²-WB is a combination of PacT ech´s unique sol - der ball jetting technology with a wire feeding mecha - nism to perform wiring process. This innovative solution has very low stress as it …

5 6
Model
SB² - SMs Quantum
SB²- SMs Quantum:
The introduction of the dual-drawer system and vision-on-
the-y enables the loading and unloading of the products
to match the soldering speed of the SB² machine. This
brings contactless and uxless soldering technology into
3D component soldering. The SB²-SMs is a compact ma-
chine for automated sequential laser soldering, catering to
a variety of dierent microelectronic substrates, especially
dedicated for camera modules and optical devices.
SB² - SMs Quantum
Dimension
1200 x 1300 x 1700 mm
Workspace
2 drawers, 250 x 250 mm per drawer
Solder Ball Speed
6 - 8 balls / s
Solder Ball Ø
≥ 100 µm
Accuracy
+/- 5 µm (1 sigma)
Work Station
Tray
Automation
Dual drawer system
Laser Man. Alignment
-
Laser Auto Alignment
ü(2D)
Pattern Recognition
ü
2D Applications
ü
3D Applications
ü
Repair
-
Products
Camera modules, industrial, automotive, medical and others
Applications Technical Specications
Camera Module
Assembly
3D Soldering
Camera Modules Assembly
SOLDER JETTING
Model
SB² - Compact
SB
2
-Compact:
Small machine foot print yet being packed with the ad-
vanced laser soldering technology, SB
2
-Compact comes
with universal machine interface which can be upgraded
easily into any manufacturing line in a plug-and-play model
and can be multiplied quickly for production ramp. It has
a user-friendly touch-screen interface which is simple for
mass production operation.
SB² - Compact
Dimension
1100 x 704 x 1893 mm
Workspace
200 x 200 mm
Solder Ball Speed
Up to 6 balls / s
Solder Ball Ø
≥ 150 µm
Accuracy
+/- 5 µm (1 sigma)
Work Station
Stacked Drawers / In-line conveyor
Automation
2D Auto-rotatioon Bars
Laser Man. Alignment
ü
Laser Auto Alignment
Optional
Pattern Recognition
ü
2D Applications
ü
3D Applications
ü
Repair
-
Products
Camera modules, nger print sensors, facial recognition and others
Applications Technical Specications
3D Joint for
Optoelectronic
Cu Coil Soldering
3D Soldering for Flexible Manufacturing
Integration
SOLDER JETTING
Easy upgrade with
standarized modules and
connectors
Reel-to-Reel
Cassette Feeding
JEDEC Tray Feeder
In-line Conveyor
Drawer / Stacked Drawer
Extendable Assembly Line
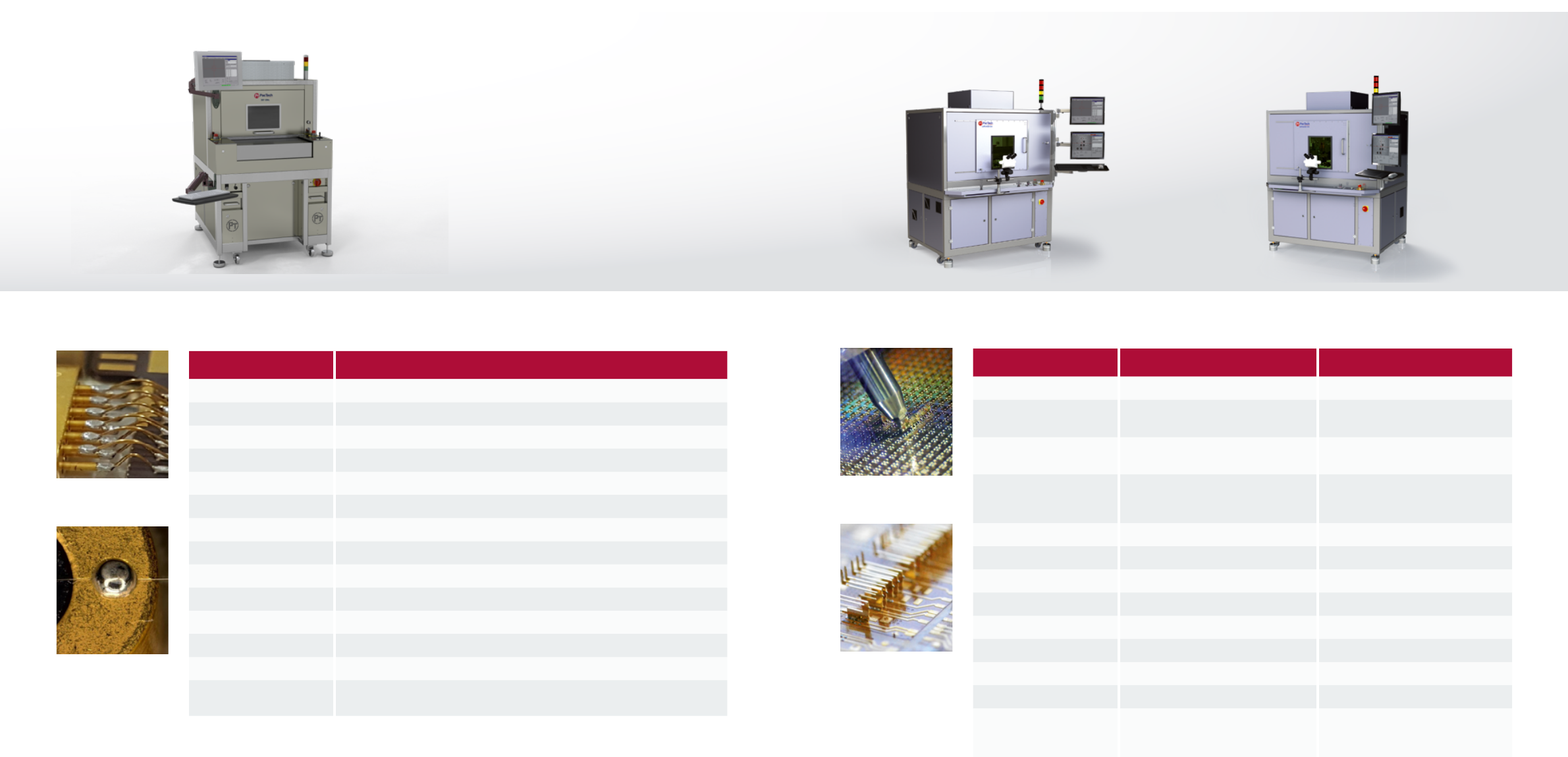
7 8
Applications
SB
2
-WB
The SB²-WB is a combination of PacTech´s unique sol-
der ball jetting technology with a wire feeding mecha-
nism to perform wiring process. This innovative solution
has very low stress as it is bonded with very short laser
pulse and requires no mechanical contact. The system is
highly exible, with various loop formation capabilities or
even no wire loop formation to enable smaller package
size, at the same time allowing combination of dierent
solder alloy and wire, wire bundles or ribbon. Higher re-
liability as compared to conventional wire bonding with
consistent wire thickness and better match of CTE varia-
tion between materials. Additionally, the solder wire bond
can be reworked selectively at ease. SB
2
-WB is a exible
wire-bonding alternative for multifunctional system plat-
forms and heterogeneous integration.
Optical bres
wiring
Connector Joining
Advanced Wire Bonding Solution
Technical Specications
Model
SB
2
-WB
SOLDER JETTING
SB² - WB
Dimension
1200 x 1300 x 1950 mm
Workspace
≥ 150 x 150 mm or 320 x 320 mm
Solder Ball Speed
2 – 4 sec per pin/pad connection
Material Ø
Solder ball Ø ≥ 50 µm; wire Ø ≥ 100 µm
Prefered Pad Material
NiAu, Au, Cu
Accuracy
+/- 5 µm (1 sigma)
Work Station
Chuck / In-line conveyor
Laser Man. Alignment
ü
Laser Auto Alignment
Optional
Pattern Recognition
ü
2D Applications
ü
3D Applications
ü
Repair
ü
Products
IC packaging, LED packaging, connectors, optical bre, 2D/3D packaging
and others
Applications
LAPLACE-Can/LAPLACE-VC
Our solution for ultra-ne-pitch cantilever assembly and
laser bonding for wafer probe cards with optional rework
capability.
This platform is also suited for the vertical attachment of
chips or similar devices loaded into the machine from feed-
ing station to various carrier substrates loaded manually
onto the machine’s work stage. The system uses a unique
patented laser thermode tool, which is integrated in the
vacuum pick and place unit of the bonder. For the high
exibility of the laser thermode, the system requires only a
thin layer of solder on the substrate.
Cantilever
Assembly
Vertical Chip
Bonding
Ultra Fine Pitch Assembly
LAPLACE-Can LAPLACE-VC
Dimension
1520 x 1100 x 1890 mm 1520 x 1100 x 1890 mm
Workspace
Work area: 330 x 330 mm
Substrate size: up to 500 x 500 mm
Work area: 330 x 330 mm
Substrate size: up to 500 x 500 mm
Cycle time
(pick & place incl. Laser reow)
≥ 7 sec / pin ≥ 10 sec / chip
Accuracy
Placement: +/- 3.5 µm (3 sigma)
Hump tilt: +/- 3 µm
Height control: +/- 4 µm
+/- 3 µm (1 sigma)
Tooling
Customized bond tool Customized bond tool
Die Handling
Wae Pack / Probe Wafer Wae Pack / Wafer
Substrate Handling
Manual / Automatic Manual / Automatic
Product Output
Manual / Automatic Manual / Automatic
Pattern Recognition
ü ü
2D Applications
– –
3D Applications
ü ü
Repair
optional –
Products
Probecards, DRAM,
ash memory, NAND
Memory chips, diode (photodiode,
LED, µLED), MEMS (sensors,
gyroscopes, etc.)
Technical Specications
Model
LAPLACE-Can
Model
LAPLACE-VC
LASER BONDING
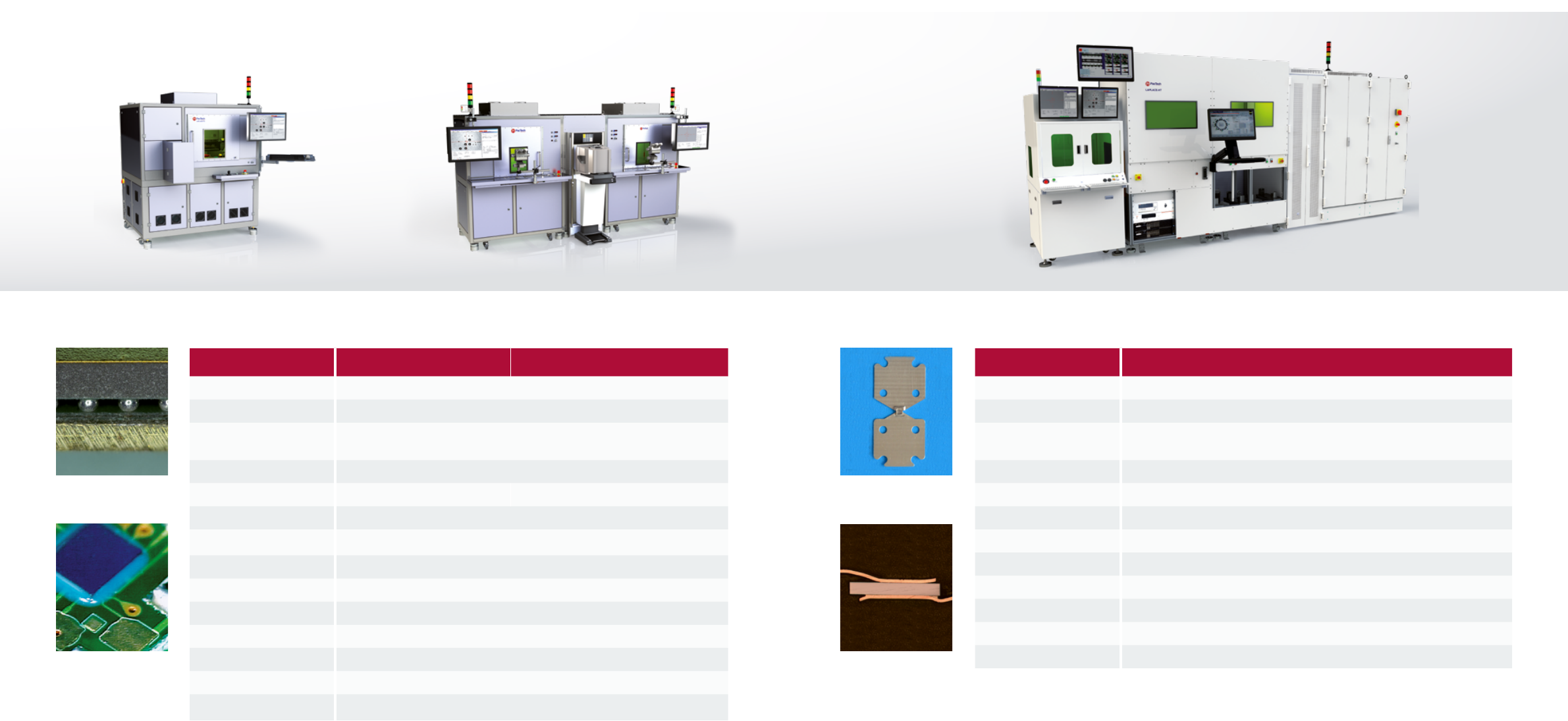
9 10
Applications
Model
LAPLACE-FC / LAPLACE-GENESIS
LAPLACE-FC
The LAPLACE-system provides an integrated solution for
ip chip assembly, the laser reow will be done during the
placement – all in one step. The laser assisted assembly
can be applied for soldering, ACF and NCP interconnec-
tions. The optional dispensing unit in the ip chip assembly
platform allows a maximal exibility for ux, solder paste
and/or ACF, NCP dispensation.
LAPLACE-FCR:
The LAPLACE-FCR is an automatic laser bonding system
for ip chip assembly and chip rework, enabling localized
rework without second reow and mechanical pressure
to the completed units. The system will remove defect ip
chips from the wafer or carrier substrate with the vacuum
bond tool based on pre-dened mapping les or 2D in-
spection. New chips are loaded from customizable feeding
station such as wae pack prior to laser assembly.
Flip-Chip Rework
Flex to ex bonding
LAPLACE-FC LAPLACE-GENESIS
Dimension
1500 x 1200 x 2200 mm
Workspace
320 x 320 mm
Cycle time
(pick & place incl. Laser reow)
≥ 5 sec / chip
Chip size
≥ 0.3 x 0.3 x 0.1mm
Accuracy
+/- 4.5 µm (3 sigma) +/- 0,5 µm (3 Sigma)
Tooling
Customized bond tool
Die Handling
Wae Pack, Sawing Frame, Tape and Reel
Substrate Handling
Manual / Automatic
Product Output
Manual / Automatic
Pattern Recognition
ü
2D Applications
ü
3D Applications
–
Repair
optional
Products
Flip Chip, passive components, sensors, MEMS
Technical Specications
Model
LAPLACE-FCR
Flip Chip Attach & Rework
LASER BONDING
LAPLACE-HT
The LAPLACE-HT is an automatic laser soldering assem-
blyline for schottky diodes and bypass diodes – especially
for solar cell modules. Using a rotary table the automat-
ic machine punches and forms lead frames, dispenses
solder paste and performs diode laser attach to the lead
frame. A nal electrical and visual test is done on the as-
sembled modules and chip packages within the machine.
A complete standalone turnkey solution! Additional appli-
cations are LED, MOSFET and camera module assembly.
LAPLACE-HT
Dimension
5000 x 3000 x 2200 mm
Workspace
Customizable work station
Cycle time
(pick & place incl. Laser reow)
≤ 1 sec / component
Accuracy
+/- 50 µm (1 sigma)
Tooling
Customization based on product
Die Handling
Sawing Frame, Tape and Reel
Substrate Handling
Automatic
Product Output
JEDEC Tray, others
Pattern Recognition
ü
2D Applications
ü
3D Applications
ü
Products
Bypass diode for solar cells, LEDs, chips on lead frame
Bypass Diode
Cross section of
assembled Diode
Integrated Diode Assembly
Applications Technical Specications
LASER BONDING
Model
LAPLACE-HT
Disclaimer: The data provided in all technical specications are reference data from standard platforms and may vary
subject to application, modication and customization.