67021-ultraviolet-led-multi-chip-module-based-on-ceramic-substrate.pdf - 第5页
Figure 6: LED-chip soldered to an Al 2 O 3 su b- strate. Relevant process para meters are te mperature profile and reflow re gime as well as bonding force (app lied pressure duri ng placemen t and reflow). More than 30 a…
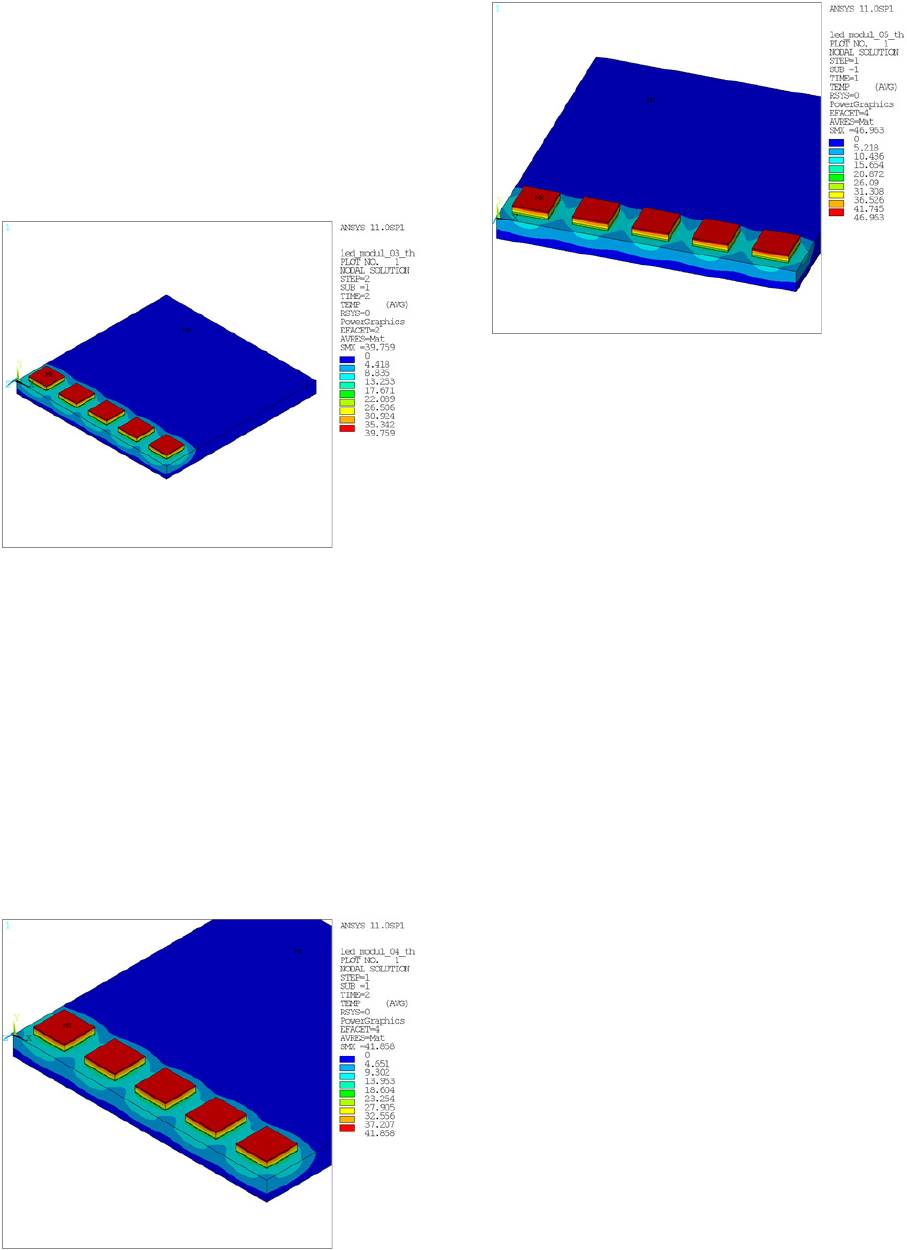
Stresses are significantly lower than for the solder
attach and thus below the ultimate tensile stresses
of the substrate materials. Due to lower Young’s
modulus of the adhesive – 1.2 GPa compared to
68 GPa for AuSn – the inherent stresses within the
adhesive layers are significantly lower than within
the solder. The results show equivalent stresses
within the adhesive of 3.1 MPa for 10 µm layers
and 2.6 MPa for 30 µm layers, respectively.
Figure 3: Temperature distribution within LED-
chips and Al
2
O
3
substrate (thickness 0.38 mm)
for eutectic AuSn solder (layer thickness 10 µm)
and 1.65 W thermal load.
Thermal analysis for a thermal load of 1.65 W per
chip results in chip temperatures of 42 K above
substrate temperature for 10 µm layers and 47 K for
30 µm layers (see Figure 4 and Figure 5). These
calculations indicate that a proper cooling of the
chips could be achieved using thermally conductive
adhesives. Thicker adhesive layers increase chip
temperature significantly. In the case of thin
bonding layers – either solder alloy or adhesive –
thermal properties are mainly influenced by the
chips and the substrate itself.
Figure 4: Temperature distribution within LED-
chips and Al
2
O
3
substrate (thickness 0.38 mm)
for silver-filled adhesive (layer thickness 10 µm)
and 1.65 W thermal load.
Figure 5: Temperature distribution within LED-
chips and Al
2
O
3
substrate (thickness 0.38 mm)
for silver-filled adhesive (layer thickness 30 µm)
and 1.65 W thermal load.
The results of the FE calculations show acceptable
thermo-mechanical stresses for both substrate ma-
terials and soldering with eutectic gold-tin. The
thermal matching of sapphire based LED-chips and
the used substrate materials AlN and Al
2
O
3
keep
the tensile stresses below ultimate yield strength.
Thermal results show proper extraction of heat
during operation. The high thermal conductivity of
AlN of 180 W/(m·K) leads to a lower chip tem-
perature during operation compared to Al
2
O
3
. Sil-
ver-filled adhesives provide similar performance if
thin layers could be successfully processed. The
results allow the comparison of different die-attach
technologies and can be transferred to other chip
types.
Experimental – Die Attach
Three different Die-attach technologies are compa-
ratively used: 1) eutectic gold-tin solder and flip-
chip-assembly, 2) standard vacuum reflow of a flux
enhanced SnPb solder (Figure 6), and 3) two differ-
ent silver-loaded adhesives. Flip-Chip assembly is
conducted using a ficonTEC Flip-Chip-Bonder BL-
2000 and a Finetech Fineplacer Lambda, respec-
tively. Reflow during flip-chip-placement is esta-
blished by using a heated pick-up tool (PUT) and a
hotplate with a substrate holder. The use of a sub-
strate hotplate allows a stand-by temperature below
solder alloy reflow and the subsequent placement
and soldering of single chips by the PUT. LED-
chips with a manufacturer-made gold metallization
are used for SnPb soldering and adhesive attach.
Sputtered eutectic gold-tin is used for additional
metallization of LED-chips for flip-chip-attach
[10]. An optional increase of solder layer thickness
is conducted by application of additional solder
volume by means of Solderjet Bumping [24].
IMAPS/ACerS 8th International CICMT Conference and Exhibition (2012) | April 16-19, 2012 | Erfurt, Germany
000241
Downloaded from http://meridian.allenpress.com/imaps-conferences/article-pdf/2012/CICMT/000238/2360912/cicmt-2012-tp61.pdf by guest on 03 January 2023

Figure 6: LED-chip soldered to an Al
2
O
3
sub-
strate.
Relevant process parameters are temperature profile
and reflow regime as well as bonding force (applied
pressure during placement and reflow). More than
30 assemblies using testing elements are manufac-
tured for mechanical testing and process optimi-
zation. Soldering of chips using less than 10 µm
sputtered AuSn layers (as-sputtered, without addi-
tional solder applied) did not prove to be reliable
joined. Low shear forces and unregular wetting are
observed. An additional Ø300 µm solder sphere is
applied to provide for an additional solder layer
thickness of 12 µm. Fully operational 7×2-chip
samples are made for optical testing (Figure 7).
Figure 7: Fully assembled 7×2 UV-LED module.
The third die-attach technology used is adhesive
bonding with silver-loaded and thermally con-
ductive adhesives. Although being a well estab-
lished and commercially used technology the appli-
cation of highly filled adhesives requires major
adaptations of dispense and chip placement techno-
logies. The optimization of the process flow, curing
conditions and homogenization of the adhesive is
necessary to achieve reproducible thin joint fis-
sures.
Experimental – Analysis of Solder Joints
Mechanical testing of soldered components, both
LED-chips and testing vehicles is conducted using
shear force measurements. Using components with
an additional solder volume, 6 N to 18 N with glass
testing elements for variation of process parameters
are achieved. LED-chips show a shear force greater
than 10 N with the main failure mode being the
rupture of chips rather than failure of solder joints
or layer interfaces. Cross section views (Figure 8)
show a homogenous filling and a solder layer thick-
ness below 30 µm.
Figure 8: Cross section view of a AuSn soldered
LED-chip.
Micro-Computer-Tomography (Micro-CT) analysis
confirms a void free and homogenous solder layer
for AuSn soldering (Figure 9). In comparison the
micro-CT shows significant voiding for the vacuum
soldered LED-chips (Figure 10). The increase of
thermal resistance of solder joints with a higher
fraction of voids is obvious. Flux-free processing of
gold-tin solder furthermore eliminates the need for
additional cleaning after soldering.
Figure 9: Micro-CT of AuSn soldered LED-
chips.
Figure 10: Micro-CT of SnPb soldered LED-
chips.
IMAPS/ACerS 8th International CICMT Conference and Exhibition (2012) | April 16-19, 2012 | Erfurt, Germany
000242
Downloaded from http://meridian.allenpress.com/imaps-conferences/article-pdf/2012/CICMT/000238/2360912/cicmt-2012-tp61.pdf by guest on 03 January 2023

Optical Measurements
Optical power measurements and wavelength shift
are observed using an integrating sphere. A setup of
an Ulbricht sphere that allows for the mounting of
the proposed ceramics substrate attached to a heat
sink is constructed. This structure permits the oper-
ation of the LED-chips at high power ratings while
diffusing the light for an integrating measurement
of total power without concerns about the direc-
tional characteristics of the LED assembly. The de-
sign of the heat-sink and the substrate clamping
lead to approx. 30% NA-loss during measurements.
A calibration of the Ulbricht sphere with respect to
this fact is used to correct the results.
The results of optical output power of the four die-
attach variants – adhesive 1, adhesive 2, SnPb
solder, and AuSn solder – are shown in Figure 11.
Measurement has been conducted using one chan-
nel of 1×7 chips per substrate and for operational
currents of 350 mA, 700 mA and 1050 mA. A sig-
nificant improvement of output power is observed
for AuSn die-attach. Adhesive 2 shows a decrease
of output power with increased current.
Figure 11: Optical output power of one channel
(1×7 chips) for four die-attach variants.
Using both channels of 2×7 chips an optical output
power of 7.7 W is achieved at 1050 mA for AuSn
soldered assemblies. The resulting peak irradiance
is 30.8 W/cm² at the LED surface with respect to
the footprint and pitch of the attached chips. The
optimized cooling of AuSn-soldered LED-chips is
demonstrated by the increased optical output power
compared to adhesively joined LEDs (Figure 12).
Figure 12: Optical output power of both
channels (2×7 chips) for the gold-tin solder
(AuSn) and adhesive (Adh2) die-attach.
Additionally the thermally induced shift of emis-
sion wavelength can be used to compare different
die-attach technologies with respect to thermal
transfer capabilities. Better cooling corresponds to a
lower chip temperature and thus to a lower wave-
length shift. Both soldering techniques show
improved behavior compared to the adhesives
(Figure 13). Gold-tin solder layers show a lower
drift than the void-prone SnPb solder.
Figure 13: Wavelength shift over current for
four die-attach variants.
Summary and Outlook
The assembly of a UV-LED multi-chip module
using different die-attach technologies has been
demonstrated. Finite element analysis proves ac-
ceptable thermo-mechanical stresses and the reali-
zation of thermally high conductive joints using
solder alloys and new highly conductive silver-
loaded adhesives if thin layers could be processed.
The design of a multi-chip sub-module is flexible
and versatile to use. Line-shaped light sources are
possible by stackable modules. A six-module
assembly is demonstrated. Easy scaling of optical
output power as well as a simplified servicing by
changing single modules add to the customer
benefit. Measurements of optical output power and
low thermally induced wavelength drift as well as
analysis of solder layer structure show the
performance of thin gold-tin solder layers. A 14
chip module attains 7.7 W optical output power and
a respective peak irradiance of 30.8 W/cm². Long
term behavior and the investigation of reliability
over life time are the next steps to confirm the
usability of the proposed module design and die-
attach technologies.
Acknowledgements
The work presented in this paper was funded by the
TAB (Thüringer Aufbaubank) with funds provided
through EFRE (Europäische Fonds für regionale
Entwicklung) OP 2007-2013 under project FK
2009VF0003. The authors would like to thank G.
Leibeling, T. Feigl and A. Joswig for sample prepa-
ration, P. Kühmstedt for micro-tomography ana-
lysis and R. Schmidt for equipment manufacturing.
IMAPS/ACerS 8th International CICMT Conference and Exhibition (2012) | April 16-19, 2012 | Erfurt, Germany
000243
Downloaded from http://meridian.allenpress.com/imaps-conferences/article-pdf/2012/CICMT/000238/2360912/cicmt-2012-tp61.pdf by guest on 03 January 2023