00198370-01_UM_SWS-DE.pdf - 第72页
3 Technische Daten und Baugruppen Betriebsanl eitung SIPLACE Wafer System (SWS) 3.4 Beschreibung der SWS-Baugruppen Ausgabe 02/2018 72 3.4.2 Flip-Unit 3 Abb. 3.4 - 2 Flip-Kopf - Ansicht von vorne (1) Pipetten- bzw . T o …
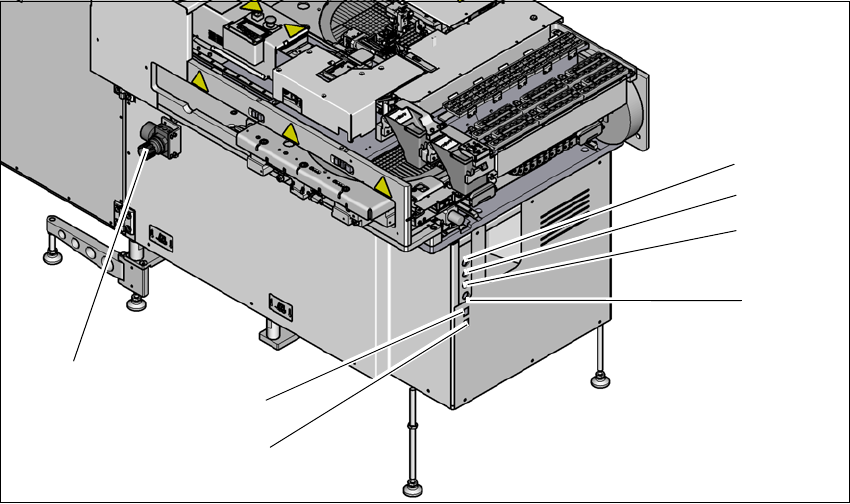
Betriebsanleitung SIPLACE Wafer System (SWS) 3 Technische Daten und Baugruppen
Ausgabe 02/2018 3.4 Beschreibung der SWS-Baugruppen
71
3.4 Beschreibung der SWS-Baugruppen
3.4.1 Versorgungseinheit
3
Abb. 3.4 - 1 Versorgungseinheit (Beispiel SWS 2/4)
3
(1) Einstellung der Blasluft für Flip Kopf Seg-
mente bzw. Die Attach Segment
(2) Spannungsversorgung
(3) Interface Sicherheitsabschaltung mit SIP-
LACE CA4 V2
(4) CAN-Bus (nur für SW 605.x)
(5) Öffnung für Druckluftschlauch von der
SIPLACE CA4 V2
(6) LAN1 - Kommunikation mit externen Map-
server
(7) LAN2 -Kommunikation mit SIPLACE CA4
V2 und evtl. anderen SWS
(1)
(2)
(3)
(4)
(6)
(7)
(5)

3 Technische Daten und Baugruppen Betriebsanleitung SIPLACE Wafer System (SWS)
3.4 Beschreibung der SWS-Baugruppen Ausgabe 02/2018
72
3.4.2 Flip-Unit
3
Abb. 3.4 - 2 Flip-Kopf - Ansicht von vorne
(1) Pipetten- bzw. Toolaufnahme, Segment 1
(2) Pipetten- bzw. Toolaufnahme, Segment 2
(3) Motor für Flipper Z-Achse
(4) Motor für Flipper-Rotations-Achse
Die Flip-Unit nimmt das ausgestochene Die von der Wafer-Folie. Im Flip-Chip-Modus dreht sie
das Die um 180° in die Abholposition des Bestückkopfes. Im Die-Attach-Modus dreht die Flip-Unit
das Die um ca. 130° in die Übergabeposition zur Die-Attach-Unit.
1
3
4
2
Betriebsanleitung SIPLACE Wafer System (SWS) 3 Technische Daten und Baugruppen
Ausgabe 02/2018 3.4 Beschreibung der SWS-Baugruppen
73
Die Flip-Unit ist mit zwei um 180° entgegengesetzt angeordneten Pipetten ausgestattet. Dies er-
möglicht im Flip-Chip-Modus während des Abholvorgangs des Bestückkopfes die gleichzeitige
Aufnahme eines Dies vom Wafer.
Die Flip-Unit kann sowohl mit Standard-SIPLACE-Pipetten (9xx) als auch mit speziellen Adapter-
pipetten für Die-Bonding-Tools arbeiten. Die Dies werden, wie auch bei anderen SIPLACE-Be-
stückautomaten, durch ein Vakuum an die Pipetten angesaugt.
Die Flip-Unit enthält eine Rotationsachse sowie eine von einem Linearmotor angetriebene
Z-Achse. Im optionalen Die-Attach-Modus ist ein weiterer Linearmotor zum Transfer des Dies an
den Die-Attach-Kopf und eine weitere Rotationsachse für den Die-Attach-Kopf enthalten. Die Ro-
tationsachse ist für die Drehung in 180°-Lage (Flip-Chip-Modus) bzw. 130°-Lage (Die-Attach-Mo-
dus) zuständig. Die Z-Achse bewirkt die Bewegung des Segments während des Pick-Prozesses.
Der optionale Linearmotor im Die-Attach-Modus bewirkt eine Bewegung des Segments für den
Transfer des Dies an den Die-Attach-Kopf.
3.4.3 Wafer-Kamera-System
Die Wafer-Kamera ist auf die Wafer-Oberfläche gerichtet. Das Kamerabild dient dem Visionsys-
tem zur Erkennung des definierten Musters für das zu bestückende Die (auch Referenz-Die), Ink-
punkterkennung, Berechnung der Die-Position und zur Waferrand-Erkennung. Nach
Positionierung des Wafers auf das nächste auszustechende Die, wird das Visionmodell überprüft
und die Position des Dies bestimmt. Bei zu großer Abweichung vom Sollwert (Toleranz kann de-
finiert werden) wird der Wafertisch erneut positioniert, um die Ausstechposition zu optimieren.
Die Wafer-Randlagenerkennung ist notwendig um Abweichungen der Waferlage relativ zum Wa-
fer-Rahmen zwischen verschiedenen Wafern des gleichen Typs auszugleichen.
Spezifikation Standard-Kamera-System
Das Standard-Kamera-System wird für Die-Größen von 0,8 bis 12 mm verwendet.
Das Gesichtsfeld der Kamera beträgt etwa 10,5 x 6,7 mm.
3.4.4 Wafer-Tisch
Der Wafer-Tisch besteht aus einer X-Y-Einheit (Bewegungssystem mit 2 linearen Achsen) und der
Wafer-Aufnahme.
Der Wafer-Tisch bewegt die Wafer-Aufnahme mit dem Wafer zu den benötigten Positionen im Ar-
beitsbereich.