00197497-03_UM_SiplaceCA-Serie_DE.pdf - 第201页
Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS) Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung 201 Um das ganze S pektrum prozessorientierter Funktionen zu unterstützen sind folgend…

4 SIPLACE Wafer-System (SWS) Betriebsanleitung SIPLACE CA-Serie
4.1 Funktionsbeschreibung Ab Softwareversion SR 708.0 Ausgabe 12/2014
200
4.1 Funktionsbeschreibung
4.1.1 Funktionsprinzip des SIPLACE Wafer-Systems (SWS)
Das neue SWS bietet ein vollautomatisches Wafer- und Chip-Handling-System. Es ist voll in einen
Stellplatz des SIPLACE CA-Bestückungssystems integriert. Jeder Stellplatz kann (mit Einschrän-
kungen) mit einem SWS oder mit einem X-Tisch ausgerüstet werden.
Das SWS arbeitet für das SIPLACE-System wie ein Förderer und befördert die Dies vom Wafer
an eine einzelne, fest bestimmte Abholposition für den Bestückkopf. Der Bestückkopf holt das Die
beim SWS ab und platziert dieses wie auch beim SMD-Handling auf der Leiterplatte.
Das SWS erscheint in SIPLACE Pro wie ein X-Förderer mit einem speziellen Förderer-Typ. Die
Programmierung des SIPLACE-Systems erfolgt wie von der SIPLACE X-Serie bekannt. Das Die-
Handling wird am gesonderten Bedienterminal am SWS programmiert. Die zu programmierenden
Haupt-Parameter sind folgende:
– Wafer- und Die-Dimensionen
– Magazin-Typ
– Waferrahmen-Typ
– Die-Erkennung
– Die-Ausstech-Parameter
– Wafer-Map-System
– Verknüpfung zum in SIPLACE Pro programmierten Bauelement
4.1.2 Grundfunktionen des SWS
Die wesentlichen Komponenten für das Die-Handling sind der Wafer-Tisch, das Ausstech-Sys-
tem, die Flip-Unit und die Kontrolleinheit inklusive der zugehörigen Software.
Der Wafer mit dem entsprechenden Die wird aus dem Magazin geladen und auf dem Wafer-Tisch
fixiert. Der Wafer-Tisch platziert das Die über dem Ausstech-System, wo das Die von der Wafer-
Folie gelöst und zur Flip-Unit übergeben wird. Die Flip-Unit dreht das Die um 180° und stellt die-
sen zur Abholung durch den Bestückkopf bereit.
Die SIPLACE CA verwendet einen hochgenauen SIPLACE-Bestückkopf, der speziell für höhere
Genauigkeit ausgesucht wurde um die Vorgaben von 35 µm bei 3 Sigma bei normalen und 25 µm
bei 3 Sigma unter eingeschränkten Bedingungen zu erfüllen (Einschränkungen siehe "Lieferun-
gen und Leistungen").
4
HINWEIS
Alle Bewegungsachsen im SWS zur Positionierung sind Servo-Achsen!
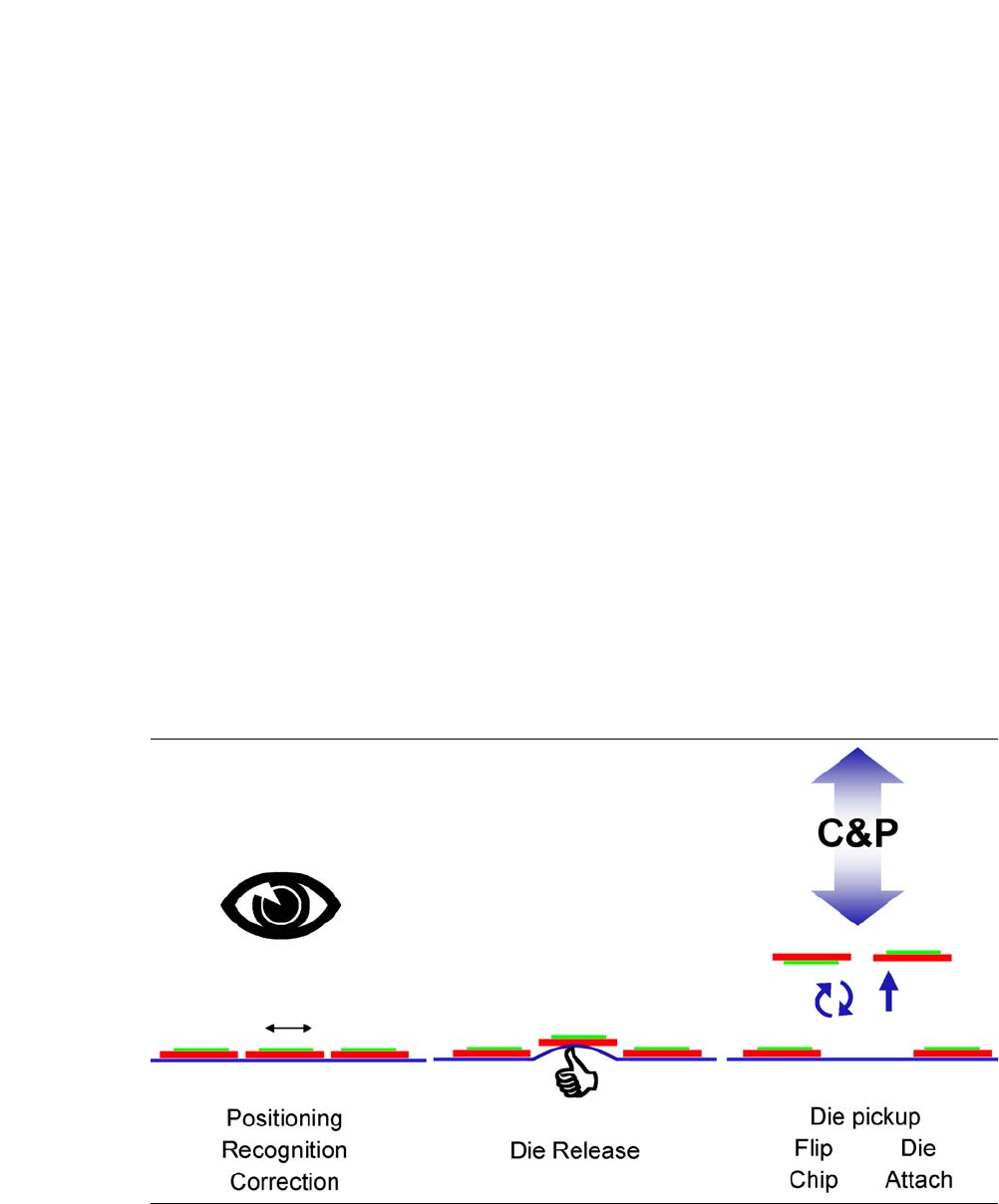
Betriebsanleitung SIPLACE CA-Serie 4 SIPLACE Wafer-System (SWS)
Ab Softwareversion SR 708.0 Ausgabe 12/2014 4.1 Funktionsbeschreibung
201
Um das ganze Spektrum prozessorientierter Funktionen zu unterstützen sind folgende Optionen
verfügbar:
– Wafer-Map-System
– Linear-Dipping-Unit
– Die-Attach-Unit
– Small-Die-Kit (auf Anfrage)
– Barcodescanner
– Wafer-Expander
– Inspektionskamera
4.1.3 Basic-Die-Presentation-Prozess
Der von der SWS unterstützte Basic-Die-Presentation-Prozess kann in 3 Hauptabschnitte unter-
teilt werden:
– Die-Erkennung und Positionierung für den Ausstechvorgang (incl. Ink-Punkt-Erkennung oder
Wafer-Map)
– Ausstechvorgang
– Abholvorgang für Die-Attach- oder Flip-Chip-Verarbeitung.
Abb. 4.1 - 1 Basic-Die-Presentation-Prozess
Grundsätzlich gibt es zwei wesentliche Bestückvarianten, den Flip-Chip- und den Die-Attach-Pro-
zess.
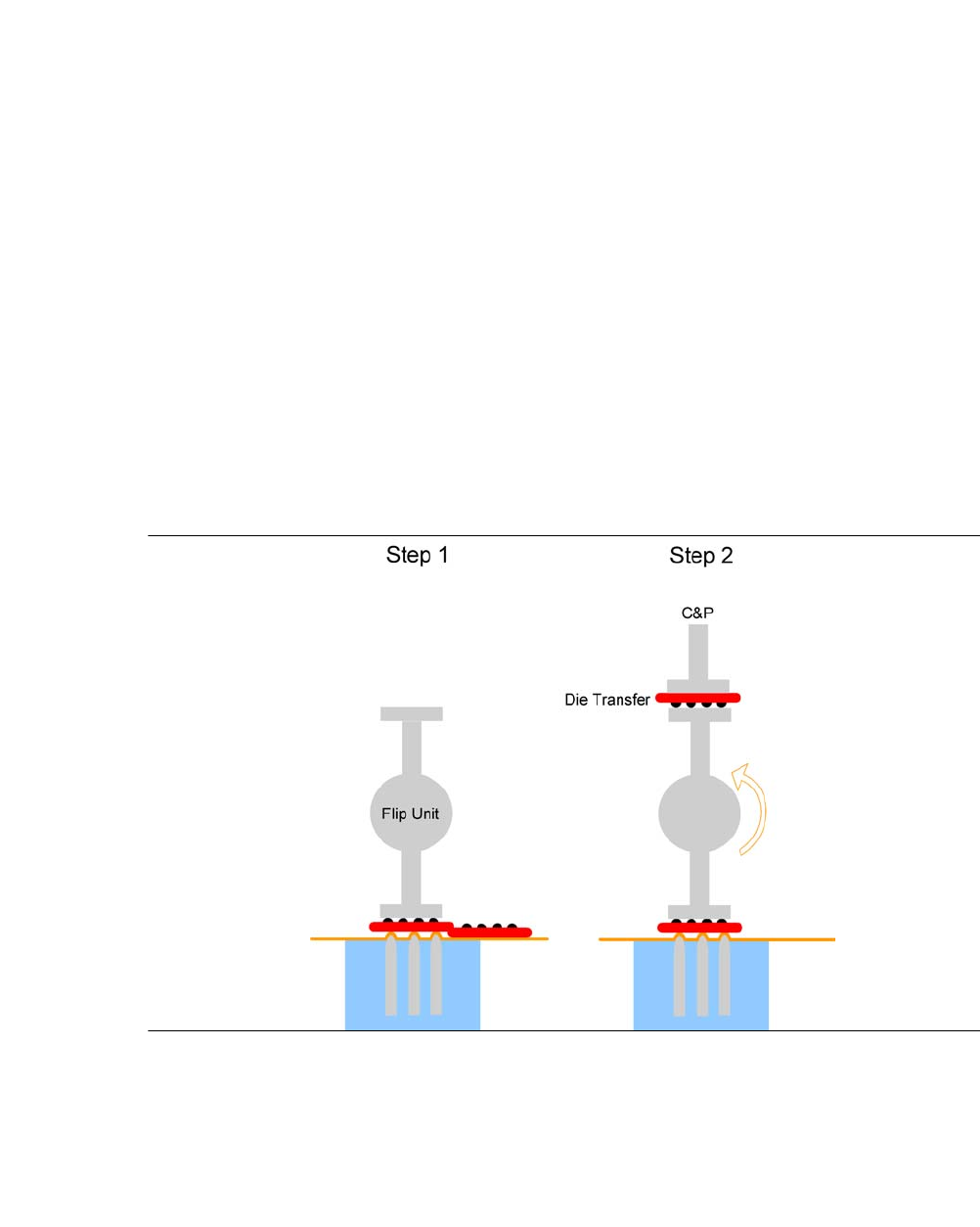
4 SIPLACE Wafer-System (SWS) Betriebsanleitung SIPLACE CA-Serie
4.1 Funktionsbeschreibung Ab Softwareversion SR 708.0 Ausgabe 12/2014
202
4.1.3.1 Flip-Chip-Prozess
Der Flip-Chip-Prozess ist das Standardverfahren des SWS. Dabei wird das Die vor der Bestü-
ckung auf der Platine um 180° gedreht (Face-Down-Bestückung).
Der Flip-Chip-Prozess ist eine stark wachsende Technologie. Dieser Prozess wird vor allem für
Baugruppen in der Consumer-Elektronik verwendet (z. B. Prozessoren, Grafik-Prozessoren,
Speicher).
Die Ein-/Ausgänge (E/A) des Dies sind direkt mit der Leiterplatte verbunden, was gegenüber dem
klassischen Die-Attach-Prozess einige Vorteile hat:
Geringerer Platzverbrauch
Schnellere Signalübertragung
Höhere E/A-Dichte pro Bauteil
Abb. 4.1 - 2 Flip-Chip-Prozess
Die Schritte des Flip-Chip-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um 180° gedreht und an den Bestückkopf übergeben. Parallel dazu wird
das nächste Die mit der zweiten Pipette der Flip-Unit aufgenommen.