00197546-03_UM_SiplaceCA-Serie_ZH.pdf - 第198页
4 SIPL ACE 晶圆 系统 (SW S) 《用户手册》 SIPLACE CA- 系列 4.1 功能 使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文 198 4.1.3.1 倒装片处理 倒装片处理是 SWS 的标准方法。它 包括了在贴装到印制板上之前将晶 粒旋转 180° (面朝下贴 装) 。 倒装片处理方法当前正在成为一个主 流趋势。此工艺主要被运用在消费性电子产品组件中 (如, 处理器、图形处理器、内…
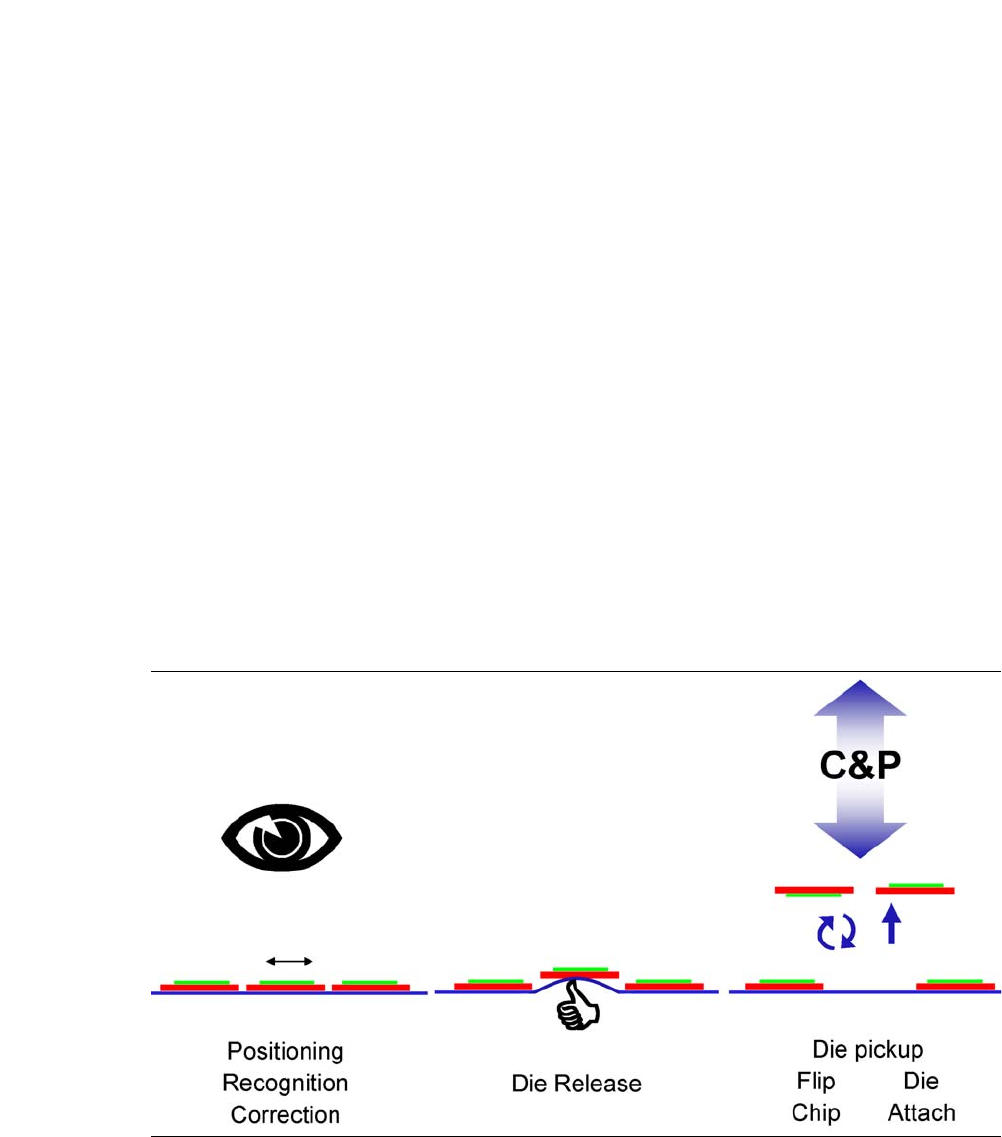
《用户手册》 SIPLACE CA- 系列 4 SIPLACE 晶圆系统 (SWS)
使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文 4.1 功能
197
为支持全范围的处理导向型功能,以下选项可供选择:
– 晶圆布局图系统
– 线性浸渍单元
– 晶粒贴附单元
– 小号晶粒套件 (根据要求提供)
– 条形码扫描仪
– 晶圆延伸器
– 检验相机
4.1.3 基本晶粒呈现处理
由 SWS 支持的基本晶粒呈现处理可以划分为 3 个主要步骤:
– 推出前的晶粒识别和定位 (包括墨点识别或晶圆图)
– 推送处理
– 为晶粒贴附或倒装片处理进行拾取。
图 4.1 - 1 基本晶粒呈现处理
有两种主要的贴装变化 - 倒装片和晶粒贴附。
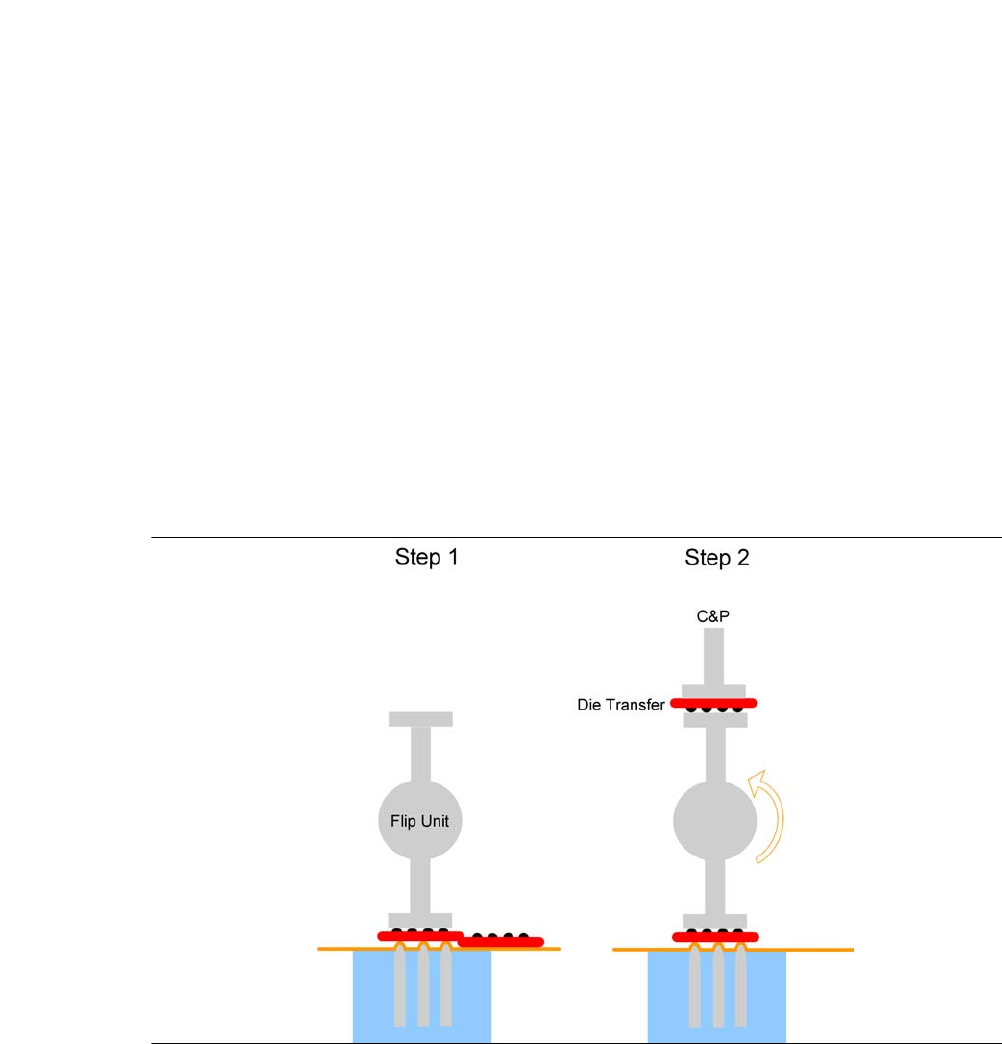
4 SIPLACE 晶圆系统 (SWS) 《用户手册》 SIPLACE CA- 系列
4.1 功能 使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文
198
4.1.3.1 倒装片处理
倒装片处理是 SWS 的标准方法。它包括了在贴装到印制板上之前将晶粒旋转 180° (面朝下贴
装)。
倒装片处理方法当前正在成为一个主流趋势。此工艺主要被运用在消费性电子产品组件中 (如,
处理器、图形处理器、内存)。
晶粒的输入 / 输出 (I/A)直接与 PCB 相关联,所以与传统的晶粒贴附工艺相比它带来了几个优
势:
更小的空间要求
更快的信号转送
每个元件更高的 I/O 密度
图 4.1 - 2 倒装片处理
倒装片处理的步骤有:
– 第 1 步:晶粒释放
– 第 2 步:晶粒被旋转 180° 然后被传送给贴片头。与此同时,下一个晶粒被倒装单元的第二个
吸嘴拾起。
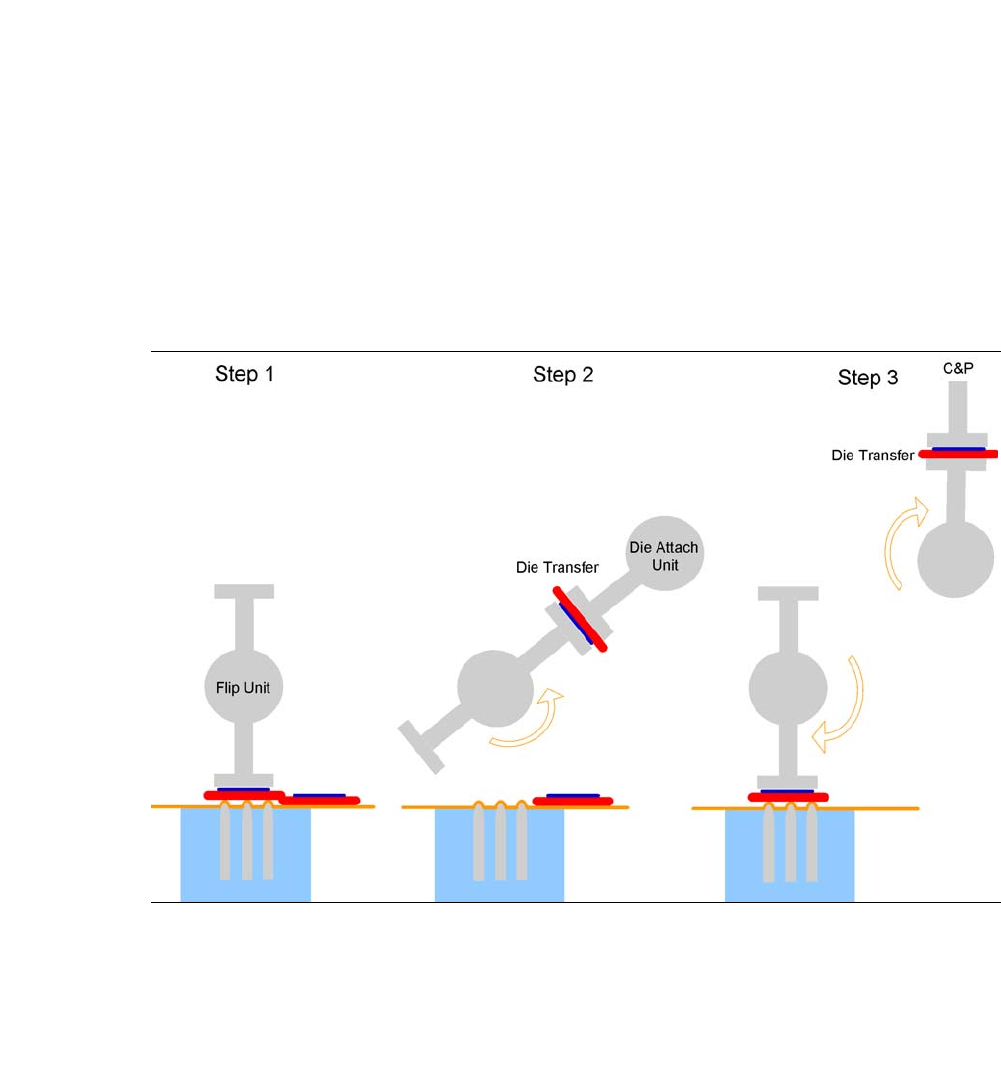
《用户手册》 SIPLACE CA- 系列 4 SIPLACE 晶圆系统 (SWS)
使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文 4.1 功能
199
4.1.3.2 晶粒贴附处理
进行晶粒贴附处理需要安装可选的晶粒贴附单元。
在这种方法中,晶粒以与其在晶圆盖箔中同样的底部 / 顶部定位被贴装 (“ 面朝上 ” 贴装)。
晶粒贴附是一个传统的晶粒贴装工序。它需要一个额外的步骤才能建立晶粒到印制板间的连接
(线路连接)。
图 4.1 - 3 晶粒贴附处理的步骤
晶粒贴附处理的步骤有:
– 第 1 步:晶粒释放
– 第 2 步:晶粒被旋转大约 130°,然后被转送到晶粒贴附单元。
– 第 3 步:晶粒贴附单元将晶粒旋转到拾取位置,然后将它转送给贴片头。如此同时,倒装单
元将拾起下一个晶粒。