00197546-03_UM_SiplaceCA-Serie_ZH.pdf - 第201页
《用户手册》 SIPLACE CA- 系列 4 SIPLACE 晶圆系统 (SWS) 使用软件版本 SC.708.0 或更新 2014 年 1 2 月版 简体中文 4.1 功能 201 4.1.3.5 拾取处理 在拾取处理中,晶粒被转送到倒 装单元的工具或吸嘴上。倒装单元将其上的晶粒转送给贴片头 (倒装片处理)或者晶粒贴 附单元 (晶粒贴附 处理) 。 晶粒贴附单元再次旋转晶粒然后 将它呈交给贴片头。 完成这个步骤需要使用以下设备 : …
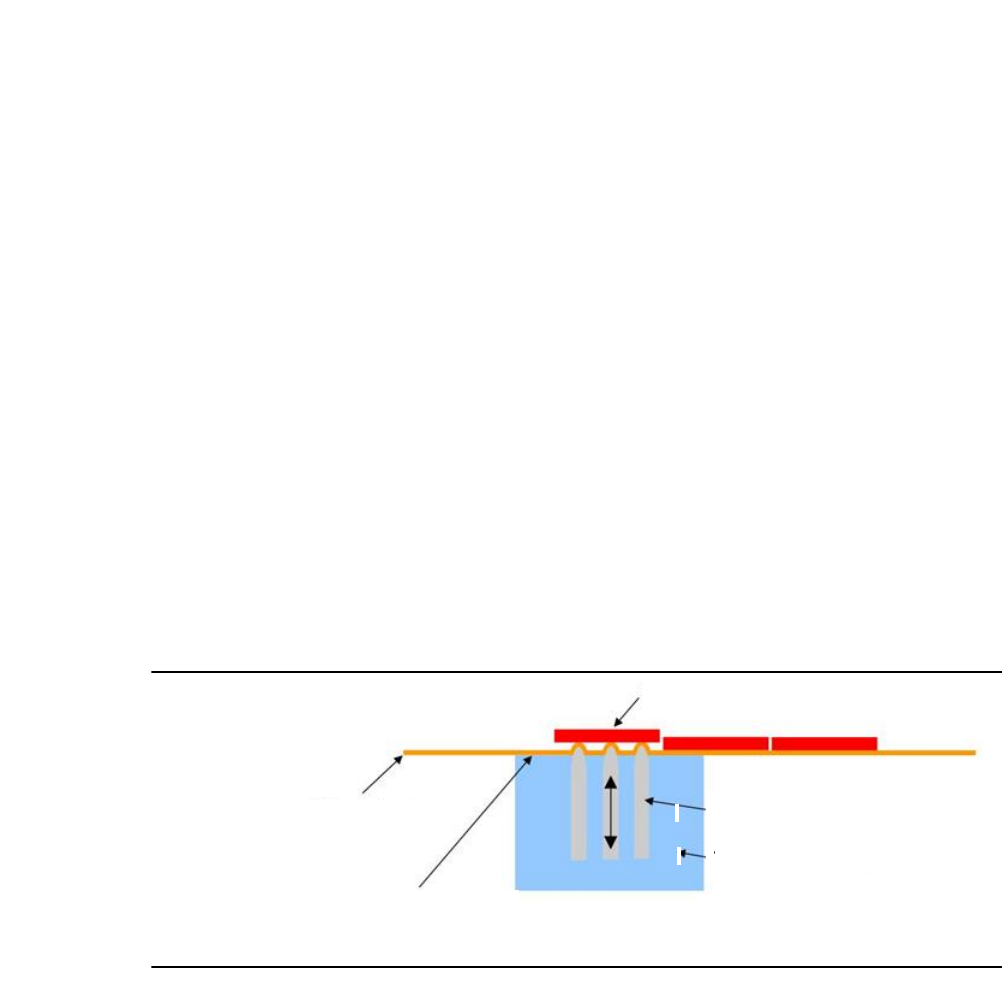
4 SIPLACE 晶圆系统 (SWS) 《用户手册》 SIPLACE CA- 系列
4.1 功能 使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文
200
4.1.3.3 晶粒的识别和定位
晶圆以一个固定的位置和角度公差被固定到晶圆盖箔中。
因此在不进行识别和更正的情况下,将无法把晶粒准确地安放在推送单元的中心位置。为保证准
确可靠的推送效果,对于小型晶粒而言这一点尤其重要。
不单如此,您还可能仅需要处理一部分的晶粒。通过使用一个墨点标记出 “ 坏 ” 晶粒,或者为相
应的晶圆使用一个晶圆布局图文件来确定选择范围。
完成这个步骤需要使用以下设备:
用于定位的 2 轴晶圆台
用于识别晶粒和可选墨点的晶圆相机系统
可选的晶圆布局图系统
4.1.3.4 推送处理
一旦使用推送系统将晶粒对中,就可以使用顶针将其从晶圆料膜中释放出来,然后转送给倒装单
元。在顶针从盖箔中释放出晶粒时,晶圆盖箔通过抽吸的方式被移向推送系统。
图 4.1 - 4 晶粒呈现处理
此工序需要使用到以下设备:
– 带可交换推送工具的推送系统
推送顶针
真空帽
推送系统
活跃元件 - 准备好被拾取
晶圆盖箔
晶圆盖箔在真空帽处被真空吸起

《用户手册》 SIPLACE CA- 系列 4 SIPLACE 晶圆系统 (SWS)
使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文 4.1 功能
201
4.1.3.5 拾取处理
在拾取处理中,晶粒被转送到倒装单元的工具或吸嘴上。倒装单元将其上的晶粒转送给贴片头
(倒装片处理)或者晶粒贴附单元 (晶粒贴附处理)。
晶粒贴附单元再次旋转晶粒然后将它呈交给贴片头。
完成这个步骤需要使用以下设备:
倒装单元
晶粒贴附单元 (可选)
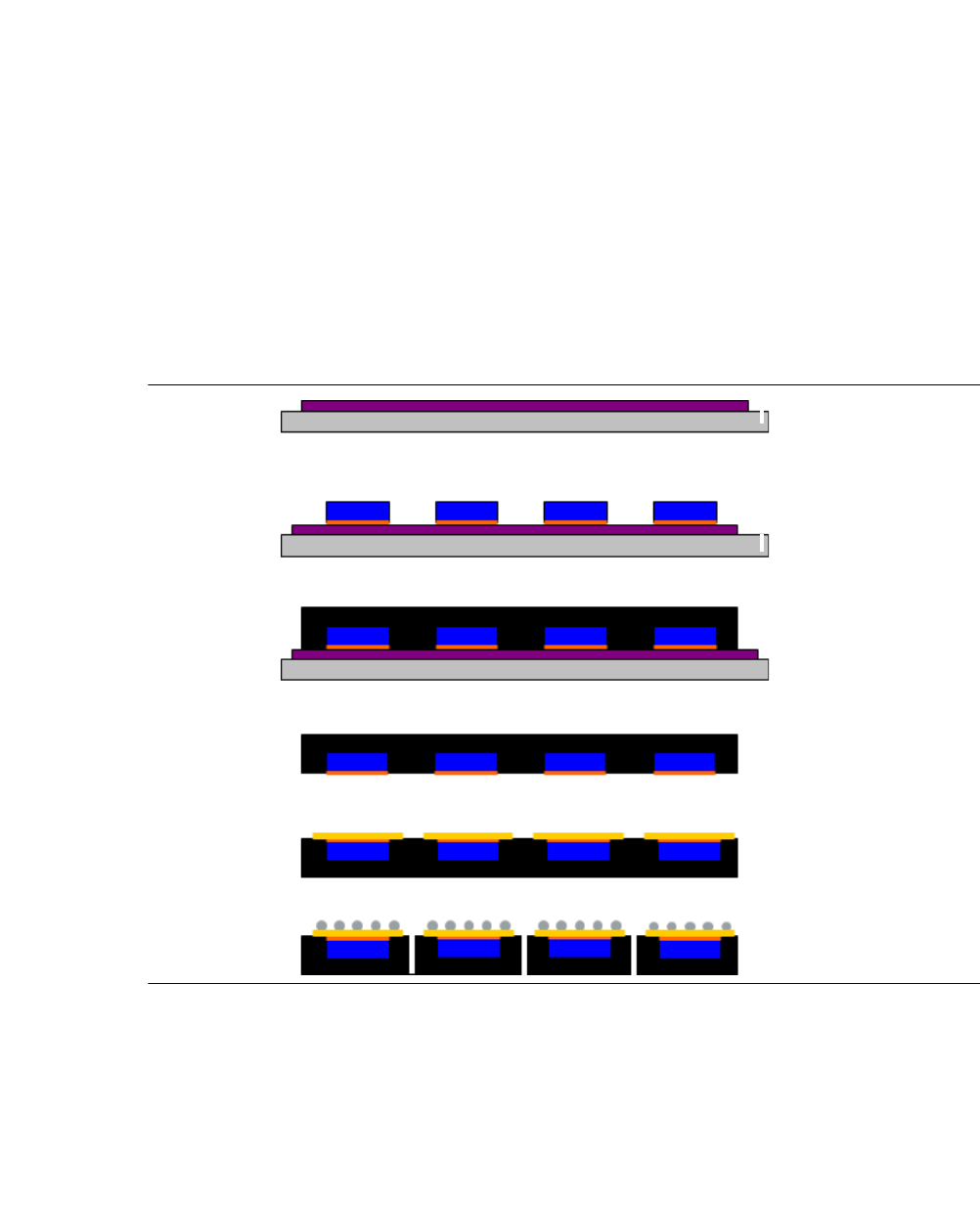
4 SIPLACE 晶圆系统 (SWS) 《用户手册》 SIPLACE CA- 系列
4.1 功能 使用软件版本 SC.708.0 或更新 2014 年 12 月版 简体中文
202
4.1.4 嵌入式晶圆级球栅阵列 (eWLB/WLFO) 处理
嵌入式晶圆级球栅阵列是一种封装技术,它允许您借助芯片扩散性解决方案生产电导性极佳的薄
元件。这就意味着连接衬垫所用的区域大于实际的硅,从而创建出适合 SMD 的接触距离。
这一处理过程将通过两面均可粘合的料膜,使芯片元件活跃的表面向下贴装在盤架上。该结构会
在贴片后成型。完成盤架上的晶粒接着流程后,将使用晶圆结构流程来创建电气触点。硅周边的
成型区被用作 “ 导电通路 ” (扩散性)的盤架。然后就会对元件进行测试,贴标及封装,即封装
至料带中。
4
图 4.1 - 5 嵌入式晶圆级球栅阵列工艺的步骤
(1) 金属盤架上的层压热剥离料带
(2) 确保由晶圆 (倒装片)所贴装的活跃的一侧将会面朝下进入热剥离料带中
(3) 处于 150°C 时的加压成型;硬化
(4) 释放
(5) 重新 - 分配层 (RDL)
(6) 植球 & 单个
(7) 测试、贴标、封装
1
2
3
4
5
6