00198370-01_UM_SWS-DE.pdf - 第18页
1 Einleitung Betriebsanleitung SIPLACE Wafer System (SWS) 1.2 Funktionsbeschreibung Ausgabe 04/2018 18 1.2.3 Basic-Die-Present ation-Prozess Der von der SWS unterstützte Ba sic-Die-Presentation-Prozess kann in 3 Haup tab…

Betriebsanleitung SIPLACE Wafer System (SWS) 1 Einleitung
Ausgabe 04/2018 1.2 Funktionsbeschreibung
17
1.2.2 Grundfunktionen des SWS
Die wesentlichen Komponenten für das Die-Handling sind der Wafer-Tisch, der Magazinlift, das
Ausstech-System, die Flip-Unit und die Bedieneinheit inklusive der zugehörigen SWS-Software.
Der Wafer mit dem entsprechenden Die wird aus dem Magazin geladen und auf dem Wafer-Tisch
fixiert. Der Wafer-Tisch platziert das Die über dem Ausstech-System, wo das Die von der Wafer-
Folie gelöst und zur Flip-Unit übergeben wird.
Die Flip-Unit verarbeitet das die in zwei verschiedenen Funktionen:
– Die Flip-Unit dreht das Die um 180° und stellt diesen zur Abholung durch den Bestückkopf
bereit.
Oder 1
– Die Die Flip-Unit übergibt es an die Die-Attach Unit, welche dann vom Bestückkopf angefah-
ren wird und das Die in der selben Lage wie auf dem Wafer auf die Leiterplatte setzt.
Die SIPLACE CA4 V2 verwendet einen hochgenauen SIPLACE-Bestückkopf, der speziell für hö-
here Genauigkeit ausgesucht wurde um die Vorgaben bei normalen und unter eingeschränkten
Bedingungen zu erfüllen (Einschränkungen siehe "Lieferungen und Leistungen").
1
Um das ganze Spektrum prozessorientierter Funktionen zu unterstützen sind folgende Optionen
verfügbar:
– Linear-Dipping-Unit
– Die-Attach-Unit
– Barcodescanner
– Wafer-Expander
– Inspektionskamera
HINWEIS
Alle Bewegungsachsen im SWS zur Positionierung sind Servo-Achsen!
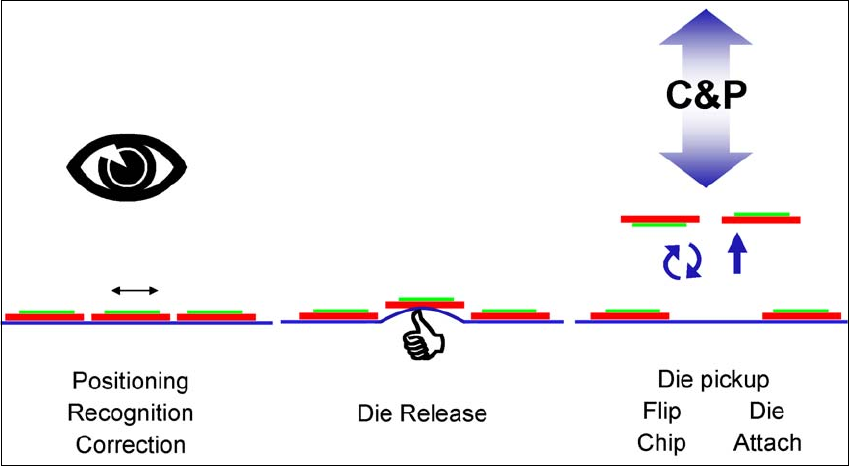
1 Einleitung Betriebsanleitung SIPLACE Wafer System (SWS)
1.2 Funktionsbeschreibung Ausgabe 04/2018
18
1.2.3 Basic-Die-Presentation-Prozess
Der von der SWS unterstützte Basic-Die-Presentation-Prozess kann in 3 Hauptabschnitte unter-
teilt werden:
– Die-Erkennung und Positionierung für den Ausstechvorgang (incl. Ink-Punkt-Erkennung)
– Ausstechvorgang
– Die-Attach- oder Flip-Chip-Verarbeitung.
1
Abb. 1.2 - 1 Basic-Die-Präsentation-Prozess (Prinzip-Darstellung)
Grundsätzlich gibt es zwei wesentliche Prozesse für die Verarbeitung von Dies:
– Flip-Chip-Prozess
– Die-Attach-Prozess.
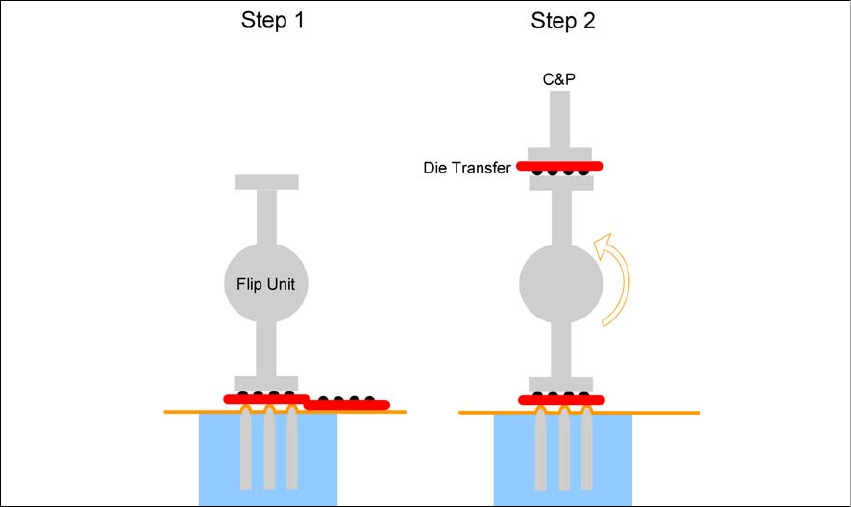
Betriebsanleitung SIPLACE Wafer System (SWS) 1 Einleitung
Ausgabe 04/2018 1.2 Funktionsbeschreibung
19
1.2.3.1 Flip-Chip-Prozess
Der Flip-Chip-Prozess ist das Standardverfahren des SWS. Dabei wird das Die vor dem Bestü-
cken um 180° gedreht (Face-Down-Bestückung).
1
Abb. 1.2 - 2 Flip-Chip-Prozess (Prinzip-Darstellung)
Die Schritte des Flip-Chip-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um 180° gedreht und an den Bestückkopf übergeben. Parallel dazu wird
das nächste Die mit der zweiten Pipette der Flip-Unit aufgenommen.