00198370-01_UM_SWS-DE.pdf - 第21页
Betriebsanleitung SIPLACE Wafer System (SWS) 1 Einleitung Ausgabe 04/2018 1.2 Funktionsbeschreibung 21 1.2.3.3 Die-Erkennung und -Positionierung Die W afer sind grundsätzlich, mit einer bestimmten Positions- und Winkelto…
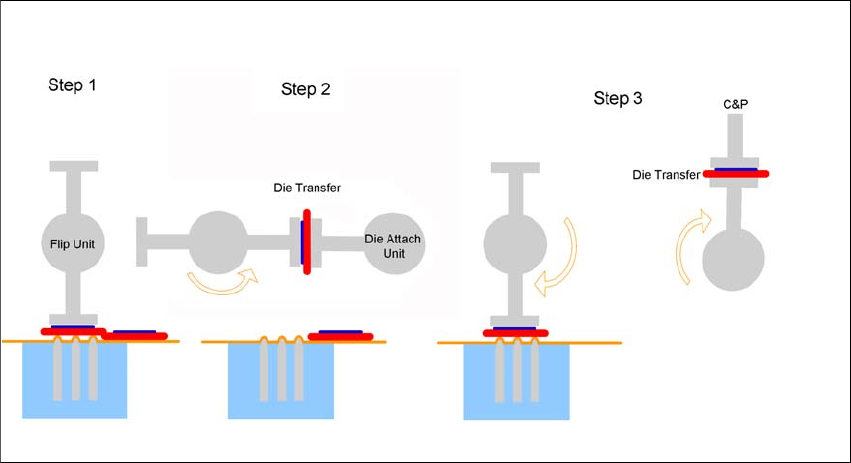
1 Einleitung Betriebsanleitung SIPLACE Wafer System (SWS)
1.2 Funktionsbeschreibung Ausgabe 04/2018
20
1.2.3.2 Die-Attach-Prozess
Für den Die-Attach-Prozess wird die optionale Die-Attach-Unit benötigt.
In diesem Verfahren wird das Die in der selben Oben-Unten-Orientierung bestückt wie es auf der
Wafer-Folie vorliegt (Face-Up-Bestückung).
1
Abb. 1.2 - 3 Schritte des Die-Attach-Prozesses (Prinzip-Darstellung)
Die Schritte des Die-Attach-Prozesses:
– Step 1: Die-Release
– Step 2: Das Die wird um ca. 130° gedreht und an die Die-Attach-Unit übergeben.
– Step 3: Die Die-Attach-Unit dreht das Die zur Abholposition und übergibt es an den Bestück-
kopf. Parallel dazu wird von der Flip-Unit das nächste Die abgeholt.
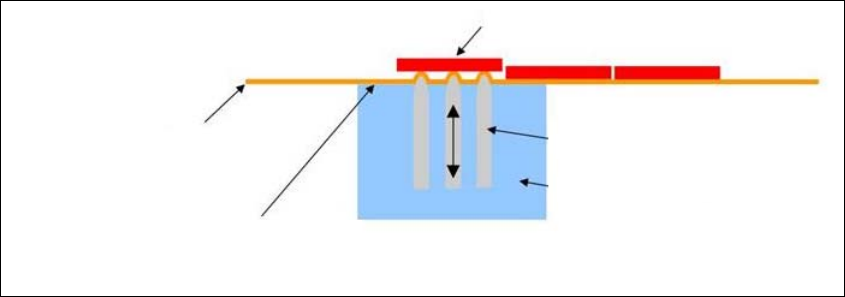
Betriebsanleitung SIPLACE Wafer System (SWS) 1 Einleitung
Ausgabe 04/2018 1.2 Funktionsbeschreibung
21
1.2.3.3 Die-Erkennung und -Positionierung
Die Wafer sind grundsätzlich, mit einer bestimmten Positions- und Winkeltoleranz, auf einer Wa-
fer-Folie befestigt.
Daher ist es nicht möglich das Die ohne Erkennung und Korrektur sicher in der Mitte der Ausste-
cheinheit zu platzieren. Dies ist besonders bei kleinen Dies notwendig um einen einwandfreien
Ausstechvorgang sicherzustellen.
Darüber hinaus kann es notwendig sein nur eine Auswahl an Dies zu verarbeiten. Eine solche
Auswahl kann über eine Ink-Punkt-Markierung und/oder mit einer zum jeweiligen Wafer gehöri-
gen Wafer-Map-Datei erfolgen.
Für diesen Verfahrensschritt kommen folgende Komponenten zum Einsatz:
– 2-Achsen-Wafer-Tisch für die Positionierung
– Wafer-Kamera-System für die Die- und die optionale Ink-Punkt-Erkennung
– Barcodescanner für die Wafer-Identifizierung (Optional)
1.2.3.4 Ausstechvorgang
Ist das Die über dem Ausstechsystem zentriert, dann kann es mit Hilfe von Nadeln von der Wafer-
Folie abgelöst und an die Flip-Unit übergeben werden. Dabei kommen Piercing- oder Non Pier-
cing Nadeln zum Einsatz.Während die Nadeln das Die von der Folie lösen, wird die Wafer-Folie
in Richtung Ausstechsystem gesaugt.
Für diesen Verfahrensschritt kommen folgende Komponenten zum Einsatz:
– Ausstecheinheit
Abb. 1.2 - 4 Ausstechvorgang - Non Pierching (Prinzip-Darstellung)
Ausstechnadel
Vakuum-Kappe
Ausstechsystem - Non Piercing Nadeln
Aktives Bauteil - bereit zur Abholung
Wafer-Folie
Die Wafer-Folie wird mit Vakuum an
die Vakuum-Kappe angesaugt
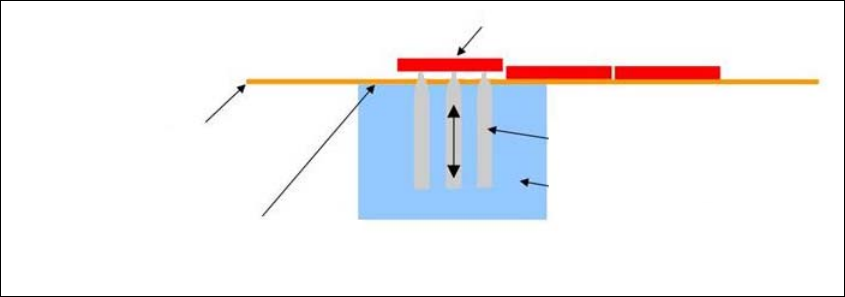
1 Einleitung Betriebsanleitung SIPLACE Wafer System (SWS)
1.2 Funktionsbeschreibung Ausgabe 04/2018
22
Abb. 1.2 - 5 Ausstechvorgang - Pierching (Prinzip-Darstellung)
1.2.3.5 Pickup-Prozess
Während des Pickup-Prozesses wird das Die an das Tool bzw. an die Pipette der Flip-Unit über-
geben. Die Flip-Unit übergibt das Die darauf entweder an den Bestückkopf (Flip-Chip-Prozess)
oder an die Die-Attach-Unit (Die-Attach-Prozess).
Die Die-Attach-Unit stellt das Die nach einem weiteren Drehvorgang für den Bestückkopf bereit.
Für diesen Verfahrensschritt ist folgende technische Ausrüstung notwendig:
Flip-Unit
Die-Attach-Unit (optional)
1
Ausstechnadel
Vakuum-Kappe
Ausstechsystem - Piercing Nadeln
Aktives Bauteil - bereit zur Abholung
Wafer-Folie
Die Wafer-Folie wird mit Vakuum an
die Vakuum-Kappe angesaugt