IPC-7095D-CHINESE NP 2019.pdf - 第120页
IPC-7095D-W AM1 CN 2019 年 1 月 104 图 7-21 印制板 BGA 连接盘周围阻焊膜去除后的影响 A– 俯视图显示由于线条连接,有效连接盘直径的增加 B– 切片视图显示当阻焊膜从连接盘边缘去除后,焊料会沿着连接盘边缘向下润湿 7.2 组装后的工艺 7.2.1 敷形涂覆 敷形涂覆是与印制板组件及其元器件形状一致的电气绝缘材料。施加它的目的是为了改善表 面介电性质并保护组件免受恶劣环境和表面湿气(造成腐蚀)的影…

IPC-7095D-WAM1 CN2019 年 1 月
103
7.1.6.2 不需要清洗的助焊剂残留物(免清洗)
由于使用清洗型助焊剂会带来环境问题和处理溶剂废液和清
洗设备的成本问题,使得免清洗型助焊剂的使用已有增长。但是,免清洗并非为普适性的工艺。免清洗助焊剂
的活性通常比其它类型的助焊剂低,因此其焊接效果可能不如预期,除非在工艺中采取足够的措施。一些免清
洗助焊剂需要充氮再流焊环境以产生可接受的结果;然而,大部分免清洗助焊剂可在空气环境下进行再流焊。
免清洗助焊剂残留必须有充分的惰性,才不会损坏印制板或元器件。这些残留通常呈轻微离子态和/或略呈酸
性,会导致产品潜在失效。这些残留导致的失效模式可能包括:
• 印制板的腐蚀
• 由于枝晶生长导致金属线条之间短路
• 由于离子污染物扩散到芯片有源结而导致集成电路功能的退化
腐蚀和短路是表面现象,且潜伏期相对较短。这些影响可通过印制板表面的 SIR 或电化学迁移(ECM)测试
检测到。
发生功能退化取决于外部离子(如有)要花多长时间穿过封装密封材料区而扩散进入芯片区。这些外部离子一
旦到达硅芯片,芯片的功能可能会受到影响。在正常的工作环境中扩散时间通常是若干年。通常,需要某些加
速试验(如 SIR 或 ECM),在合理的测试期内来测量这种影响。另外,所有用于印制板组件的免清洗助焊剂(如
焊膏、波峰焊助焊剂及返工用助焊剂)会残留在组件上,并互相混合。
这些助焊剂应该既要组合在一起进行测试,也要单独测试,以了解清洁度的整体情况。
7.1.7 封装间隙高度
封装间隙高度是决定 BGA 焊点可靠性的主要参数之一。BGA 间隙高度的定义为封装基
板底部连接盘与印制板表面顶部连接盘之间的距离。此距离随不同焊球类型而变化:高铅类焊球保持着非常一
致的尺寸;然而共晶焊球则会减小封装间隙高度,这也称为焊球塌陷高度。
举例来说,当 1.27mm 锡铅 BGA 焊球连接至封装时塌陷 0.1mm,而封装焊接时,则焊球额外有 0.2mm 的塌陷。
所以总的来说,对于 1.27mm 的焊球比再流前预期的值会减少 0.25mm 至 0.3mm。高铅和铜焊球不塌陷,因为
它们不熔化。在建立工艺期间应该验证无铅 BGA 的间隙高度。
建议建立工艺来再现具体元器件的间隙高度。再流焊后,决定 BGA 封装与印制板间隙高度的因素包括:
• BGA 封装重量
• 焊球尺寸
• 焊球材料
• 连接盘尺寸
• 连接盘构造(SMD 或 NSMD)
间隙高度会随着封装重量增加而减小。然而,对于有较高焊球数的封装,封装重量对于间隙高度的影响可能会
较小。有关这两种参数之间关系的一项研究发现,对于 615 个焊球、1.27mm 节距的 BGA 封装,封装重量增
加 5 倍,间隙高度只下降约 0.05mm。
由于每个焊球有较大的焊料量,较大的焊球尺寸导致有较大封装间隙高度。间隙高度与连接盘直径成反比,对
于 NSMD,连接盘外围没有阻焊膜而使间隙高度减小,这是因为焊料会沿着导体和连接盘边缘向外润湿。如
图 7-21 所示。

IPC-7095D-WAM1 CN 2019 年 1 月
104
图 7-21 印制板 BGA 连接盘周围阻焊膜去除后的影响
A– 俯视图显示由于线条连接,有效连接盘直径的增加
B– 切片视图显示当阻焊膜从连接盘边缘去除后,焊料会沿着连接盘边缘向下润湿
7.2 组装后的工艺
7.2.1 敷形涂覆
敷形涂覆是与印制板组件及其元器件形状一致的电气绝缘材料。施加它的目的是为了改善表
面介电性质并保护组件免受恶劣环境和表面湿气(造成腐蚀)的影响。
应该规定敷形涂覆满足 IPC-CC-830 的要求,并应该在主组装图纸中予以规定。当有 UL 强制要求时,敷形涂
覆
应当
由 UL 批准以供使用。设计师应该认识到兼容性问题。敷形涂敷通常不需要施加在没有电气导体的表面
或区域(见 IPC-2221)。
敷形涂敷可能为五种类型中的任意一种,建议的厚度范围如下:
1)丙烯酸树脂(AR) – 0.03 mm 至 0.13 mm
2)环氧树脂(ER) – 0.03 mm 至 0.13 mm
3)聚氨酯树脂(UR) – 0.03 mm 至 0.13 mm
4)硅树脂(SR) – 0.05 mm 至 0.21 mm
5)对二甲苯树脂(XY) – 0.01 mm 至 0.05 mm
所有敷形涂覆类型提供了不同级别的防护,以防止来自溶剂、湿气、腐蚀、电弧及其他危及电路工作的环境因素。
较厚的敷形涂覆也可用作防冲击和振动的阻尼介质。这种形式的应用在低温漂移期间会给玻璃和陶瓷密封元件
带来机械应力风险。使用这种材料可能需要缓冲材料。
应该注意防止用敷形涂覆材料对 BGA 底部填充。相关测试表明当用敷形涂覆材料对 BGA 底部完全填充时(对
二甲苯树脂除外),由于 Z 轴方向上的膨胀,焊点疲劳失效会在热循环测试中发生。
A
A
B
IPC-7095d-7-21-cn
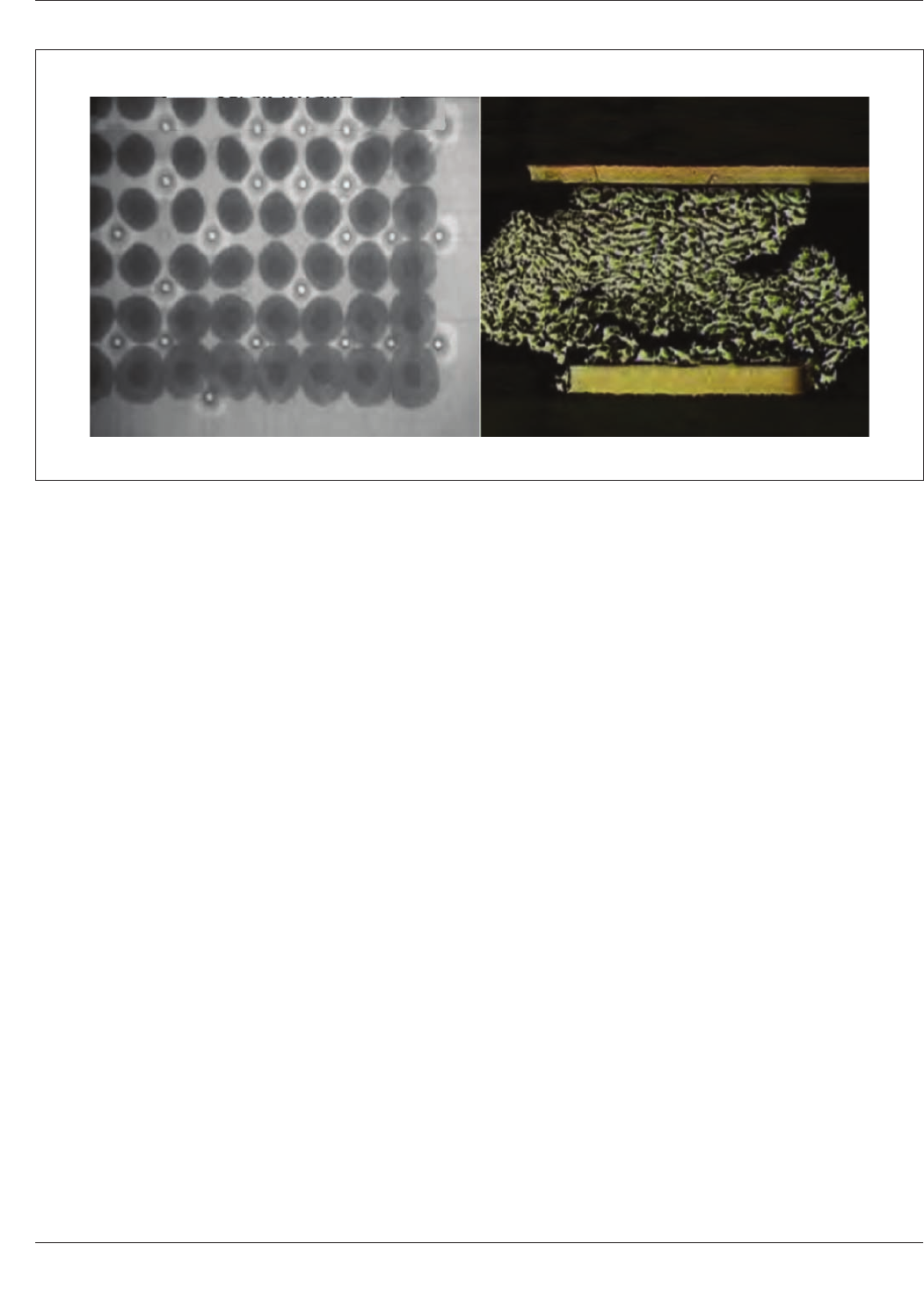
IPC-7095D-WAM1 CN2019 年 1 月
105
不要将敷形涂覆用作底部填充,如果错误地将敷形涂覆用作灌封材料,焊点会严重变形,导致失效。(见图 7-22)
AB
IPC-7095d-7-22-cn
图 7-22 敷形涂覆使用不当的影响
A –X 射线图像
B – 金相图
敷形涂覆不应该与密封材料相混淆。密封剂作为芯片元件封装的一部分,主要用来保护裸芯片。塑料密封剂为
BGA 提供外部防护。密封材料和散热涂层的兼容性问题是非常相似的。
敷形涂覆的具体内容,参见 IPC-CC-830 和 IPC-HDBK-830。
7.2.2 底部填充和粘合剂的使用
BGA 可能需要使用粘合剂以进一步加强封装和板间的互连。无铅焊料的实施
和节距的减小造成封装结构更脆弱,特别是那些受冲击和弯曲的区域。较小电子装置的终端用户携带机会多同时跌
落机会也多,导致对冲击和跌落有更多的规范要求。因为这些因素,底部填充和结构粘合在电子封装中十分常见。
BGA 封装的聚合物增强材料应用的市场诸如:手持式设备、医疗电子、航空电子和军事用途。
增强 BGA 与板间互连的三种最常使用的聚合物方法有:全毛细流底部填充、部分毛细流底部填充和角落施加
粘合剂。不流动底部填充技术正在研发之中,但这种方法的应用在大批量制造中还没出现。一些研究表明,
相比于没有聚合物增强的封装,能看到在代表性的封装上应用底部填充的抗冲击和弯曲性能改善大约 100%-
200%。BGA 的聚合物增强比其它已尝试过的许多方法都更好(如较大的连接盘尺寸、金属限定连接盘、改变
连接盘形状等)。
形状因数(即 BGA 本体尺寸和/或焊球节距)不是采用聚合物增强的主要决定因素。BGA 元器件使用的细分
市场类型,对于决定需要角落点胶还是在底部填充更关键。产品设计人员必须要确定产品是否需要对 BGA 进
行额外的机械保护以满足特定市场的可靠性要求(例如冲击、弯曲、振动、跌落、温度循环等)。
图 7-23 表示一些典型类型粘合方式的概念图,它针对代表性电子产品的设计寿命叠加了可靠性要求。该图将
这些参数分组为三种不同的粘合方式。
1)高性能底部填充(图 7-23 中亮蓝色阴影)
2)工艺导向的底部填充(图 7-23 中紫色阴影)
3)角落施加粘合剂(图 7-23 中红色阴影)
图 7-23 中绿色阴影表示没有粘合剂。