IPC-7095D-CHINESE NP 2019.pdf - 第164页
IPC-7095D-W AM1 CN 2019 年 1 月 148 8.2.1 锡银铜( SAC )对锡铅 BGA 焊点的热疲劳裂纹生长机理的比较 与 SAC BGA 焊点相比,共晶锡铅焊 点在热疲劳测试(如温度循环)期间形成不同的损伤机理。 图 8-1 显示了由于热疲劳引起的焊料微观结构变化。在 此疲劳中 , BGA 经受了热循环疲劳 ( -55 ° C 至 125 ° C 的循环 500 次) ,导致焊点以 X 图形状微观结构明显粗…

IPC-7095D-WAM1 CN2019 年 1 月
147
8.1.5.2 瞬时弯曲
瞬时弯曲(或挠曲),表征为应变相对较慢的低频次挠曲(典型为 1 至 10 次挠曲事件)。
这些事件可由制造过程诱发,特别是:
• 测试装置中诸如使用弹簧型探针的 ICT 或 FT
• 连接器插入时
• 用螺丝将印制板拧入机箱时
• 次级组件的模块化组装(支架系统)时
瞬时弯曲也会发生在元件维修、运输以及终端使用环境中。如同冲击一样,这些失效典型地发生在互连界面中,
并会引起完全开路,或是因为部分断裂而在现场最终完全开路的潜在现场风险。
8.1.5.3 循环弯曲
循环弯曲的特点是含有数千甚至更多次数的事件但应变级别相对较低。这些事件通常由重
复性的动作导致,如键盘动作、触摸屏导航,运输和连接器插入或拔出(例如笔记本接口)。随着时间推移,
疲劳失效可能会出现。
8.1.5.4 振动
振动的特点是持续小幅度位移同时频率相对较高(相比于 8.1.5.1 至 8.1.5.3 中描述的其它机械
应力)。当 BGA 靠近振动子系统(如电机、风扇或者硬盘驱动器)时,振动会对它产生影响。如果互连系统
所承受的应力达到界面断裂点时,振动可能会加剧这种问题而导致电气开路;但是,这种失效的机理还没有搞
清楚。
8.1.5.5 持续加速
在某些应用中,可能会对带有 BGA 互连的印制板施以持续加速。施力可能是线性的或旋
转的。持续的加速可以认为是对 BGA 器件相对于印制板持续施力。这可能是:
• 把 BGA 压入印制板
• 把 BGA 拉离印制板
• 推 / 拉 BGA 发生任何维度的偏离
该作用力可以通过 BGA 器件的加速度和质量来计算。持续加速可通过测试来模拟,包括施加实际加速度的机
制或在 BGA 互连上持续施加适当的作用力。
8.2 焊料连接的损伤机理和失效
电子组件的可靠性取决于要素间热、机和电气界面(或连接)的各个要素
可靠性的总和。表面贴装焊接互连,是互连界面类型中的一种但又是独特的,因为这种焊点不仅提供了电气互
连,而且也是电子元器件到印制板之间唯一的机械连接,它通常也提供关键的热传递功能。单个焊点没有所谓
的可靠或者不可靠,只有在具体应用背景下才有这种评估。
元器件、基板和焊点这三要素的特性加上使用条件、设计寿命和可接受故障概率决定了表面贴装焊接互连的可
靠性。
使用无铅焊料时有些额外的考量。与锡铅焊料相比,大部分无铅焊料的一般特性包括:
• 显著增加的合金刚度
• 显著降低的蠕变速率
• 较困难的适度延展
• 显著上升的焊接温度
较大的刚度或较低的延展性以及较低的蠕变速率导致的后果是,当温度变化时对整体焊接结构产生的较大应
力。这会导致 CTE 不匹配,或印制板 / 元器件翘曲或弯曲。这些较高的应力,加之焊料到基材连接强度薄
弱(由于不充分润湿或界面结构薄弱),可能会导致界面脆性失效。
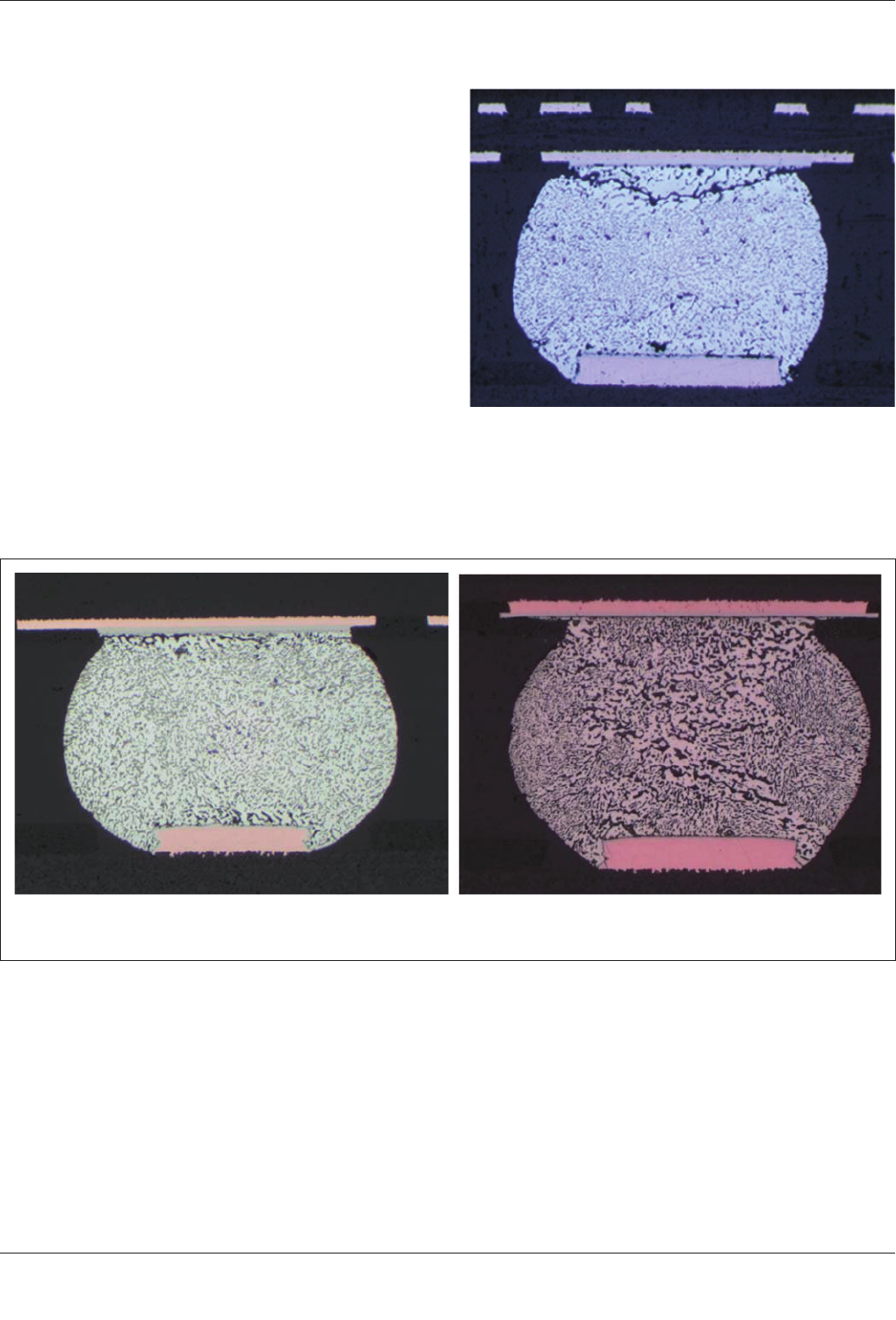
IPC-7095D-WAM1 CN 2019 年 1 月
148
8.2.1 锡银铜(SAC)对锡铅 BGA 焊点的热疲劳裂纹生长机理的比较
与 SAC BGA 焊点相比,共晶锡铅焊
点在热疲劳测试(如温度循环)期间形成不同的损伤机理。
图 8-1 显示了由于热疲劳引起的焊料微观结构变化。在
此疲劳中,BGA 经受了热循环疲劳(-55°C 至 125°C
的循环 500 次),导致焊点以 X 图形状微观结构明显粗
化。在理想情况下,由于 CTE 不匹配引起的最大剪切
应力平面将呈 45°角(如图 8-1 所示)。图 8-1 中没有
明显的疲劳裂纹,但如果热循环继续,沿着 45°角的
剪切面之一就会形成裂纹。
图 8-2A 显示了已经经受了热循环疲劳(-55°C 至
125°C 的循环 500 次)的 BGA 在裂纹区域形成了明显
的微观结构粗化,导致焊点疲劳。焊点大部分微观结
构变化不大,主要由于 CTE 不匹配导致元器件焊盘 /
焊点界面的剪切应力。
除了在元器件焊盘 / 焊点界面和印制板焊盘 / 焊点界面
处显示有微观结构粗化,图 8-2B 与图 8-2A 基本相同。它也显示了元器件焊盘 / 焊点界面的疲劳裂纹。裂纹约
为界面宽度的 60%,导致焊点失效。
BA
IPC-7095d-8-2-cn
图 8-2 热循环后的 BGA 显示有疲劳裂纹的裂纹(A)和 粗 化( B)
对于共晶锡铅 BGA 焊点而言,在温度循环过程中,纹理粗化现象发生在由于热膨胀不匹配造成的应变积聚的
焊点区域。这些粗化的纹理比初期固化时的纹理更柔软,并促进了裂纹扩张(见图 8-3)。
当无铅 SAC BGA 焊点受到热循环作用时,会在热机应力较大的区域发生纹理再结晶现象。这些再结晶纹理比
原纹理的尺寸要小且更易发生纹理边界滑动和蠕动变形。这会使疲劳裂纹沿着再结晶区域扩张(见图 8-4)。
图 8-1 由于热机械疲劳导致的焊点裂纹示例

IPC-7095D-WAM1 CN2019 年 1 月
149
8.2.2 混合合金焊接
混合合金 BGA 的焊接是不想出现的情况,但偶尔可能有必要在同一块印制板组件上用
锡铅或无铅焊料焊接锡铅和无铅 BGA。最可能的情况是使用锡铅焊料来焊接无铅 BGA。这种情况经常发生在
供应商获得无铅 BGA 比处于替代品的锡铅 BGA 更有利,此时锡铅 BGA 组件生命周期已结束,或重新设计不
能实现的情况下。当面临这种情况时,有以下几种选择:
• 拒绝生产印制板组件
• 用锡铅焊球对 BGA 植球(可能不会被所有公司接受)
• 说服供应商提供锡铅版本的 BGA
8.2.2.1 采用无铅温度曲线再流焊料
研究表明,SAC 焊料中含铅重量小于 20% 的均质污染并不会降低疲劳
寿命至低于锡铅焊料。对混合合金组件,建议进行足够的可靠性试验(如切片、热循环或冲击测试)以确认焊
点在预期使用环境中的可靠性。
在焊接之前,应评估混合合金(使用锡铅焊料焊接无铅 BGA)印制板上所有元器件的无铅焊接工艺兼容性。
这项评估要确保所有元器件在暴露于无铅焊接温度后,证实它们继续有可接受的可靠性。尽管大部分锡铅元器
件标明 230°C 的峰值温度,有证据表明许多锡铅元器件在暴露于无铅焊接温度后保持可接受的可靠性,但并
不总是这种情形。再次强调,应该进行足够的可靠性试验来确认预期的可靠性。
8.2.2.2 采用锡铅曲线再流焊
当组件同时由无铅 SAC BGA 和 SnPb BGA 组成和 / 或当印制板还没有转化为
无铅系统,或者不要求成为无铅系统时,锡铅共晶焊膏仍旧需要使用。
在这种的情况下,必须要采用有足够的峰值温度、保温时间和适当的预热温度的锡铅共晶再流焊温度曲线。章
节 7 关于此情况提供了更多细节。
8.2.2.3 低银 SAC 和非 SAC BGA 焊球合金的 BGA 实施
在业界早期无铅转换阶段,所用的 BGA 焊球合金
与典型的 Sn9Ag3.0Cu0.5(SAC305), SnAg3.8Cu0.7(SAC387)或 SnAg4.0Cu0.5(SAC405)组装工艺合金相
匹配。但易受机械冲击和热应变等问题已促使 BGA 供应商开始评估并建议采用其它合金的焊球。
对于某些封装,涉及的变化是银含量从 3%-4% 降至 1%-3%。取决于具体的银含量,银含量降低后会使焊球熔
点增加多达 10°C,这对于组装工艺有极大的负面影响。当 BGA 采用新合金并对具有新合金的 BGA 进行组装
时必须特别小心。
在 SAC 系统中添加掺杂元素在某些机械性质方面得到了改善。但是,这种添加物并不大大改变其物理性质,
也不降低该合金熔点。一些掺入元素可能会影响焊料过冷度,晶格性质以及金属间化合物的形成。
图 8-3 陶瓷球栅阵列(CBGA)模块中共晶锡铅焊点
的热疲劳裂纹扩张
A
B
图 8-4 陶瓷球栅阵列(CBGA)模块中 SnAg3.8Cu0.7
焊点的热疲劳裂纹扩张
A– 终止 B– 裂纹