IPC-7095D-CHINESE NP 2019.pdf - 第125页
IPC-7095D-W AM1 CN 2019 年 1 月 109 7.2.2.2 角落施加粘合剂 角落施加粘合剂(也称作角 落点胶、角落粘合或角落粘着)是一种仅在 BGA 角落 和 / 或外部边缘施加胶水的方法 。该理论认为通过增 强处于应力最大的封装区域 (离封装中心最远处的焊 球) ,封装性能会得到改善。 角落施加粘合剂改善封装性能不如传统的完全毛细流 底部填充那样多 ,但往往所获得的优势是明显的并足 以满足市场要求 。角落施加粘…
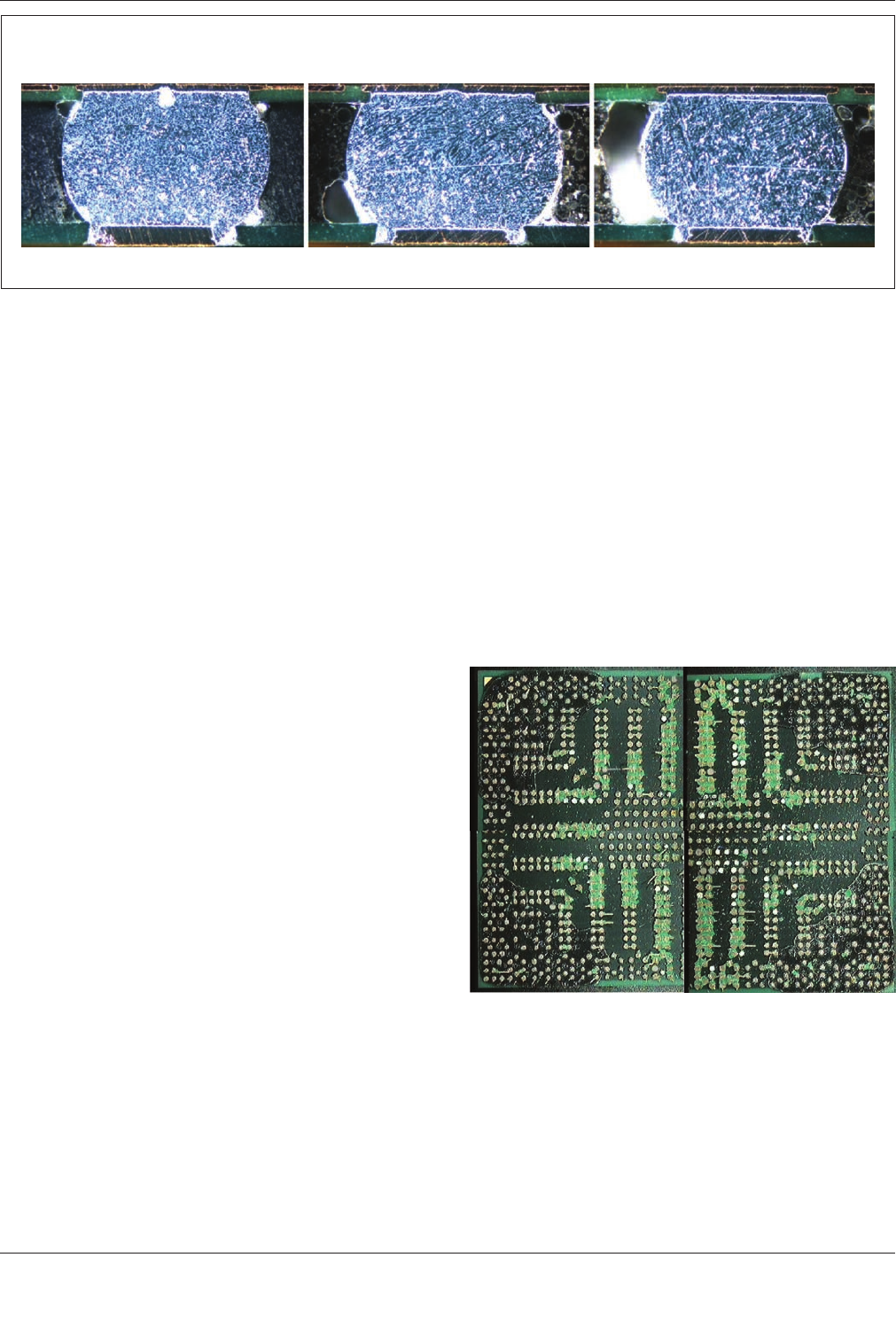
IPC-7095D-WAM1 CN 2019 年 1 月
108
图 7-26 底部填充中空洞的示例
A–(左)小空洞
B–(中)中等空洞
C–(右)大空洞
为了达到最好的底部填充性能,需要有适当的填充高度。在大多数应用场合,沿封装侧面向上至封装中心线之
间有 25%-100% 的填充,被认为是可以接受的。
围绕需要底部填充的 BGA 周边,对其它器件和开窗导通孔的隔离是必要的。隔离的保守规则是:在 BGA 封
装的非分配边,从印制板表面至 BGA 基板正面高度的 1.5 倍,在 BGA 分配边为 6mm。
底部填充封装要在炉中固化。对这些板子进行固化的一种合适的方法是使用标准 SMT 再流焊炉,将温度设定
低于正常再流温度让板子单次通过炉子。许多底部填充化学品在 120°C-165°C,运行 5-20 分钟即可固化,这
种性质有利于单次通过炉子的方法。固化也可用离线再流焊炉,也可获得可在较低温度下固化且固化时间较短
的底部填充配方。
从历史上来说,大批量生产环境下底部填充环氧树脂
一直是不可返工的。这对最初的一些设备例如早期手
机是可接受的,因为其印制板组件成本相对较低,报
废一些组件不会带来显著的成本增加。但是,如今底
部填充已进入高端市场。所以,底部填充剂供应商正
在研发能在大批量生产环境下便于返工的化学材料。
部分或仅角落底部填充是在 BGA 封装角落附近,通过
点状或“L”形模式分配底部填充剂来完成的。流入的
底部填充剂大致呈圆弧状并裹住各个角落中的几个焊
球。图 7-27 显示了从组件拆除后的 BGA, 能看到角落
的黑色填充。
这种方式与完全底部填充相比的优点是:所使用底部
填充材料大为减少且底部填充材料流动时间也显著减
少,这有助于提高与分配工序相关的生产率。如所预计的一样,部分或仅角落底部填充没有像完全底部填充那
样有很大的强度改善;但是,在许多情况下,部分底部填充所带来的性能提升已足够满足市场对封装 / 印制板
保护的要求。(一项实验案例表明,部分角落底部填充 BGA 对比于未经过填充的相同 BGA,耐受机械损伤持
续发生的抗冲击水平上提升 1.5 倍,这是非常显著的)。
一些移动电脑主板制造商使用部分底部填充材料来加强主板上的 BGA 强度。
ABC
IPC-7095d-7-26-cn
图 7-27 部分底部填充示例
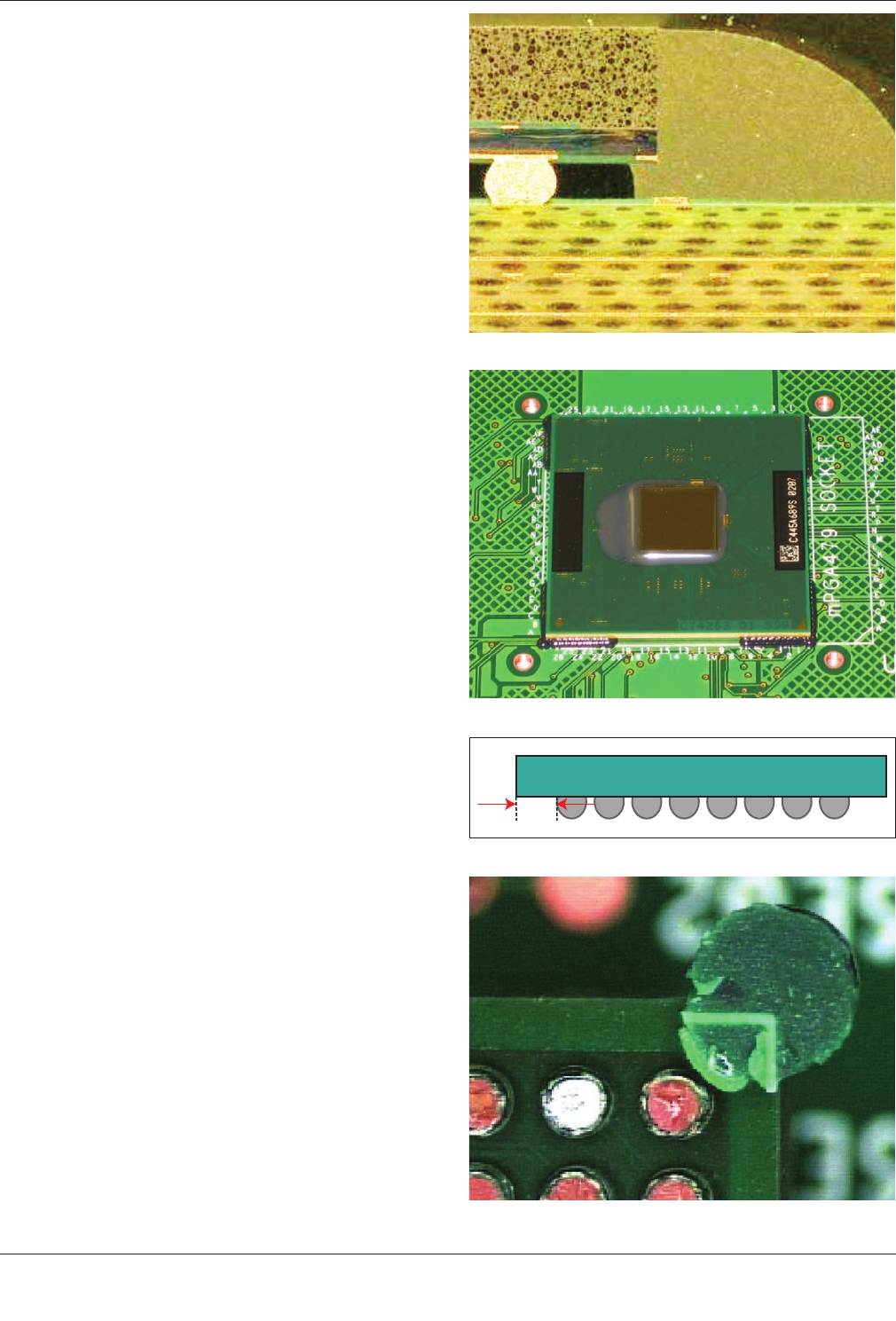
IPC-7095D-WAM1 CN2019 年 1 月
109
7.2.2.2 角落施加粘合剂
角落施加粘合剂(也称作角
落点胶、角落粘合或角落粘着)是一种仅在 BGA 角落
和 / 或外部边缘施加胶水的方法。该理论认为通过增
强处于应力最大的封装区域(离封装中心最远处的焊
球),封装性能会得到改善。
角落施加粘合剂改善封装性能不如传统的完全毛细流
底部填充那样多,但往往所获得的优势是明显的并足
以满足市场要求。角落施加粘合剂方法已被广泛应用
于高机械性能要求(如冲击、振动和弯曲)的大尺寸
BGA(20×20mm 至 45×45mm)。移动电脑主板市场
也符合这种情况。
图 7-28 显示了角落施加粘合剂的 BGA 显微剖切。图
7-29显示采用角落施加粘合剂连接的BGA封装的照片。
角落施加粘合剂可以在 BGA 封装放置和再流焊之前
直接施加到印制板上或在再流焊之后施加到已组装的
BGA 封装上。再流焊前进行角落施加粘合剂要求 BGA
封装在焊球最外排的最后一个焊球的外部边缘有足够
基板空间(见图 7-30)。
预先施加角落粘合剂于基板的最小可用宽度大约需
0.7mm。若封装基板的宽度小于该值,此工艺在大量生
产环境下就无法受控。随着封装基板尺寸持续缩减,
预计在再流焊之前对角落点胶的做法也将会减少。
组装和再流焊后角落施加粘合剂的有效性取决于所选
择的粘合剂类型和与每个角落接触的总表面积。涂覆
量从每个角实质上的单点变化到粘合剂通过“L”形支
架在角落的每一侧沿着封装边缘向下延伸多达六个焊
球。较长的“L”型分配支架可以显著地改善机械可靠
性。例如,一项研究表明了冲击性能的改善,造成机
械损伤开始发生的加速度水平从 180G 增至 300G。
施加在每个角落比较好的粘合剂起点量应该是,沿
“L”型支架的每条边向内应延伸至 3 到 6 个焊球的深
处。角落粘合的一大隐患是使用的胶水量太少而使覆
盖表面不够。测试表明,沿基板一边不超过一个焊球
宽度的单点粘合剂覆盖并不会显著增加 BGA 冲击或弯
曲方面的性能。这是因为通常情况下,阻焊膜与下面
的 FR-4 材料或 BGA 基板的接合强度较低,如果角落
施加粘合剂的表面区域太小,这样的结构将很容易发
生裂纹。
图 7-31 显示粘合剂区域过小导致的角落施加粘合剂在
冲击后的典型失效模式。可以看到,从印制板组件剥
离的阻焊膜并没保护到焊点。
图 7-28 角落施加粘合剂的 BGA 显微剖切图
图 7-29 角落施加粘合剂的 BGA 顶视图
图 7-30 再流前角落施加粘合剂的关键尺寸
图 7-31 角落施加粘合剂典型的失效模式
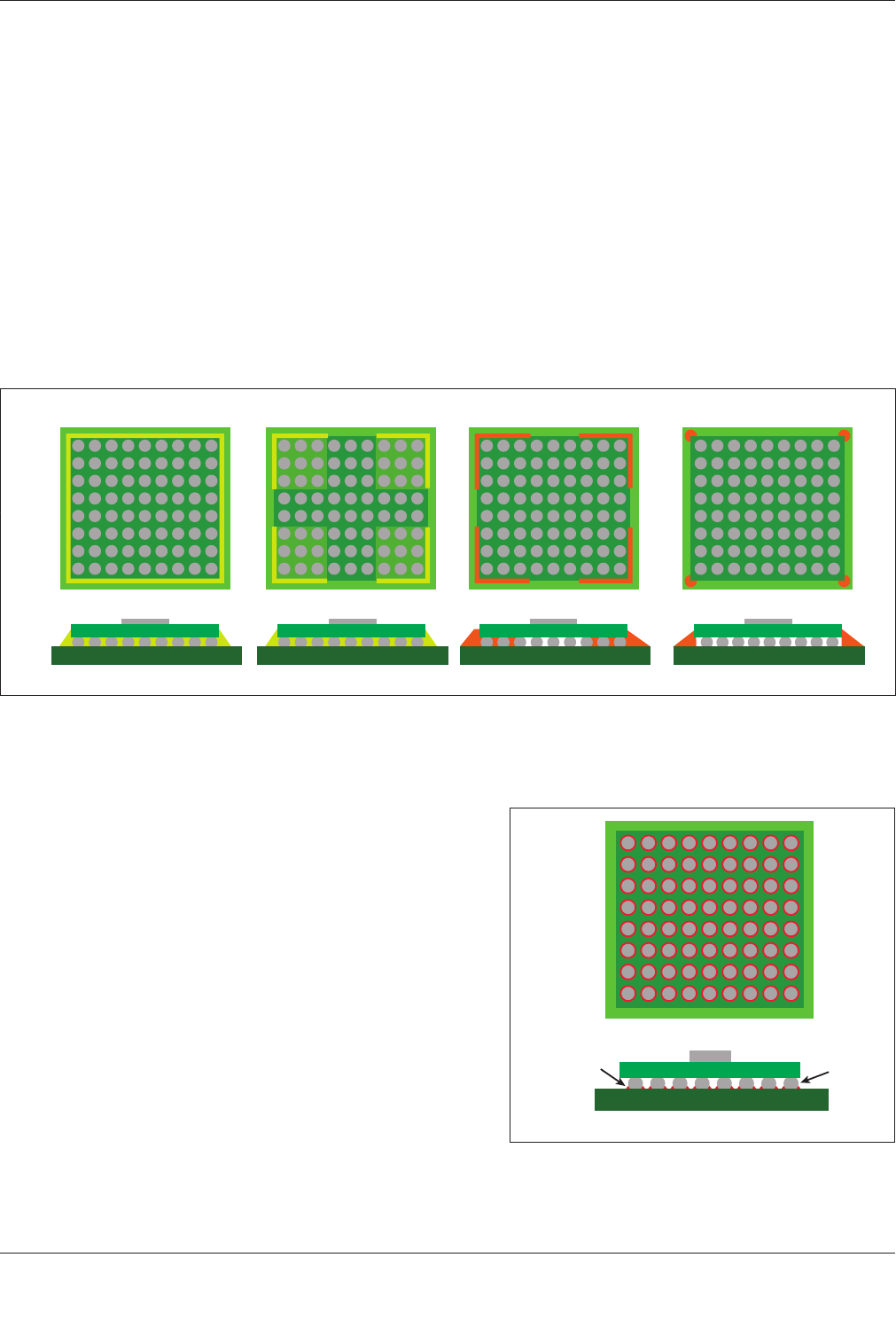
IPC-7095D-WAM1 CN 2019 年 1 月
110
角落施加粘合剂的其它准则:
• 粘合剂的整个涂敷线平均应该润湿封装基板垂直边至少达到 50% 以上。
• 即使环氧树脂向内流动到足以接触到某些焊球,也应该强制环氧树脂材料在 BGA 封装底部流动到一定深度。
• 再流焊后角落施加粘合剂的典型分配设备包括给注射器和针头装置提供空气的气动源。这种设备成本低,适
宜于人工费率低于可用资产的制造环境下配置。
• 角落施加粘合剂是类似于底部填充材料的环氧树脂。典型的固化周期是 60°C-180°C 温度下保持 5-60 分钟。
也可获得 UV 光固化版本。
7.2.2.3 焊点密封材料(SJEM)
面阵列元器件,特别是那些微处理器、存储器和芯片组,有持续小型化的趋
势。面阵列元器件(如 BGAs、CSPs 和 WLPs)尺寸的减小意味着焊点尺寸的减小。当经历振动和冲击下的机
械应力暴露以及经历温度和功率循环下的热机械应力时,这就导致需要加强它们的稳健性。此外,这些焊点在
现场经受的温度很高,因此有必要配置面阵列焊点增强聚合物以降低焊点在现场失效的风险。
图 7-32 提供了 BGA 焊点聚合物增强四种类型的顶视和截面视图。
A
B
CD
EF
IPC-7095d-7-32-cn
图 7-32 BGA 焊点聚合物增强四种方法的示例
A– 顶视 C– 完全底部填充 E– 边缘粘合
B– 截面(印制板位于底部而 BGA 封装位于顶部) D– 部分底部填充 F– 角落粘合
焊点密封材料(SJEM)(也称作助焊底部填充,环氧树脂助
焊剂或聚合物助焊剂)可以用作一个替代方案,来解决底部
填充和边缘及角落施加粘合剂的一些弊端。
图 7-33 显示了施加和固化后的 SJEM 顶视和截面原理图。
SJEM 部分或完全覆盖 BGA 的每个焊点,在与焊点、印制
板层压板和阻焊膜的接触区域形成粘合键合,这种粘合剂键
合和固化后 SJEM 的粘合强度一起形成了由 SJEM 提供的焊
点增强的基础。
在 BGA 焊点应用中,SJEM 明显比底部填充或角落粘合提
供了更多灵活性。BGA 在贴装至印制板前,可以浸入 SJEM
的贮槽中,类似于为 PoP 组装施加粘性助焊剂。SJEM 可在
BGA 贴片前分配或喷射到印制板上或直接丝网印刷至连接
盘。值得注意的是,对于不同的施加方法,SJEM 的触变性
需要优化。
D
A
B
C
IPC-7095d-7-33-cn
图 7-33 焊点密封材料(SJEM)
A– 顶视
B– 截面(印制板位于下
部而 BGA 封装位于上
部)
C– SJEM
D– 焊点