IPC-7095D-CHINESE NP 2019.pdf - 第101页
IPC-7095D-W AM1 CN 2019 年 1 月 85 图 6-42 使用卡构连接 BGA 的散热片 A– 卡钩 C– 硅脂 / 凝胶 / PCM相变材料 E– 印制板 B– 散热片 D–BGA 图 6-43 展示了通过卡钩固定在印制板孔内并与 BGA 进行连接的散热片。这些小孔不需要电镀处理。与前面的 情况不同,当卡钩作用时印制板会支撑散热片的重量,但在机械冲击和振动过程中依然会有一些应力传递到焊 球上。另外,当组件垂直放置…

IPC-7095D-WAM1 CN 2019 年 1 月
84
6.7.4.2 硅脂
导热硅脂是一种金属填充聚合物,它具有粘性液体的固有优势而能适应 BGA 元器件和散热片
间宏观和微观不规则性表面。与粘合剂不同它们具有优异的散热性能且不需要固化。导热硅脂的主要缺点在于
随着时间的推移它们有从散热片和封装之间流出的趋势。这种现象被称为“泵出”,是由温度循环期间作用于
粘合界面的机械热应力导致的。
6.7.4.3 相变材料(PCM)
相变材料(PCM)室温时为固态,但当 BGA 表面导热时温度升高而转变为液态。
因为它们通常呈薄膜形态且不需要固化,所以操作和添加比较方便。但它们的热传导性质比导热硅脂、粘合剂
和其它 TIM 替代品要差,故它们只适合在低功率器件上使用。
6.7.4.4 凝胶
凝胶由轻交联的硅聚合物组成,并填充金属或陶瓷颗粒以实现 TIM 应有的热导率。凝胶结合了
导热硅脂和固化粘合剂两者的优点,不会泵出也不需固化作业。凝胶的模量较低减轻了热机应力而避免连接界
面的分层。它们有较高的体积热导率,已应用于 BGA 包括高功率 CPU 器件的冷却。
6.7.4.5 导热压敏带
导热压敏带偶尔可以用来提供 BGA 散热所必要的热导率。这种 TIM 操作方便只要将其
粘贴在需冷却的 BGA 元器件表面即可。
6.7.5 BGA 散热片连接方法
有若干种散热片连接至 BGA 方法,在本章节以插图来说明。
图 6-41 展示了用导热胶连接 BGA 封装顶部的散热片。这种粘合剂可同时起到热传导媒介和机械连接媒介的作
用。这种技术需要焊接后的热固化以实现粘合剂交叉连接和硬化的目的。
C
B
D
A
IPC-7095d-6-41-cn
图 6-41 使用粘合剂连接 BGA 的散热片
A– 散热片
B– 粘合剂
C– BGA
D– 印制板
图 6-42 显示了通过卡钩固定在 BGA 基板并与 BGA 封装顶部相连的散热片。这种方法的 TIM 采用的是导热硅
脂,PCM 或凝胶(即不需要在散热片和 BGA 封装顶部之间提供较强的机械连接的一种方法)。
这种方法有两个缺点:
1) 散热片的重量由封装所承担
,在机械冲击和振动过程中,焊球需要经受住散热片附加质量所产生的机械
应力。
2)安装卡钩时对焊点有造成损伤的风险
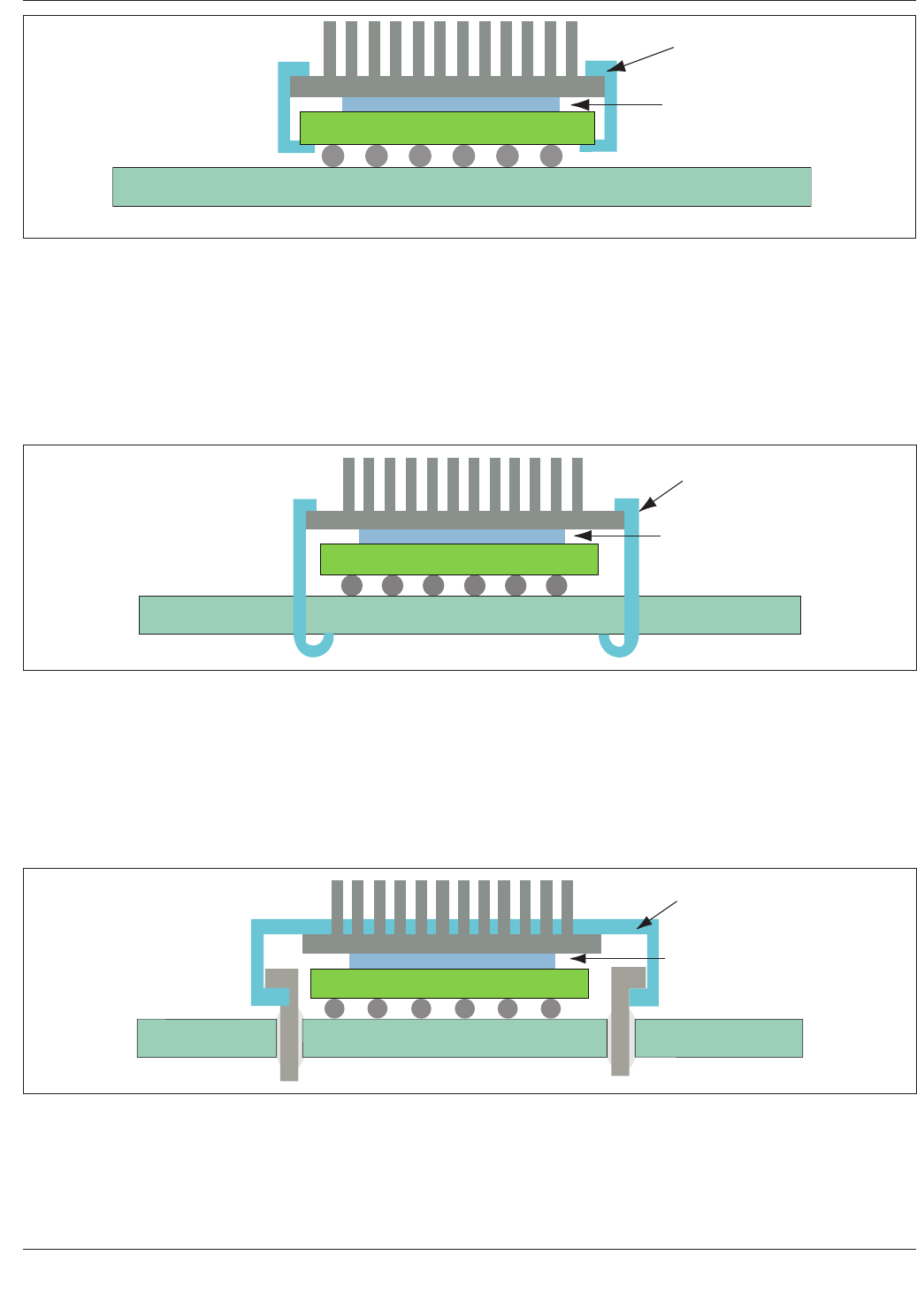
IPC-7095D-WAM1 CN2019 年 1 月
85
图 6-42 使用卡构连接 BGA 的散热片
A– 卡钩 C– 硅脂 / 凝胶 / PCM相变材料 E– 印制板
B– 散热片 D–BGA
图 6-43 展示了通过卡钩固定在印制板孔内并与 BGA 进行连接的散热片。这些小孔不需要电镀处理。与前面的
情况不同,当卡钩作用时印制板会支撑散热片的重量,但在机械冲击和振动过程中依然会有一些应力传递到焊
球上。另外,当组件垂直放置时散热片会对焊点产生悬臂荷载,此荷载会使焊点失效早期发生。
C
E
B
D
A
IPC-7095d-6-43-cn
图 6-43 用勾住印制板孔的卡钩,连接 BGA 的散热片
A– 卡钩 C– 硅脂 / 凝胶 /PCM 相变材料 E– 印制板
B– 散热片 D– BGA
图 6-44 展示了通过卡钩固定由波峰焊接在印制板上的柱子,并将散热片连接在 BGA 顶部。在机械冲击和振动
过程中,这种连接方法传递至焊球的应力比前面方法的更小。但是柱子的焊点需要承受大部分应力。
C
B
D
E
A
IPC-7095d-6-44-cn
图 6-44 用勾住焊接在印制板上柱子的卡钩,连接 BGA 的散热片
A– 卡钩 C– 硅脂 / 凝胶 /PCM 相变材料 E– 印制板
B– 散热片 D– BGA
C
B
D
A
E
IPC-7095d-6-42-cn
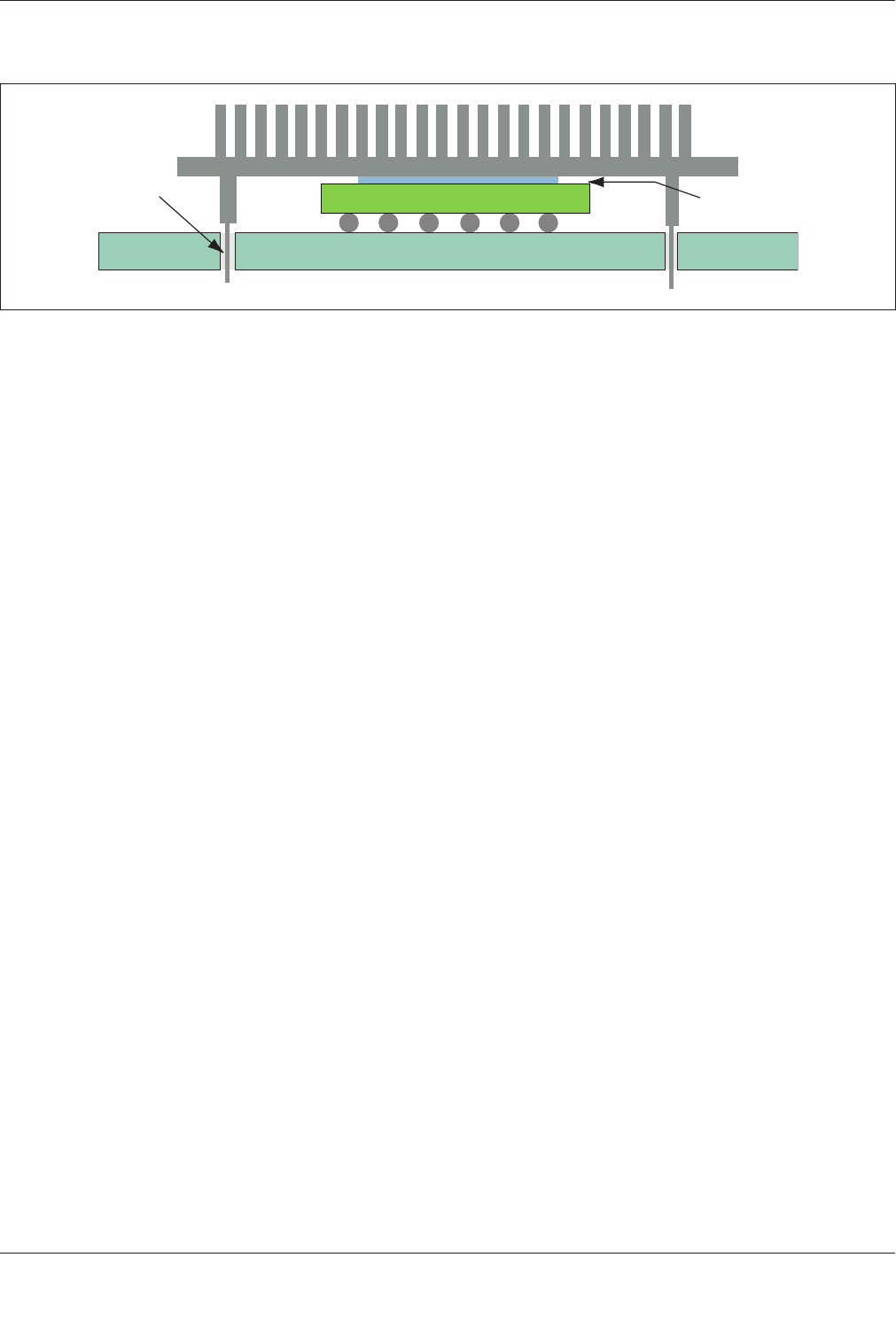
IPC-7095D-WAM1 CN 2019 年 1 月
86
图 6-45 展示了连接 BGA 的散热片直接通过波峰焊接至印制板上。这种散热片设计有 4 个或以上的引脚,在波
峰焊接之前将它们插入印制板的孔内。与前面方法不同的是,这种方法不需要任何组装后加工来连接散热片。
C
B
D
A
IPC-7095d-6-45-cn
图 6-45 将散热片引脚通过波峰焊焊接在通孔中,连接 BGA 的散热片
A– 硅脂 / 凝胶 /PCM
B– BGA
C– 散热片引脚
D– 印制板
图 6-43、6-44、6-45 所示的方法有一个缺点在图 6-41 和图 6-42 所示方法中不会出现,即它们在印制板上需设
计有安装孔,这些孔可能会减少印制板所有层用于布线的空间。对于高密度板设计,这可能会影响印制板最终
需要的层数。
7 BGA 组件
7.1 表面贴装工艺
连接 BGA 的组装工艺比连接密节距外围元器件的组装工艺在某些方面更为宽松,但是在
其它方面要求则更多。制程缺陷率远比外围密节距元器件低,但良好的工艺控制是必要的。
7.1.1 焊膏及其施加
表面贴装组件使用焊膏将 BGA焊球连接到连接盘。焊膏可通过三种方式施加到连接盘上:
1)丝印(很少使用)
2)模板印刷
3)点涂(仅用于特定应用)
对于 BGA 组件,通常用模板(用于维修的点涂)通过开孔将焊膏印刷在 BGA 连接盘上,模板的开孔尺寸与
BGA 连接盘尺寸相同或稍小。
模板厚度和开孔尺寸决定设计的焊膏量,焊膏量对于某些 BGA 类型的焊点可靠性是至关重要的。刮刀类型和
工艺参数设定会影响沉积的焊膏量。使用较密节距 BGA 元器件时需要减小模板厚度;但减小模板厚度时需要
特别小心,不要使其它元器件的焊膏量过少。
焊膏由金属粉末颗粒和助焊剂均质混合而成。焊膏的金属含量(约占总质量的 90%)决定了焊点中的焊料量。
最常见的焊膏合金是共晶 SnPb37 和无铅合金 SnAg3Cu0.5(SAC305)。金属粉末颗粒通常为球状。形状均匀的
颗粒有助于印刷或点涂工艺且可通过减小表面积来减少氧化。
助焊剂占了焊膏剩余成分的绝大部分。助焊剂中的活化剂可将氧化物从焊料颗粒、连接盘和 BGA 焊球中清
除,它们也提升了再流焊过程的可焊性。由于多种原因,再流过程中的外来焊球通常是可靠性所关心的问题,
特别是涉及密节距器件时。溶剂对于控制焊膏的粘性有重要的作用,并且会影响流变性质。BGA 焊点中空洞
的形成与焊膏中的溶剂有关。低沸点的溶剂和 / 或不正常的再流参数会使 BGA 焊点中空洞的发生率增加。
为了成功印刷 FBGA,焊膏必须能透过模板上极小的开孔。焊膏需要在一定的时间内保持可印刷性和粘性,同
时必须在再流焊之前或期间保持印刷焊膏的清晰度。焊膏粘度、颗粒大小和模板寿命是施加焊膏时的关键参数。