IPC-7095D-CHINESE NP 2019.pdf - 第144页
IPC-7095D-W AM1 CN 2019 年 1 月 128 点可靠性。收缩空洞可以通过增加焊接过程中的冷却速率和避免凝固时对焊点的扰动而使其最小化。从根本上 说,这些收缩空洞是表面裂纹,不会产生任何可靠性问题。 7.5.3.4 微导通孔空洞 微导通孔空洞由印制板连接盘上设计有微导通孔导致。如果它位于封装高应力区域的 焊点中,较大的微导通孔空洞会影响焊点可靠性。通过电镀将微导通孔封闭或者通过两次印刷用焊膏完全填塞 微导通孔,可最小…
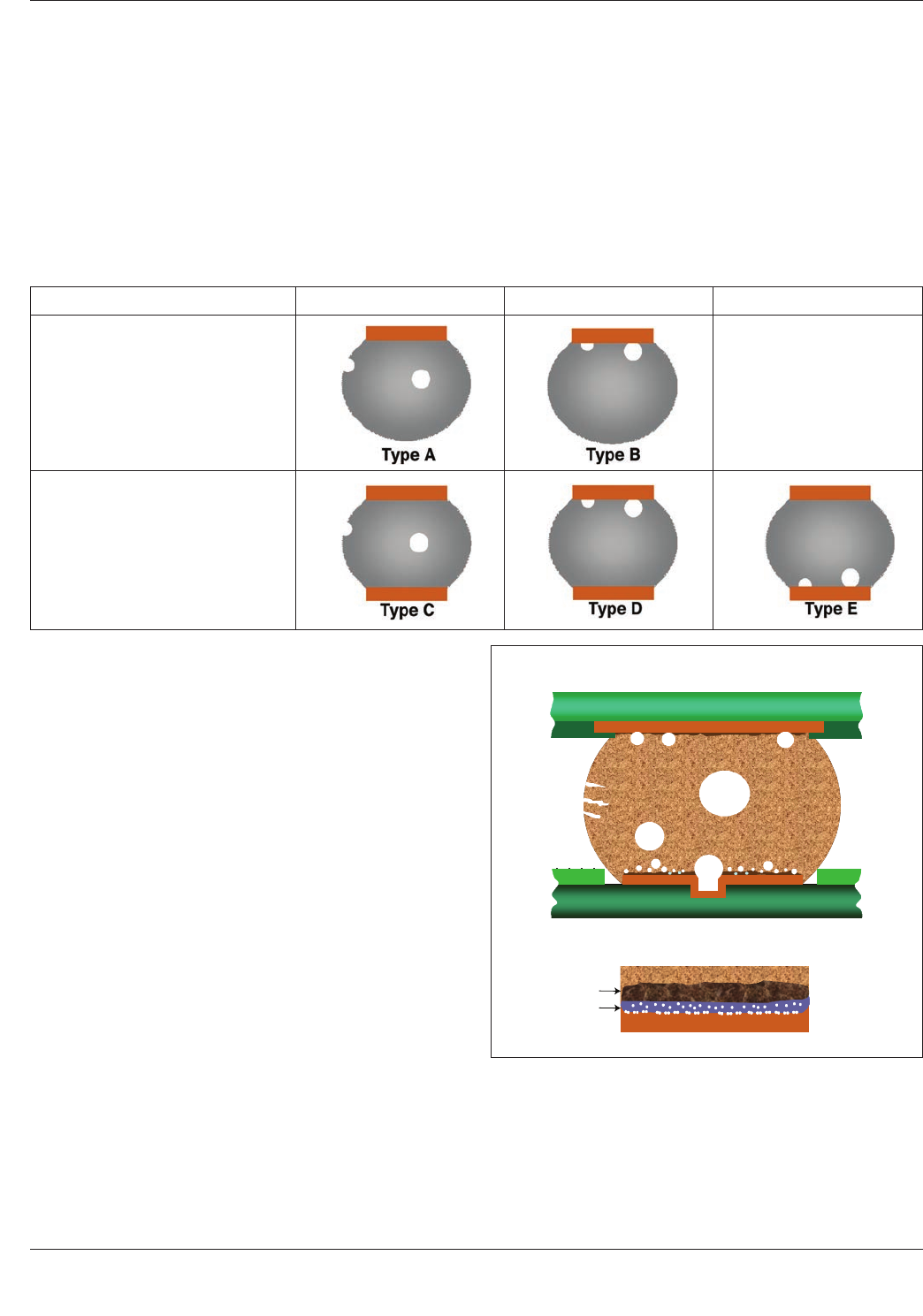
IPC-7095D-WAM1 CN2019 年 1 月
127
7.5.2 空洞的分类
为了评估不同情况,基于空洞的位置给予了特定的类别码,以建立空洞的识别方法和为工
艺改进采取纠正措施的可能性。表 7-10 给出了细节以及显示了 BGA 焊料球结构中的空洞位置分类标准。
以下说明如何识别五种不同类型的空洞:
类型 A:收料时焊球中的空洞(封装级)
类型 B:收料时焊球 / 封装基板界面的空洞
类型 C:在板级组装后焊球中的空洞
类型 D:在板级组装后,焊球 / 封装基板界面的空洞
类型 E:在板级组装后,焊球 / 产品基板界面的空洞
表 7-10 空洞分类
空洞分析 焊球内的空洞 封装界面的空洞 安装表面界面的空洞
连接到印制板前焊球内的空洞
类型 A 类型 B
N/A
连接到印制板后焊球内的空洞
类型 C 类型 D 类型 E
7.5.3 BGA 焊点中的空洞
焊点中有六种类型的空洞
得到识别和描述。图 7-65 显示了每种空洞特性,并说
明了这些空洞在 BGA 焊点中的典型尺寸和位置。不
管何时发现焊点中的空洞,首先识别空洞种类以确定
其对焊点可靠性的影响,并评估最小化或消除这种空
洞的纠正措施,参见 7.5.3.1 至 7.5.3.6。
7.5.3.1 大空洞
大空洞是焊点中最广泛出现的空
洞。它们由焊接工艺中产生的挥发性化合物所导致。
这些大空洞通常不会影响焊点可靠性,除非它们出现
在裂纹通常会扩张的焊点界面区域。
7.5.3.2 平面微空洞
平面微空洞是位于印制板连接
盘和焊料界面的、基本处于同一平面的一系列小空
洞。它们是由浸银(ImAg)涂覆连接盘下方的铜凹
坑引起的。它们并不会影响最初的产品质量,但是会
影响焊点长期的可靠性。它们可在表面处理电镀过程
中,通过对浸银电镀溶液、微蚀化合物以及其它关键
工艺参数的持续严格管控来消除。
7.5.3.3 收缩空洞
收缩空洞由凝固过程中的收缩导
致,常见于 SAC 和其它无铅焊料中。它们通常不会出
现在焊料到 PCB 连接盘界面的附近,并且不会影响焊
图 7-65 BGA 焊点内各种类型空洞的典型尺寸和位置
A– 再流焊后的 BGA 焊点
B– 高温老化后的铜金属间化
合物(IMC)焊料界面
C– Cu6Sn5
D– Cu3Sn
1– 大空洞
2– 平面微空洞
3– 收缩空洞
4– 微导通孔空洞
5–IMC 微空洞
6– 针孔空洞
1
1
1
1
1
2
2
2
4
6
6
1
1
1
1
1
2
2
2
3
5
4
6
6
A
B
C
D
IPC-7095d-7-65-cn

IPC-7095D-WAM1 CN 2019 年 1 月
128
点可靠性。收缩空洞可以通过增加焊接过程中的冷却速率和避免凝固时对焊点的扰动而使其最小化。从根本上
说,这些收缩空洞是表面裂纹,不会产生任何可靠性问题。
7.5.3.4 微导通孔空洞
微导通孔空洞由印制板连接盘上设计有微导通孔导致。如果它位于封装高应力区域的
焊点中,较大的微导通孔空洞会影响焊点可靠性。通过电镀将微导通孔封闭或者通过两次印刷用焊膏完全填塞
微导通孔,可最小化这些空洞的形成。
7.5.3.5 金属间化合物(IMC)微空洞
IMC 微空洞发生在铜和高锡焊料形成的 IMC 中,焊料包括 SAC 和锡
铅焊料。IMC 微空洞不会在焊接工艺后立即形成,但会在高温老化后或在焊点热循环期间产生。这种现象发
生的根本原因仍在调查研究中,但是一种名为 Kirkendall 的空洞形成机理可以作出部分解释。这些空洞可以影
响焊点可靠性,特别是在焊点遭受跌落或者机械冲击、IMC 内的脆性裂纹开始出现时。在焊料中掺加某些元
素(如锌),是一种减少这些 IMC 微空洞数量的方法。
7.5.3.6 针孔空洞
针孔空洞是由印制板铜连接盘上的针孔引起的。如果达到足够的数量,它们会影响焊点可
靠性。这些空洞由这些针孔内截留的印制板制造用的化学物质并在再流焊时挥发而导致。针孔的形成是由板制
造商镀铜工艺的偏差造成,可以通过改善镀铜工艺控制系统来消除它。
7.6 空洞测量
7.6.1 X 射线探测和测量注意事项
一些用来检测焊
料空洞的实时 X 射线检测系统(见图 7-66),采用了会
表现为电压过曝或磷过曝异常的 X 射线成像器件。理
论上使用图像增强器或平板探测器的任何系统都会过
曝。但是,配有图像增强器或平板探测器的现代高对
比度 X 射线系统更能提供理想的图像。
如果 X 射线检测系统表现出电压过曝,以下建议有助
于获得较精确的空洞尺寸测量:
• 已发现不受电压过曝影响的 X 射线胶片图像,可提
供空洞尺寸更精确的测定。
• 通过切片或者模拟确定了空洞的实际尺寸,来协调 X
射线源电压与过曝度之间的关联。
• 注:色调质量应该足以看到穿过空洞的导线。
• 电压和电流每次设定,灰阶应当复位至在 120 到 140
之间。对于 1 至 256 灰阶系统,灰阶标准化可维持测
量间的一致性。
7.6.2 空洞的影响
空洞可能通过弱化焊球并降低功能性来影响可靠性,因为横截面积的减少会降低热传递和
载流能力。
较大的空洞更有害,然而事先存在的小空洞在再流焊期间会合并形成大空洞。通常优先考虑消除空洞或至少实
质性地减小空洞。在工艺的开发阶段,应该建立使空洞最小化的工艺控制。
研究已显示中等尺寸的空洞在性能方面观察到有小的增加,这些情况常见于工艺受控时。可靠性的增加起因于
焊点高度的增加和焊点裂纹扩张暂时的、局部的延缓。
需要 X 射线检验来探测 BGA 焊点中的空洞;为确定空洞的影响或其位置和尺寸,切片方法可能是必要的。
低成本设备的原理基于透射 X 射线。与有引线元器件不同,BGA 不仅仅在元器件外围有焊点,而且有无法通
过常规视觉技术能检测到的内部焊点。
图 7-66 带有空洞的焊球 X 射线图像
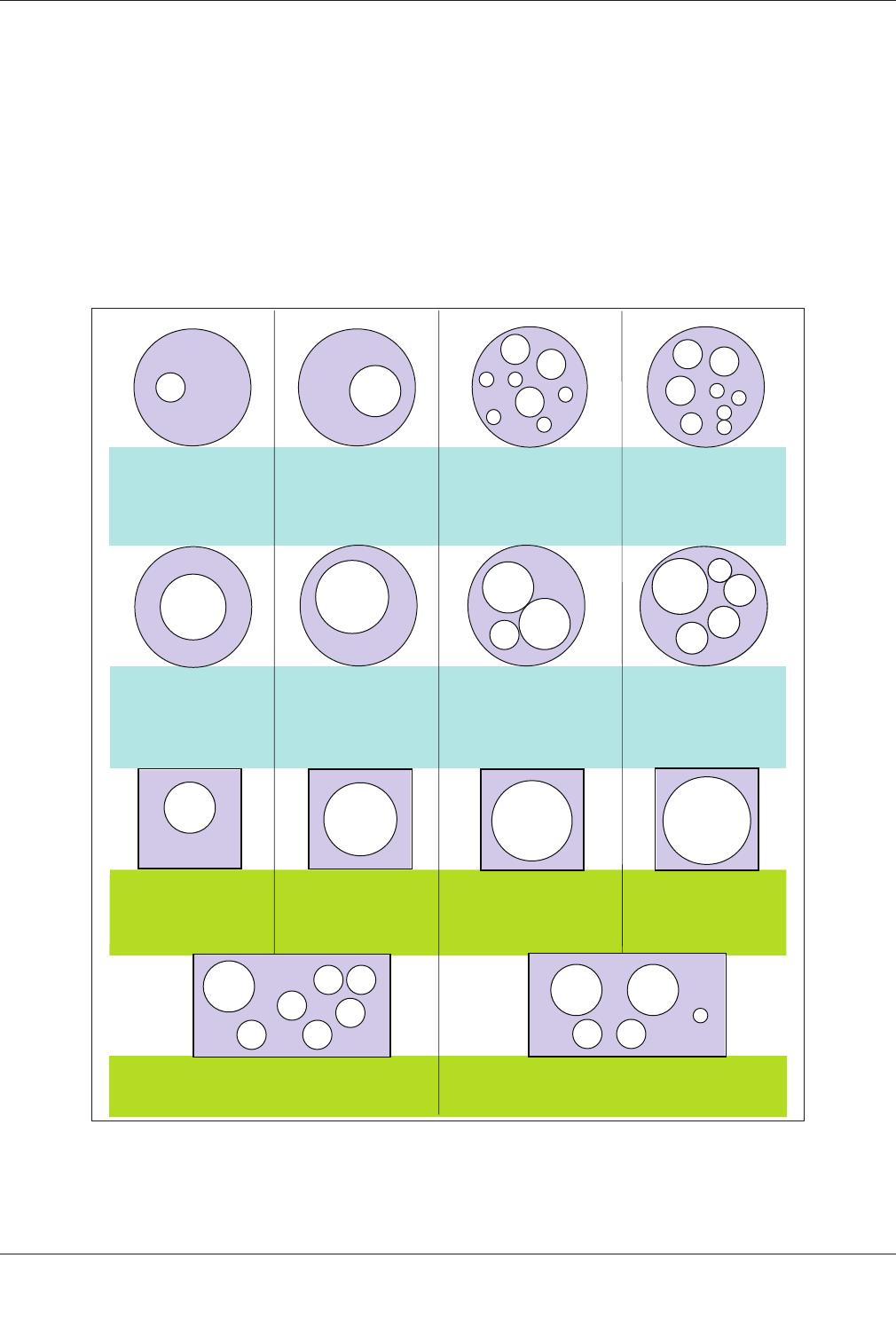
IPC-7095D-WAM1 CN2019 年 1 月
129
高成本设备的原理是基于 X 射线的断层合成成像或分层成像。两种系统都可提供有用的技术以探测和定位空
洞(见 7.3.1 节 )。
生产放行前应该先对可接受空洞的工艺进行鉴定。
7.6.3 空洞协议开发
在许多应用场合,通过受控实验确定项目特性之后,工程团队会建立可允收的空洞协议。
表 7-11 提供了空洞协议的案例,描述了各种连接盘图形下相比于其直径的空洞大小变化。
对于过程控制,空洞面积使用 <35% 作为阈值,空洞直径 <50% 作为阈值。对于拒收 / 返工,空洞面积使用
<45% 作为阈值,空洞直径 <65% 作为阈值。
表 7-11 建议的空洞协议示例
0.635mm连接盘
0.152mm空洞
24%直径
6%面积
0.635mm连接盘
0.330mm空洞
52%直径
27%面积
0.508mm x 0.762mm
0.254mm空洞
50%直径
10%面积
0.508mm x 1.016mm
一个0.254mm空洞及六个0.127mm空洞
0.508mm x 0.635mm
两个0.254mm空洞,两个0.127mm空洞以及一
个0.076mm空洞
0.508mm x 0.762mm
0.356mm空洞
70%直径
19%面积
0.508mm x 0.762mm
0.406mm空洞
80%直径
25%面积
0.508mm x 0.762mm
0.457mm空洞
90%直径
31%面积
0.635mm连接盘
0.381mm空洞
60%直径
36%面积
0.635mm连接盘
0.254mm空洞
50%直径
16%面积
0.635mm连接盘
三个0.152mm空洞以及
三个0.076mm空洞
24%面积
0.635mm连接盘
两个0.254mm空洞以及一
个0.152mm空洞
38%面积
0.635mm连接盘
一个0.254mm空洞,三
个0.152 mm空洞以及一
个0.102mm空洞
37%面积
0.635mm连接盘
三个0.152mm空洞,一
个0.102mm空洞以及四
个0.076mm空洞
25%面积