IPC-7095D-CHINESE NP 2019.pdf - 第86页
IPC-7095D-W AM1 CN 2019 年 1 月 70 6.3.4 减轻机械应变的设计 机械应变和印制板挠曲是印制板和 BGA 焊点损伤的主要原因。已开发出一些 BGA 布局策略以减小机械应变对 BGA 的影响。 印制板: • 用平行于侧边的直线将每个 BGA 分成 4 个相等的象 限。在每个象限, 布线导体和连接盘至导通孔 (狗骨) 实现从 BGA 连接盘引出导通孔 ,这样它们以 45 度 角从 BGA 呈辐射状引出 (见图…

IPC-7095D-WAM1 CN2019 年 1 月
69
A
B
C
0.300
0.250
0.200
0.150
0.100
0.050
0.000
0.4 0.5 0.6 0.7 0.8 0.9 1 1.1 1.2 1.3 1.4 1.5
D
IPC-7095d-6-19-cn
图 6-19 不同阵列节距的导体和间距宽度
A– 导体和间距宽度 (mm)
B– 阵列节距 (mm)
C– 单根布线 (mm)
D– 两根布线 (mm)
单根布线宽度 = W
1
= 0.33(0.5 × P) ,其中 P 是阵列
节距
两根布线宽度 = W
2
= 0.2(0.5 × P),其中 P 是阵列节距
图 6-20 说明了如何采用单根和两根布线将导体连接至
阵列连接盘图形。
6.3.3 连接盘至导通孔(狗骨)布线图形
图 6-21 显
示了一个典型的连接盘至导通孔(狗骨)布线图形,
包括了一个连接盘,导通孔和连接这两个特征的扇出。
图 6-22 说明了可用于连接导体和阵列连接盘图形的连
接盘至导通孔(狗骨)图形的两种类型。
AB
IPC-7095d-6-20-cn
图 6-20 单根和两根导体布线
A– 单根
B– 两根
图 6-21 典型的连接盘至导通孔(狗骨)布局
A– 导通孔
B– 扇出
C– 连接盘
A
B
C
IPC-7095d-6-21-cn
图 6-22 连接盘至导通孔(狗骨)布线选项
IPC-7095d-6-22-cn
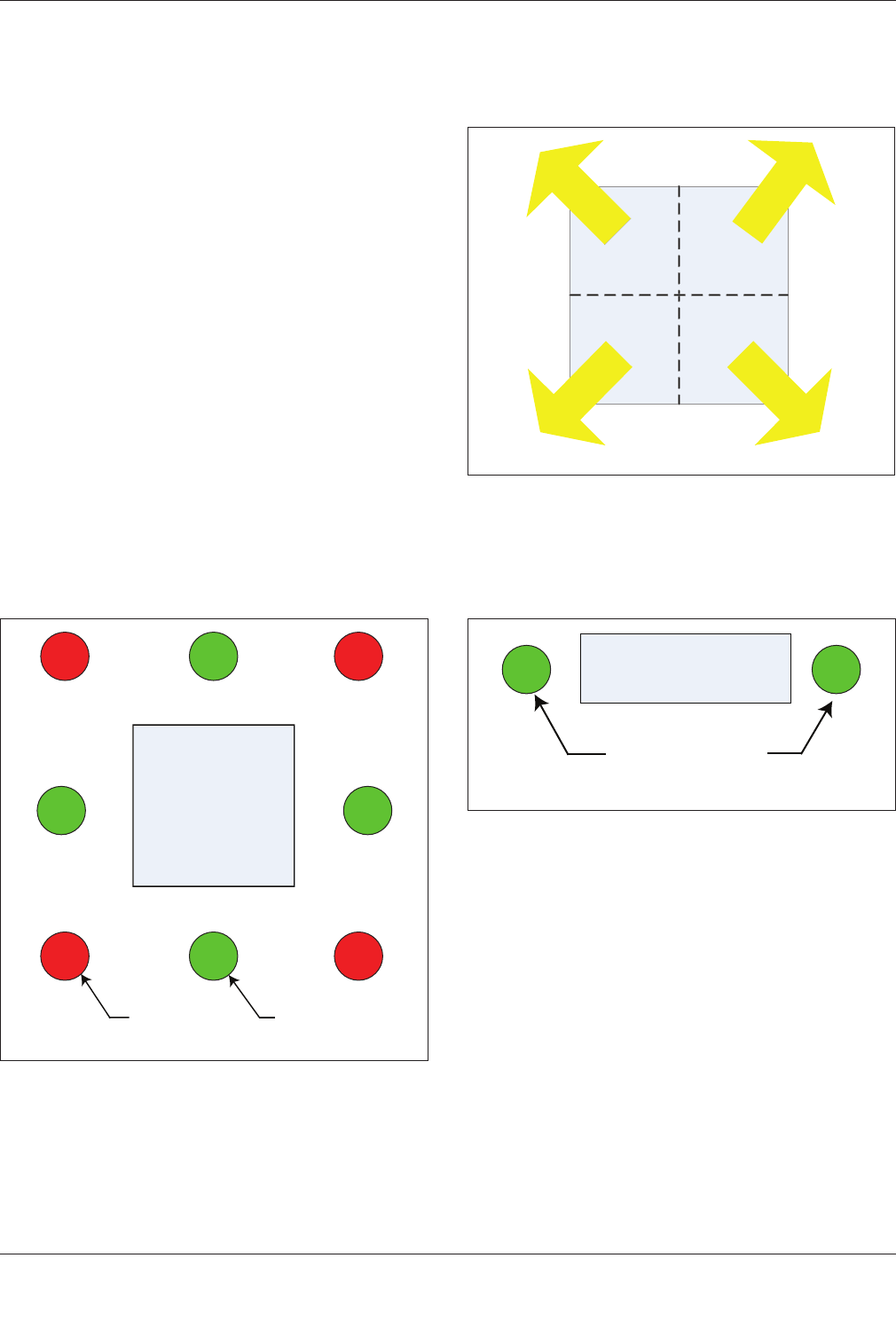
IPC-7095D-WAM1 CN 2019 年 1 月
70
6.3.4 减轻机械应变的设计
机械应变和印制板挠曲是印制板和 BGA 焊点损伤的主要原因。已开发出一些
BGA 布局策略以减小机械应变对 BGA 的影响。
印制板:
• 用平行于侧边的直线将每个 BGA 分成 4 个相等的象
限。在每个象限,布线导体和连接盘至导通孔(狗骨)
实现从 BGA 连接盘引出导通孔,这样它们以 45 度
角从 BGA 呈辐射状引出(见图 6-23),这可增加角
落连接盘承受损伤的应变量级。
• BGA 角落连接盘的连接盘至导通孔(狗骨)或布线,
应放大或添加泪滴。
• 印制板组件和外壳 :
• 不要将螺钉放置于 BGA 角落而与封装对角线重叠。
(见图 6-24,红色位置)
• 将螺钉放在 BGA侧边的中点。(见图 6-25,绿色位置)
• 使用本体为刚性的牛角连接器并在其两端提供印制
板组装的支持,尤其对于插拔力较高的连接器。
• 螺钉头下面采用的垫圈不大于螺钉凸台外径,使印
制板组件的扭曲变形最小化。
B
B
B
B
A
IPC-7095d-6-23-cn
图 6-23 BGA 连接盘至导通孔(狗骨)连接盘图形
的优先导体布线方向
A – BGA
B – 连接盘至导通孔(狗骨)方向
A
BC
IPC-7095d-6-24-cn
图 6-24 螺钉和支撑的优先布局
A – BGA
B – 避免角落布局
C – 优先布局
A
IPC-7095d-6-25-cn
图 6-25 连接器螺钉支撑布局
A – 在印制板上为连接器两端提供支撑

IPC-7095D-WAM1 CN2019 年 1 月
71
6.3.5 未遮蔽焊盘内导通孔及其对可靠性的影响
BGA 的焊盘内导通孔(镀覆导通孔,在印制板反面遮蔽)
会在 BGA 焊点中引发空洞,这可能会影响可靠性。对于直径为 0.75mm 焊球、大小为 25mm 至 35mm 标准封装,
没有与空洞相关的可靠性风险。已进行的加速老化试验表明,与标准的连接盘至导通孔(狗骨)设计对比其失
效率在统计上是等效的。此问题的说明如图 6-26 和 6-27 所示。
图 6-26 具有焊盘内导通孔结构的 0.75mm 焊球切
片图
图注:
焊球左上角缩进是人为的
IPC-7095d-6-27-cn
图 6-27 显示导通孔遮蔽与焊球的焊盘内导通孔设计
的切片图示
单面遮蔽的导通孔会表现出各种可靠性问题。每个问题都应该结合特定的环境设计标准进行评估:
• 导通孔部分填塞,造成应力分布不均匀
• 空洞会占用相当大的一部分连接区域,减少了结构上的支撑
• 空洞可能会减少导热通道
当采用焊盘内导通孔技术,除非在印制板元器件贴装面将导通孔遮蔽,不然焊点中会出现空洞(如图 6-28 所
示)。这些由空气截留导致的空洞是可以接受的,它们不会对焊点可靠性造成影响。无疑,这些空洞的形成条
件不仅取决于工艺,还与 BGA 的连接盘尺寸和其上面的导通孔直径有关。另外,不同类型的孔如贯通孔、盲
孔和微导通孔,情况也有所不同。
图 6-28 也显示了:
• 这三种孔的结构特点以及当焊膏印刷后和 BGA 贴装后,来料时的状态
• 再流焊过程中焊球和孔内的状况
• 最终形成的焊点特性。
空洞出现的主要原因之一是开始锡膏印刷和 BGA 贴装时,空气截留在焊膏下面。在再流焊过程中,截留的空
气和焊膏中的挥发物需要排出,这会使焊球中心部位出现轻微的焊料空缺(如图 6-28 所示)。