IPC-7095D-CHINESE NP 2019.pdf - 第82页
IPC-7095D-W AM1 CN 2019 年 1 月 66 扇出图形应该为电源区域显示出特有的十字 。由于电 源间隙的原因,当 BGA 扇出时没有使用十字图形,可 能发生电源隔离的情况 ,而在内部电源引脚的周围形 成了围墙。这种十字图形也为内部或交叉的 BGA 网络 布线留下余地(见图 6-12 )。 成功的 BGA 扇出包括: • 只要可能,坚持布局网格与扇出网格对齐。 • 在布线时保护 BGA 扇出导通孔。 • 合适的导通孔和…

IPC-7095D-WAM1 CN2019 年 1 月
65
为了实现这一目标,需要采用 BGA 焊球和连接盘设计
的一种替代策略。一种策略是抛弃 I/O 固定网格位置的
概念,取而代之的是采用多网格设计方法,也被称为焊
球随布。这大大增加了印制板对于高密度 I/O 元器件的
可布能力。
焊球随布 I/O 布局设计方法区别于固定网格位置设计
方法。焊球随布设计包含了不同网格的多个连接盘区
域,甚至一些没有规则网格的连接盘区域,因此增加了
PCB 的可布线性以减少层数。
图 6-10 显示了 CPU 元器件的一个连接盘图形,是焊球
随布连接盘设计的一个示例。其连接盘按照不同网格来
布局。
• 角落的连接盘按照一种网格。
• 中心区域连接盘按照另一种网格,
• 侧面按照另一种网格,它是散布网格图形,并具有最
密的连接盘间隙。
这种连接盘图形设计中最靠近的连接盘至连接盘节距是
0.4mm,这些不同网格区域之间的过渡区域似乎有一些
连接盘 没放置在任何网格上。
将图 6-10 的连接盘图形和图 6-11 显示的均匀网格图形
作比较,可以发现,焊球随布连接盘图形可能的线性布
线密度(图 6-10)比均匀网格连接盘图形的(图 6-11)
多 40% 至 50%,导致较低的层数和印制板成本。
焊球随布封装在印制板设计上是为特定应用和客户定制
的,用户需要与封装供应商合作获得焊球随布封装。
6.3 出线和布线策略
与外围引线封装不同,BGA 焊
点不容易全部在印制板外层访问,尤其是对于大尺寸、
全栅阵列的 BGA 封装,可能需要增加额外层将信号从封装中间的底下引出。
例如,一个节距为 1.27mm,引脚数为 357 的 PBGA,为角落不带焊球 19×19 的全栅阵列。如果使用尺寸为
0.63mm 的连接盘,则连接盘之间可供布线的间距仅为 0.63mm。在这种情况下,只能允许在连接盘间布置一
条宽度为 0.2mm 的导体,即封装只有最外两排引脚(共计 136 个)可通过外层将其导出。剩下的引脚(共计
221 个)需要连接导通孔并通过其它信号层将其引出。如果导体宽度和间距均为 125
μ
m,连接盘之间可布置两
条导体,于是最外三排的引脚(共计 192 个)可通过外层引出,剩余的引脚(共计 165 个)则需要借助导通孔
将其引出。
随着 BGA、FBGA 及 CSP 的节距不断缩小,印制板导通孔图形需要更严格的要素控制。
图 6-10 焊球随布 BGA 器件的焊球随布连接盘图形
设计
A– 最窄的通道
B– 较宽的通道
图 6-11 均匀网格 BGA 连接盘图形

IPC-7095D-WAM1 CN 2019 年 1 月
66
扇出图形应该为电源区域显示出特有的十字。由于电
源间隙的原因,当 BGA 扇出时没有使用十字图形,可
能发生电源隔离的情况,而在内部电源引脚的周围形
成了围墙。这种十字图形也为内部或交叉的 BGA 网络
布线留下余地(见图 6-12)。
成功的 BGA 扇出包括:
• 只要可能,坚持布局网格与扇出网格对齐。
• 在布线时保护 BGA 扇出导通孔。
• 合适的导通孔和连接盘尺寸。
BGA 扇出的一种可替代方法是不扇出 BGA 最外两排 /
列周围引脚。对于最外两排,可允许布线工具以宽松
的距离规则布置扇出导通孔。最外两排宽松的扇出可
在 BGA 周围形成双排直插(dip-like)图形,可由自动
布线器来完成。双排直插图形和 BGA 图形的间距使得
非 BGA 网格可以跨过 BGA 区域,而不需要通过内部
BGA 扇出图形。这种方法可在带有 BGA 的印制板布
线出现问题时进行尝试。
为了便于布线,可将电源和接地引线布置在阵列图形
的中心,这样它们可以与导通孔直接相连接而不会妨
碍封装外围边缘的布线。
BGA 可为方形或矩形。方形阵列的行数与列数相等。
图 6-13 所示为 4×4 的方形阵列。
矩形阵列的行数与列数不相等。图 6-14 所示为 4×5 的
矩形阵列。
阵列可填充,也可在某些位置不填充。图 6-15 所示为
中间一列未使用、空白或空缺的 4×5 矩形阵列。
图 6-12 BGA 象限图形
IPC-7095d-6-13-cn
图 6-13 方形阵列
IPC-7095d-6-14-cn
图 6-14 矩形阵列
IPC-7095d-6-15-cn
图 6-15 有空缺的矩形阵列
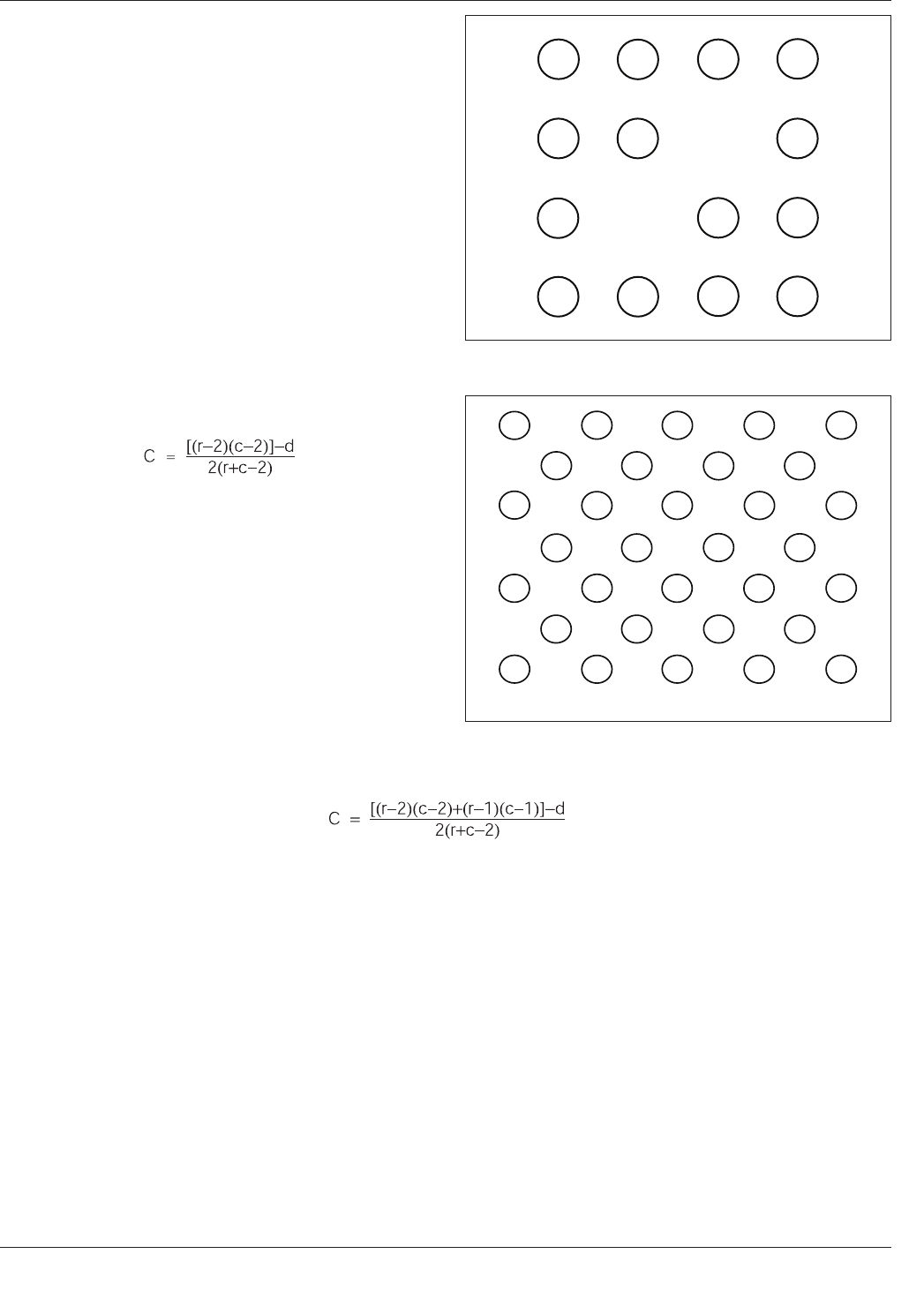
IPC-7095D-WAM1 CN2019 年 1 月
67
图 6-16 所示为一些焊球缺失、空白或空缺的 4×4 方
形阵列。
外围焊球扇出导体到周边与外界互连相对来说并不
难。但是阵列内部的焊球必须要从外围焊球之间走线。
随着阵列尺寸的增加,越来越多的导体阵列内部焊球
中引出,而必须在外围焊球之间走线以连接外界。重
要的是基板设计人员要知道在相邻焊球间距中需要容
纳多少导体数量,以便确定导体的宽度和导体间的间
距。这些信息有助于设计人员构建信号完整性模型以
确保应用成功。
在简单的 r×c 阵列中,每个出口的导体数量 C 可通过
下述关系式给出,式中 r 和 c 分别代表给定阵列的行
数和列数,d 代表阵列的空白位置数。
假使上述等式给出的 C 为整数,则相邻焊球之间每阵
列出口需要容纳 C 条导体。如果 C 为分数,那么一些
出口包含的导体数向下取 C 的整数值,剩余则向上取
C 的整数值。小数部分为出口较低导体数和较高导体
数的比值。
阵列中的焊球也可以散状分布(如对角线阵列)。图 6-17
中为 5×5 散布阵列示例。
下述关系式可用来确定散布阵列中每个出口所含导体
数。
如果 C 为分数,将其向下取整会得到某些相邻焊球间所需布置较少导体数目,若向上取整则可得到剩下的相
邻焊球间所需布置的较大导体数目。小数部分给出了这两个数目所占的比例。
焊料连接盘和导通孔连接盘的尺寸也会影响 BGA 封装的布线能力。1.27mm 节距,大小为 0.8mm 的焊料连
接盘,剩下的连接盘间距仅 0.5mm 可供布线。为了能够在焊料连接盘间布置两条导体,有必要使用规格为
100
μ
m 间距的导体。但是,如果使用大小为 0.6mm 的焊料连接盘,此时在连接盘间可布置间距为 125
μ
m 的
两条导体。
由于密节距 BGA(节距小于等于 1mm)的焊料连接盘间距较小,需要采用较小的导通孔连接盘和钻头尺寸。
随着钻头尺寸减少,印制板最大允许加工厚度也会随之减少。这就迫使设计人员采用较少的层数或者减少层间
的介质厚度。如果使用微导通孔,可能要迫使印制板的外两层作为信号层。
IPC-7095d-6-16-cn
图 6-16 焊球缺失的方形阵列
IPC-7095d-6-17-cn
图 6-17 散布阵列