MIL- STD-883F 2004 TEST METHOD STANDARD MICROCIRCUITS.pdf - 第274页
MIL-STD-883F METHOD 2012.7 1 June 1993 8 (f) Any wire mak ing a st raight line r un from di e bonding pad to pac kage post that has no arc, unless spec ific ally des igned in t his manner (e.g. , cl ips or rigi d connect…
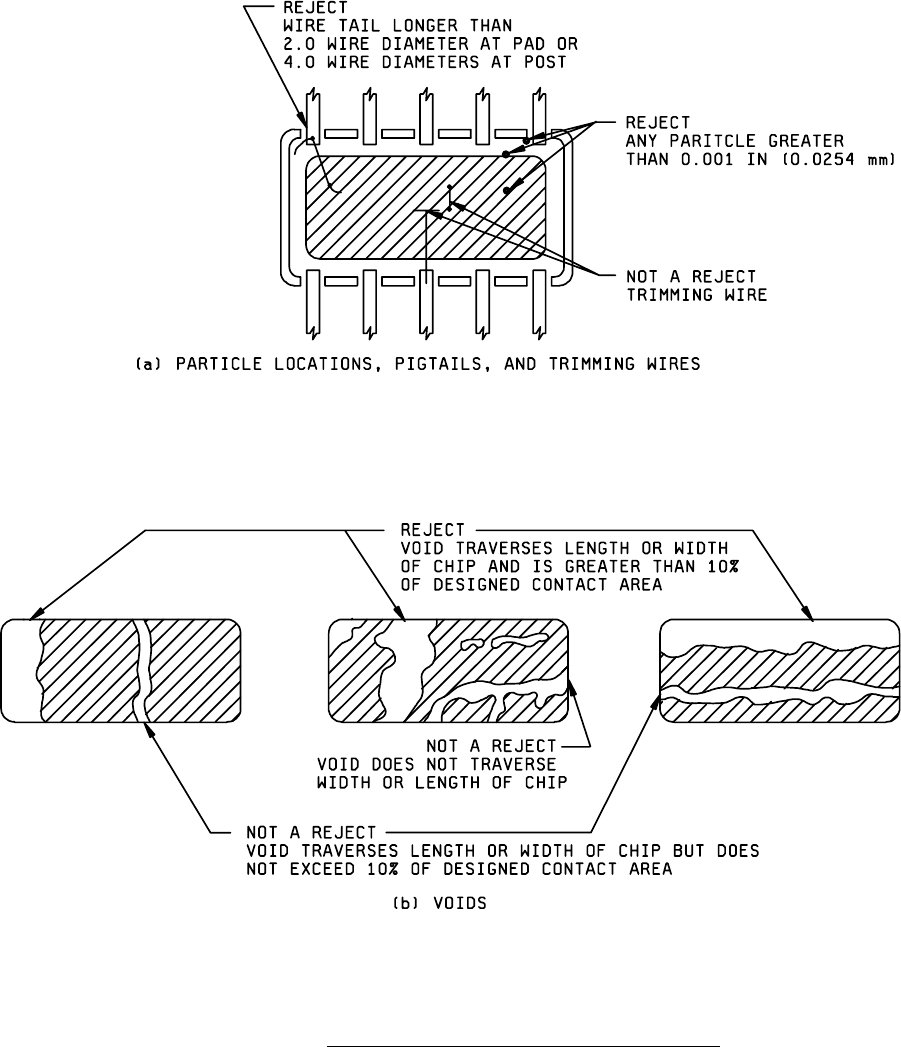
MIL-STD-883F
METHOD 2012.7
1 June 1993
7
FIGURE 2012-1. Particle locations, pigtails, trimming wires, and voids
.
MIL-STD-883F
METHOD 2012.7
1 June 1993
8
(f) Any wire making a straight line run from die bonding pad to package post that has no arc,
unless specifically designed in this manner (e.g., clips or rigid connecting leads).
(g) Any internal post that is bent more than 10° from the vertical (or intended design position) or is
not uniform in length and construction or comes closer than one post diameter to another post.
(h) Where a low profile case (such as TO-46) is used, any post which comes closer to the top of
the case than 20 percent of the total inside dimension between the header and the top of the
case. In devices which have the semiconductor element vertical to the header, any device
where the semiconductor element comes closer than 0.05 mm (0.002 inch) to the header or to
any part of the case.
(i) Any case which does not have a header design incorporating a header edge or other feature
(e.g., a "splash ring") to prevent solder or weld splash from entering the interior of the case.
(3) Cylindrical axial lead type (see figure 2012-8).
(a) Whisker to case distance less than one-half of the diameter of the external lead wire.
(b) Distance from case to semiconductor die or to any eutectic bonding material less than 0.05
mm (0.002 inch).
(c) Whisker tilted more than 5° in any direction from the device lead axis or deformed to the
extent that it touches itself.
(d) C and S shaped whisker with air gap between any two points on it less than twice the
diameter or thickness of the whisker wire. On diodes with whiskers metallurgically bonded to
the post and to the die, the whisker may be deformed to the extent that it touches itself if the
minimum whisker clearance zone specified in figure 2012-8 (a) is maintained.
(e) Whiskerless construction device with anode and cathode lead connections displaced more
than 0.25 mm (0.01 inch) with respect to the central axis of the device.
(f) Semiconductor element mounting tilted more than 15° from normal to the main axis of the
device.
(g) Die hanging over edge of header or pedestal more than 10 percent of the die area.
(h) Less than 75 percent of the semiconductor element base area is bonded to the mounting
surface.
(i) Voids in the welds, from any edge, between the leads and the heat sink slugs greater than 15
percent of the lead wire diameter. Any voids whatever in the central part of the area that
should be welded.
(j) Devices with package deformities such as, body glass cracks, incomplete seals (voids,
position glass, etc), die chip outs and severe misalignment of S and C shaped whisker
connections to die or post.

MIL-STD-883F
METHOD 2012.7
1 June 1993
9
FIGURE 2012-2. Acceptable and unacceptable bonding material build-up
.
FIGURE 2012-3. Extraneous bonding material build-up
.