MIL- STD-883F 2004 TEST METHOD STANDARD MICROCIRCUITS.pdf - 第465页
MIL-STD-883F METHOD 2032.2 18 June 2004 59 Cla ss H Class K 3.3.3 c . Evi dence of s eparati on (delami nation) of 3.2. 3 c . Del amination. meta l plates o r cracks al ong the plane of the metal plates (see f igure 2032…

MIL-STD-883F
METHOD 2032.2
18 June 2004
58
Class H Class K
3.3.3 Ceramic chip capacitor defects "low
magnification". No element shall be acceptable that
exhibits:
a. Crack, chip or void in the body that exposes a. Same as class H.
metal plates, (see figure 2032-55h).
FIGURE 2032-55h. Class H metal plate exposure criteria
.
b. Crack that is greater than 50 percent of the b. Crack.
width of the unmetallized sides, top, or NOTE: No cracks are allowed.
bottom, or that extends around a corner (see
figure 2032-56h).
FIGURE 2032-56h. Class H crack criteria
.
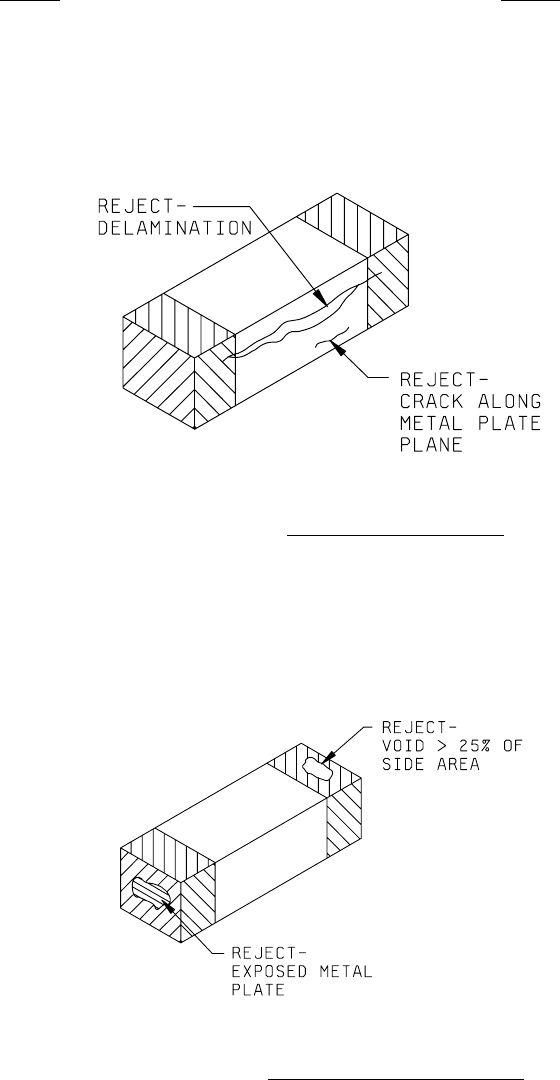
MIL-STD-883F
METHOD 2032.2
18 June 2004
59
Class H Class K
3.3.3 c. Evidence of separation (delamination) of 3.2.3 c. Delamination.
metal plates or cracks along the plane of
the metal plates (see figure 2032-57h).
NOTE: Narrow grooves or channel less than NOTE: No delamination is allowed.
1.0 mil wide that exhibit a glass-like
appearance and do not expose metal
plates are acceptable.
FIGURE 2032-57h. Class H delamination criteria
.
d. Crack or void in the metallization d. Same as class H.
that exposes metal plates,
or voids that are greater than 25 percent
of the area of the metallized
terminal (see figure 2032-58h).
FIGURE 2032-58h. Class H termination defect criteria
.

MIL-STD-883F
METHOD 2032.2
18 June 2004
60
Class H Class K
3.3.3 e. Void in the metallized edges of the 3.3.3 e. Same as class H.
element that are greater than 10 percent
of the metallized edge dimension, or bare
corners of metallized terminals
(see figure 2032-59h).
NOTE: This criteria ia applicable to
solder attached elements only.
FIGURE 2032-59h. Class H metallized edge defect criteria
.
f. Attached foreign material on the body that f. Same as class H.
covers an area greater than 5.0 mils
square on any side.
3.3.4 Tantalum chip capacitor defects, "low
magnification." No element shall be acceptable that
exhibits:
a. Flaking or peeling of the encapsulant that a. Same as class H.
exposes any underlying material.
b. A metallized terminal that is less than 90 b. Same as class H.
percent free of encapsulant material.
c. Less than 50 percent continuous metallized c. Same as class H.
terminal weld area without cracks. For capacitors
with riser wires, a riser wire connection with less
than 25 percent continuous weld area.
d. Metallized terminal containing residue from the d. Same as class H.
welding operation that is not firmly
attached metallurgically to the anode cap.