S1.pdf - 第13页
Slide 13 EUV Reticle frontside protection options Public Reticle Reflected illumination EUV Reticle (13.5nm) Reticle particle pellicle Reticle w ith pellicle Clean sy stem (without pellicle)
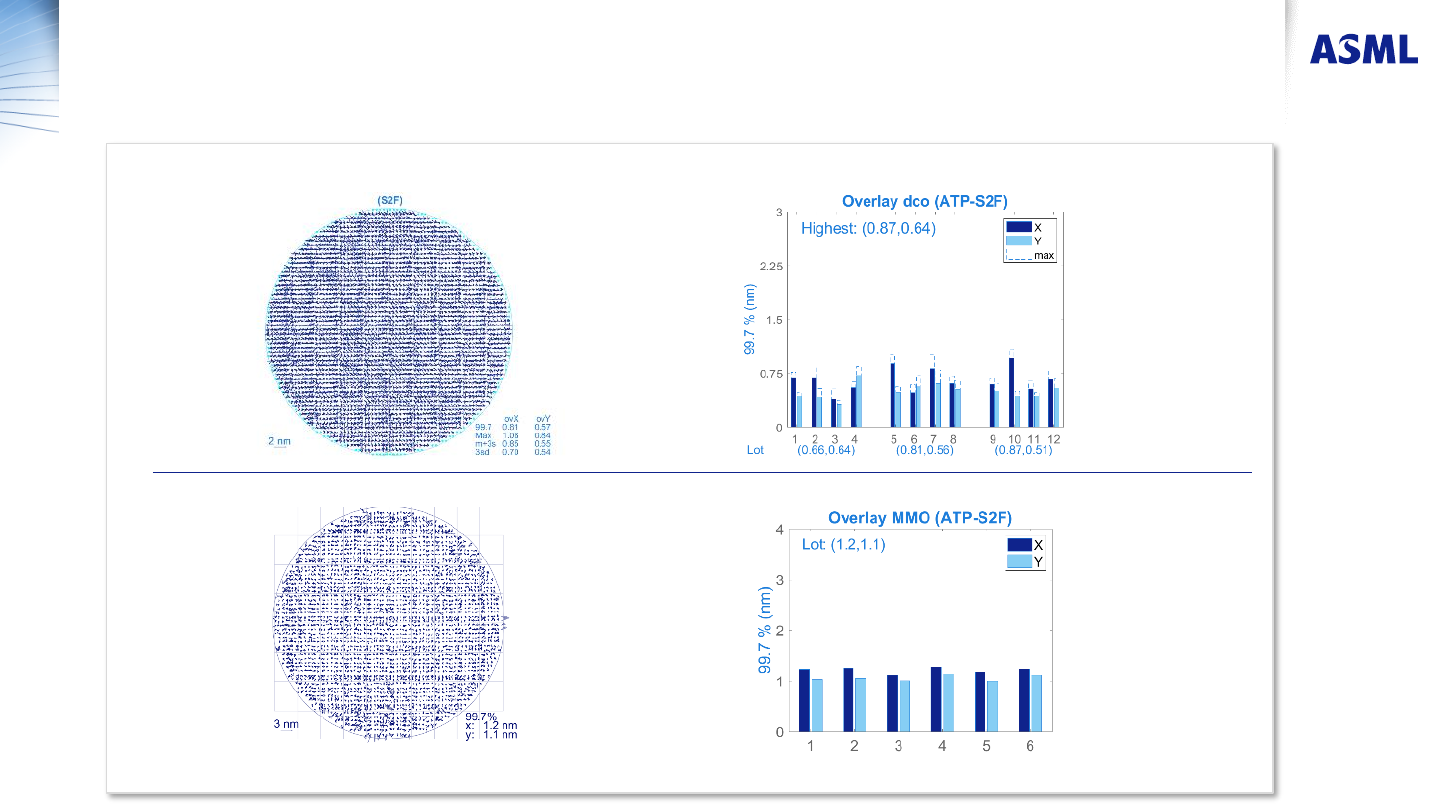
Slide 12
World class overlay performance now at 170wph on
NXE:3400C systems
Overlay well in spec at 170 WPH throughput
DCO
MMO
Public
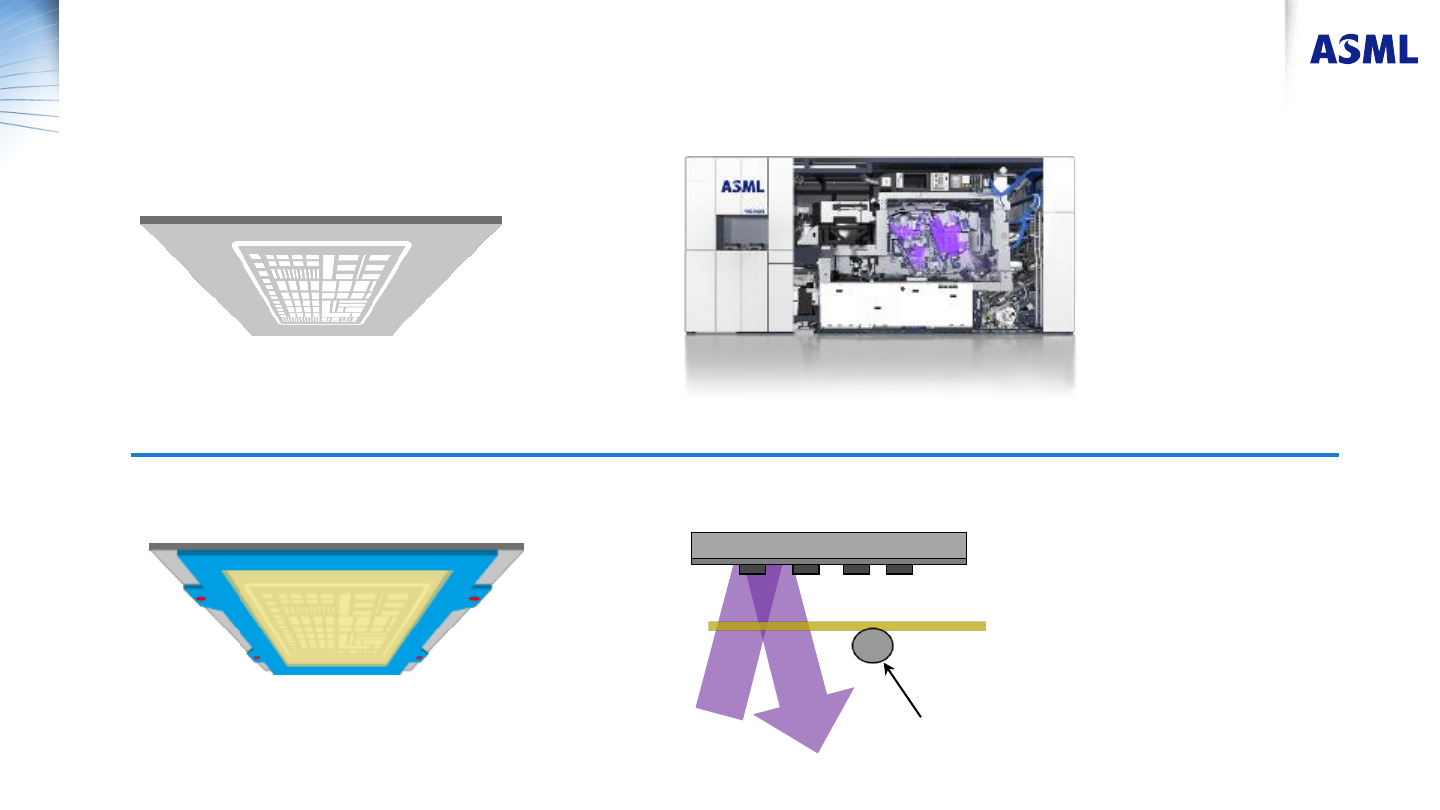
Slide 13
EUV Reticle frontside protection options
Public
Reticle
Reflected
illumination
EUV Reticle (13.5nm)
Reticle
particle
pellicle
Reticle with pellicle
Clean system
(without pellicle)

Slide 14
0
20
40
60
80
100
120
Aug-16 Nov-16 Mar-17 Jun-17 Sep-17 Dec-17 Apr-18 Jul-18 Oct-18 Feb-19
Particles added to reticle front
-side
per 10,000 wafer exposures
Reticle front-side adder performance
NXE:3350B NXE:3400B
Each data point represents between 1,000 and 10,000 wafer exposures in ASML factory or at a customer
HVM target
<1/10k
Improvements on hydrogen gas
curtain, parts cleanliness, in-situ
cleaning, factory way-of-working.
Continuous fine-tuning and
reduction of electrostatic effects
Improvement roadmap in place
to consistently meet HVM target.
Addressing particle generation,
release, and transport.
2016 20182017
Reticle front-side defectivity ~1/10k
Clean Scanner
Public