S1.pdf - 第37页
Slide 37 EUV Lithography System Schematic R eticle-s tage W af er s tage LPP Sour ce Intermediate focus Illuminat or Pr ojection optics Collect or Drive Laser Plasma Public

EUV Source: Architecture
and Operation Principles
Slide 36
Public

Slide 37
EUV Lithography System Schematic
Reticle-stage
Wafer stage
LPP Source
Intermediate focus
Illuminator
Projection optics
Collector
Drive
Laser
Plasma
Public
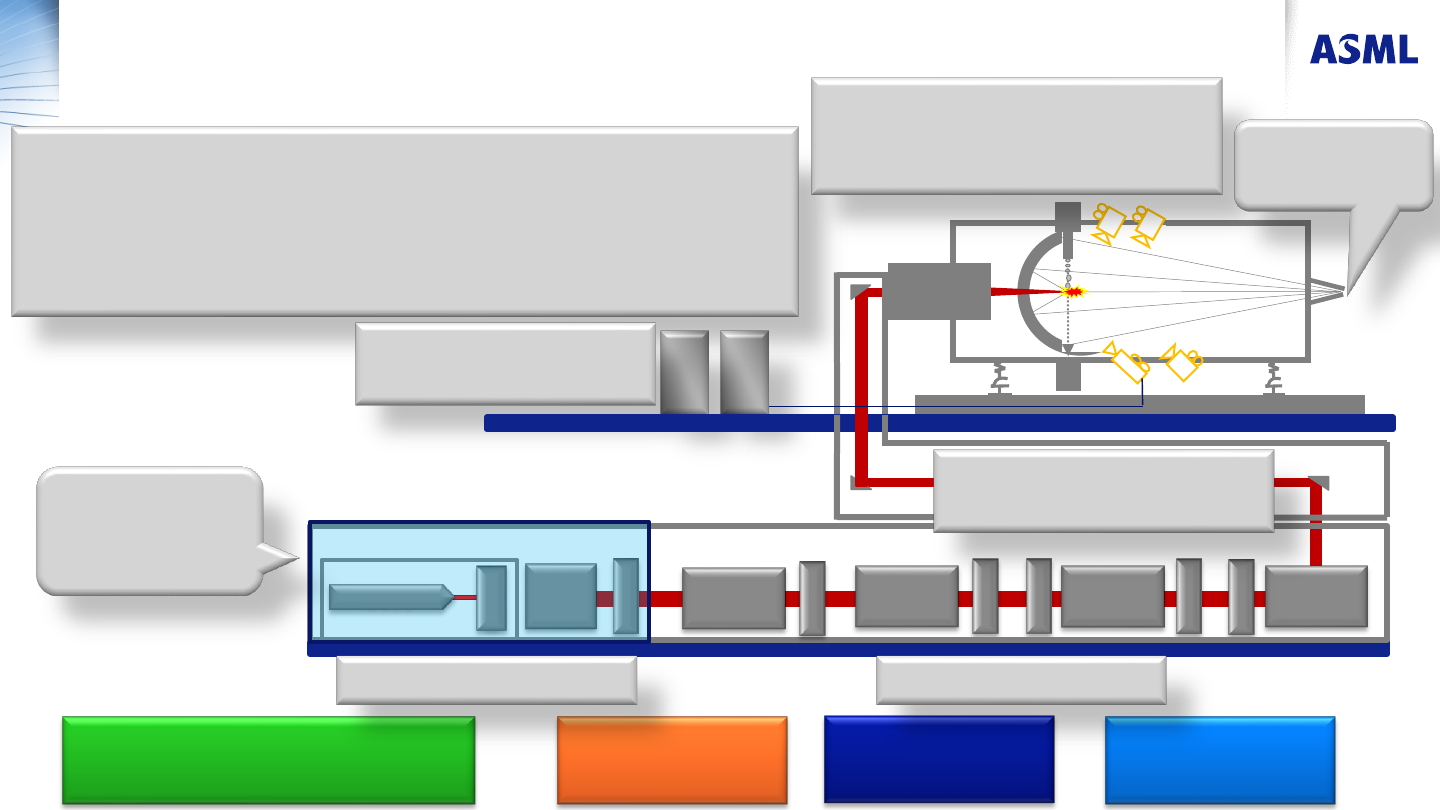
• Key factors for high source power are:
High input CO
2
laser power
High conversion efficiency (CO
2
to EUV energy)
High collection efficiency (reflectivity and lifetime)
Advanced controls to minimize dose overhead
Vessel
With Collector, Droplet
Generator and Metrology
Focusing
Optics
Electronics
Electronics
Controllers for Dose
and Pre-pulse
*
EUV power
(source/scanner interface, [W])
CO
2
power [W]
Conversion
Efficiency
1 – Dose
Overhead
*
Pre-Pulse
Isolator
Pre
Amp
PA
Seed
optics
optics
PA
optics
optics
PA
optics
Power Amplifier
Beam Transport System
Fab Floor
Sub-Fab Floor
Master Oscillator
PA
optics
Pre-pulse
seed laser
trigger control
Slide 38
LPP: Master Oscillator Power Amplifier (MOPA)
Pre-Pulse Source Architecture
Public
Intermediate
Focus, (IF)