S1.pdf - 第19页
Performance of NXE:3400B in the Field Slide 19 Public
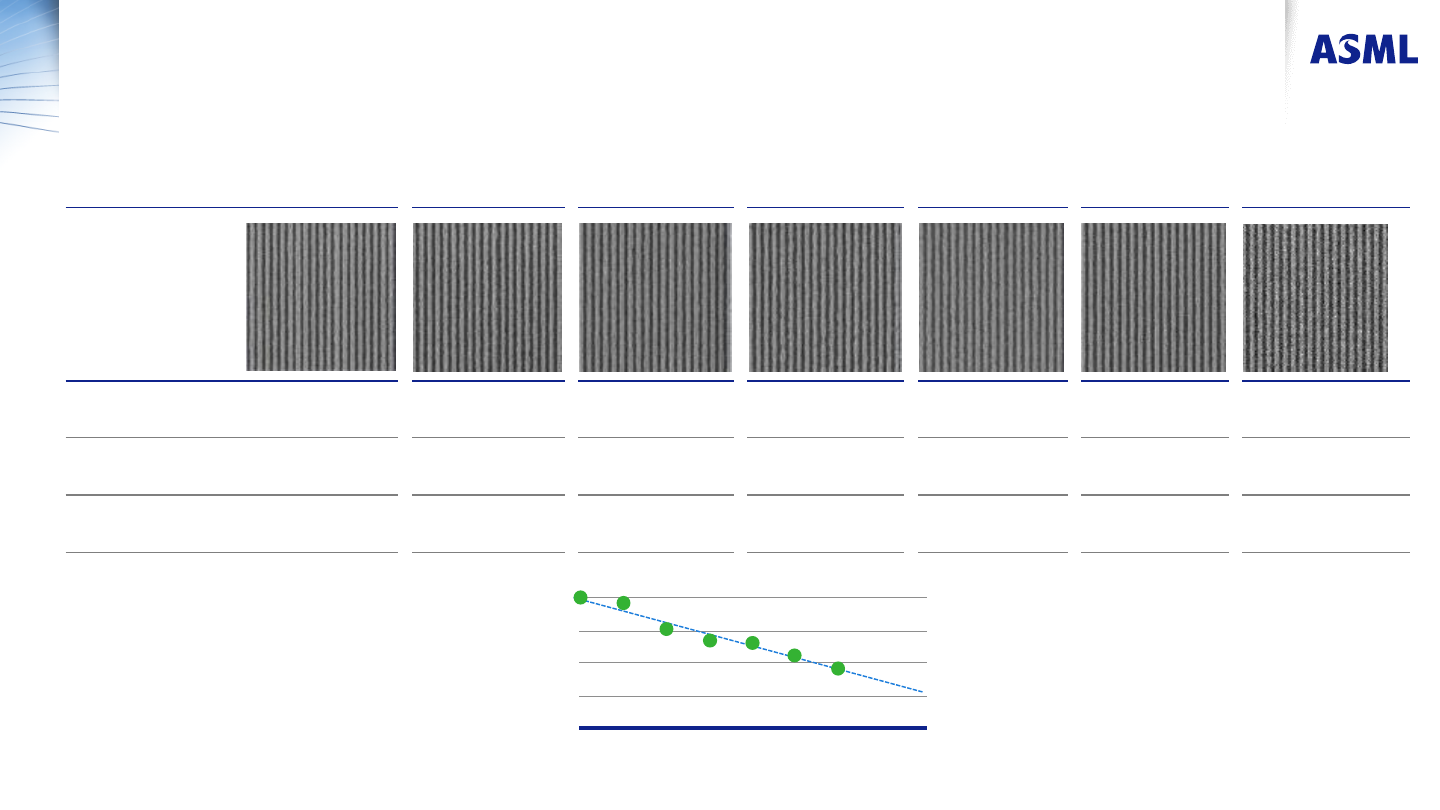
Slide 18
Resist improved more than 2x in the last 6 years
Improved Line Width Roughness (LWR) and dose as measured by Z-factor*
EUVJ-2107
2013 2014 2015 2016 2017 2018 2019
Dose 50mJ 58mJ 42mJ 23mJ 21mJ 38 mJ 37mJ
LWR 4.4nm 4.0nm 4.2nm 5.3nm 5.5nm 3.8 3.5
Z-factor 4.0 3.8 3.0 2.6 2.6 2.2 1.9
*Z-factor = Res
3
x LWR
2
x Dose
16nm DL horizontal; Dipole90Y
Source: ‘Progress in EUV resists towards high-NA EUV lithography’, Xiaolong Wang et al. (PSI), SPIE 2019
2013 2015 2017 2019 2021
0
1
2
3
4
Z-Factor (10 )
-8
Public

Performance of NXE:3400B in the Field
Slide 19
Public

0%
10%
20%
30%
40%
50%
60%
70%
80%
90%
100%
0%
10%
20%
30%
40%
50%
60%
70%
80%
90%
100%
201814
201816
201818
201820
201822
201824
201826
201828
201830
201832
201834
201836
201838
201840
201842
201844
201846
201848
201850
201852
201902
201904
201906
201908
201910
201912
201914
201916
201918
201920
201922
201924
201926
201928
201930
201932
201934
201936
NXE:3400B’s availability substantially improved in 2018
Growing installed base needs further improvements for high volume
Availability 13wma (%)
High volume manufacturing target
Data from growing installed base without configuration repair / upgrades
Weeks (2018/2019)
Maintenance
USD
Average (13wma)
6 systems
29 systems
Upgrades
Slide 20
Public