S1.pdf - 第6页
Slide 6 EUV development has progressed over 30 years from NGL t o HVM insertion ’ 84 1 st lithography (LLNL, Bell Labs, Japan) USA 40 nm hp 70 nm L&S Japan 80 nm 160 nm NL 28 nm Lines and spaces USA 5 m m ASM L start…
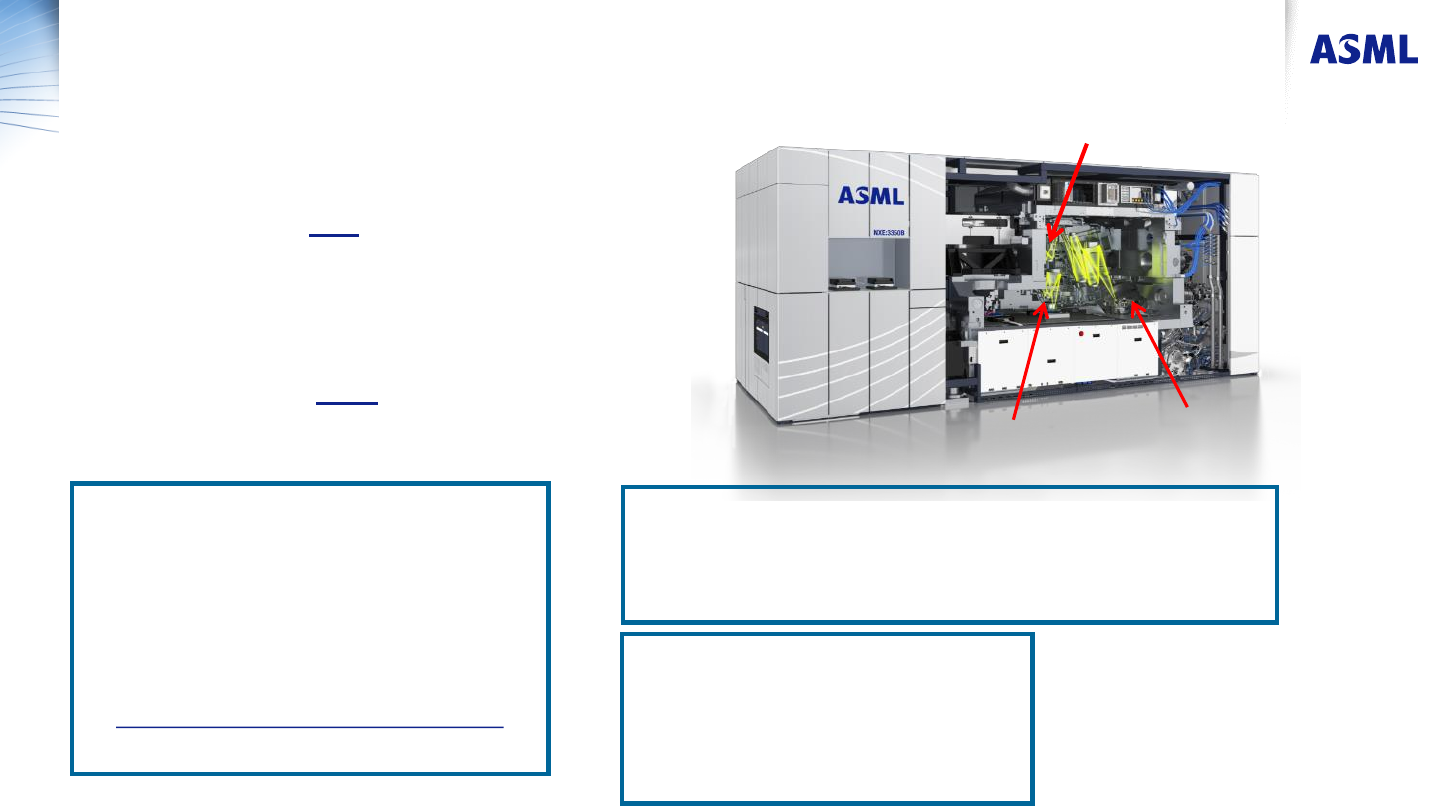
Why EUV? - Resolution in Optical Lithography
Slide 5
Critical Dimension:
Depth of focus:
k: process parameter
NA: numerical aperture
: wavelength of light
KrF-Laser: 248nm
ArF-Laser: 193 nm
ArF-Laser (immersion): 193 nm
EUV sources: 13.5 nm
EUV source
Wafer stage
Reticle stage
theoretical limit (air): NA=1
practical limit: NA=0.9
theoretical limit (immersion):NA ≈ n (~1.7)
k
1
is process parameter
traditionally: >0.75
typically: 0.3 – 0.4
theoretical limit: 0.25
Public

Slide 6
EUV development has progressed over 30 years
from NGL to HVM insertion
’84
1
st
lithography
(LLNL, Bell Labs,
Japan)
USA
40 nm hp
70 nm
L&S
Japan
80 nm
160 nm
NL
28 nm
Lines and spaces
USA
5 mm
ASML starts
EUVL research
program
ASML ships 1
st
pre-production NA
0.25 system
NXE:3100
ASML ships 1
st
NA 0.33 system
NXE:3300B
NL
13 nm L/S
ASML ships 1
st
HVM NA0.33 system
NXE:3400B
NL
7 nm and 5 nm
node structures
’85 ’86 ’87 ’88 ’89 ’90 ’91 ’92 ’93 ’94 ’95 ’96 ’97 ’98 ’99 ’00 ’01 ’02 ’03 ’04 ’05 ’06 ’07 ’08 ’09 ’10 ’11 ’12 ‘13 ’14 ’15 ’16 ’17 ’18
NL
19 nm
Lines and spaces
ASML ships
2 alpha demo tools:
IMEC (Belgium) and
CNSE (USA)
USANL NL NL
Public

1
10
100
1,000
1985 1990 1995 2000 2005 2010 2015 2020 2025
High-NA EUV targets <7nm resolution
Relative improvement:5X over ArFi, 40% over 0.33 NA EUV
Year of introduction
Slide 7
13.5, EUV
193, ArF
248, KrF
365, i-line
436, g-line
>10x
NA+67%
Resolution, nm
= k
1
x Wavelength / NA
Wavelength, nm
>2021
i-Line 365 nm
KrF 248 nm
ArFi 193 nm
ArF 193 nm
EUV 13.5 nm
Production systems
Development systems
XT:1400
NXT:1950i
NXE:3400
High-NA
g-Line 436 nm
NA+45%
Public