S1.pdf - 第27页
High-NA Field and Mask Size productivity Throughpu t >185wph with Half Fie lds Fast stages enable high throughput despite half fi elds WS, RS, current WS 2x, R S 4x HF FF Slide 27 Throughput [300mm/ hr ] Source P ower…
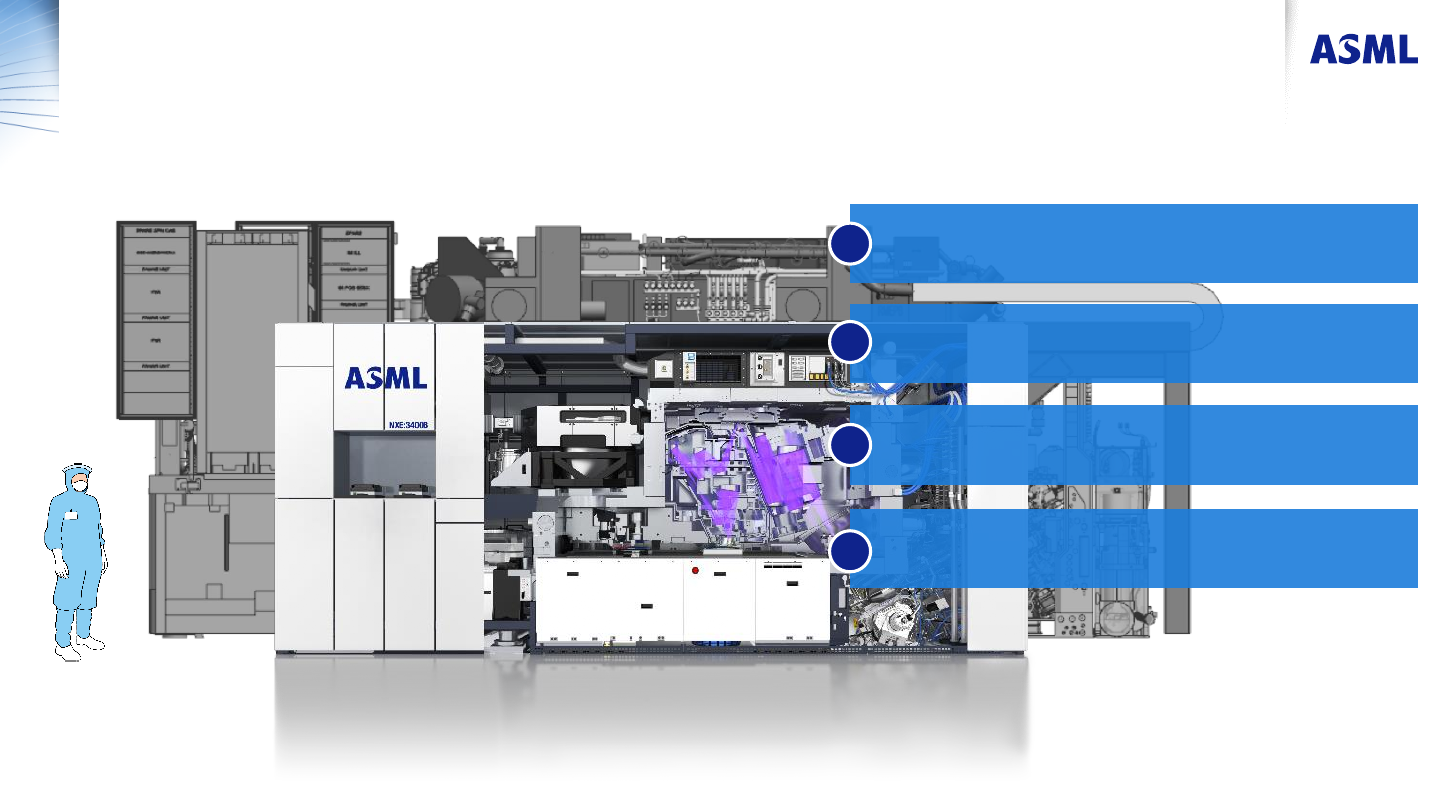
In the same way that 0.33NA enables 7nm and 5nm Logic, 0.55NA EUV
will be needed to enable 3nm Logic
Deliver continuation of shrink roadmap: EXE platform
Process simplification and improved
device performance
>50% cost reduction
compare to multi-patterning schemes
3 to 6x cycle time reduction for critical
layers
Best in class overlay performance
and focus performance
Public
Slide 26

High-NA Field and Mask Size productivity
Throughput >185wph with Half Fields
Fast stages enable high throughput despite half fields
WS, RS, current
WS 2x, RS 4x
HF
FF
Slide 27
Throughput [300mm/
hr]
Source Power/Dose [W/(mJ/cm
2
]
Throughput for various source powers and doses
0
20
40
60
80
100
120
140
160
180
200
0 5 10 15 20 25 30 35
500 Watt
30 mJ/cm
2
0.33NA
High-NA
250 Watt
20 mJ/cm
2
Acceleration of mask stage ~4x..
Acceleration of wafer stage ~2x..
Public

EUV: Principles of Generation
Slide 28
Public