S1.pdf - 第52页
Slide 52 EUV Collector: Normal Incidence • Ellipsoidal design • Plasma at first focus • Pow er delivere d to exposure tool at second focus (intermedia te focus) • W avelength matching across the entire collection area No…
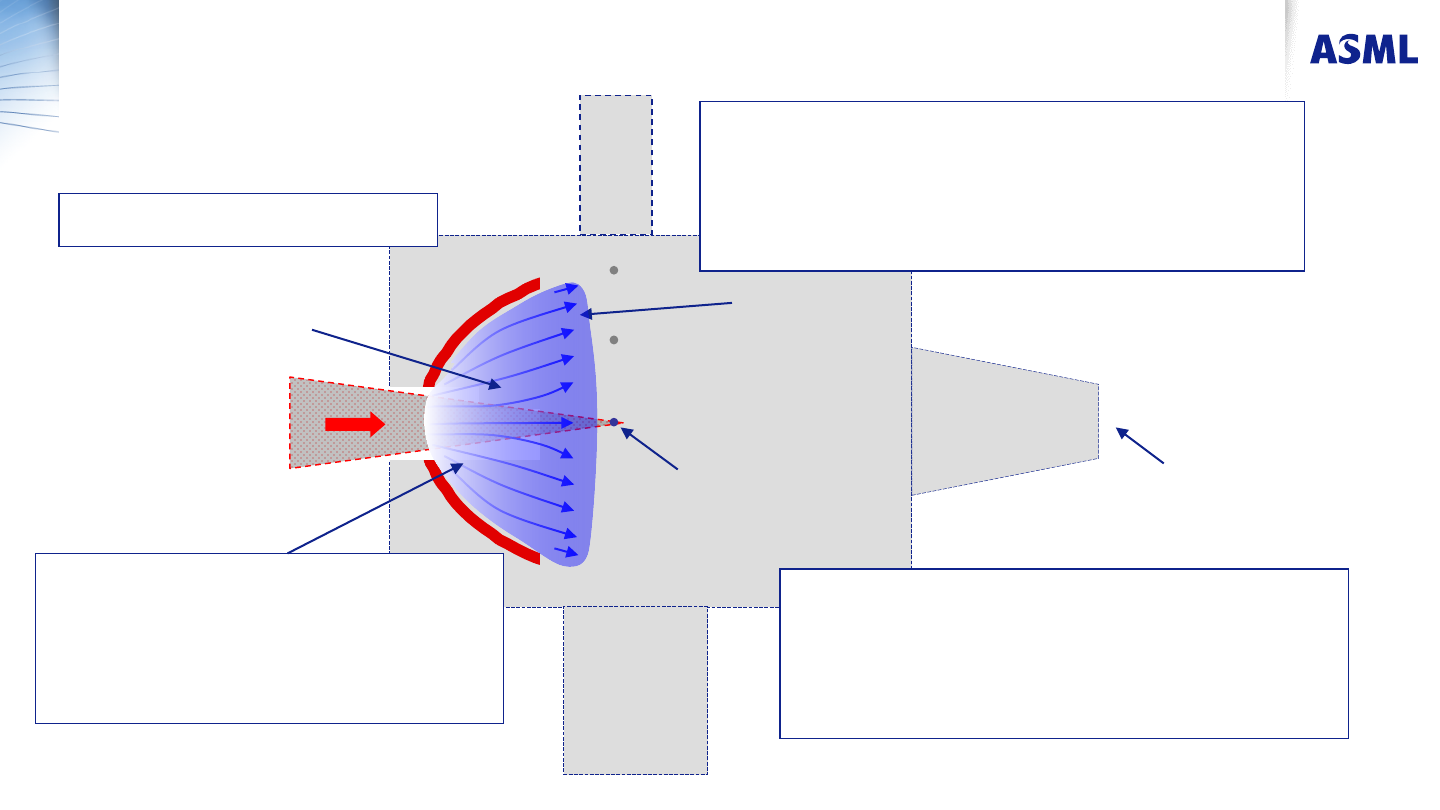
Slide 51
Collector Protection by Hydrogen Flow
Sn droplet /
plasma
H
2
flow
Reaction of H radicals with Sn
to form SnH
4
, which can be
pumped away.
Sn (s) + 4H (g) → SnH
4
(g)
• Hydrogen buffer gas (pressure
~100Pa) causes deceleration of ions
• Hydrogen flow away from collector
reduces atomic tin deposition rate
Laser beam
Intermediate
Focus
Sn
catcher
DG
EUV collector
• Vessel with vacuum pumping to
remove hot gas and tin vapor
• Internal hardware to collect micro
particles
Public

Slide 52
EUV Collector: Normal Incidence
• Ellipsoidal design
• Plasma at first focus
• Power delivered to exposure tool
at second focus (intermediate
focus)
• Wavelength matching across the
entire collection area
Normal Incidence Graded
Multilayer Coated Collector
Public

Slide 53
Hydrogen gas central to tin management strategy
Hydrogen performs well
for all these tasks!
Requirements for buffer gas:
➢ Stopping fast ions (with high
EUV transparency)
➢ Heat transport
➢ Sn etching capability
High heat capacity
High thermal conductivity
High EUV transparency
Public