S1.pdf - 第16页
Slide 16 EUV pellicle industrialization 83% transmission Target 90% Pellicle Film as of 2018 EUV T ran smission at 83% first 88% transmissive pelli cle film availabl e mid 2020 Public 88% transmission Next generation Pel…

Slide 15
Pellicles robust to at least 10k wafers at 250W
No measurable degradation after 3k
Public
NXE:3400B @ 250W, 96 fields per wafer, 50mJ/cm2 sensor based, 35mJ/cm2 in resist
Pellicle #1 0-3k wafers, Pellicle #2 0-6k wafers, Pellicle #3 0-10k wafers, all latest version Mk2.2.
– 0.5%
– 0.6%
– 0.5%
0.0%
+0.3%
unexposed
300 wafers
3000 wafers
6000 wafers
10000 wafers
Pellicle #3 pre/post EUVT
delta at 300, 3k, 6k and 10k wafers
0
50
100
150
200
250
300
0 2000 4000 6000 8000 10000 12000
Source Power [W]
Wafers exposed
Mk2.2 pellicles exposed for up to 10k wafers at 250W
Pellicle #3 Pellicle #2 Pellicle #1
-1.5
-1.25
-1
-0.75
-0.5
-0.25
0
0.25
0.5
0 2000 4000 6000 8000 10000 12000
Chnage in EUVT [%]
Wafers exposed [#]
Mk2.2 degradation at 250W
Pellicle #1
Pellicle #2
Pellicle #3
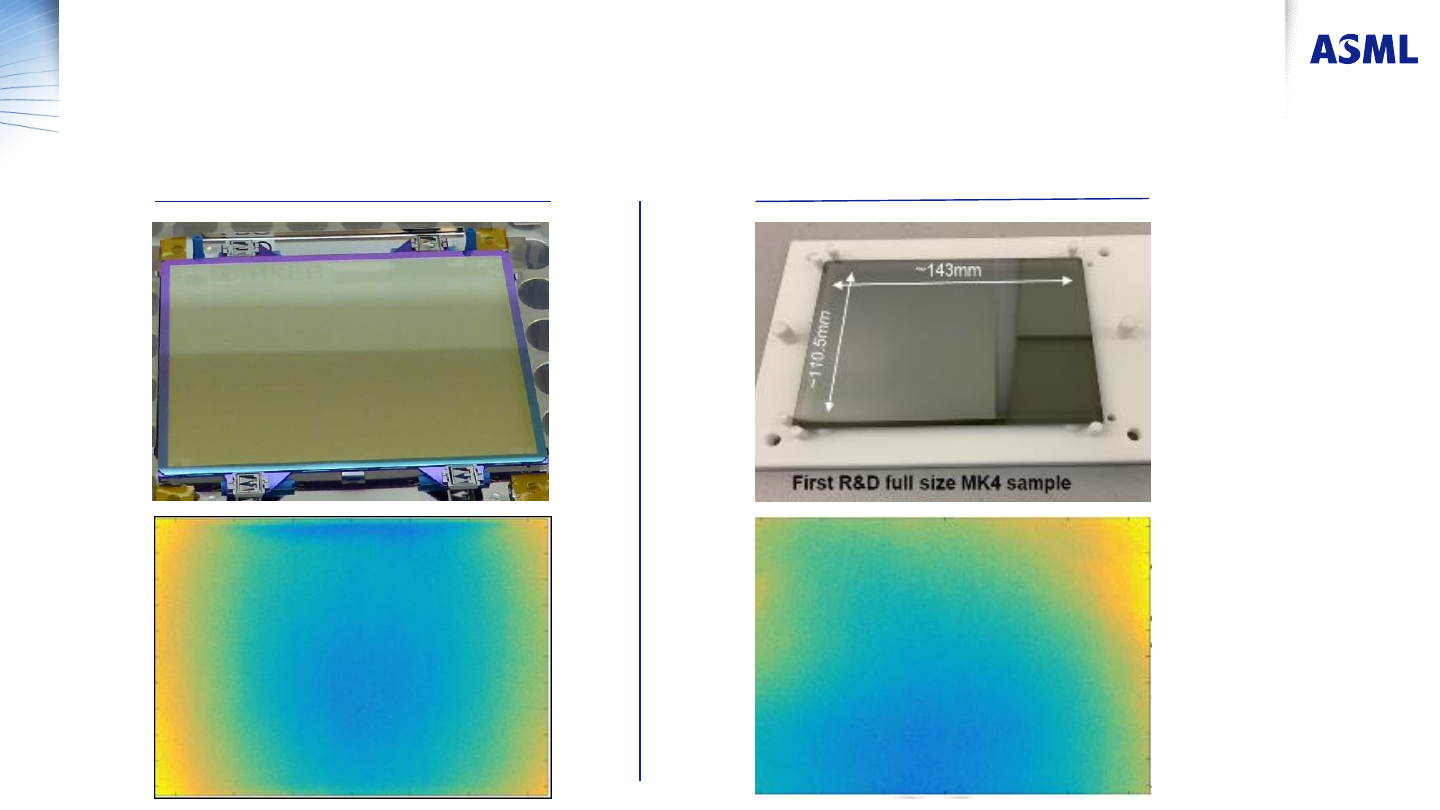
Slide 16
EUV pellicle industrialization
83% transmission
Target 90%
Pellicle Film as of 2018
EUV Transmission at 83%
first 88% transmissive pellicle film available mid 2020
Public
88% transmission
Next generation Pellicle
EUV Transmission at 88%
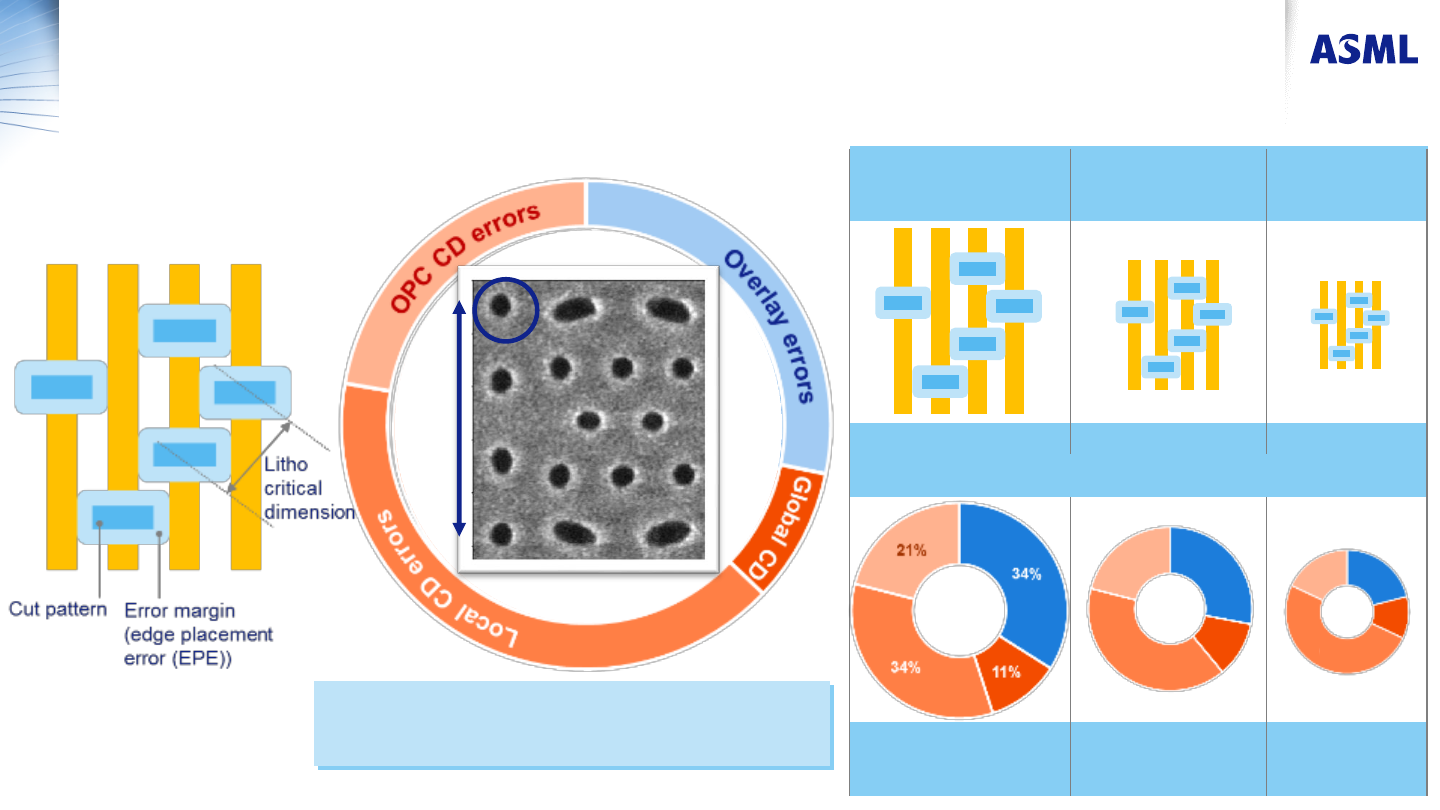
Scaling drives multiple patterning performance
Driven by Edge Placement Error and increasing local CD and placement
7nm 5nm
3nm
15 ~ 20nm
Typical Logic Pattern
Typical Logic EPE budget
9 ~ 13nm
12 ~ 14nm 8 ~ 11nm
7 ~ 9nm 5 ~ 7nm
50%
21%
12%
18%
EPE budget
Logic Node
CD: Critical Dimension, OPC: Mask Optical Proximity Correction
Minimum Half Pitch
40%
28%
11%
21%
Edge placement error (EPE): combined error
of overlay and CD uniformity (global CDU,
local stochastic and OPC error)
250 nm
Slide 17
Public