S1.pdf - 第18页
Slide 18 Resist improved more than 2x in the last 6 years Improved Line Width Roughn ess (L WR) and dose as measured by Z-factor* EUVJ-2107 2013 2014 2015 2016 2017 2018 2019 Dose 50mJ 58mJ 42mJ 23mJ 21mJ 38 mJ 37mJ L W …
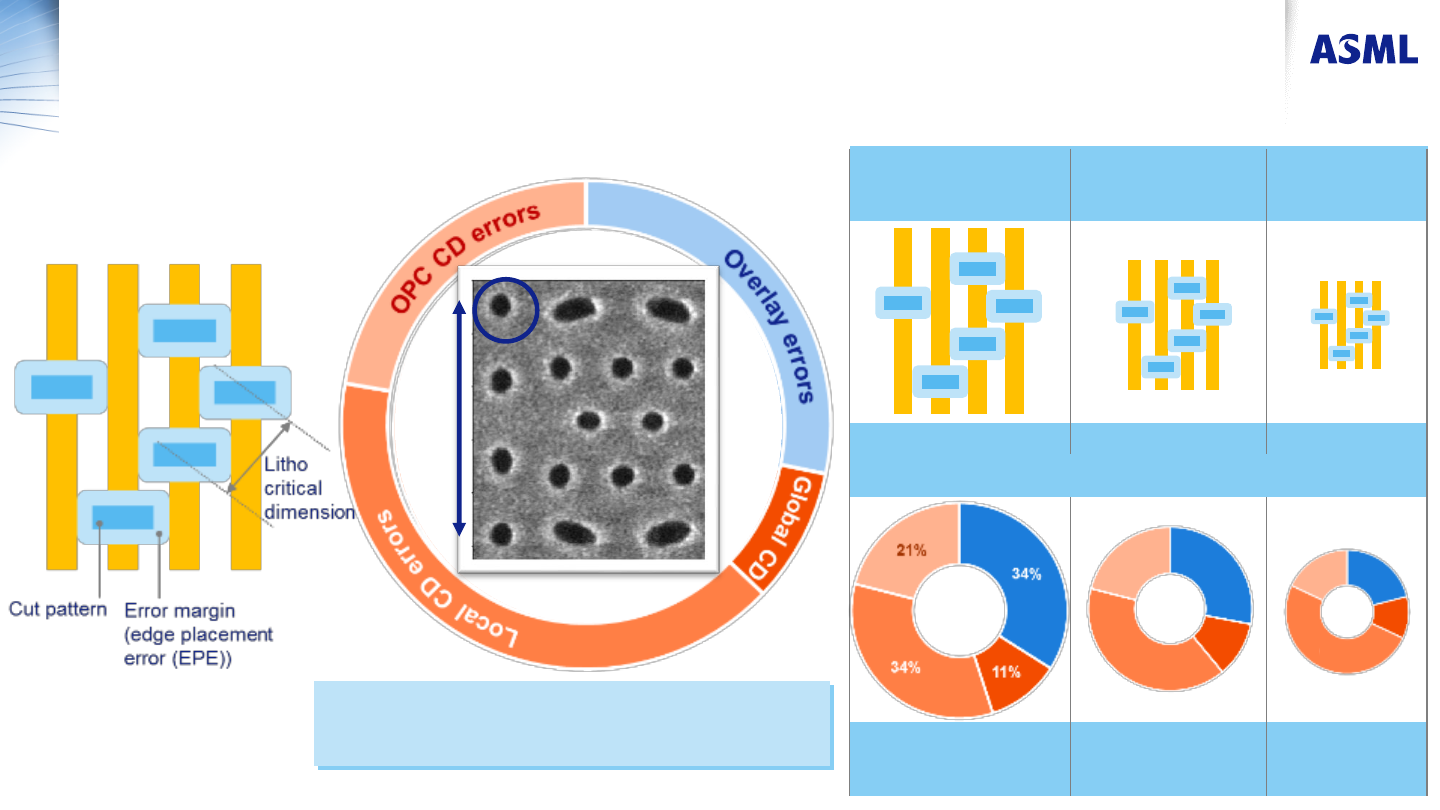
Scaling drives multiple patterning performance
Driven by Edge Placement Error and increasing local CD and placement
7nm 5nm
3nm
15 ~ 20nm
Typical Logic Pattern
Typical Logic EPE budget
9 ~ 13nm
12 ~ 14nm 8 ~ 11nm
7 ~ 9nm 5 ~ 7nm
50%
21%
12%
18%
EPE budget
Logic Node
CD: Critical Dimension, OPC: Mask Optical Proximity Correction
Minimum Half Pitch
40%
28%
11%
21%
Edge placement error (EPE): combined error
of overlay and CD uniformity (global CDU,
local stochastic and OPC error)
250 nm
Slide 17
Public
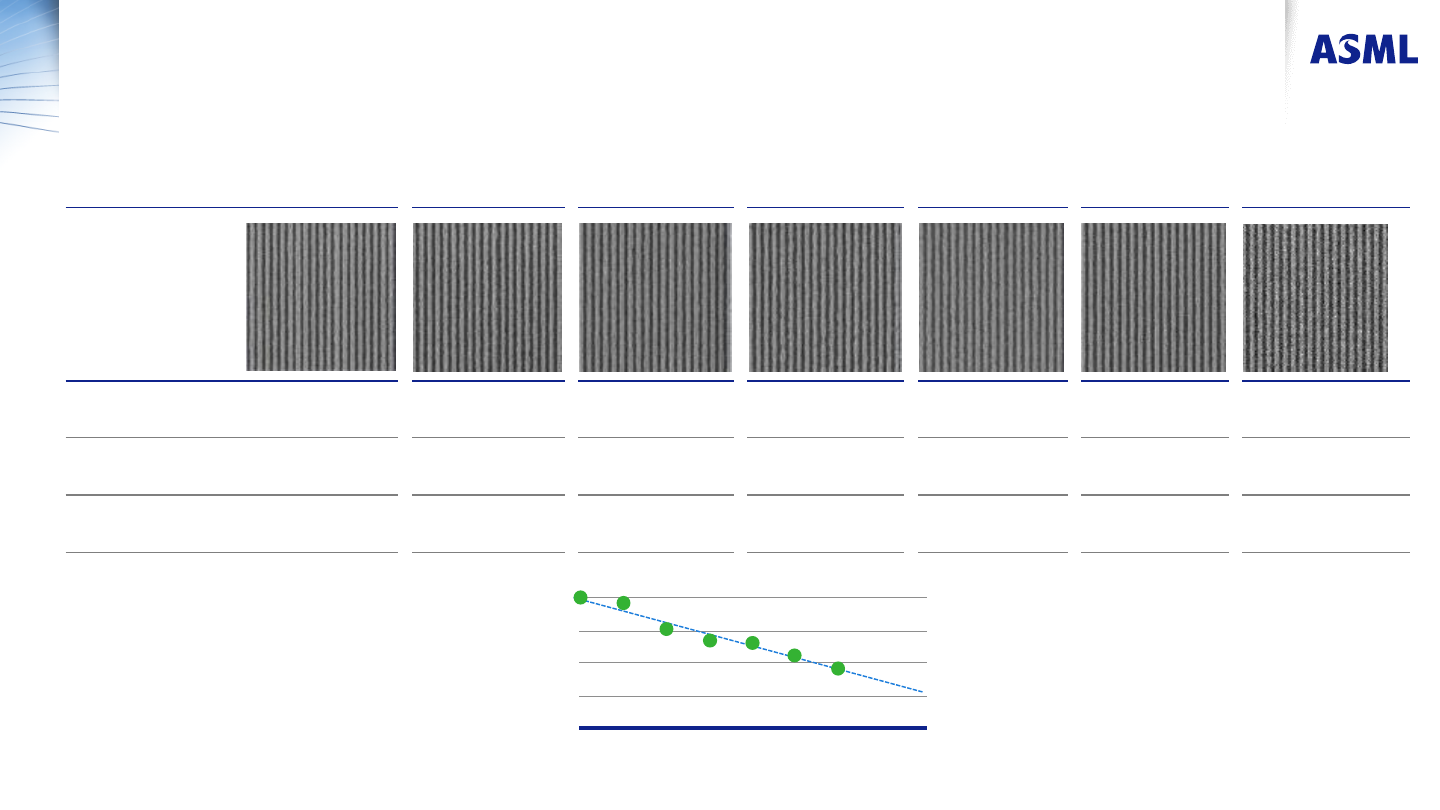
Slide 18
Resist improved more than 2x in the last 6 years
Improved Line Width Roughness (LWR) and dose as measured by Z-factor*
EUVJ-2107
2013 2014 2015 2016 2017 2018 2019
Dose 50mJ 58mJ 42mJ 23mJ 21mJ 38 mJ 37mJ
LWR 4.4nm 4.0nm 4.2nm 5.3nm 5.5nm 3.8 3.5
Z-factor 4.0 3.8 3.0 2.6 2.6 2.2 1.9
*Z-factor = Res
3
x LWR
2
x Dose
16nm DL horizontal; Dipole90Y
Source: ‘Progress in EUV resists towards high-NA EUV lithography’, Xiaolong Wang et al. (PSI), SPIE 2019
2013 2015 2017 2019 2021
0
1
2
3
4
Z-Factor (10 )
-8
Public

Performance of NXE:3400B in the Field
Slide 19
Public