IPC-A-610E CN2010年4月.pdf - 第302页
Bob Willis 所 著 的 《 封装 上的 封装 ( PoP ) — 封装 的 叠装 》 提供了 其 他的 封装叠装 工 艺 指南 。 可接受 - 1,2,3级 •如 果 PCB 上有 角 标, 元器 件 已 和 角 标 记 对 准,图 8-164 。 • 焊 料 球 和 焊盘 的对准 符 合 8.3.12.1 节 的要求。 • 焊 接 连 接 符 合 8.3.12.3 节 的要求,图 8-165 ,并 已 再流 , 显 示 润湿…

设计导致的空洞,例如:焊盘上的微导孔,不在此要求范围内。这种情况下,验收要求应当由制造
商和用户协商确定。
制造商可以通过测试或分析来开发已考虑了最终应用环境的空洞验收要求。
可接受 - 1,2,3级
• X射线影像区内任何焊料球的空洞等于或小于
25%。
缺陷 - 1,2,3级
• X射线影像区内任何焊料球的空洞大于25%。
可接受 - 1,2,3级
• 存在所要求的底部填充或加固材料。
• 底部填充或加固材料完全固化。
缺陷 - 1,2,3级
• 要求底部填充或加固时,材料不足或不存
在。
• 底部填充或加固材料出现在规定的范围以
外。
• 底部填充或加固材料未完全固化。
8 表⾯贴装组件
8.3.12.4 表⾯贴装⾯阵列 – 空洞
8-89IPC-A-610E-2010
2010年4月
8.3.12.5 表⾯贴装⾯阵列 – 底部填充/加固
SINGLE USER LICENSE - NOT FOR USE ON A NETWORK OR ONLINE
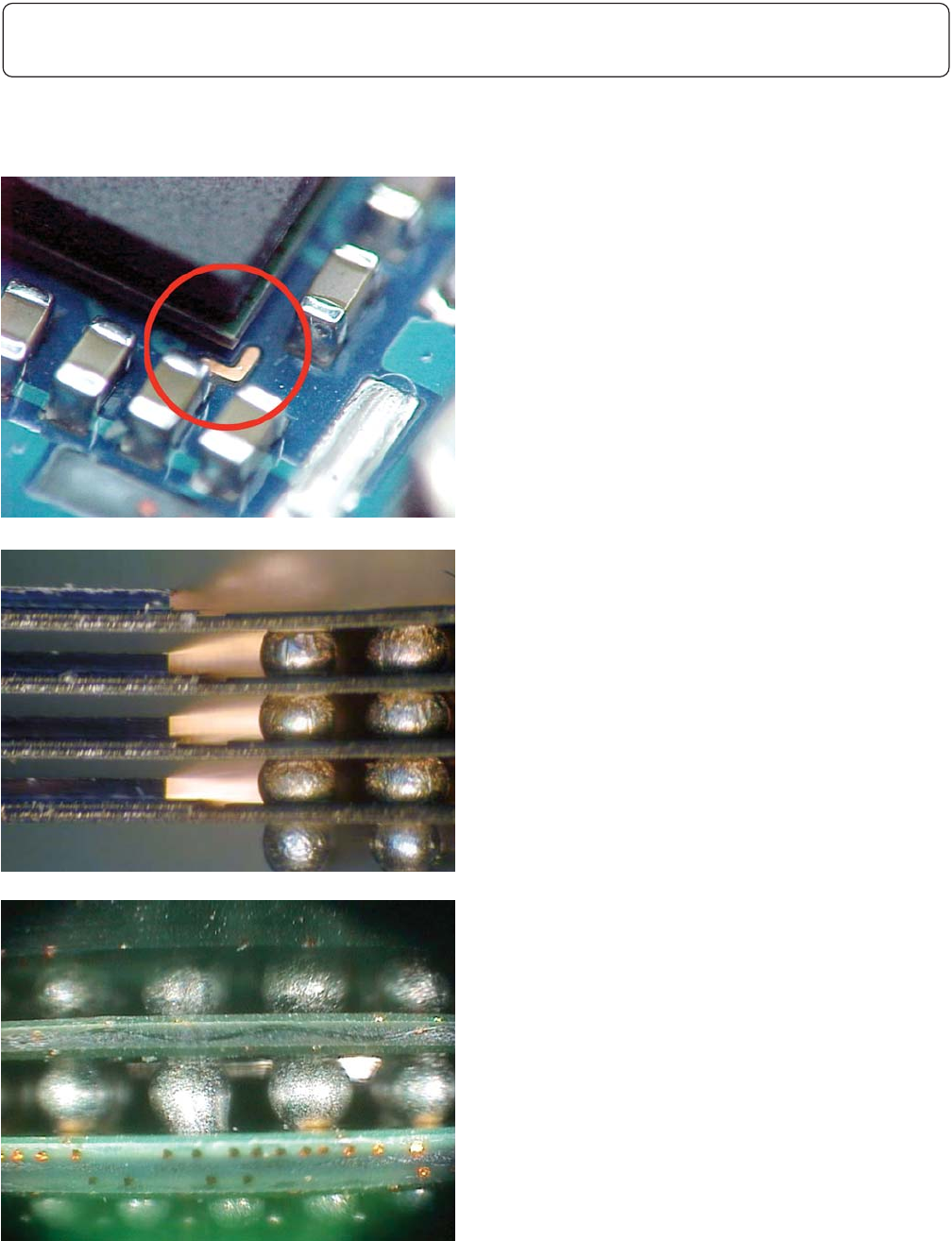
Bob Willis所著的《封装上的封装(PoP)—封装的叠装》提供了其他的封装叠装工艺指南。
可接受 - 1,2,3级
•如果PCB上有角标,元器件已 和 角 标记对
准,图8-164。
• 焊料球和焊盘的对准符合8.3.12.1节的要求。
• 焊接连接符合8.3.12.3节的要求,图8-165,并
已再流,显示润湿了所有封装层上的焊盘。
• 封装的翘曲或扭曲未妨碍对准或焊接连接的
形成。
缺陷 - 1,2,3级
• 焊料球与焊盘的对准不符合8.3.12.1节的要
求。
• 焊接连接不符合8.3.12.3节的要求。图8-166仅
显示只润湿了中间的焊料球。
• 焊料球缺失,图8-167。
• 封装的翘曲或扭曲妨碍了对准或焊接连接的
形成,图8-168、图8-169。
图8-164
图8-165
图8-166
8 表⾯贴装组件
8.3.12.6 表⾯贴装⾯阵列 – 叠装
8-90 IPC-A-610E-2010
2010年4月
SINGLE USER LICENSE - NOT FOR USE ON A NETWORK OR ONLINE

图8-167
图8-168
图8-169
8 表⾯贴装组件
8.3.12.6 表⾯贴装⾯阵列 – 叠装(续)
8-91IPC-A-610E-2010
2010年4月
SINGLE USER LICENSE - NOT FOR USE ON A NETWORK OR ONLINE