00197498-03_UM_SiplaceCA-Serie_EN.pdf - 第201页
User Manual SIPLACE CA-Series 4 SIPLACE Wafer System (SWS) From software version SC.708.0 Edition 12/20 14 4.1 Functions 201 The following o ptions are available to support the whole spectrum of process-or iented functio…

4 SIPLACE Wafer System (SWS) User Manual SIPLACE CA-Series
4.1 Functions From software version SC.708.0 Edition 12/2014
200
4.1 Functions
4.1.1 SIPLACE Wafer System (SWS) Function
The new SWS provides a fully automatic wafer and chip handling system. This is fully integrated
into one of the SIPLACE CA placement system locations. Each location can (with restrictions) be
fitted with an SWS or with an X table.
The SWS functions like a feeder for the SIPLACE system and transports the dies from the wafer
to a single, fixed pickup position for the placement head. The placement head picks the die up
from the SWS and places this on the board as done during SMD handling.
The SWS appears in SIPLACE Pro as an X feeder with a special feeder type. The SIPLACE sys-
tem is programmed as usual for the SIPLACE X-Series. Die handling is programmed at a separate
terminal on the SWS. The main parameters to be programmed are as follows:
– Wafer and die dimensions
– Magazine type
– Wafer frame type
– Die recognition
– Die ejection parameters
– Wafer Map System
– Link to the component programmed in SIPLACE Pro
4.1.2 Basic SWS Functions
The main die handling components are the wafer table, the ejector system, the flip unit and the
control unit with corresponding software.
The wafer with the relevant die is loaded from the magazine and fixed onto the wafer table. The
wafer table places the die using the ejector system, which releases the die from the wafer foil, and
transfers it to the flip unit. The flip unit rotates the die by 180° and makes this available for pickup
by the placement head.
The SIPLACE CA uses a high-precision SIPLACE placement head, which has been specially de-
signed for high accuracy, to achieve the set 35 µm at 3 Sigma for normal and 25 µm at 3 Sigma
for restricted conditions (for restrictions see "Scope of Delivery").
4
PLEASE NOTE
All movable positioning axes in the SWS are servo axes!
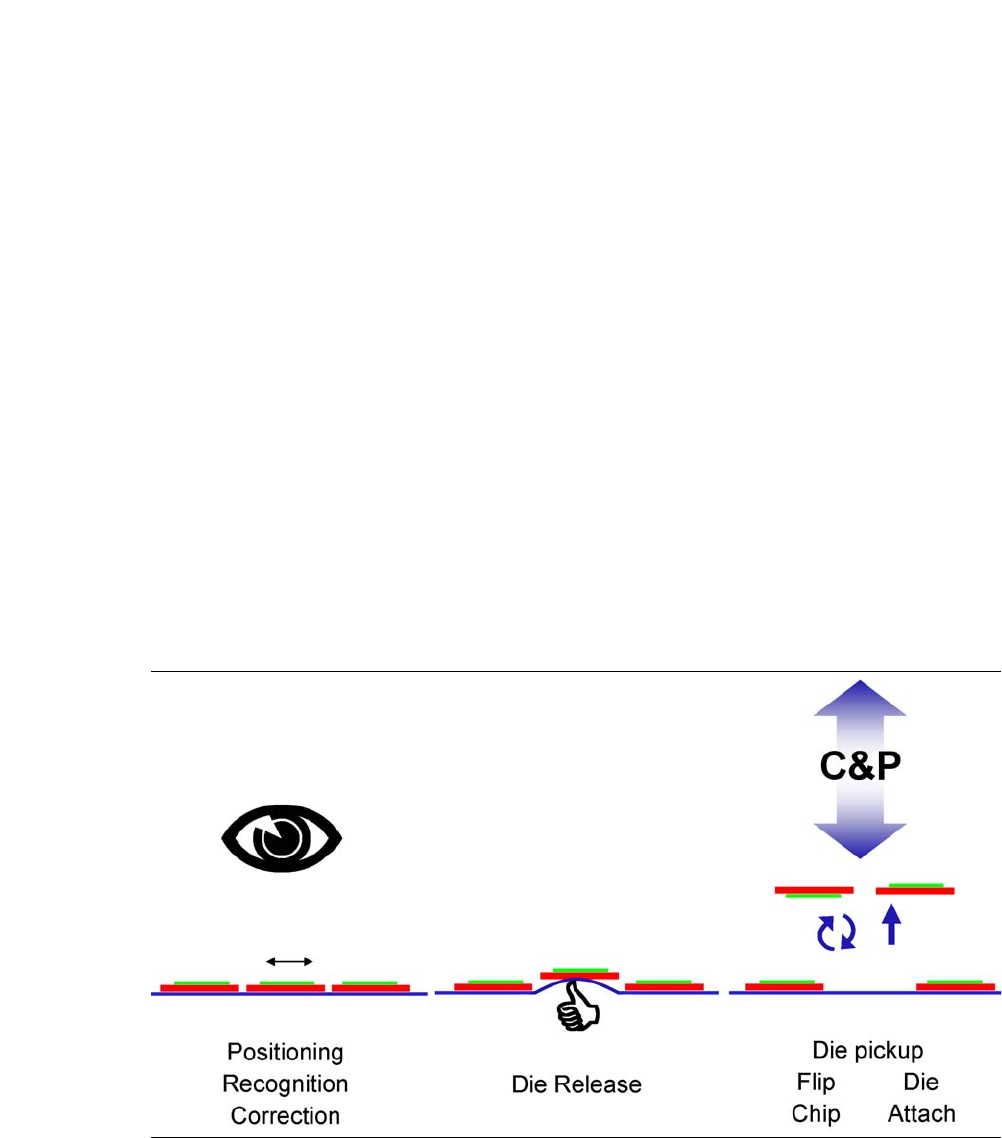
User Manual SIPLACE CA-Series 4 SIPLACE Wafer System (SWS)
From software version SC.708.0 Edition 12/2014 4.1 Functions
201
The following options are available to support the whole spectrum of process-oriented functions:
– Wafer map system
– Linear Dipping Unit
– Die attach unit
– Small die kit (on request)
– Barcode Scanner
– Wafer stretcher
– Inspection camera
4.1.3 Basic Die Presentation Process
The basic die presentation process supported by the SWS can be divided into 3 main steps:
– Die recognition and positioning for ejection (inc. inkspot recognition or wafer map)
– Ejection Process
– Pickup for die attach or flip chip processing.
Fig. 4.1 - 1 Basic die presentation process
There are two main placement variants - flip chip and die attach.
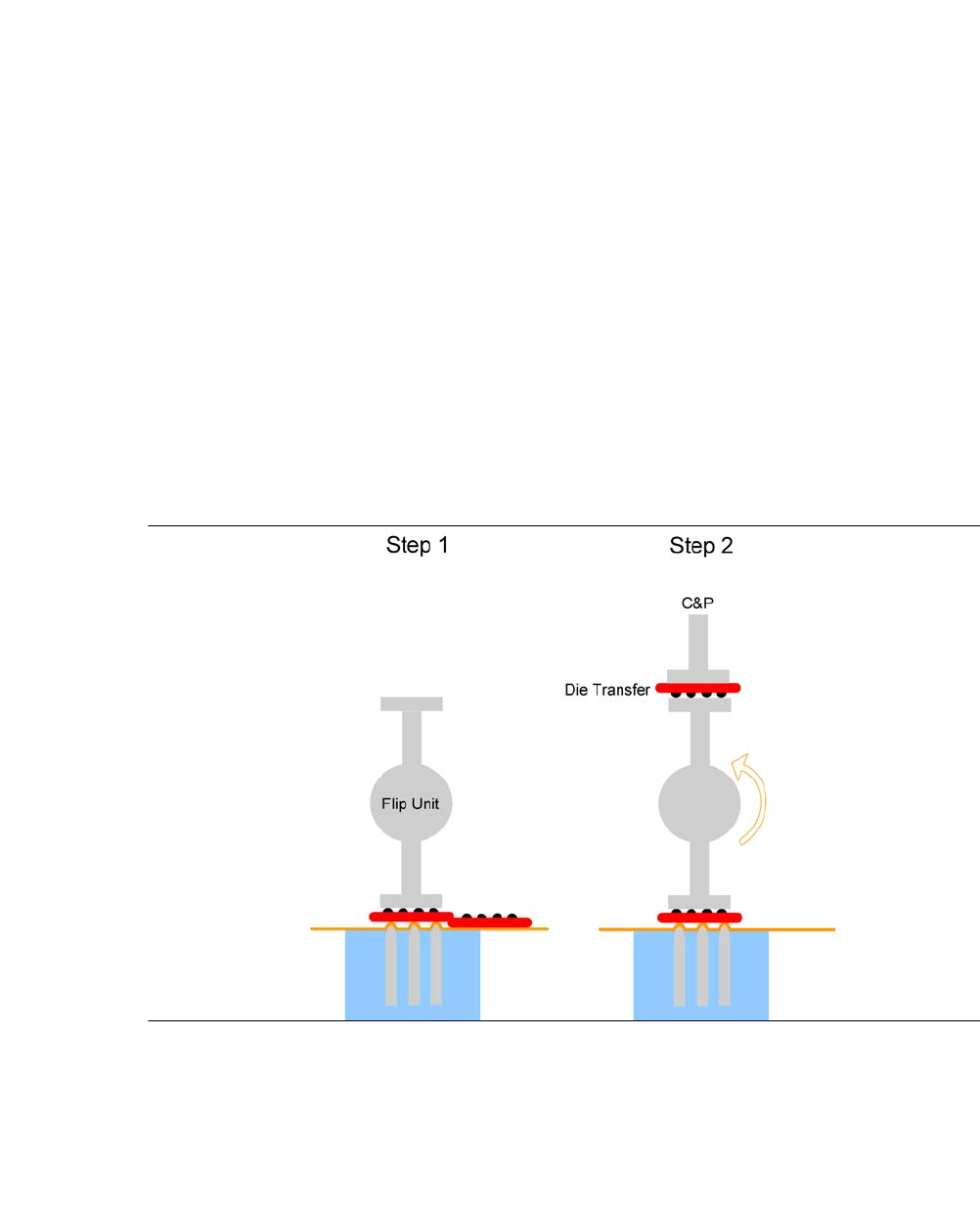
4 SIPLACE Wafer System (SWS) User Manual SIPLACE CA-Series
4.1 Functions From software version SC.708.0 Edition 12/2014
202
4.1.3.1 Flip Chip Process
The flip chip process is the standard method for SWS. This involves rotating the die by 180° before
it is placed on the board (face down placement).
The flip chip process is a method which is rapidly gaining in popularity. This process is primarily
used for consumer electronics assemblies (e.g. processors, graphics processors, memory).
The inputs/outputs (I/A) of the dies are directly connected to the PCB which results in several ben-
efits compared to the classical die attach process:
Less space required
Faster signal transfer
Higher I/O density per component
Fig. 4.1 - 2 Flip Chip Process
The flip chip process steps are:
– Step 1: Die release
– Step 2: The die is rotated by 180° and is passed on to the placement head. Parallel to this,
the next die is taken up by the second nozzle of the flip unit.