00195941-03-UM SiplaceCA-EN.pdf - 第151页
User Manual SIPLACE CA 3 Technical Data Edition 08/2011 EN 3.7 SIPLACE Wafer System (SWS) 151 3.7.3.1 Flip Chip Process The flip chip pro cess is the st andard method for SW S. This involves rot ating the die by 180° bef…
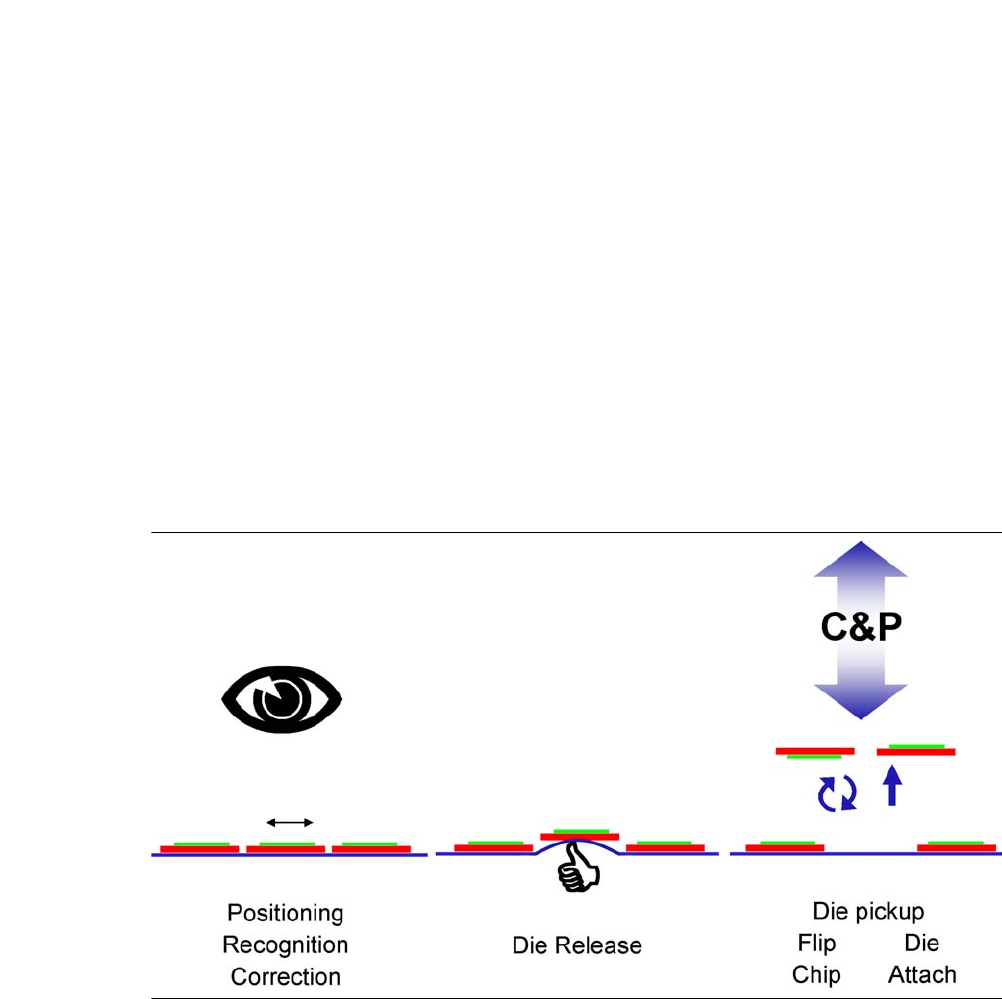
3 Technical Data User Manual SIPLACE CA
3.7 SIPLACE Wafer System (SWS) Edition 08/2011 EN
150
In order to support the whole range of process-oriented functions, the following options are avail-
able:
– Wafer map system
– Linear dipping unit
– Die attach unit:
– Small die kit (on request)
– Barcode scanner
– Wafer stretcher
– Inspection camera
3.7.3 Basic Die Presentation Process
The basic die presentation process supported by the SWS can be divided into 3 main steps:
– Die recognition and positioning for ejection (inc. inkspot recognition or wafer map)
– Ejection process
– Pickup for die attach or flip chip processing.
Fig. 3.7 - 2 Basic die presentation process
There are two main placement variants - flip chip and die attach.
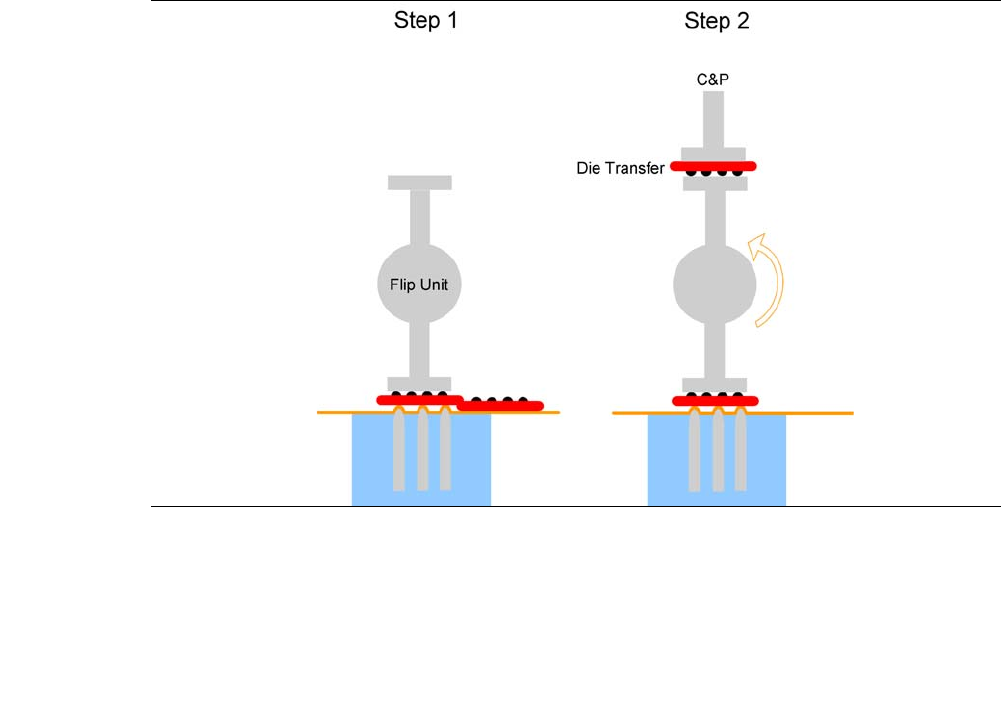
User Manual SIPLACE CA 3 Technical Data
Edition 08/2011 EN 3.7 SIPLACE Wafer System (SWS)
151
3.7.3.1 Flip Chip Process
The flip chip process is the standard method for SWS. This involves rotating the die by 180° before
it is placed on the board (face down placement).
The flip chip process is a method which is rapidly gaining in popularity. This process is primarily
used for consumer electronics assemblies (e.g. processors, graphics processors, memory).
The inputs/outputs (I/A) of the dies are directly connected to the PCB which results in several ben-
efits compared to the classical die attach process:
Less space required
Faster signal transfer
Higher I/O density per component
Fig. 3.7 - 3 Flip Chip Process
The flip chip process steps are:
– Step 1: Die release
– Step 2: The die is rotated by 180° and is passed on to the placement head. At the same time
the next die is picked up by the second nozzle of the flip unit.
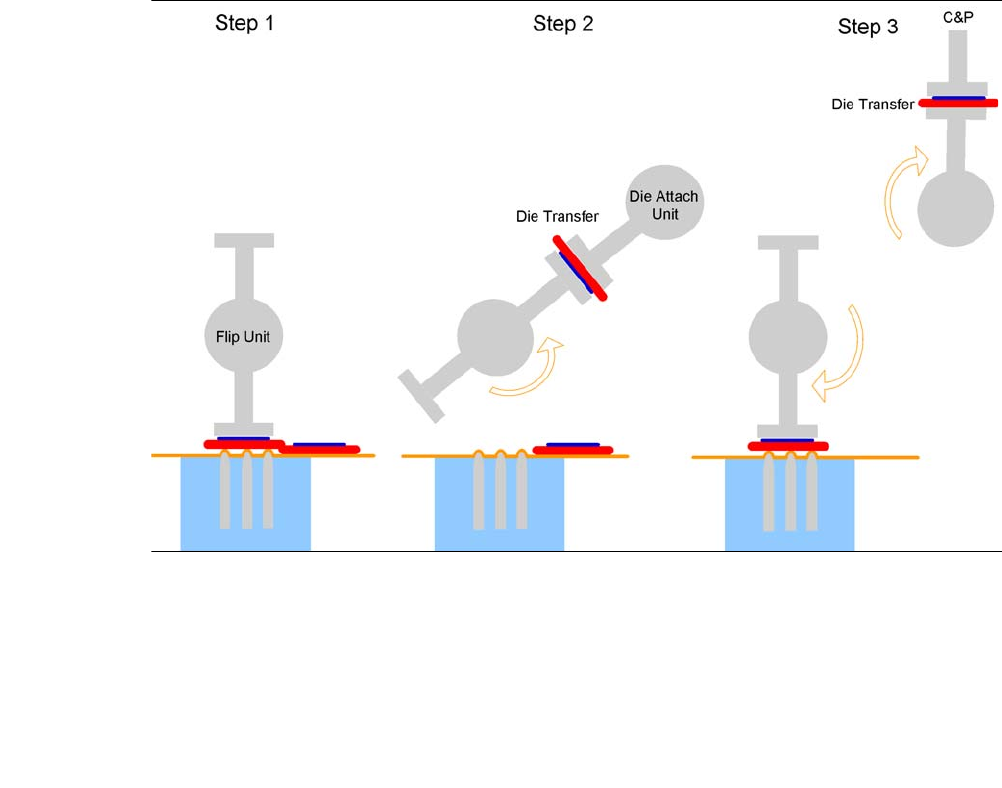
3 Technical Data User Manual SIPLACE CA
3.7 SIPLACE Wafer System (SWS) Edition 08/2011 EN
152
3.7.3.2 Die Attach Process
The optional die attach unit is used for the die attach process.
In this method, the die is placed in the same bottom/top orientation as it was on the wafer foil
("face-up" placement).
Die attach is the conventional die placement procedure. It requires an additional step in order to
establish the connection from the die to the board (wire connections).
Fig. 3.7 - 4 Die attach process steps
The die attach process steps are:
– Step 1: Die release
– Step 2: The die is rotated by approx. 130°and handed over to the die attach unit.
– Step 3: The die attach unit rotates the die into pickup position and passes it on the placement
head. At the same time the flip unit picks up the next die.