多功能晶圆单元使用说明书.pdf - 第94页
5. Job 的设定和编辑 INS-NXTMWU-4.2S 80 多功能晶圆单元使用说明书 5.3.2 补充信息 关于 Vision Process Pattern 的设定 多功能晶圆单元为了进行 bad die 检出和吸取位置补正, 在吸取晶片之前进行影像处理。 请 参照下表,选择 Vision Proce ss Pattern。 关于 Process Times 的设定 该项目只是在使用晶圆图表时才 有效。 如果使用晶圆图表, 则事…

INS-NXTMWU-4.2S 5. Job 的设定和编辑
多功能晶圆单元使用说明书 79
创建 Bad Mark 数据时的注意事项
如果设定了大于 Bad Mark 的扫描区域,就不能正确地进行 Bad Mark 判定。请将扫描区域设
定在 Bad Mark 内。
使用手动指令取得影像后,就能够确认是否能够正确地识别 Bad Mark。关于影像获取指令,
请参照 "8.5.2 影像获取 "。
Top View
Lighting Color
(Red/Blue) 指定检查晶片时的影像处理用光源的颜色
Top View
Lighting
Pattern
(Incident+Sideligh
t/Incident/
Sidelight)
指定检查晶片时的影像处理用光源的类型
[Error]
Vision Error
Recovery Times
(0 ~ 99) 设定晶片吸取前发生影像处理错误时的补
件次数
[Bad Mark]
Color (Black/White) 指定晶片的 bad mark 的颜色。
Read Level (0 ~ 256) 设定晶片的 bad mark 的明暗判定的 CCD
等级。
Position X, Y (-12.700 ~ 12.700
mm)
设定晶片的 bad mark 的坐标 (X,Y)。
Scan Area X, Y (0.000 ~ 25.400
mm)
设定晶片的 bad mark 的扫描区域 (X,
Y)。
Do Check when
using Wafer Map
(Yes/No) 使用晶圆图表时如果进行 bad mark 的识
别,则设定 Yes。
项目名 值 说明
01NST-1996S
ᠿᦣऎඳᠿᦣऎඳ
㤤՟˖
%DG0DUNݙ䆒ᅮᠿᦣऎඳ
ϡ㛑ℷ⹂߸ᅮⱘ՟˖
䆒ᅮњѢ%DG0DUNⱘᠿᦣऎඳ

5. Job 的设定和编辑 INS-NXTMWU-4.2S
80 多功能晶圆单元使用说明书
5.3.2 补充信息
关于 Vision Process Pattern 的设定
多功能晶圆单元为了进行 bad die 检出和吸取位置补正,在吸取晶片之前进行影像处理。请
参照下表,选择 Vision Process Pattern。
关于 Process Times 的设定
该项目只是在使用晶圆图表时才有效。
如果使用晶圆图表,则事先在晶圆图表设定不良晶片的位置。生产时不进行设定位置的影像
处理。不良晶片在大范围内时,不进行必要的位置补正而直接进行吸取动作,有可能错误地
吸取了相邻的晶片。
即使存在不良晶片,通过设定 Process Times 能够按照被设定的间隔读取影像并补正位置,
防止误吸取。
备注 )跳过晶片不是 Process Times 的对象。晶圆上不存在晶片或不能进行影像读取的晶片
作为跳过晶片设定的对象。
Auto 通常请选择该类型。根据晶片的尺寸和是否有晶圆图表等条件,从以下 3
种自动地选择 1 种。
·All Die: 晶片的短边为 1mm 以下时。
·Custom: 晶片的短边超出 1mm 并且使用晶圆图表,不识别 bad mark 时。
·PP First: 晶片的短边超出 1mm 并且使用晶圆图表,识别 bad mark 时。
晶片的短边超出 1mm 并且不使用晶圆图表时。
All Die 为标准模式。对每个晶片进行 [ 影像取入 ]-[ 吸取位置补正 ]-[ 吸取 ]。
因为吸取精度良好,所以,尺寸 1 mm 以下的晶片使用该模式进行吸取。
对于超出 1 mm 的晶片,如果想要提高吸取精度时,请选择该模式。
对所有的晶片进行影像处理,并且在不使用晶圆图表的时候进行 bad mark
的检出。如果使用晶圆图表,则按照设定进行 bad mark 的检出。
(Do Check when using Wafer Map)
即使没有晶圆图表也能进行生产。
PP
First
为高速模式 A。首先,在 1PP 周期内对所有的晶片成批进行影像取入,然
后成批进行吸取。与标准模式相比,虽然产能提高了,但是吸取精度降
低。
尺寸超出 1 mm 的晶片使用该模式进行吸取。
对所有的晶片进行影像处理,并且在不使用晶圆图表的时候进行 bad mark
的检出。如果使用晶圆图表,则按照设定进行 bad mark 的检出。
(Do Check when using Wafer Map)
即使没有晶圆图表也能进行生产。
Custom 为高速模式 B。在 1PP 周期内只对开头的晶片进行影像取入,然后进行吸
取。与高速模式 A 相比,产能提高了。尺寸超出 1 mm 的晶片使用该模式
进行吸取。
因为并不是对所有的晶片进行影像处理,所以不检测 bad mark。
生产时,需要使用晶圆图表。
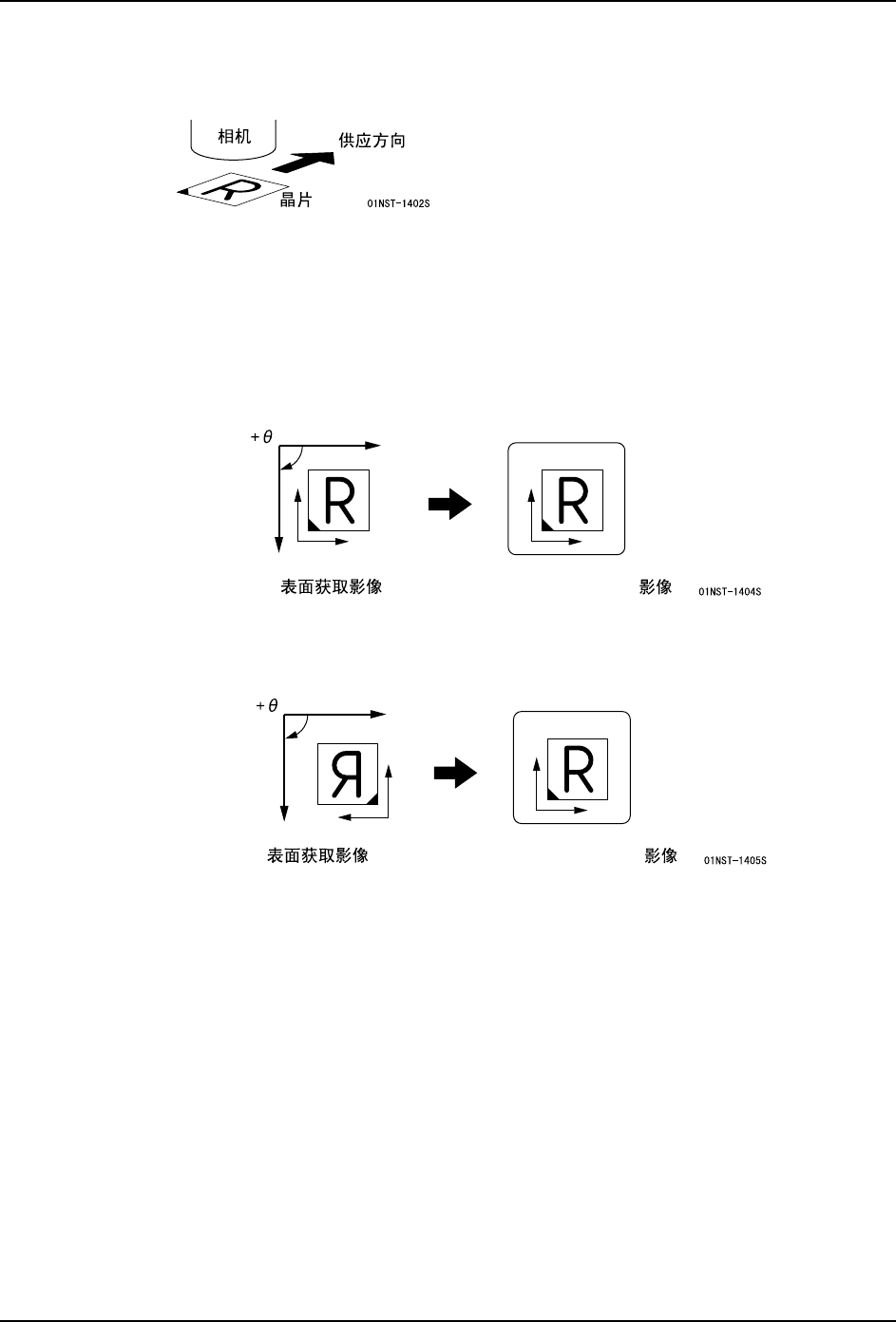
INS-NXTMWU-4.2S 5. Job 的设定和编辑
多功能晶圆单元使用说明书 81
关于上面影像处理数据的创建
此处,说明表面获取影像和 Seek Temeplete Editer 编辑影像。
备注 )VT60 时,使用 Seek Templete Editer 所编辑的数据在生产中不能使用。
此处开始的插图均表示从上看到的状态。另外,是按照贴装 0 deg 进行记述,所以,如果存
在贴装角度时,获取影像与插图有所不同。
· 往复臂供应模式:MWU PP 相机的情况
通过测试指令,使用 PP 相机进行拍摄。通过该影像创建数据。
· 直接供应模式:NXT 定位相机的情况
通过测试指令,使用定位相机进行拍摄。通过该影像创建数据。
H
+X
+Y
V
Seek Templete Editer
+X
+Y
H
+X
+Y
V
Seek Templete Editer
+X
+Y