IPC-TM-650 EN 2022 试验方法.pdf - 第410页
IPC-2-4-53-20 Figure 20 T ypical Dye and Pull Separation Locations A. Solder ball B. Metal pad C. Package substrate D. Board E. Fracture at package side intermetallic compound (IMC)/solder interface F . Fracture at board…
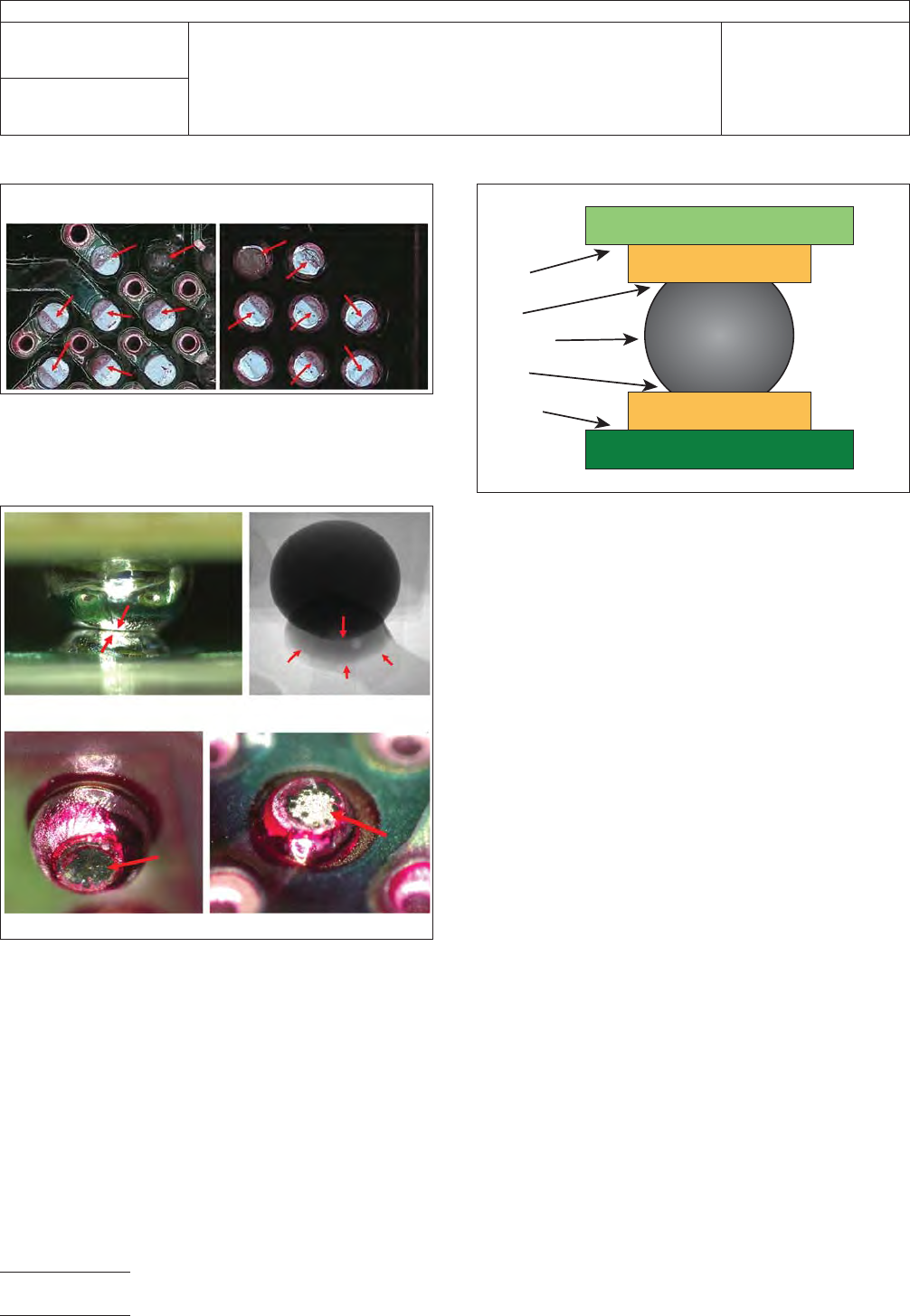
Figure 17 Example of Separation Surfaces After
Component Removal
1. Board side
2. Part side
12
Figure 18 Examples of Head on Pillow (HoP) Failures
A. Optical; IC carrier side on top and board side on bottom
B. X-ray image
C. Post dye and pull; IC carrier side
D. Post dye and pull; board side
A
B
C
D
IPC-2-4-53-19
Figure 19 Example of Dye and Pull Location Type
1. Type 1X
2. Type 2X
3. Type 3X
4. Type 4X
5. Type 5X
6. BGA substrate
7. Copper pad on BGA
8. BGA solder sphere
9. Copper pad on board
10. Board laminate
1
2
5
3
6
7
9
8
10
4
IPC-TM-650
Number
2.4.53
Subject
Dye and Pull Test Method (Formerly Known as Dye and Pry)
Date
8/2017
Revision
Page8of11

IPC-2-4-53-20
Figure 20 Typical Dye and Pull Separation Locations
A. Solder ball
B. Metal pad
C. Package substrate
D. Board
E. Fracture at package side intermetallic compound (IMC)/solder interface
F. Fracture at board side IMC/solder interface
G. Fracture at package metal/IMC interface
H. Package pad lift/crater
J. Fracture within bulk solder
K. Board pad lift/crater
L. Fracture at board metal/IMC interface
A
B
C
D
E
F
G
H
J
K
L
B
IPC-TM-650
Number
2.4.53
Subject
Dye and Pull Test Method (Formerly Known as Dye and Pry)
Date
8/2017
Revision
Page9of11

IPC-2-4-53-21
Figure 21 Example of Dye and Pull Location Type Coverage Mapping
B
A
= 0 %
= 1 to 25 %
= 26 to 50 %
= 51 to 75 %
= 76 to 100 %
B
C
D
E
CDE
1
AX
X X
X
B
C
D
E
F
G
H
J
K
L
M
N
O
P
Q
R
T
U
V
W
2345678910111213
2B 4B 3D
3D
2D
3E
3B
3B
2B
2B
14 15 16 17 18 19 20
IPC-TM-650
Number
2.4.53
Subject
Dye and Pull Test Method (Formerly Known as Dye and Pry)
Date
8/2017
Revision
Page 10 of 11